ESte manuscrito presenta: Fragmentos de vidrio) Y Café (chip flexible)) Material de embalaje technologies. Con el desarrollo de la tecnología de embalaje de alta densidad, Engranajes Y Café La tecnología se ha utilizado ampliamente en todo tipo de pantallas planas y productos móviles personales. Engranajes Y Café Debido a su alta densidad, la tecnología se ha convertido en la principal tecnología de embalaje utilizada en la fabricación de LCD, Múltiplo I/O, Y utiliza principalmente el embalaje de pegamento conductO.
Palabras clave Engranajes, Café, adhesivo conductor anisotrópico, paquete LCD
1. Prefacio
La popularización de la electrónica móvil y la pantalla grYe promueve el rápido desarrollo de bajo costo, Tecnología de producción electrónica de alta densidad y alta densidad. Productos electrónicos grYes, como pantallas LCD, TV LCD, TV de plasma, Productos electrónicos medianos y pequeños, como teléfonos móviles, Cámara digital, Cámara digital, Otros productos 3....C tienden a ser ligeros, Delgado y corto. Esto requiere alta densidad y pequeño tamaño. La nueva generación de tecnología de embalaje se puede instalar libremente para satisfacer las necesidades anteriores. En este caso,Engranajes Y Café Rápido desarrollo de la tecnología, Convertirse en el principal envoltorio del controlador Circuito integradoPara pantallas planas como LCD y PDP, Luego se convierte en una parte importante de estos módulos de visualización. Al mismo tiempo, Tener Adhesivo conductor anisotrópico Tecnología de embalaje, Su campo de aplicación se está expYiendo rápidamente, Y se ha aplicado a la RFID, Equipo Médico Electrónico, Electrónica personal móvil y otros productos microelectrónicos.
2... Estructura Engranajes Y Café
Nombre completo Engranajes ¿Hay un chip en el vidrio?, En chino, se llama "Tecnología de chips de vidrio".. Encapsula directamente Circuito integrado A través del vidrio Adhesivo conductor anisotrópico((ACF)), Y realiza la interconexión y encapsulación Circuito integrado Proyecciones conductivas en vidrio y almohadillas conductivas transparentes Ito. Nombre completo Café Es un chip flexible o un chip de película fina, Qué es la tecnología de chips Sustrato flexible Chino, También se ha convertido en una tecnología de ensamblaje de película blYa. Similar a Engranajes Tecnología, Este Circuito integrado El chip se encapsula directamente en una placa de circuito impreso flexible para lograr una alta densidad de embalaje, Pérdida de peso, Reducción del volumen, Flexión e instalación libres.
Si Circuito integrado, Sustrato flexible, Panel de vidrio, Placa de circuito impreso, and other passive components (capacitors, Resistencia, Etc..) are connected in an appropriate way (such as the Circuito integrado Conexión directa al panel de vidrio a través de ACF, Sustrato flexible y Circuito integrado and glass panel use ACF) For connection, Los sustratos flexibles y los componentes pasivos pueden conectarse mediante soldadura de reflujo convencional, Sustrato flexible Placa de circuito impreso can be connected by traditional soldering or plugging) to form a display module with Engranajes or Café packaging.
Engranajes and Café Uso principal del embalaje Adhesivo conductor anisotrópico Realización Circuito integrado Sustrato de vidrio o sustrato flexible, Y Circuito integrado Estructura del chip flip - chip. La tecnología de puntos salientes del chip flip - Chip y la tecnología de puntos salientes en el sustrato se presentarán a los lectores en futuros artículos especiales.. A continuación se describen las tecnologías básicas de fabricación flexible e interconexión ACF..
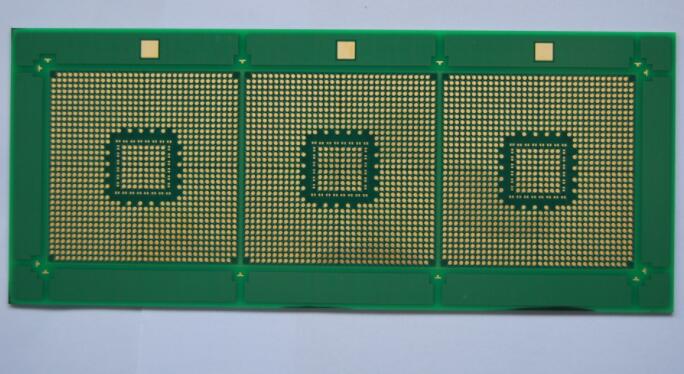
3. Producción de circuitos finos Sustrato flexible
Con el aumento de la densidad de visualización de la pantalla, la E / S del chip conductor debe aumentar considerablemente, y la distancia entre las almohadillas de plomo es inferior a 30℃. Por lo tanto, la demanda de patrones de circuitos finos para sustratos flexibles también está aumentando, y el espaciamiento de la almohadilla de interconexión también está aumentando. Ha alcanzado 15 ¼m y sigue bajando. Por lo tanto, la tecnología de fabricación de Placa de circuito impreso flexibles se convierte en el foco de la investigación. En la actualidad, la producción de circuitos finos en sustratos flexibles incluye principalmente métodos de sustracción, semi - adición y adición.
3.1 Capa de sustracción r Métodos
The subtractiveCapa El método es el método principal del método tradicional FPC Producción. Se utiliza para pegarCapa Película seca o recubrimiento fotosensibleCapa Fotorresistente líquido en fccl, Y luego a través de la exposición, Desarrollo, Grabado, Descamación, Y finalmente formar el patrón de circuito necesario. La distancia de ancho de línea obtenida por sustracción está estrechamente relacionada con la resolución del fotorresistente.Capa. Resolución del fotorresistenteCapa Determinado por el espesor del inhibidor de la corrosiónCapa. Espesor más delgado, Puede formar un patrón de circuito más fino en un fotorresistenteCapa. Esto se debe a que la luz se dispersa a través de los inhibidores de la corrosiónCapa. Cuanto más gruesa es la resistencia a la corrosiónCapa, Cuanto mayor es el grado de dispersión, mayor es el error de la línea formada. Hacer que el ancho de línea sea inferior a 50 μm, El espesor de la película seca debe ser inferior a 20 μm, Pero es muy difícil hacer una película seca demasiado delgada., Por lo tanto, se prefiere un proceso de película húmeda más delgado y controlable que la película seca.. La empresa incluso puede utilizar rodillos recubiertos con fotorresistentes líquidos para producir películas húmedas de 5 ¼m. Pero la película húmeda demasiado delgada inevitablemente tendrá defectos tales como agujeros de alfiler, Espuma, Scratch, Su uniformidad no es tan buena como la película seca., Por lo tanto, la película seca no puede sustituirse a corto plazo.. Por las razones anteriores, Además, el grabado lateral inevitable en el proceso de grabado, El ancho de línea límite de la sustracción es de 20 ¼m. Si quieres un circuito más delgado, Debe mezclar con diluyente 9 ¼m, Lámina de cobre ultrafina de 5 pulgadas o incluso 3 pulgadas, Para minimizar el tiempo de grabado, Reducir la corrosión lateral, Y obtener líneas finas. Sin embargo,, Estas láminas de cobre gruesas y los procesos conexos están en fase experimental y no pueden fabricarse a gran escala..
3.2 SemiaditividadCapa method
If you want to make a more refined circuit, Puede considerar el uso de semiadicionesCapa method. This
The base material of the semi-additive method is mostly 5μm thin copper foil, and someTiempos the conventional copper foil can be used after being thinned by Etc.hing [9]. De esta manera, La dispersión de la luz no tiene ningún efecto adverso en el patrón del circuito, Y un agente anticorrosivo más gruesoCapa Se puede utilizar para hacer que el circuito sea inferior a 20 μm.
3.3 Capa adicional method
TheCapaEl método de adición es un método de procesamiento directo de un sustrato aislante para formar un patrón de circuito.
La razón de la película sputteringCapa CR entre Pi y cobre posteriorCapa Para aumentar la fuerza de unión entre Pi y cobreCapa Y prevenir el cobre posteriorCapa De la descamación. Este método puede producir el mejor circuito disponible actualmente, Distancia entre líneas hasta 3 ¼m. Otra ventaja de este método es que se puede utilizar una película seca fotosensible gruesa para aumentar el espesor del circuito., Por ejemplo, una relación de aspecto de 8, which can suppress the increase in DC resistance (R) when the circuit is refined. Sin embargo,, Este método requiere el uso de dispositivos de fabricación de semiconductores, Proceso complejo y alto costo.
4.. Interconnection technology of chip and substrate
En la actualidad, la tecnología de interconexión de sustratos flexibles y circuitos integrados incluye principalmente la interconexión eutéctica au SN, la interconexión de adhesivos conductores anisotrópicos y la interconexión de adhesivos no conductores.
4.1 proceso de Unión eutéctica au SN
El proceso utiliza Circuito integrado Chip y estaño FPC Los cables interiores forman eutéctica au - SN en la superficie de contacto mediante calentamiento y presión para lograr el objetivo de la conexión. The soldering temperature of this method must be above the formation temperature of the gold-tin eutectic (325-330°C), Esta es una prueba estricta de la resistencia al calor del sustrato. Además, La temperatura de soldadura correcta es difícil de dominar. Cuando la temperatura de la conexión es relativamente baja, Falta de formación eutéctica del plomo interno, Hacer que el plomo interno se abra. Sin embargo,, Cuando la temperatura del conector es demasiado alta, Cuando la eutéctica au - SN permanece fundida, la herramienta de soldadura se eleva y se aleja, Esto puede conducir fácilmente a un circuito abierto de plomo interno. Y, Cuando la temperatura es baja, el recubrimiento de estaño en el plomo interno es más grueso., the tin will not be absorbed by the gold (no eutectic formation), Esto causará cortocircuitos y fugas. Es importante elegir la temperatura adecuada., Hoy en día, la temperatura de 400 grados Celsius es más común.
Con el fin de satisfacer la necesidad de una unión más estrecha, se ha desarrollado un proceso de unión por compresión en caliente para contactos au - au. El mecanismo de difusión metálica se utiliza para formar una unión local. Sin embargo, debido al Alto punto de fusión del oro, la Unión au - au requiere una temperatura de unión más alta y un tiempo de unión más largo que la Unión au - SN para formar difusión. En este punto, la deformación del sustrato puede ser muy grave. Sin embargo, el uso de la tecnología de soldadura asistida por ultrasonido y la tecnología de limpieza de la superficie de plasma puede reducir eficazmente la temperatura necesaria para la soldadura. La industria está de acuerdo en que la tecnología eutéctica puede satisfacer más de 20 um de distancia de línea de conexión, de lo contrario es fácil de cortocircuito.
4.2 Película adhesiva conductora anisotrópica (ACF) connection process
El material ACF dispersa partículas metálicas finas o bolas de plástico recubiertas de metal en el material de resina y existe en forma de película en estado de fase B. Después de unir el ACF entre las protuberancias Circuito integrado y el circuito en el sustrato, la resina fluye con la presión, temperatura y tiempo adecuados, y las partículas conductoras entran en contacto con las protuberancias y el circuito en el sustrato para realizar la conducción eléctrica. Al mismo tiempo, debido al tamaño adecuado de las partículas conductoras y a la cantidad añadida, las proyecciones y las proyecciones no pueden ponerse en contacto entre sí para realizar la conductividad anisotrópica.
Hay varios tipos de ACF en el mercado, pero el m ás comúnmente utilizado son partículas de plástico chapado en oro de 3 - 5 ¼m de diámetro, que se forman dispersando en un sistema de resina epoxi termoestable con una densidad de 40000 - 60000 PCS / Milímetro cuadrado. Debido a que la resina epoxi se cura y contrae después de La prensa caliente, la fuerza de unión entre las proyecciones Circuito integrado y el circuito de sustrato es buena. Las partículas conductoras son extrudidas y deformadas, y la fuerza elástica generada hace que las partículas conductoras entren en contacto más estrecho con la interfaz superior e inferior, y la conductividad eléctrica es mejor. Además, dado que las partículas conductoras son elásticas, incluso si la superficie de conexión no es muy plana, la diferencia de presión generada por las partículas conductoras puede ser contrarrestada por la fuerza elástica de las partículas conductoras. Sin embargo, debido a las partículas conductoras, el ACF tiene un problem a de cortocircuito, y el ancho de línea demasiado pequeño hace que las partículas conductoras que pueden ser capturadas en el contacto sean muy pequeñas, lo que hace que sea imposible procesar conexiones Circuito integrado con un ancho de línea inferior a 17 ¼m. La fiabilidad eléctrica de la conexión ACF no es tan buena como la del proceso Eutéctico. En el proceso de reflow posterior, también puede deformarse debido al estrés térmico, lo que conduce a una disminución de la conductividad eléctrica o incluso a un circuito abierto. Sin embargo, la fiabilidad del ACF puede satisfacer plenamente los requisitos si se dominan los parámetros del proceso de Unión del ACF (temperatura de compresión, presión, tiempo, velocidad de calentamiento, etc.). Además, el proceso ACF tiene las características de baja temperatura de prensado (por debajo de 200℃), procesamiento simple, alto rendimiento y protección del medio ambiente. Se ha convertido en el principal método de interconexión entre Engranajes y Café. Al mismo tiempo, ACF es la forma principal de conectar el sustrato flexible y el panel de vidrio.
4.3 Adhesivo no conductor (NCA) connection process
El método de unión NCA se basa principalmente en el contacto directo entre el chip y los electrodos a ambos lados del sustrato para realizar la conducción eléctrica, mientras que el objetivo del NCA es completar la Unión de compresión de electrodos mediante el endurecimiento y la contracción de la resina, y utilizar las propiedades mecánicas de la resina para mantener el Contacto y la conducción eléctrica entre los electrodos. La fuerza opresiva necesaria. La función del material NCA es proporcionar una fuerza de unión entre el bulto y el punto indirecto del Circuito del sustrato, y proteger los contactos y mantener una buena fiabilidad. Por lo tanto, el material debe tener las siguientes características: buenas propiedades mecánicas y físicas, incluyendo alto Tg, Alto Módulo elástico, Alto encogimiento y bajo coeficiente de expansión térmica, buen efecto humectante, resistencia a la humedad, adherencia y resistencia al impacto; Puede curarse a alta temperatura (20 segundos, 150 ~ 250℃) durante un corto período de tiempo; Tiene un excelente rendimiento de aislamiento eléctrico. El proceso NCA es compatible con el proceso ACF y sólo necesita añadir un dispositivo de Unión Eléctrica antes del equipo de calibración. En el proceso NCA, la probabilidad de cortocircuito transversal es muy pequeña debido al contacto mecánico directo entre el bulto y el circuito del sustrato. Por lo tanto, el NCA puede manejar conexiones Circuito integrado (17 ¼m o menos) que son m ás pequeñas que el espacio límite entre los procesos eutécticos y ACF. Sin embargo, la NCA requiere más materiales que la ACF. Por ejemplo, la planitud de la altura de la protuberancia del chip debe ser buena, la superficie del sustrato debe ser muy plana, el sustrato debe tener una mayor estabilidad dimensional, y los cables de conexión deben ser dorados para evitar la formación de óxido. La fiabilidad de la conexión de NCA debe ser probada. Estos factores limitan el uso del ANC y lo impiden temporalmente convertirse en un proceso principal.
6. Conclusiones
Con el desarrollo de la tecnología de embalaje de alta densidad, Engranajes and Café La tecnología se ha utilizado ampliamente en todo tipo de pantallas planas y productos móviles personales. Engranajes and Café La tecnología se ha convertido en la principal forma de encapsulación del controlador LCD Circuito integradoDebido a sus muchas ventajas, como la alta densidad, Múltiplo I/O principalmente encapsulado con adhesivo conductor. Café Es una tecnología de embalaje muy prometedora. Debido al progreso de la tecnología de fabricación de circuitos flexibles, Su alta resistencia a la flexión, Puede añadir componentes pasivos, No es necesario hacer cables colgantes, Y la tasa de utilización del área del panel es alta. Se ha extendido al campo de embalaje de alta densidad, además de Paquete LCD, combined with ACF Interconexión technology, Café La tecnología se ha convertido en una de las formas de embalaje más densas en la actualidad..