El encapsulamiento multichip (mcp) ha satisfecho durante mucho tiempo la necesidad de encapsular más rendimiento y funciones en un espacio cada vez más pequeño (pcb). Es natural esperar que el MCP de la Memoria se extienda para incluir asic como procesadores de Banda base o multimedia. Pero también hay dificultades, es decir, altos costos de desarrollo y propiedad / reducción de costos. ¿¿ cómo resolver estos problemas? El concepto de encapsulamiento IC en cascada (pop) está siendo ampliamente aceptado en la industria.
Pop (packaging on packaging), también conocido como componente apilado, también conocido como capa de embalaje. El pop es un encapsulamiento compuesto por dos o más bga (encapsulamiento de matriz de rejilla esférica) apiladas juntas. Por lo general, la estructura de encapsulamiento apilado de pop adopta la estructura de bola de soldadura bga, y en la parte inferior del encapsulamiento de pop se integran dispositivos lógicos de señal digital o híbrida de alta densidad para satisfacer las características de los dispositivos lógicos de varios pines. Como una nueva forma de embalaje altamente integrada, pop se utiliza principalmente en teléfonos inteligentes modernos, cámaras digitales y otros productos electrónicos portátiles, desempeñando un papel muy amplio.

El MCP es una tecnología híbrida que apila verticalmente varios tipos de chips de memoria o no memoria de diferentes tamaños en una carcasa envasada en plástico. Esto puede ahorrar espacio para los PCB de placas de circuito impreso pequeñas.
Desde el punto de vista arquitectónico, sip es integrar múltiples chips funcionales, incluidos procesadores, memorias y otros chips funcionales en un solo paquete, logrando así funciones básicas y completas. Desde el punto de vista de los productos electrónicos terminales, SIP no solo presta atención al rendimiento / consumo de energía del CHIP en sí, sino que también realiza todo el producto electrónico terminal corto, delgado, multifuncional y bajo consumo de energía. Con el auge de productos ligeros como dispositivos móviles y portátiles, la demanda de sip es cada vez más evidente.
El concepto básico de Soc es integrar más dispositivos en el mismo chip de metal desnudo para lograr el objetivo de reducir el tamaño, mejorar el rendimiento y reducir los costos. Sin embargo, en el mercado de teléfonos móviles, donde el ciclo de vida del proyecto es muy corto y los costos son altos, las soluciones SOC tienen grandes limitaciones. Desde el punto de vista de la configuración de la memoria, diferentes tipos de memoria requieren mucha lógica, y dominar diferentes reglas y tecnologías de diseño puede ser muy desafiante, lo que afectará el tiempo de desarrollo y la flexibilidad necesaria para la Aplicación.
SOC y sip
SOC es muy similar a sip porque ambos combinan sistemas que contienen componentes lógicos, componentes de memoria e incluso componentes pasivos en una sola unidad. Desde el punto de vista del diseño, SOC es un alto grado de integración de los componentes necesarios para el sistema en el chip. Desde el punto de vista de la encapsulación, sip es un método de encapsulamiento lado a lado o superpuesto para diferentes chips. Es un único paquete estándar que integra múltiples componentes electrónicos activos con diferentes funciones, dispositivos pasivos opcionales y otros dispositivos, como Dispositivos microelectrónicos o ópticos, para lograr ciertas funciones.
En términos de integración, por lo general, SOC solo integra sistemas lógicos como ap, mientras que sip integra AP + Mobile Dr. Hasta cierto punto, sip = SOC + ddr. A medida que la integración sea cada vez mayor en el futuro, es probable que emmc se integre en el sip. Desde el punto de vista del desarrollo de envases, SOC se ha establecido como el foco y la dirección de desarrollo del diseño futuro de productos electrónicos debido a los requisitos de volumen, velocidad de procesamiento o características eléctricas de los productos electrónicos. Sin embargo, con el aumento continuo de los costos de producción de SOC y la aparición frecuente de obstáculos técnicos en los últimos años, el desarrollo de Soc se enfrenta a cuellos de botella, lo que hace que el desarrollo de sip atraiga cada vez más la atención de la industria.
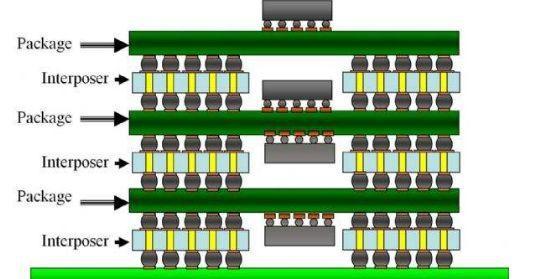
El camino de desarrollo de MCP a pop
Los productos de memoria combinados (flash + ram) que integran múltiples Flash nor, Nand y Ram en un solo paquete son ampliamente utilizados en aplicaciones móviles. Estas soluciones de encapsulamiento único incluyen encapsulamiento multichip (mcp), encapsulamiento a nivel de sistema (sip) y Módulos multichip (mcm).
La necesidad de ofrecer más funciones en teléfonos cada vez más pequeños es el principal motor del crecimiento de mcp, sin embargo, desarrollar soluciones que mejoren el rendimiento manteniendo el tamaño pequeño es un desafío difícil. No solo el tamaño es un problema, sino también el rendimiento, como cuando se utilizan chipsets de Banda base o coprocesadores multimedia en teléfonos móviles, se utilizan memorias MCP con interfaces SDRAM y ddr.
El encapsulamiento apilado pop es una buena manera de lograr una miniaturización altamente integrada. En los envases apilados, el embalaje exterior (pop) se ha vuelto cada vez más importante en la industria de envases, especialmente en aplicaciones móviles, debido a su capacidad de apilar unidades lógicas de alta densidad.
Ventajas del encapsulamiento pop
1. los dispositivos de almacenamiento y los dispositivos lógicos se pueden probar o reemplazar por separado para garantizar la producción;
2. el encapsulamiento pop de doble capa ahorra el área del sustrato, y un mayor espacio longitudinal permite más capas de encapsulamiento;
3. mezclar dram, ddramslam, flash y microprocesadores a lo largo del PCB longitudinal;
4. proporcionar flexibilidad de diseño para diferentes fabricantes de chips puede mezclarse simplemente para satisfacer las necesidades de los clientes y reducir la complejidad y el costo del diseño;
5. en la actualidad, esta tecnología se puede utilizar para cubrir y ensamblar chips de capa en dirección vertical;
6. las conexiones eléctricas apiladas entre los dispositivos superiores e inferiores permiten una velocidad de transmisión de datos más rápida y pueden hacer frente a la interconexión de alta velocidad entre los dispositivos lógicos y los dispositivos de memoria.