Il nome completo di BGA è "Ball Grid Array", che significa un PCB con una struttura a griglia sferica. È un metodo di confezionamento per circuiti integrati che utilizzano vettori organici. Le schede PCB con BGA generalmente hanno più piccoli fori e il foro passante inferiore BGA è solitamente progettato come un foro finito con un diametro di 8-12mil. Il foro passante inferiore BGA deve essere collegato, il cuscinetto di saldatura non può essere inchiostrato e il cuscinetto di saldatura non è forato.
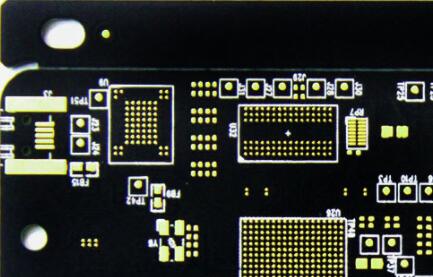
BGA è un tipo di componente che utilizza il metodo di imballaggio della matrice di sfere di saldatura. Produce sfere di saldatura sul fondo del substrato di imballaggio come interfaccia del circuito stampato, che è collegato al circuito stampato. I componenti BGA sono adatti per componenti di montaggio superficiale, con un gran numero di pin nel circuito, maggiore densità di imballaggio, maggiore funzionalità e maggiore affidabilità. La CPU di BGA è utilizzata principalmente sui laptop.
Norme generali per la progettazione di tamponi BGA
1) Il diametro del cuscinetto di saldatura è solitamente più piccolo del diametro della sfera di saldatura. Per ottenere un'adesione affidabile, viene generalmente ridotta del 20% -25%. Più grande è il pad di saldatura, minore è lo spazio di cablaggio tra i due pad.
2) Il pad sul substrato BGA ha lo stesso diametro del pad sul PCB.
3) Il design del cuscinetto di saldatura di BGA dovrebbe garantire che l'apertura del modello causi perdite di pasta di saldatura di ¥ 0,08 mm3, che è il requisito minimo per garantire l'affidabilità del giunto di saldatura.
Principio del processo di imballaggio BGA
Il flusso di processo principale degli imballaggi BGA include la produzione di sfere di saldatura, la produzione di substrato, l'incollaggio di chip, la solidificazione dell'imballaggio e l'imballaggio di taglio.
1) Produzione di sfere di saldatura: Facendo uso di lega di stagno-piombo ad alta purezza o materiali senza piombo per produrre sfere di saldatura, formando una matrice sferica regolare del perno.
2) Produzione di substrati: Utilizzando circuiti stampati multistrato come substrati per raggiungere l'interconnessione elettrica ad alta densità e ad alte prestazioni.
3) Collegamento del chip: Attaccare il chip al substrato e collegarlo al substrato utilizzando saldatura senza piombo o a base di piombo.
4) Imballaggio e indurimento: Il chip è incapsulato con resina epossidica per proteggerlo dalle influenze ambientali.
5) Imballaggio diviso: tagliare il chip confezionato in pacchetti BGA separati.
Tecniche di imballaggio BGA
1. Pad design: Per garantire la qualità e l'affidabilità della saldatura, pad design deve seguire alcune linee guida. In primo luogo, è necessario assicurarsi che la dimensione del cuscinetto di saldatura corrisponda a quella della palla di saldatura. In secondo luogo, l'influenza della forma e del layout del pad sull'espansione termica e la contrazione deve essere considerata. Infine, occorre prestare attenzione anche al trattamento superficiale del cuscinetto di saldatura per migliorare l'affidabilità della saldatura.
2. processo di saldatura: la saldatura BGA utilizza solitamente la tecnologia di saldatura di riflusso. Per garantire la qualità della saldatura, è necessario controllare la temperatura di saldatura, il tempo e la curva della temperatura del forno. Inoltre, occorre prestare attenzione anche allo stress termico al momento della saldatura per evitare difetti di saldatura.
3. ispezione di qualità: Dopo l'imballaggio e la saldatura BGA, l'ispezione di qualità è necessaria per garantire l'affidabilità della connessione. I metodi di rilevazione comunemente usati includono test a raggi X, test di emissione acustica, ecc. L'ispezione a raggi X può osservare visivamente la struttura interna dei punti di saldatura e rilevare i difetti di saldatura. Il test delle emissioni acustiche determina la qualità della saldatura analizzando i segnali acustici.
4. riparazione e manutenzione: Per l'imballaggio BGA con saldatura scadente, attrezzature speciali di riparazione possono essere utilizzate per la ri-saldatura. Di solito, il processo di riparazione include passaggi come la pulizia del pad, il rifornimento della palla di saldatura e il riattaccamento del chip. Durante il processo di riparazione, è necessario controllare la temperatura e il tempo di riscaldamento per evitare danni al chip.
5. progettazione e layout: nella progettazione del circuito, il layout e il cablaggio degli imballaggi BGA sono cruciali. Fattori quali le prestazioni elettriche, le prestazioni termiche e la resistenza meccanica devono essere pienamente considerati. Durante il processo di layout, si dovrebbe prestare attenzione a questioni come l'integrità del segnale, la stabilità dell'alimentazione e la gestione termica per ottenere sistemi elettronici ad alte prestazioni.
Vantaggi e svantaggi degli imballaggi BGA
Vantaggi:
1) Alta densità: l'imballaggio BGA ha una più grande spaziatura dei pin, che può raggiungere un numero maggiore di pin I/O e soddisfare i requisiti dei circuiti integrati ad alte prestazioni.
2) Prestazioni eccellenti di trasmissione del segnale: A causa del breve percorso di connessione delle sfere di saldatura, l'imballaggio BGA ha induttanza parassitaria e capacità inferiori, che è favorevole alla trasmissione del segnale ad alta velocità.
3) Buona prestazione termica: le sfere di saldatura incapsulate BGA possono condurre efficacemente il calore, contribuendo a ridurre la temperatura di funzionamento del chip.
Svantaggi:
Processo produttivo ad alta domanda: gli imballaggi BGA hanno requisiti elevati per i processi e le attrezzature di saldatura, il che aumenta i costi di produzione.
Il packaging BGA è una tecnologia di montaggio superficiale caratterizzata dalla formazione di una matrice sferica regolare di pin nella parte inferiore della confezione. Questo metodo di imballaggio presenta vantaggi come la grande spaziatura dei pin, la buona prestazione termica e la prestazione superiore della trasmissione del segnale, rendendolo ampiamente utilizzato nei circuiti integrati ad alta velocità e ad alte prestazioni.