Affidabilità dei giunti di saldatura del piede a sfera del circuito stampato
1. la differenza dei coefficienti di espansione termica locale Poiché il CTE del chip stesso è solo 3ppm / grado Celsius, mentre il bordo trasportatore organico è vicino a 15 ppm / grado Celsius, quindi quando l'imballaggio e l'assemblaggio sono sottoposti a calore forte, così come la generazione di calore interno nel lavoro successivo del componente, causerà un sacco di stress. Lo stress di trazione, e poi sotto lo sforzo accumulato, spesso causano la rottura del collo e la rottura. Tuttavia, nei passaggi di utilizzo della colla d'argento come Anjing, se la colla d'argento può essere ispessita, alcuni problemi locali di disallineamento CTE possono anche essere alleviati. Poiché l'area centrale del fondo addominale non è facile ottenere abbastanza calore ed è difficile saldare sotto di esso, i progettisti osano solo posizionare importanti sfere di segnale alla periferia del fondo addominale e solo alcune insignificanti sfere di collegamento terra e dissipazione del calore possono essere disposte all'interno.
In secondo luogo, l'altezza della ballaMaggiore è l'altezza della palla post-saldatura, migliore è l'affidabilità. Solitamente l'altezza della sfera post-saldatura di 63/37 è di circa 400-640μm, ma l'altezza di Sn/Pb90 può essere aumentata a 760-890μm. In generale, vari processi ad alta temperatura appiattiranno l'altezza della palla; Ad esempio, l'altezza originale di una palla è 750μm, l'altezza dopo l'impianto della scheda portante sarà ridotta a 625μm e l'altezza del PCB sarà ridotta a 500μm dopo l'assemblaggio. Più la palla è piatta, peggiore è l'affidabilità. La tabella a destra mostra la relazione tra altezza 63/37 palla, campo palla e diametro pad. L'altezza della palla originale è solitamente ridotta del 10% dopo la saldatura a fusione e l'altezza della palla originale sarà ridotta del 250% se c'è un dissipatore di calore.
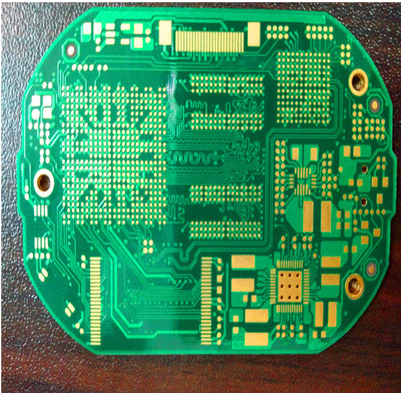
3. l'influenza della forma del pad e del trattamento superficialeBGA's top carrier ball planting place dopo il riscaldamento ripetuto, può causare crepe dell'interfaccia a causa della forza di taglio, quindi il pad a sfera deve essere appositamente progettato con meno rischio "limite di vernice verde". Tuttavia, questo tipo di giunti di saldatura che limitano l'espansione della saldatura diventerà una zona pericolosa di concentrazione di stress e la sua affidabilità sarà notevolmente minacciata se lo stagno non è completamente disperso. Nel caso della stessa altezza in piedi, se il SMD viene cambiato in NSMD, la saldatura scorrerà lungo la parete laterale del pad di rame nel sito di espansione, formando un forte legame come un barb. Nei giunti di saldatura PCB che non sono eccessivamente corti in altezza ma possono essere pienamente utilizzati, la successiva durata a fatica dei giunti di saldatura PCB sarà 1,25-3 volte più lunga di quella dei giunti di saldatura della scheda portante.
Lo strato di trattamento ENIG sulla superficie di supporto non è adatto per la saldatura BGA a causa della difficoltà di opacizzazione nera. La ragione principale della formazione del tampone nero è che l'acqua d'oro attacca la superficie relativamente vecchia e debole del nichel, di modo che lo strato di nichel è troppo tardi per dissolversi durante il processo di sostituzione, ma è circondato dallo strato d'oro rapidamente depositato e continua ad ossidarsi e deteriorarsi all'interno per diventare un tampone nero NixOy.
Inoltre, è meglio non impostare PTH in o vicino all'area del cuscinetto a sfera BGA della superficie della scheda PCB per impedire che la saldatura fluisca nel foro durante la saldatura della pasta di saldatura. Per quanto riguarda quelli con fori ciechi nei cuscinetti, è più probabile che causino vuoti nei giunti di saldatura. Attualmente, i vuoti aggiuntivi causati dall'aria nei fori ciechi sono considerati nell'articolo precedente e l'accettazione di tali vuoti aggiuntivi può essere discussa separatamente. Infatti, è impossibile distinguere quale sia la pasta di saldatura materia organica e umidità o il vuoto causato dal foro cieco. Attualmente, i fori ciechi con un diametro inferiore a 2mil sono stati efficaci, ma è ancora difficile appiattire fori ciechi più grandi con un diametro di 5mil o più.
Quarto, l'analisi di guasto del punto fresco del piede della palla (1) ciclo di temperatura:
Dopo aver saldato deliberatamente il BGA o CSP sulla scheda, attraverso cicli termici multipli di varie alte e basse temperature, o dopo shock termico, i giunti di saldatura spesso si rompono alla scheda, ma raramente al PCB. Ciò è dovuto al fallimento della modalità di taglio.
(2) Prova di piegatura:
Quando la superficie PCB del BGA o CSP viene saldata e superata la prova di piegatura forzata meccanica, non solo si verificheranno estremità rotte, ma si verificheranno anche piedi rotti, specialmente quelli con stress accumulato nelle quattro aree angolari, o la lunghezza della scheda. I piedi della palla elencati nella direzione sono anche inclini a teste rotte o piedi rotti. In termini di posizione di montaggio della scheda PCB, questo test è il più probabile che fallisca nell'area di facile flessione al centro della scheda.
(3) Prova di caduta:
Quando la scheda assemblata del prodotto elettronico portatile BGA o CSP viene saldata per la prova di caduta, i suoi quattro angoli sono anche più probabilmente rotti e rotti. Il meccanismo di guasto sia della prova di piegatura sopra menzionata che della prova di caduta qui dovrebbe teoricamente appartenere al modo di strappo.
Al fine di ridurre la rottura dei giunti di saldatura a sfera BGA/CSP in vari prodotti elettronici portatili, American Amkor ha utilizzato colla su entrambi i lati dei quattro angoli di questi componenti tipo griglia per rafforzare il divario tra scheda e scheda. Il processo di giunzione aggiuntivo è chiamato riempimento angolare per sostituire il metodo Under Fill di costosi imballaggi flip chip.