Substrato di imballaggio IC - Tecnologia di fondo PCB
Con la tendenza di sviluppo della miniaturizzazione, portabilità, multifunzionalità, basso consumo energetico e basso costo dei prodotti elettronici, la tecnologia di imballaggio 2D (bidimensionale) non è stata in grado di soddisfare i requisiti e alcuni prodotti hanno iniziato a svilupparsi nella direzione di imballaggi 2.5D o 3D. Nella struttura di imballaggio 2.5D o 3D, la combinazione di scheda adattatore a base di silicio e substrato organico è un modo importante per realizzare l'interconnessione tra chip e chip, chip e substrato.
Il processo di fabbricazione tradizionale del PCB del substrato dell'adattatore TSV è il seguente: 1) facendo fori ciechi sul substrato; 2) Lo strato di passivazione sulla parete laterale del foro passante è stato depositato dal PECVD su un lato del substrato; 3) Attraverso lo strato della barriera di adesione/diffusione della parete laterale del foro e il metallo dello strato del seme sono stati depositati sul substrato mediante sputtering monolaterale del magnetron; 4) Attraverso il riempimento del metallo del foro è completato dal processo di galvanizzazione; 5) Attraverso l'appiattimento del metallo del foro; 6) Il metallo passante sul retro del substrato è esposto per assottigliamento; 7) Fare cavi metallici, pad e il suo strato protettivo.
Il metodo tradizionale di preparazione del substrato IC di trasferimento TSV presenta i seguenti difetti o carenze:
(1) L'uniformità dello strato di passivazione sulla parete laterale del foro profondo depositato dal PECVD è povera. Lo spessore dello strato isolante nella parte inferiore del foro profondo è solo circa 1/5 di quello in alto e la copertura dello strato isolante nella parte inferiore è scarsa. È facile produrre difetti discontinui, che influiscono seriamente sull'effetto isolante e sull'affidabilità. Ciò limita anche la capacità di deposizione del rapporto di larghezza di profondità del processo di deposizione dello strato di passivazione;
(2) L'uniformità dello strato della barriera di adesione/diffusione e dello strato del seme sulla parete laterale del foro profondo depositato dallo sputtering magnetron è povera. Lo spessore del fondo del foro profondo è solo circa 1/5 di quello della parte superiore. La copertura del fondo del buco profondo è scarsa. È facile produrre difetti discontinui e portare a cavità durante la galvanizzazione, che influisce seriamente sull'affidabilità del foro passante. Attualmente, la capacità di deposizione dell'apparecchiatura di sputtering magnetron più avanzata è inferiore a 15:1, che limita la capacità di deposizione di TSV;
(3) quando il rapporto di aspetto del foro profondo è 20: 1-30: 1, è difficile realizzare il processo di riempimento galvanizzato libero del foro e la grande apertura occuperà l'area di assemblaggio dei componenti e ridurrà l'area di cablaggio, che non è favorevole all'imballaggio ad alta densità;
(4) Limitato al tradizionale processo di fabbricazione del substrato di trasferimento TSV, lo spessore del substrato di trasferimento è solitamente inferiore a 200 μ m. Può essere utilizzato solo come substrato di trasferimento e non può essere montato direttamente con l'intera scheda;
(5) il costo del bordo adattatore TSV è alto e il processo di imballaggio è complesso, quindi non ha alcun vantaggio di costo in molte tecnologie di imballaggio;
(6) la piastra dell'adattatore TSV ha il problema di affidabilità a causa della differenza fisica tra il silicio e il materiale organico del substrato, quindi è difficile integrare la struttura;
(7) Il substrato organico ordinario può soddisfare i requisiti generali di imballaggio di densità, ma non può raggiungere i requisiti di imballaggio di densità ultra-alta (come il montaggio inverso dell'urto di intervallo inferiore a 55um).
Lo scopo del modello di utilità è realizzato come segue
La struttura di un substrato di imballaggio ic comprende un substrato comune, in cui la superficie superiore del substrato comune è dotata di una pluralità di tamponi I e la superficie inferiore è dotata di una pluralità di tamponi II,
Include anche substrato ad altissima densità, chip ad alta densità, chip a bassa densità e strato di incapsulamento I. lo strato di incapsulamento I è disposto sulla superficie superiore del substrato ordinario. Il substrato ad altissima densità è composto da diversi strati di strati metallici di riavvolgimento ad alta densità e da uno strato isolante distanziato selettivamente tra di loro e la superficie superiore è fornita di un cuscinetto, Due o più strati degli strati metallici di riavvolgimento ad alta densità sono collegati selettivamente tra loro elettricamente, il substrato ad altissima densità è incorporato nello strato di incapsulamento I, e la sua superficie superiore e pad sono esposti dallo strato di incapsulamento I e parte del pad sulla superficie superiore del substrato ad altissima densità è inversamente collegato al chip ad alta densità, Diversi elettrodi metallici esterni del substrato sono formati fuori dall'area verticale del chip ad alta densità, la superficie superiore di una parte dell'elettrodo metallico esterno del substrato è collegata inversamente al chip a bassa densità e la superficie inferiore dell'elettrodo metallico esterno del substrato è collegata al pad I parziale del substrato comune attraverso il foro cieco che penetra lo strato di imballaggio I e il metallo nel foro cieco, Una parte della superficie inferiore dell'elettrodo metallico esterno del substrato è collegata a una parte del pad del substrato ad altissima densità e il pad II è dotato di un urto di saldatura. La larghezza della linea / distanza della linea dello strato metallico di riavvolgimento ad alta densità del substrato ad altissima densità del modello di utilità è inferiore a 6 / 6um. In alternativa, la larghezza della linea / distanza della linea dello strato metallico di riavvolgimento ad alta densità del substrato ad altissima densità è di 5 / 5um, 3 / 3um o 1,8 / 1,8um. Il numero di strati dello strato metallico di riavvolgimento ad alta densità del substrato ad altissima densità del modello di utilità è più di cinque. In alternativa, il numero di strati dello strato metallico di riavvolgimento ad alta densità del substrato ad altissima densità è 6, 7 e 8. Il modello di utilità comprende anche uno strato di incapsulamento II, che copre le parti esposte del chip ad alta densità, il chip a bassa densità, il substrato ad alta densità, lo strato di incapsulamento I e l'elettrodo metallico esterno del substrato. In alternativa, include anche un foro passante, il foro passante penetra lo strato di rivestimento I e il substrato comune, la parte interna del foro passante è riempita di metallo e la superficie inferiore della parte dell'elettrodo metallico esterno del substrato è collegata con il pad parziale II del substrato comune attraverso il metallo nel foro passante.
L'effetto benefico del modello di utilità è che:
La struttura mista del substrato di imballaggio di densità del modello di utilità adotta il substrato organico ad altissima densità invece dell'interposer di Si ed è incorporata nella struttura organica comune del substrato per fornire la più piccola distanza di linea/linea e più strati di strato metallico di riavvolgimento ad alta densità, in modo da integrare e imballare più chip ad alta densità e chip a bassa densità all'interno della stessa area di imballaggio, può non solo abbreviare efficacemente il percorso di trasmissione delle informazioni, ma anche realizzare più funzioni, più potenza e più cavi, che è favorevole alla trasmissione del segnale più veloce, in modo da adattarsi al miglioramento rapido dei componenti IC semiconduttori ad alta velocità, alta frequenza e grande capacità, e ridurre ulteriormente lo spessore complessivo dell'imballaggio, è una tecnologia di imballaggio conveniente e flessibile per adattarsi a molte applicazioni ad alte prestazioni interessate dallo spazio;
Il modello di utilità fa pieno uso delle caratteristiche flessibili del substrato ad altissima densità, migliora l'affidabilità dell'imballaggio ed è favorevole al miglioramento della resa del prodotto.
Tra questi: substrato ad altissima densità 10, elettrodo metallico esterno 110, foro cieco 150, foro passante 170, substrato ordinario 20, pad I 230, pad II 250, palla di saldatura 251, strato di rivestimento I 310, strato di rivestimento II 430, chip ad alta densità 51, chip a bassa densità 53, strato di rivestimento II 610.
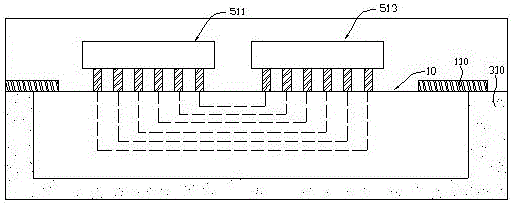
Esempio specifico di modalità di attuazione
Il substrato ic comune 20 si riferisce generalmente ai materiali di base per la fabbricazione di substrato di imballaggio elettronico e scheda madre che trasportano componenti elettronici. Ha tre funzioni di conduzione, isolamento e supporto. Generalmente, il substrato è placcato in rame laminato. Attraverso la lavorazione selettiva del foro, la placcatura chimica del rame, la placcatura del rame, l'incisione, ecc., la grafica del circuito è ottenuta sul substrato e diversi pad i230 e diversi pad 2 250 sono formati sulla superficie superiore del substrato comune 20. Generalmente, la distanza di larghezza/linea dello strato metallico del substrato comune 20 è 40/40um, 20/20um e 8/8um e la larghezza di linea/spaziatura può essere raggiunta da 10/10um nella situazione limite. La struttura del substrato di imballaggio del modello di utilità è disposta sopra il substrato comune 20 con un substrato ad alta densità 10 con caratteristiche flessibili. Il substrato ad altissima densità 10 è composto da diversi strati di strato metallico di re-cablaggio ad alta densità e lo strato isolante spaziato selettivamente tra di loro. C'è un collegamento elettrico selettivo tra due o più strati metallici di ri-cablaggio ad alta densità. Il cuscinetto di saldatura è impostato sulla superficie superiore del substrato ad altissima densità 10, che ha le caratteristiche di luce, sottile, resistenza alla caduta e di alta plasticità di forma. Si può vedere che rispetto al substrato ordinario 20, la distanza larghezza / linea del substrato UHD 10 è più piccola, il numero di strati di strato metallico di re-cablaggio ad alta densità è più e lo strato metallico di re-cablaggio dell'area dell'unità è più denso. Pertanto, è chiamato substrato ad altissima densità 10, il cui spessore totale non è più di 100um, che è favorevole a ridurre lo spessore complessivo dell'imballaggio ic.
Il substrato di imballaggio del modello di utilità adotta la tecnologia di elaborazione del livello del wafer, non ha bisogno di utilizzare il complicato processo TSV, evita una serie di problemi come il processo di galvanizzazione del foro profondo e l'applicazione del substrato flessibile ad altissima densità 10 migliora l'affidabilità dell'imballaggio, che è favorevole al miglioramento della resa del prodotto.