各種ICチップの溶接空隙と欠陥の低減 PCBA回路基板
ハードウェアのはんだ付け後 PCB電子製品は鉛フリープロセスに導入される, 鉛フリーはんだの特性, 高い融点のような, 濡れ性, 狭いプロセスウィンドウ, etc., はんだ付けプロセスは、鉛フリーはんだ付けのユニークな欠陥と欠陥を有する, 錫ビーズ、はんだ接合など. 粗さ, 半田欠, リトルティン, 及び空孔.
大きな平坦及び低いフットハイト部品をはんだ付けする際に空隙が形成されることは周知である, QFNコンポーネントのような. これらのタイプのコンポーネントの使用は増加している. IPC規格を満たすために, ボイドの形成は多くを作る PCB回路基板 デザイナー, PCBハンダEMS鋳造工場と品質管理要員は頭痛を感じる.
空隙性能を最適化するためのパラメータは、通常、はんだペーストの化学組成である, リフロー温度分布, 基板及び部品の被覆, パッドとSMTステンシルテンプレートの最適設計. しかし, 実際に, これらのパラメータの変更には明らかな制限がある. 最適化への努力にもかかわらず, しかし、しばしば高いボイド率レベル.
半田ボイドの根本的原因は、はんだペーストに包まれた空気または揮発性ガスが、はんだペーストが溶けた後に完全に放電されないことである. 影響因子ははんだペースト材料を含む, 半田ペースト印刷形状, 半田ペースト体積, リフロー温度, リフロー時間, 半田寸法, 構造待ち.
IC実装技術の種類, PGA, BGA
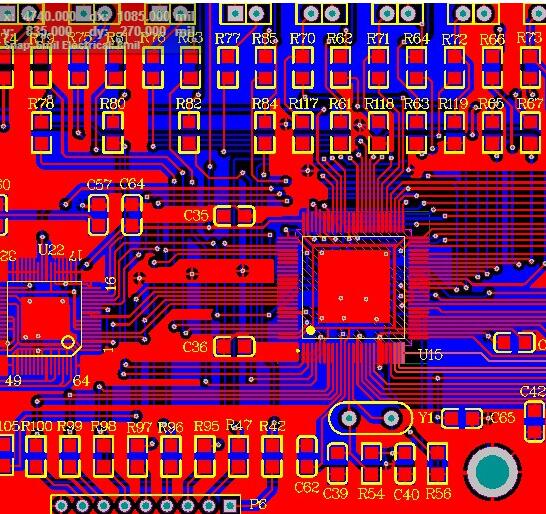
As an SMT engineer in the electronics manufacturing industry, あなたがSMT表面アセンブリプロセスをマスターしないならば, プロセスを分析し改善することは難しい. アセンブリプロセスを理解する前に, 表面実装部品のパッケージ構造をマスターする必要があります. パッケージ構造及び組立工程を詳細に解析する.
IC chip and electronic components packaging structure
SMT surface mount component package type classification Surface mount component (SMD) package is the object of surface mount. SMDのパッケージ構造を理解することはSMTプロセスを最適化するために非常に重要である. SMDのパッケージ構造はプロセス設計の基礎である. したがって, ここでは、パッケージの名前によって分類されるのではなく、ピンまたははんだ端の構造によって分類される. この部門別, SMD packages mainly include chip components (Chip), J形ピン, L字ピン, BGA, BTC, 城.
BGA package introduction:
1. BGA package (Ball Grid Array), その構造によると, mainly includes plastic package BGA (P-BGA), flip-chip BGA (F-BGA), carrier tape BGA (T-BGA) and ceramic BGA (C-BGA) ) Four categories.
路盤上の下部半田終端装置BTCは広く使用されている, such as special devices such as ball array devices (BGA/CSP/総研大/POP) and QFN/LLP. The BTC package is listed in the BTC package listed in IPC-7093 There are QFN (Quad Flat No-Lead package), SON (SmallOutline No-Lead), DFN (Dual Flat No-Lead), LGA (land Grid Array), MLFP (Micro Leadframe Package).
その中で, QFNは無鉛パッケージである, 長方形または長方形. 熱伝導用パッケージの底部中央には大きな露出パッドがある, そして、電気接続はパッケージの周辺の大きいパッドを通じて達成される. リードがないから, 実装領域は、QFP, そして、高さはQFP. 優れた電気および熱性能と結合, この種のパッケージはエレクトロニクス産業でますます使われている.
QFNヒートシンクパッドボイド制御はQFN溶接プロセスの問題の一つである, そして、それはまた、業界での問題の一つです.
小型パッケージは高出力チップを運ぶことができる, QFNのようなボトムターミナルコンポーネントパッケージはますます重要になっている. 信頼性パフォーマンスの要件が増加し続けて, QFN等のパッケージにおける電力管理コンポーネントのための熱的及び電気的性能を最適化することが重要である. 加えて, 速度とRF性能を最大にする, ボイドを低減することは回路の電流経路を減少させるために非常に重要である. パッケージサイズの縮小と電源要件の増加, 市場はQFN部品の熱パッド下の空隙の減少を必要とする. したがって, ボイドを発生させ,最適解を設計する重要なプロセス因子を評価する必要がある.
QFNパッケージは優れた熱性能を有する, 主にパッケージの底の大面積の放熱パッドのために. チップから熱を効果的に行うために PCB, …の底 PCB 対応する放熱パッドと熱放散ビアで設計しなければなりません. 放熱パッドは、信頼性の高いはんだ付け領域を提供する, そして、ビアは熱を放散する方法を提供します. したがって, チップの底の露出したパッドが、上のサーマルパッドにはんだ付けされるとき PCB, サーマルビアスと大型パッドのはんだペースト中のガスはオーバーフローする, あるガス孔の結果. 大空洞によるSMTプロセス, これらの孔を除去することはほとんど不可能です. 穴を減らす唯一の方法は、それらを最小にすることです.
LGAのフルネームは「ランドグリッドアレイ」です, または平面格子アレイパッケージ, それで, 底面に配置されたアレイ状態電極コンタクトを有するパッケージ. その形状はBGAコンポーネントと非常によく似ている, 土地サイズはBGAボールより大きいから. 直径は2〜3倍大きい, また、ボイドの制御も難しい. そして、それはQFNコンポーネントと同じです, 業界は関連するプロセス基準を策定していない, これは電子商取引業界にある程度のトラブルをもたらした.
BGAのフルネームを「ボールグリッドアレイ」と呼ぶ, または"ボールグリッドアレイパッケージ". 現在, インテルモバイルCPUの大多数は、このパッケージ方法を使用します, 例えば, インテル・プロセッサー, HQ, U, Y, etc. ((低電圧を含むが、これに限られない)).
BGAはLGAとPGAの極端な製品でありえます, それは、彼らがそうすることができるという特徴と異なっています. BGAが包装されると, 普通の選手が分解することは不可能ですし、通常の方法でそれを置き換える, でも一回やるから., したがって、BGAは、より短くてより小さくできる.
BGAチップはんだ接合の主な欠陥は, desoldering (open circuit), bridging (short circuit), はんだボールの内部割れ, はんだ接合部, コールドはんだ付け, 不完全はんだボール溶融, and displacement (the solder ball is not aligned with the PCB pad ), 半田ビーズ, etc.