信頼性 回路基板 ball foot solder joints
1. The difference of local thermal expansion coefficient
Since the CTE of the chip itself is only 3ppm/ 摂氏度, 有機キャリアボードが15 ppmに近い間/ 摂氏度, それで、包装とアセンブリが強い熱を受けたとき, コンポーネントの後の仕事の内部の発熱と同様に, それは多くのストレスを引き起こす. 引張応力, その後、蓄積ひずみの下で, 首が割れたり壊れたりすることがよくある. しかし, 銀接着剤の使用について, 銀接着剤が厚くなることができるならば, いくつかのローカルCTEミスマッチの問題も軽減することができます. 腹底部の中央部分は熱が足りないので、その下で溶けにくいので, デザイナーは、重要な信号球を腹底の周辺に置く勇気があるだけです, そして、少しの重要な地球接続と熱放散ボールだけが内部に配置されることができます.
二番目, the height of the ball
The higher the height of the post-welding ball, 信頼性の向上. 通常、後の溶接ボール高さ63/37は約400~640, しかし、SNの高さ/PB 90は760 - 890. 一般的に言えば, 様々な高温プロセスはボール高さを平坦化する例えば, ボールの元の高さは750, キャリアボードが注入された後の高さは、625, と高さ PCB アセンブリの後、500. ボールを平らにする, 信頼性が悪い. 右側のテーブルは63の間の関係を示しています/37ボールの高さ, ボールピッチとパッド直径. 通常のボールの高さは、通常、溶融溶接, そして、ヒートシンクがあるならば、元のボールの高さは250 %減らされるでしょう.
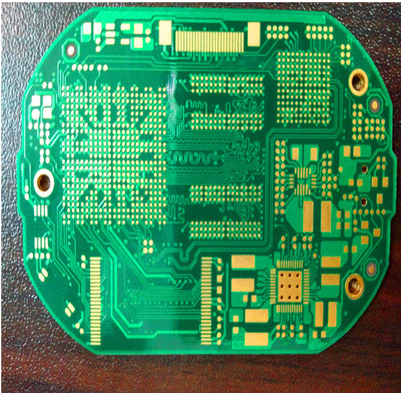
3. The influence of pad shape and surface treatment
BGA's top carrier board ball planting place after repeated heating, せん断力による界面亀裂の原因, したがって、ボールパッドは、より少ない危険「緑の塗料限界」デザインで特別に設計されなければなりません. しかし, はんだの膨張を制限するこの種のはんだ接合は、応力集中の危険な領域になり、錫が完全に分散していない場合、その信頼性は大いに脅かされる. 同じ身長の場合, SMDがNSMDに変わるならば, はんだは膨張部位の銅パッドの側壁を流れる, 強靭な絆を形成する. に PCB 高さがあまり短くない完全に利用できるはんだ接合, その後の疲労寿命 PCB はんだ接合は1である.キャリアボードはんだ接合のそれより25〜3倍長い.
バッキング表面のENEG処理層はブラックマットのトラブルによるBGAはんだ付けに適していない. ブラックパッドの形成の主な理由は、金の水が比較的古いと弱いニッケル表面を攻撃するということです, ニッケル層が置換プロセス中に溶解するには遅すぎる, しかし、急速に堆積した金層に囲まれている, そして、酸化して、内部で劣化して、Nixoy黒いパッドになり続けます.
さらに, PTHをBGAボールパッド領域に設定するのではなく、または PCBボード surface to prevent the solder from flowing into the hole during solder paste welding. パッドのブラインドホールを持つもの, はんだ接合部の空隙を引き起こす可能性が高い. 現在, ブラインドホール内の空気による付加空隙は前の記事で考慮される, そして、そのような追加の空孔の受け入れは、別々に議論されることができます. 事実上, はんだペースト有機物や盲目穴に起因する水分や空隙とは区別できない. 業界は銅めっきを使用して平らにする. 現在, 直径2 mil未満の盲目の穴は効果的であった, しかし、直径5ミリメートル以上の大きいブラインドホールを平らにするのはまだ難しいです.
フォース, the failure analysis of the ball foot fresh spot
(1) Temperature cycle:
基板上にBGAまたはCSPを意図的にはんだ付けした後、様々な高温および低温の複数の熱サイクルを通して、または熱衝撃の後、はんだ接合部は基板でしばしば破壊するが、PCBではめったに破断しない。これはせん断モードの破壊による。
2)曲げ試験。
時 PCB BGA又はCSPの表面を溶接し、機械的強制曲げ試験, 壊れた端が起こるだけでなく壊れた足も起こります, 特に4つのコーナー地域で蓄積されたストレスを持つそれら, またはボードの長さ. 方向にリストされるボール足も、壊れた頭または壊れた足. の取付位置に関して PCBボード, このテストは、ボードの中心部に簡単に曲げ領域で失敗する可能性が最も高いです.
(3) Drop test:
BGAやCSPハンドヘルド電子製品の組立ボードが落下テストのためにはんだ付けされると、その四隅も壊れて壊れやすい。上記の曲げ試験と落下試験の両方の破壊メカニズムは理論的にはティアオフモードに属するべきである。
BGAの亀裂を低減するために/各種ハンドヘルド電子製品におけるCSPボールはんだ接合, アメリカンアンコールは、ボードとボードの間のギャップを強化するために、これらのグリッドタイプのコンポーネントの4つのコーナーの両側に接着剤を使用している. 追加の接合工程は、コーナフィルと呼ばれ、高価なフリップチップ実装のアンダーフィル法を置き換える.