Teknologi pembekalan cip aras gelombang
Ia secara langsung menyelesaikan semua operasi pada wafer yang mengakhiri proses pembuatan wafer bahagian depan. Dalam proses pakej cip, cip dipisahkan dari wafer, sehingga WLCSP boleh mencapai volum pakej minimum dengan saiz cip yang sama, yang hampir teknologi miniaturisasi pakej akhir.
Teknologi pembekalan skala cip aras gelombang, mengintegrasikan teknologi peranti pasif-filem tipis dan teknologi pembuatan spesifikasi kawasan-besar, tidak hanya menyediakan penyelesaian penyimpanan kos, tetapi juga menyediakan faktor bentuk yang konsisten dengan proses pemasangan pemasangan permukaan yang ada. Teknologi pakej skala Chip tidak hanya menyediakan peta laluan penambahan prestasi, tetapi juga mengurangkan saiz peranti pasif terintegrasi.
Sejak kemudahan teknologi WLCSP diberitahu pada tahun 1998, berbagai jenis WLCSP telah muncul di pasar tahun-tahun terakhir. Teknologi ini telah digunakan dalam peranti elektronik bimbit, seperti cip bekalan kuasa untuk telefon bimbit, dan diperluaskan kepada aplikasi produk logik.
WLCSP adalah variasi teknologi sambungan cip terbalik. Dengan bantuan teknologi WLCSP, permukaan aktif cip kosong terbalik dan disambung ke PCB dengan bola askar. Saiz bola solder ini biasanya cukup besar (300 pada jarak 0.5 mm dan pre-reflow) μm), proses underfill yang diperlukan untuk sambungan cip flip boleh dilupakan
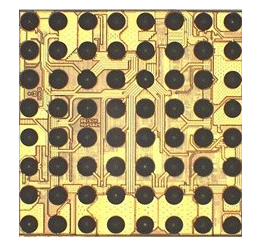
Pakej WLCSP
WLCSP boleh dibahagi ke dua jenis struktur: bump langsung dan lapisan pengedarkan semula (RDL)
Bump langsung
Bump langsung WLCSP mengandungi lapisan organik pilihan (poliimid) yang bertindak sebagai penimbal tekanan pada permukaan mati aktif. Polyimid meliputi seluruh kawasan cip kosong kecuali kawasan tingkap sekitar pad sambungan. Lapisan logam subbump (UBM) diputar atau diputar elektro di kawasan tingkap ini. UBM adalah tumpukan lapisan logam yang berbeza, termasuk lapisan penyebaran, lapisan baris, lapisan basah dan lapisan perlahan oksidasi. Bola tentera jatuh pada UBM (yang disebut bola jatuh), dan kemudian bump tentera terbentuk oleh penywelding kembali.
Lapisan Pemindahan Semula (RDL)
Lapisan pengedarkan semula (RDL) WLCSP teknologi ini boleh tukar cip kosong yang direka untuk ikatan baris (pads ikatan diatur sekeliling) ke WLCSP. Tidak seperti bumps langsung, WLCSP ini menggunakan dua lapisan poliimid. Lapisan poliimid pertama ditempatkan pada cip kosong dan menjaga pad ikatan dalam keadaan tingkap. Lapisan RDL menukar tatasusunan periferal ke dalam tatasusunan kawasan dengan menyemprot atau elektroplating. Struktur berikutnya sama dengan bump langsung - termasuk lapisan poliimid kedua, UBM dan bola jatuh.
Keuntungan WLCSP:
Mod pakej WLCSP tidak hanya mengurangkan saiz modul memori secara efektif, tetapi juga memenuhi keperluan densiti tinggi peranti bimbit untuk ruang tubuh; Di sisi lain, dalam terma prestasi, ia meningkatkan kelajuan dan kestabilan penghantaran data. Peralatan pemasangan SMT piawai boleh digunakan tanpa proses penyahisi.
1. Saiz minimum kaedah pakej cip asal:
Ciri-ciri terbesar pakej cip aras wafer WLCSP adalah untuk mengurangkan volum pakej secara efektif dan menjadikan bentuk pakej lebih ringan dan ringan. Oleh itu, ia boleh dipenuhi dengan peranti bimbit untuk memenuhi keperluan karakteristik produk mudah dan pendek yang boleh dibawa.
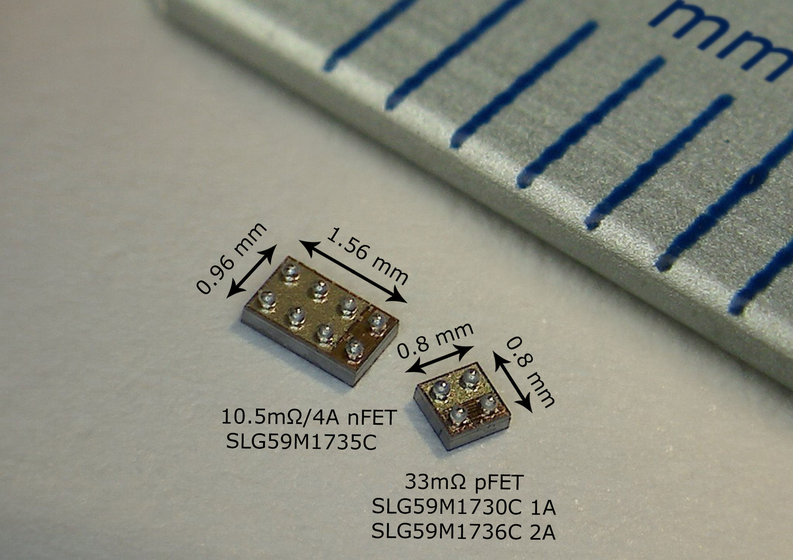
Pakej saiz minimum
2. Laluan penghantaran data pendek dan kestabilan tinggi:
Apabila menggunakan pakej WLCSP, disebabkan wayar sirkuit pendek dan tebal (garis kuning ditandai a hingga b), ia boleh meningkatkan frekuensi penghantaran data, mengurangkan konsumsi semasa dan meningkatkan kestabilan penghantaran data. Kerana ciri-ciri kalibrasi diri lembaran kosong cahaya dalam proses penywelding, hasil pengumpulan adalah tinggi.
3. Ciri-ciri penyebaran panas yang baik
Kerana WLCSP mempunyai pakej plastik atau keramik yang kurang tradisional ditutup, tenaga panas semasa operasi cip IC boleh hilang secara efektif tanpa meningkatkan suhu tubuh utama. Ciri-ciri ini sangat membantu untuk penyebaran panas peranti bimbit. Ia boleh mengurangkan induksi dan meningkatkan prestasi elektrik.
WLCSP tidak hanya boleh menyadari teknologi penting pakej dan sip yang mendesak tinggi dan prestasi tinggi, tetapi juga bermain peran utama dalam peranti yang memasukkan teknologi PCB. Walaupun proses ikatan wayar sangat matang dan fleksibel, sirkuit berbilang lapisan, grafik garis halus dan kombinasi dengan ikatan wayar teknologi WLCSP menunjukkan bahawa ia akan mempunyai aplikasi yang lebih luas dan peluang baru.
Kegagalan WLCSP: biaya WLCSP berasal dari pemprosesan wafer atau pakej. Jika produksi skala besar diperlukan, jumlah kerja perlu meningkat. Ia akan meningkatkan biaya produksi.
Masa depan teknologi WLCSP
WLCSP telah dilaksanakan dalam telefon bimbit, kad ingatan, navigator kereta dan peranti digital sejak ia dilaksanakan dalam jam elektronik pada tahun 2000. Dalam beberapa tahun ke depan, akan ada lebih banyak cip menggunakan teknologi WLCSP di pasar telefon bimbit prestasi tinggi seperti telefon bimbit.
Kombinasi teknologi WLCSP dan proses penyembelihan PCB cip boleh memastikan kestabilan kualiti pengumpulan PCB. Ini kerana WLCSP tidak hanya mudah untuk melekap PCB, tetapi juga mempunyai ciri-ciri "mati yang baik diketahui".
Teknologi WLCSP membawa lebih banyak kemungkinan untuk produksi peranti elektronik ringan dan kompak. WLCSP telah dilaksanakan pada pemasangan papan sirkuit. Baru-baru ini, ia juga menjadi bahagian penting SIP. MCP yang menggabungkan WLCSP dan teknologi ikatan wayar konvensional juga memasuki produksi massa.
Melihat pembangunan WLCSP tahun-tahun terakhir, kita boleh percaya bahawa WLCSP akan terus berkembang dan berkembang ke lebih banyak bidang dalam masa depan yang dekat.