Bila lebar baris dan jarak baris PCB are less than 50 uM (2mil), the traditional CCL Subtractive Process (SP) is almost useless. Sekarang, garis/lebar penyamaran CSP atau FC dan plat pembawa launit description in lists menghampiri 15 μm/15 μm. Dalam terma produksi massa bagi baris besar plat, hanya plat terpisah tanpa penutup foil tembaga boleh dipilih sebagai titik permulaan mSAP (Proses Semi-Tambahan) Kaedah setengah-aditif.
Proses produksi mSAP (Semi-Additive Process)
Lapisan dalaman - ABF laminaTIon - Latihan laser - Lapisan benih CU tanpa elektrik - Corak perlahan foto - PlaTIng Cu ElectrolyTIc - Pembuangan perlahan foto - Cetakan lapisan benih
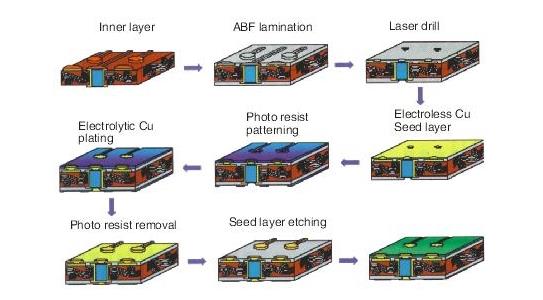
1. Struktur bahan halus ABF
Pada plat inti halus dalam dua sisi besar (atau empat lapisan) (tebal inti 2,5 mil) dengan sirkuit selesai dan rawatan oksidasi hitam, plat filem B-Stage ABF dengan filem pelindung putih bebas tembaga tetapi poliester (Mylar, Polyester) ditekan secara vakum di kedua-dua sisi, dan kemudian ia perlu dikuasai pada 180' selama 30 minit. ABF (Ajinomoto Bond Film) ini adalah plat bernilai tinggi syarikat "Taste Essence Fine Technology" (AFT) di bawah syarikat Jepun "Dayun Taste Essence". Terdapat tiga jenis produk semasa:
A. Jeneral SH9K (Tg165, TMA)
B. GX-3 Bebas Halogen (Tg153)
C. Halogen-free rendah pengembangan Z besar GX-13 (Tg156 â™™™) а The swell Z of 2 is only 155 ppm/â™™.
Perhatikan bahawa syarikat AFT tidak hanya melancarkan produk ABF biasa dalam kategori pembawa, tetapi juga memperkenalkan bahan asas jenis 2L ABF-XA5 dan bahan asas jenis 3L ABF-LE-T dalam industri papan lembut.
2. Tekan filem vakum
Pertama, papan inti dalaman akan selesai mengikut proses penghasilan papan berbilang lapisan tradisional, dan kemudian lubang resin dan seluruh permukaan papan akan sepenuhnya rata untuk memudahkan ikatan dua sisi bahan-bahan tipis ABF. Menurut bahan-bahan di laman web Ajinomoto Fine Techno (AFT), bahan-bahan ABF tiga lapisan dipotong oleh mesin pemotong filem aktif adalah seperti jenis filem kering, dan kemudian mesin pemotong filem aktif jenis vakum digunakan. Pertama, bahan ABF dua lapisan dengan penghalang yang dibuang ditempatkan pada kedua-dua sisi plat inti dalaman. Suhu filem vakum terus berlanjut adalah kira-kira 110" selama kira-kira 30 saat, dan kemudian katil tekanan panas digunakan untuk menyerap dan menguatkan filem selama 60 saat di bawah tekanan tinggi 110" dan 5kgf/cm2. Selepas itu, filem penyelamatan yang bersinar Mylar (PET) boleh dibuang dan kerja-kerja selepas keras bahan-bahan filem ABF yang ditambah boleh diteruskan. Ambil GX13 sebagai contoh, ia memerlukan 30 minit lagi penyembuhan (Pemulihan) pada 180' untuk menghitung pelengkapan lapisan tambahan.
3. Pembentukan lubang laser dan pembuangan lem papan penuh
Ketebalan filem ABF selepas tua adalah kira-kira 30-70 um, 30~40 untuk plat tipis um Dibandingkan dengan 2-4 mil lubang tembak selesai oleh laser CO2 dua sisi umum, bentuk lubang boleh kelihatan bentuk konus terbalik yang baik. Selepas pemotongan keseluruhan piring tanpa permukaan tembaga, seluruh permukaan piring dan dinding lubang boleh membentuk penampilan yang sangat kasar, dan tembaga kimia akan membantu melekat filem kering garis halus.
Tiada perbezaan besar antara tindakan untuk membuang sisa lem plat pembawa kristal dan yang umum PCB. Ia masih tiga stesen, iaitu, sebelum-bengkak, manganese (Mn+7) sol and neutralization and recovery. Perbezaan adalah bahawa umum PCB hanya berurusan dengan kawasan dinding lubang melalui lubang atau lubang buta, tetapi selain dari dinding lubang lubang buta, seluruh permukaan ABF papan perlu dikembangkan dan dicetak, in order to make 1u The m thick copper layer (more than twice as thick as the general PCB) is rougher in appearance, yang menjadikan foto filem kering dan elektroplating tembaga mendapat pegangan yang lebih baik dalam operasi wayar halus kawasan besar.
4. Perbezaan kaedah setengah-tambahan mSAP untuk pembuangan sampah karet
Secara umum, tongkat penghapusan lem plat berbilang lapisan hanya untuk PTH atau μ- Via dan dinding lubang lain, jumlah rawatan tidak besar. Namun, kaedah SAP tidak hanya berurusan dengan dinding micro-buta-lubang, tetapi juga menjawab kepada dua plat besar tanpa tembaga di permukaan. Perbezaan besar antara kedua-dua tidak boleh ditangani di laman yang sama. Perkara pertama yang perlu diubah adalah oksidasi elektrolitik tepat masa Mn+6 untuk menjaga kesan minimum cairan mandi; Kedua adalah bagaimana untuk membuang precipitat Mn+4 yang dipulihkan dalam penyelesaian mandi suhu tinggi; Yang ketiga adalah bagaimana untuk membersihkan Na2CO3 yang dikumpulkan oleh reaksi cair tank alkali kuat untuk menghasilkan CO2. Pada masa ini, tiada kaedah yang luar biasa untuk menangani masalah yang kuat seperti Mn+4 dan Na2CO3, dan hanya sebahagian dari cairan tank boleh dituangkan mengikut jumlah kawasan yang dirawat. Sudah tentu, kita juga perlu rujuk kepada graviti spesifik cair tangki untuk mengawal jumlah total Na2CO3 untuk menentukan sama ada perlu menggantikan tangki baru. Ia boleh dilihat dari ini bahawa biaya SAP tidak boleh dibandingkan dengan biaya yang biasa PCB pelacur degumming.
Perbezaan antara bahan filem ABF dan papan keras adalah selepas neutralisasi dan pemulihan, proses penggigitan pengisi seperti SiO2 atau kaca patut ditambah untuk meningkatkan kawasan permukaan luaran untuk memastikan tangkapan lapisan tembaga berikutnya. Gagal ialah sudut mati plat meningkat secara signifikan, yang menyebabkan pencetakan seterusnya lapisan tembaga yang digigit untuk membentuk garis independen, sementara lapisan palladium logam mulia untuk diaktifkan akan tetap di dalam plat, mengubur bimbang tersembunyi pengisihan yang buruk antara garis halus. Terutama apabila panel luar dikekalkan dengan lapisan tipis cat hijau, ia tidak dapat dihindari bahawa kegagalan izolasi akan berlaku semasa operasi jangka panjang dalam suhu tinggi dan persekitaran basah, dan bahkan menyebabkan masalah integriti isyarat.
5. tembaga kimia tekanan rendah sebelum imej photoresist
Selesai penampilan ABF 2 μ Selepas m tembaga kimia, photoresist filem kering boleh ditekan dan melekat, Kemudian terdedah dan dikembangkan untuk mendapatkan banyak garis dan banyak lubang buta (18 Dua sisi papan 24 "biasanya lebih dari 800000 lubang buta) - dalam pangkalan peletak tembaga untuk peletak tembaga dan tembaga mengisi lubang buta. Tembaga elektroplating di sini sama dengan tembaga sekunder PCB umum, sementara lapisan tembaga kimia sama seperti tembaga kimia dan tembaga utama ditambah pada foli tembaga CCL PCB umum.
Ia boleh dilihat bahawa tembaga kimia kaedah SAP bermain peran yang lebih penting daripada tembaga kimia PCB umum, dan kelebihannya juga diperlukan untuk ditambah ke 1! satu titik lima μ M sekurang-kurangnya dua kali lipat dari biasa. Untuk mendapat perlindungan yang lebih baik, lapisan tembaga di sini juga memberi perhatian istimewa kepada promosi pertumbuhan kristal dan pengurangan tekanan; Tidak hanya kadar produksi akan lebih lambat (kurang dari separuh tembaga konvensional), tetapi juga kos berbagai-bagai bahan kimia grad CP akan meningkat lebih daripada tiga kali. Papan pelbagai lapisan HDI umum tidak boleh membelinya sekarang, selagi papan pembawa FC tidak tahan memilih jenis grad tinggi dan tembaga kimia tekanan rendah dengan harga unit tinggi.
6. tembaga elektroplasi selepas imej filem kering
Plating tembaga yang digunakan oleh SAP adalah sama seperti yang digunakan oleh HDI biasa untuk mengisi lubang buta. Ia adalah peletak tembaga kelajuan tinggi dengan nisbah aspek rendah dan lubang tidak dalam. Dengan kata lain, ia adalah lubang pendek tembaga plating dengan sedikit perhatian kepada panjang dan kuasa tegang. Dalam pasar ELIC yang didominasi dengan menambah lapisan berulang kali dan mengisi lubang buta, permintaan utama dari peletakan tembaga kelajuan tinggi berulang ini adalah "cepat". Namun, di bawah pengendalian generasi semulajadi densiti semasa yang terbatas (Jlim) pembuluhan tembaga asid, substrat tidak boleh menarik tegangan untuk meningkatkan semasa, Selama ia dekat dengan jarak antara anod dan katod dalam bilik mandi tembaga sebanyak mungkin (plat gantung menegak telah dikurangkan dari 20 cm kepada 5~10 cm, dan plat berjalan menegak lebih mendesak kepada 2 cm), resistensi float tembaga boleh dikurangkan di bawah untuk mencapai atas densiti semasa yang tersedia. Pada masa yang sama, resistensi dan semasa boleh dikurangi dengan meningkatkan suhu cair mandi (dari 20 ♪ kepada 40 ♪). Namun, dengan cara ini, bola tembaga yang boleh solusi tidak boleh terus digunakan untuk menjaga kestabilan antarabangnya antara anod dan katod. Oleh sebab itu, anod kelas titanium yang tidak boleh ditetapkan digunakan secara luas di medan penutup tembaga lubang. Namun, anod yang tidak boleh diselesaikan menderita oleh berbagai bencana oksigen, terutama retakan dan penggunaan berlebihan aditif organik, terutama pembawa dengan jumlah terbesar. Oleh itu, jumlah komponen organik (TOC) cedera fatal penyelesaian mandi meningkat secara tetap. Untuk mempertahankan kualiti minimum platting tembaga, kita perlu menuangkan sebahagian dari penyelesaian mandi pada masa (menuangkan 1/10 penyelesaian mandi setiap minggu), hanya untuk menebus air DI untuk menahan TOC yang meningkat. Adapun konsumsi cepat anod titanium dan pembayaran oksid tembaga telah menjadi dua faktor negatif kosong lainnya. Perbezaan antara lubang dalam tradisional perlahan penutup tembaga dan lubang buta baru penutup tembaga cepat bergantung pada sikap mana.
7. Selesaikan baris selepas menggigit sebahagian tembaga
Selepas selesai proses penutup tembaga mengisi lubang buta dan garis tebal, foto boleh dibuang dan pencetakan keseluruhan boleh dilakukan secara langsung. Pada saat ini, tembaga kimia di kawasan pengisihan bukan-garis di papan adalah sangat mudah untuk dibuang, jadi perlengkapan tembaga garis pasti akan dipakai tanpa sebarang kerosakan yang tidak jelas dan meliputi, tetapi ia tidak akan menyakiti elegansi. Garis tipis tidak hanya minyak di bahu, tetapi juga kaki yang tersisa di bawah hilang. Kualitinya lebih baik! Kaedah ini dipanggil Etching berbeza.
8. Warna tidak normal bagi pad OSP bersebelahan
Semua jenis plat yang diproses oleh OSP sering mempunyai bayangan coklat yang berbeza pada dua pads beberapa kondensator. Melalui ujian kemudahan tentera dan produksi massa oleh pelanggan rendah, tiada masalah dengan kongsi tentera yang lemah. Namun, pelanggan terus-menerus masih mengejar satu sama lain dan terus-menerus meminta sebab-sebab yang sebenar dan peningkatan. Pembuat PCB juga akan cuba semua jenis kaedah dan bahkan mengesan penyedia ubat cair. Tanpa sebarang penyelesaian, ia tidak dapat dihindari untuk bertanya sama ada ada ada masalah dalam rancangan dan bentangan. Mereka mahu menendang bola kembali kepada klien untuk keluar dari masalah. Namun, tanpa bukti, kita perlu mengakui kesalahan kita dan menyelesaikan tuntutan dalam segala jenis cara untuk menyelesaikan perbedaan.
9. Kuantifikasi gigitan tembaga
Untuk memahami lebih lanjut berapa banyak tiga pads lapisan tembaga elektroplating digigit keluar dalam proses OSP dan berapa berbeza kesejukan, perisian mikroskop disengaja digunakan untuk mengukur kesejukan tiga pads tembaga untuk dibandingkan.
Selain pengukuran tebal perisian seksyen-mikro seperti itu, instrumen pengukuran kejam halus WyCo juga boleh digunakan untuk mengukur dua jenis pads tembaga yang ditandai pada permukaan bahan elektrod, supaya membuktikan kebenaran kesimpulan lagi. Menurut data yang diperoleh, tinggi tembaga seragam pad gelap independen adalah 29.1 μ m. Tinggi tembaga seragam pad warna-cahaya lubang buta sambungan adalah 25.3 μ m㴠Perhatikan bahawa warna biru dalam dua gambar berikutnya menunjukkan penampilan plat terrendah. Warna hijau adalah tinggi pad tembaga, dan warna merah di pinggir luar adalah cat hijau yang lebih tinggi.
10. Formasi filem OSP
Permukaan tembaga bersih terlebih dahulu dibuang ke dalam Cu+1 dalam solusi tangki OSP yang dilengkapi dengan asid formik atau asid acetik, dan ion tembaga monovalen ini akan segera kompleks (stagger) dengan substansi organik Imidazole dalam ubat cair untuk membentuk filem organik coklat dan secara perlahan-lahan tebal. Pad tembaga cahaya yang disebut di atas dengan lubang buta adalah cepat dan ganas dalam menggigit tembaga, yang menyebabkan sebahagian tembaga univalentnya menjadi oksidasi dengan cepat ke tembaga divalent biru dan masuk cair mandi tanpa membentuk filem. Sebagai hasilnya, tebal filem kulitnya tidak dapat dielakkan lebih rendah daripada pad yang bebas, jadi terdapat perbezaan yang kuat antara warna gelap dan cahaya.
Di sini kita berkongsi kaedah produksi massa Substrat IC in Proses mSAP.