Технология резки отдельных элементов с кристаллической окружности и последующей инкапсуляции их десятилетиями была нормой для инкапсуляции полупроводниковых интегральных схем. Однако из - за высоких производственных затрат и растущего числа RF - компонентов современных модулей основные производители полупроводников в настоящее время не используют этот метод. Таким образом, появление упаковки кристаллического круглого класса (WLP) привело к изменению парадигмы развития недорогостоящей упаковки. WLP - это технология упаковки на уровне чипа перед резким упаковкой на чипе.
Используя стандартные инструменты и процессы, WLP служит продолжением процесса изготовления кристаллических кругов. В конечном счете, изготовленный WLP DIE будет иметь металлический сварочный диск на поверхности чипа и осаждает точку сварки на каждом из них, прежде чем разрезать чип. Это, в свою очередь, делает WLP совместимым с традиционным процессом сборки PCB и позволяет тестировать устройства на самом чипе. Таким образом, это относительно недорогой и эффективный процесс, особенно когда размер чипа увеличивается, а чип DIE сжимается. За последние несколько десятилетий размер кристаллического круга увеличился с 4 дюймов, 6 дюймов и 8 дюймов в диаметре до 12 дюймов. Это привело к увеличению количества DIE на каждый чип, что привело к снижению затрат на производство. С точки зрения электрических характеристик, WLP превосходит другие технологии инкапсуляции, поскольку, как только устройство WLP интегрируется в плотный RF - модуль, оно значительно уменьшает паразитную связь EM, поскольку соединение между устройством и PCB относительно короткое, в отличие от соединений с выводами, используемых в некоторых типах технологий CSP.
Технология обратной загрузки чипов WLP
Технология инвертированных чипов, также известная как управляемое складное соединение чипов (C4), является одной из нескольких технологий сборки чипов, разработанных IBM в 1960 - х годах. Несмотря на то, что технология упаковки, основанная на соединении с выводами, является более гибкой с точки зрения свободной индукции, используемой в лабораторной отладке после сборки оборудования, а также обеспечивает хорошую теплопроводность, использование выпуклости припоя в технологии упаковки инвертированных чипов позволяет электрическому соединению между подложкой и чипом обеспечить относительное уменьшение размера и задержку, И лучшая изоляция с точки зрения ввода и вывода. На рисунке 1 показана базовая структура чипа DIE на базовой пластине с сварным шаром на верхней части колонны Cu, выращенной на поверхности чипа. Точки сварки, как правило, инкапсулируются соединениями заполненных форм для обеспечения механической поддержки точек сварки.
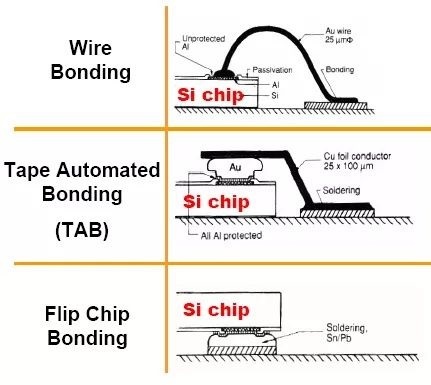
Упаковка чипов WLP
Корпорация на чипе (CSP) является одним из наиболее часто используемых методов инкапсуляции в микроэлектронике и полупроводниковой промышленности. В то время как производители микрочипов уже могут использовать несколько типов технологий CSP, новые типы CSP продолжают появляться для удовлетворения спроса на продукты, которые поддерживают новые функции и новые приложения для конкретных продуктов. Эти требования к упаковке могут варьироваться в зависимости от требуемой надежности, стоимости, дополнительных функций и общего размера. Как следует из названия, размер упаковки CSP примерно такой же, как и размер чипа DIE, что является одним из его основных преимуществ. Используя производственный процесс WLP, CSP постоянно развивается, чтобы достичь как можно меньшего соотношения размеров сердечника упакованной трубы. Как показано на рисунке 2, CSP с сферической решеткой (BGA) в упаковке позволяет несколько соединений, одновременно упрощая проводку PCB, увеличивая пропускную способность сборки PCB и снижая затраты на производство.
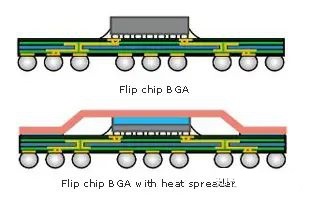
Другие технологии упаковки
Существует несколько других форм интегрированных IC - пакетов, которые позволяют беспрепятственно интегрироваться в модульные пакеты, настроенные приложениями. Четырехплоская инкапсуляция (QFP) является одной из первых технологий инкапсуляции IC для установки поверхности, в которой структура упаковки состоит из четырех сторон с расширенными соединительными выводами, как показано на рисунке 3 (a). Выдающиеся провода соединяются с каркасом упаковки для формирования конденсатора типа металл - изолятор - металл (MIM) между выводом и металлом чипа DIE, который может использоваться в качестве согласующего элемента. Эта технология применима к IC миллиметрового размера, где количество периферийных выводов в упаковке может достигать более 100. В зависимости от используемого материала этот тип упаковки имеет несколько производных, таких как керамическая четырехсторонняя плоская упаковка, тонкая четырехсторонняя плоская упаковка, пластиковая четырехсторонняя плоская упаковка (пластиковая четырехсторонняя плоская упаковка) и металлическая четырехсторонняя плоская упаковка (MQFP). QFN, Quad Flat No Lead, как показано на рисунке. 3 (b) является одной из нескольких технологий упаковки поверхностей, образованных плоской медной рамкой для проводов и пластиковой упаковкой, используемой в качестве теплопередающей прокладки радиатора. Соединения с выводами также могут использоваться для межсоединений, поскольку соединительные линии являются не только проводниками, но и индукторами, поэтому они обычно влияют на производительность устройства в соответствии с этой технологией упаковки, если они не рассматриваются как часть общей конструкции. Несмотря на то, что QFN состоит из четырех боковых соединений, двухплоские беспроводные провода (DFN) также появились и сформировали обе стороны соединительных плоских выводов.
