IC封裝 單板是指根據產品型號和功能要求對被測晶片進行加工,獲得獨立晶片的過程. IC封裝 主要提供一種介質,用於將精細的矽晶片連接到寬間距 印刷電路板 並防止設備受潮.
具體包裝形式包括:

包裝形式
鉛包裝

20世紀70年代末, 第一個被市場廣泛接受的方案是 雙列直插式(DIP), 陶瓷和塑膠包裝. 引線從封裝的兩側引出,並與封裝垂直. 通過將引脚插入電路板的通孔,可以將封裝安裝在PCB上, 然後將導線卡在電路板的另一側,並使用波峰焊科技對其進行焊接. 該封裝最多可容納40根引線和0根引線.65mm板間距.
20世紀70年代末80年代初,出現了表面貼裝科技。 晶片上的引線(引脚)和組件焊接在電路板的表面上,而不是穿過電路板。 這允許在安裝過程中使用回流焊科技,使用電路板的兩面來粘合晶片,最大引脚數為80。
到20世紀80年代中期,出現了各方面都有潛在客戶的套餐。 這種封裝被稱為四平面封裝(QFP)(引線的形狀像海鷗翼)或引線晶片載體(引線彎曲)。 J)。 最常用的典型四邊形扁平封裝的間距為0.65mm或0.5mm,引線數高達208。 20世紀90年代初,這些套裝軟體在硬碟機和圖形市場上得到了廣泛應用。
在20世紀80年代末和90年代初,裸露的Pad鉛封裝誕生了。 封裝為四邊形扁平或更小形狀的封裝,晶片鍵合端暴露在底部。 這些裸露的接合端可以焊接到電路板上,為晶片建立一條有效的散熱路徑。
The miniature Lead Frame (MLF) family of packages was developed in the 1990s. MLF is close to the Chip Scale Package (CSP), 封裝的底部引線端用於與 PCB板, 與鷗翼鉛Soic和Qual組件相反, 囙此,該組件有助於確保散熱和電力效能.
2、分層包裝
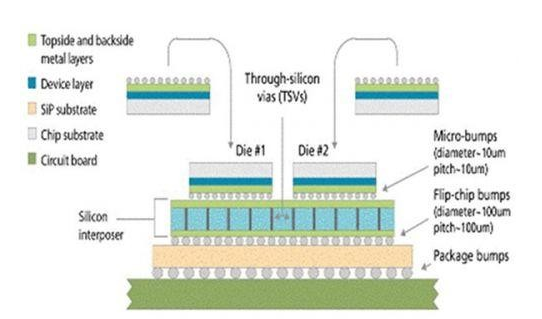
分層包裝
20世紀90年代,出現了一種稱為球栅陣列(BGA)的新型封裝,它使用層狀板作為基底資料。 基於引線框架的封裝只能通向封裝的週邊。。。 球栅陣列封裝的引線可引導至整個封裝底部的焊球。 最初,BGA封裝板的典型球距為1.27 mm。
3、晶圓級封裝
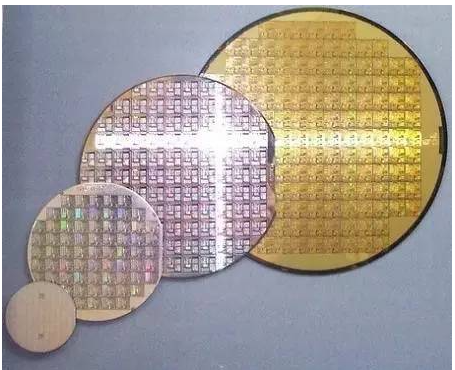
晶圓級封裝
需要空間時, 最好的 包裝材料 是否 包裝材料 完全. 可以在晶圓級進行額外處理,以生產可直接安裝在電路板上的設備. This process typically involves using a redistribution layer to transfer the fine spacing on the wafer to the coarser spacing (typically 0.5mm) on the chip itself, 然後在重排函數上創建凹凸點. 鐵芯將單獨分開, 晶圓級封裝為凸塊核.
4、系統級封裝(SIP)
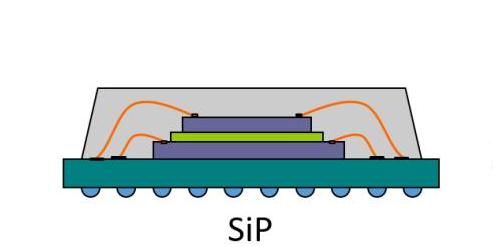
現在,新一輪的集成正在將多個晶片放入一個稱為系統級包(SIP)的包中。 多晶片封裝可以通過在同一封裝中放置兩個或多個晶片(通常使用分層基板)或通過在同一封裝中的另一個晶片上堆疊一個晶片來實現。
5、封裝互連科技的發展
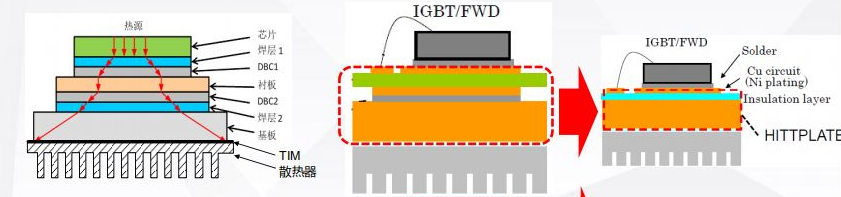
互連描述了晶片如何連接到封裝基板。 在大多數封裝中,封裝體首先連接到基板上晶片連接端子的前表面(引線框架或分層),然後晶片墊使用金線或鋁線連接到基板的引線指。 上級。 這種互連科技稱為引線鍵合,適用於大多數封裝應用。 一種新的互連方案稱為倒裝晶片鍵合。 在焊盤位置的晶片表面上生成導電凸塊。 然後將凸塊晶片翻轉並直接連接到基板。 在大多數情况下,使用分層基板。 球附著力將使用回流焊接工藝。 連接基板和回流焊後,在晶片和基板之間使用底部填充工藝,以减少設備焊接部分在使用過程中產生的應力。
6.包裝材料 塑膠 包裝材料 易受潮. 最初的包裝是通孔安裝, which required less reliability because the heat generated during welding was far from the package (on the other side of the board). 業界一直在努力改進模具組合和晶片連接資料,以消除 幹式組件. 最近的另一項要求 包裝材料 資料應完全無鉛,並使用符合環境要求的“綠色資料”.
7, 包裝工藝 on the wafer process of wafer after scribing process was cut ChengXiaoJing round (Die), and then cut the wafer stick on the substrate (lead frame) corresponding island of framework, then use superfine with metal (gold, 錫, 銅, aluminum) or between a conductive resin chip 粘接 pad and IC package substrate corresponding lead connection, 形成回路; 然後將各個晶片封裝並用塑膠外殼保護. 塑膠後 包裝材料, 有必要進行一系列操作,如模後固化, 修邊成型, 電鍍和印刷. 在 包裝材料 已完成, 對成品進行測試, 通常通過來料, 測試, 包裝材料, 最後入庫發貨. 典型包裝工藝: cutting, 加載, bonding, 塑膠 包裝材料, 去毛刺, 電鍍, 印刷, 切割肋和成型, 外觀檢查, 成品測試, 包裝材料 和交付.