有關IC基板科技能力的更多資訊,請按一下“下載工藝能力資料表”下載檔案。 如果您有問題,請聯繫我們。
關於IC基板, 請點擊: IC基板
或聯系iPCB工程師尋求幫助,電子郵件: eng-ic@ipcb.com
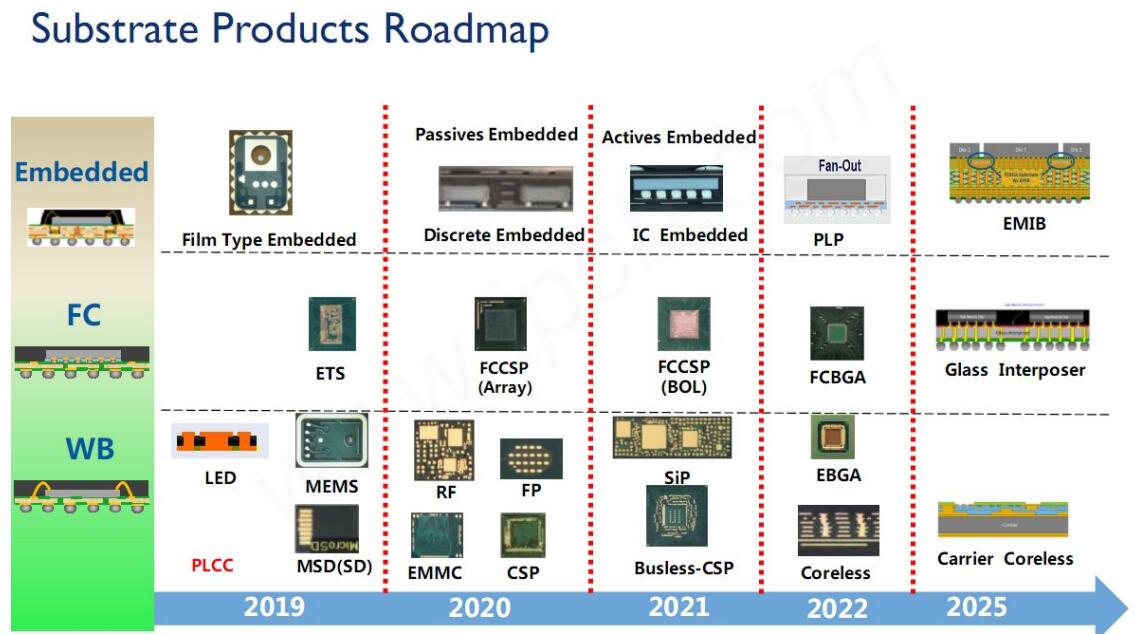

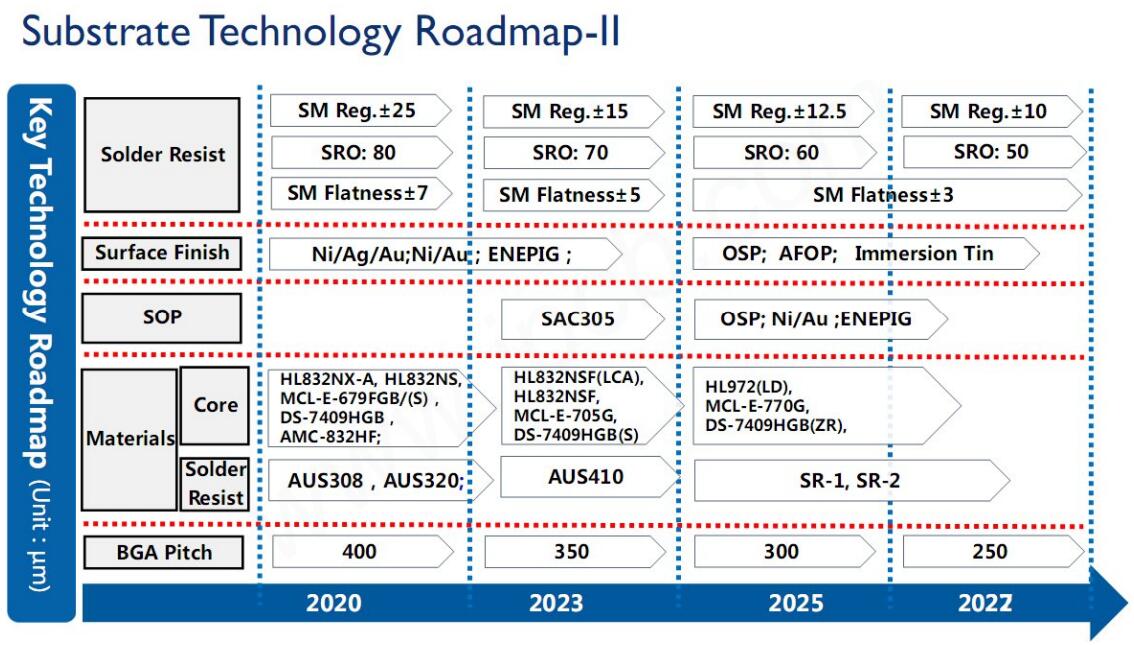
系統封裝基板(SiP)
封裝中系統是一個系統平臺,將多個異質晶片、傳感元件、無源元件等組裝到一個封裝中。 其應用包括多晶片模塊(MCM)、多晶片封裝(MCP)、堆疊晶片封裝、封裝中封裝(PiP)和嵌入式元件載體板。 封裝中系統為集成電路系統設計者提供了除了片上系統(SoC)之外的另一種計算功能集成解決方案。 它具有集成來自不同來源的異構晶片、更小更薄以及快速進入市場的優勢。
SiP可以是多晶片模塊(多晶片模塊;MCM)平面2D封裝,也可以重用3D封裝結構,有效减少封裝面積,其內部鍵合科技可以是純引線鍵合(引線鍵合),也可以使用倒裝晶片,但兩者也可以混合使用。 除了2D和3D封裝結構之外,將組件與多功能基板集成的另一種管道也可以包括在SiP的範圍內。 該科技主要將不同的組件嵌入到多功能基板中,也可以視為SIP的概念,以實現功能集成的目的。 不同的晶片佈置和不同的內部接合科技使得SIP封裝類型能够產生多種組合。 iPCB可根據客戶或產品的需求定制或靈活生產。
塑膠球栅陣列封裝基板(PBGA)
這是用於引線鍵合和封裝的最基本的球栅陣列基板。 其基本資料是浸漬有玻璃纖維的銅箔基材。 塑膠球栅陣列封裝基板可以應用於具有相對高引脚數的晶片封裝。 當晶片功能陞級時,隨著輸出/輸入引脚數量的新增,傳統的引線框封裝結構變得不足,而塑膠球栅陣列封裝基板提供了一種經濟高效的解決方案。
倒裝晶片級封裝基板(FCCSP)
電晶體晶片不是通過引線鍵合連接到襯底,而是通過倒裝晶片狀態下的凸塊與襯底互連,囙此它被稱為FCCSP(倒裝晶片規模封裝)。 倒裝晶片晶片級尺寸封裝將進一步顯示成本優勢。 在最近的過去,晶片上凸塊的工藝成本也持續下降,這也導致了封裝成本的快速降低。 倒裝晶片級尺寸封裝已成為高引脚數IC。
倒裝晶片球栅陣列封裝基板(FCBGA)
FC-BGA(倒裝晶片球栅陣列)襯底是一種高密度電晶體封裝襯底,可以實現LSI晶片的高速和多功能化。 倒裝晶片球栅陣列封裝在具有非常高的輸出/輸入引脚數的封裝(例如微處理器或影像處理器等晶片)中具有非常優异的效能和成本優勢。
如果您需要IC基板,請隨時聯系iPCB,電子郵件: sales@ipcb.com
|
SiP IC基板 |
BGA集成電路基板 |
eMMc封裝基板 |