每天 (印刷電路板)A processing, the full name of BGA is Ball Grid Array (solder ball array package), 即在封裝基板的底部製作一個焊球陣列,作為I/O電路末端與 印刷電路板 (PCB). 採用這種技術封裝的設備是表面貼裝設備. 這是一種集成電路採用有機載體板的封裝方法. 為了能够確定和控制此類過程的質量, 需要瞭解並測試影響其長期可靠性的物理因素, 例如焊料量, 電線和襯墊的定位, 和潤濕性. BGA器件的效能和組裝優於傳統器件, 但許多製造商仍然不願意投資開發大規模生產BGA器件的能力. 主要原因是BGA器件的焊點測試非常困難, 保證其質量和可靠性並不容易.
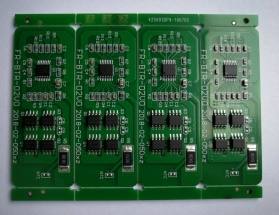
在當今資訊時代,隨著電子行業的快速發展,電腦和手機等產品越來越受歡迎。 人們對電子產品的功能要求越來越高,效能要求越來越高,但體積要求越來越小,重量要求越來越輕。 這推動了電子產品向多功能、安全、小型化、輕量化方向發展。 為了實現這一目標,集成電路晶片的特徵尺寸將變得越來越小,複雜性將繼續新增。 囙此,電路中的輸入/輸出數量將新增,封裝的輸入/輸出密度將繼續新增。 為了滿足這一發展的要求,出現了一些*高密度封裝技術,BGA封裝技術就是其中之一。
BGA封裝出現於20世紀90年代初,現已發展成為一種成熟的高密度封裝技術。 在所有半導體積體電路的封裝類型中,BGA封裝在1996年至2001年的五年期間增長最快。 1999年,BGA的產量約為10億。 然而,到目前為止,該科技最適合高密度、高密度器件封裝,並且該科技仍在朝著細間距和高I/O端子數的方向發展。 BGA封裝技術主要適用於PC晶片組、微處理器/控制器、ASIC、閘陣列、記憶體、DSP、PDA、PLD等器件的封裝。
BGA封裝的特點 PCBA加工:
1、包裝面積小;
2、功能新增,引脚數量新增;
3、PCB板在熔化和焊接過程中可以自定心,容易鍍錫;
4、可靠性高,電力效能好,整體成本低。
用BGA加工的PCB板通常有許多小孔。 大多數客戶的BGA過孔的設計成品孔徑為8-12密耳。 例如,BGA表面和孔之間的距離為31.5密耳,通常不小於10.5密耳。 需要堵住BGA通孔,不允許用墨水填充BGA焊盤,也不允許鑽BGA焊盤。
在裡面 PCBA processing, BGA devices can consistently achieve a defect rate of less than 20 (PPM) when using conventional SMT process procedures and equipment for assembly production. 自20世紀90年代初以來, 表面貼裝科技已進入成熟階段. 然而, 隨著電子產品的快速發展,朝著方便的方向發展/小型化, 網絡和多媒體, 對電子組裝技術提出了更高的要求. 密度組裝科技不斷湧現, among which BGA (Ball Grid Array package) is a high-density assembly technology that has entered the practical stage.