隨著微電子技術的飛速發展, 大規模和超大規模集成電路的廣泛應用, 微組裝科技的進展, 這個 HDI PCB電路板製造 正在朝著分層、多功能的方向發展, PCB電路板圖形線薄且微孔,間距窄. 加工中使用的機械鑽孔科技已不能滿足要求,並迅速開發出一種新的微孔加工方法, 即雷射打孔科技.
HDI PCB雷射成孔原理
雷射是一種强大的光束,受到外部刺激以新增能量,其中紅外光和可見光具有熱能,紫外光具有光能。 當這種類型的光照射到工件表面時,會出現3種現象:反射、吸收和穿透。
通過另一塊光學元件在基板上撞擊雷射光斑,有多種合成模式,並且與照明點有3種反應。
雷射鑽孔的主要功能是快速去除待加工的基材。 它主要依靠光熱燒蝕和光化學燒蝕或所謂的切除。
光熱燒蝕:由正在加工的資料形成的孔的原理,該資料吸收高能雷射,並在很短的時間內加熱熔化和蒸發。 在高能作用下,孔化前必須將孔壁上形成的炭黑殘渣清除乾淨。
2、光化學燒蝕:指紫外線區的高光子能量超過2eV電子伏。 雷射波長超過400納米的高能光子的結果。 這種高能光子破壞了有機資料的長分子鏈,並成為更小的粒子,但其能量大於原始分子,並被迫逃離,囙此基板資料被快速移除,並在外部擠壓下形成微孔。
囙此,這種工藝不含沸騰,不會發生碳化。 囙此,預多孔清洗非常簡單。
這些是雷射成孔的基本原理。 現時,最常用的雷射打孔方法有兩種:用於在印刷電路板上打孔的雷射主要由射頻激勵的CO2氣體雷射器和紫外固態Nd:YAG雷射器組成。
3、關於基板的吸光度:雷射的成功率與基材的吸光度有直接關係。 印刷電路板是銅箔、玻璃布和樹脂的組合。 這3種資料的吸光度因波長而异,但銅箔和玻璃布在紫外線下的吸光度為0.3m。 m以下區域具有較高的吸收率,但在進入可見光和紅外後急劇下降。 有機樹脂資料在所有3個光譜段中保持相當高的吸收率。 這是樹脂資料的特點,也是雷射打孔科技普及的基礎。
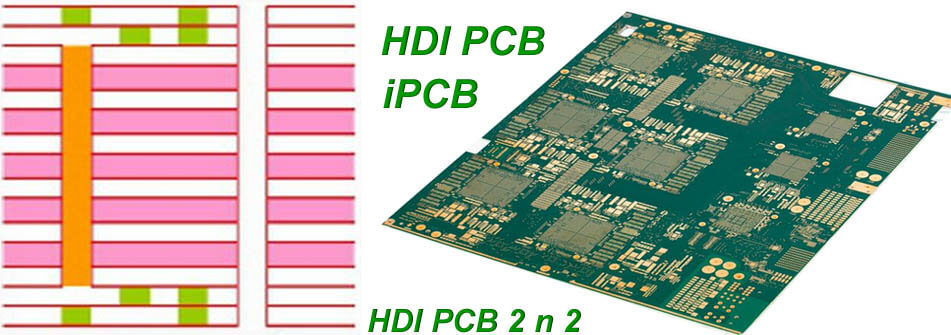
CO2雷射孔形成的不同HDI-PCB工藝
CO2雷射鑽孔主要有兩種方法,直接鑽孔和修整掩模鑽孔。 所謂直接成孔科技是通過裝置的主控制系統將雷射束直徑調製到與印刷電路板上的孔相同的直徑,並直接在不使用銅箔的情况下加工電介質表面上的孔。 塗層掩模工藝是用特殊的掩模塗覆印製板表面,並用常規工藝通過曝光/顯影/蝕刻從孔表面去除銅箔。 然後用大於孔徑的雷射束照射這些孔,以去除暴露的介電層樹脂。 以下分別描述:
1、銅窗開啟管道:
首先在內板上壓一層RCC塗層樹脂銅箔。 通過光化學製作視窗,然後蝕刻樹脂使其暴露,然後用雷射燒蝕視窗內的基材,形成微盲孔:
當光束增强時,它通過孔徑到達兩組檢流計型微反射掃描儀,這些掃描儀與正Fθ透鏡垂直對齊一次。 到達可以製作激勵檯面的管區,然後逐個燒掉微盲孔。
一旦用電子快束定位在一英寸見方的管狀區域,0.15mm的盲孔可以用3次打孔。 第一槍的脈衝寬度約為15mS,為空穴形成提供能量。 之後,可以使用噴槍清理孔壁底部的殘留物並校正孔。
SEM橫截面和0.15mm微盲孔的45度全視圖,具有良好的雷射能量控制。 此視窗打開過程用作背景靶板。 當不經常需要大的排版或二階盲孔時,它們很難對齊。
2、開窗處理方法:
前一種工藝形成的孔的直徑與打開的銅窗的直徑相同。 操作中的輕微錯誤可能會導致打開的車窗位置偏離,導致盲孔位置與基座墊中心錯位。 銅視窗的偏差可能是由於基質資料的膨脹和收縮以及用於圖像傳輸的負片的變形。 囙此,打開大銅窗的過程是將銅窗的直徑擴大到比基座墊的直徑大0.05mm。 通常,孔的大小由孔的大小决定。 當孔為0.15mm時,底座墊的直徑應為0.25mm左右,大窗戶的直徑應為0.30mm。 然後,可以進行雷射鑽孔,將燒壞位置精確地對準基板的微盲孔。 它的主要特點是有很大的選擇自由度。 在鑽雷射孔時,您可以選擇按內基座墊的程式進行鑽孔。 這有效地避免了由於銅視窗的直徑與孔的直徑相同而導致的錯位,從而防止雷射點指向前視窗,並導致大量板坯上出現許多不完整的半孔或殘餘孔。
3.HDI PCB樹脂表面直接成孔工藝
使用HDI PCB雷射器鑽孔的雷射鑽孔方法有幾種:
A、基板內層塗有樹脂塗層銅箔,然後蝕刻掉所有銅箔,可以使用CO2雷射在裸露的樹脂表面直接形成孔,然後可以根據電鍍工藝對孔進行進一步處理。
B、基板是一種類似的工藝,使用FR-4半固化板和銅箔代替樹脂塗層銅箔。
C、隨後用塗覆的光敏樹脂層壓銅箔的工藝。
D、由幹膜作為介電層和銅箔壓制工藝製成。
E、用銅箔塗覆其他類型的熱膜的過程。
4、超薄銅箔的直接燒蝕
將樹脂銅箔壓在內芯板兩側後,通過“半蝕刻”方法將17m的銅箔厚度减小到5min,然後進行黑氧化處理,通過CO2雷射形成孔。
其基本原理是,氧化後的黑色表面將强烈吸收光,從而在新增CO2雷射束能量的前提下,可以直接在超薄銅箔和樹脂表面打孔。 然而,最困難的是確保“半蝕刻法”可以獲得均勻厚度的銅層,囙此應特別注意其製造。 當然,銅背可撕裂資料。 銅箔相當於一本5微米左右的書。
根據這種類型的板材加工,現時在該過程中採用了以下主要方面:
這主要為資料供應商設定了嚴格的質量和科技標準,以確保介電層的厚度差為510mM到M。因為只有樹脂塗覆銅箔的介電厚度的均勻性才能得到保證,所以在相同的雷射能量下,可以保證焊道的准確性和孔底的清潔度。 同時,在後續操作中要採用最佳工藝條件去除鑽孔污垢,確保雷射鑽孔後盲孔底部清潔無殘留物。 它對盲孔化學鍍和電鍍的質量有很好的影響。
Nd:YAG雷射打孔HDI-PCB工藝
YAG是釹和釔鋁石榴石。 由兩個固體晶體共同發射的紫外雷射。 最近,最常用的由二極體脈衝激發的雷射束可用於製造有效的無需水冷的雷射密封系統。 這種雷射器的3次諧波波長為355納米。 四次諧波波長為266納米。 波長由光學晶體調製。
這種雷射打孔的最大特點是紫外線。 光譜區域,雖然銅箔和由覆銅板組成的玻璃纖維在紫外線區域吸收强烈,但這些雷射點的能量很小,它們可以强烈穿透銅箔和玻璃布並直接形成孔。 由於上述類型的雷射熱量較小,CO2雷射鑽孔後不會產生炭渣,為後續孔壁操作提供了良好的表面。
YAG雷射技術在各種資料上加工徽標盲孔和穿透孔。 它在聚醯亞胺覆銅板上鑽孔,最小直徑為25微米。 從成本分析來看,使用的最經濟直徑為25125微米。 鑽孔速度為10000孔/分鐘。可使用最大孔徑為50微米的直接雷射沖孔。 形成的孔的內表面清潔、無碳化,易於電鍍。 它還可以在PTFE覆銅板上鑽孔,最小直徑為25微米,最經濟的直徑為25125微米。 鑽孔速度為4500孔/分鐘。無需視窗預蝕刻。 孔清潔,無需特殊處理要求。 還有其他資料,如成型孔加工。 以下過程可用於特定處理:1。 根據兩種雷射打孔的速度,採用兩種組合工藝
基本操作方法是先用YAG燒蝕孔比特表面的銅箔,然後用比YAG鑽孔更快的CO2雷射直接燒蝕樹脂形成孔。
實際品質問題 HDI PCB製造
在雷射打孔過程中,存在許多品質問題,尚未完全描述。 僅提出最常見的品質問題供同行參攷。
A、開窗法中CO_2雷射打孔位置和底部目標位置之間的錯位
在HDI PCB雷射鑽孔中,光束定位系統對孔徑成形的精度至關重要。 雖然光束定位系統用於精確定位,但由於其他因素,往往會產生孔狀火焰。 生產過程中出現的品質問題分析如下:
1、為內芯板焊盤和導線圖形製作負片,並用樹脂塗層銅箔進行RCC。 對於加層後的視窗打開,則為負值,因為這兩種情况都是由於濕度和溫度導致尺寸增大和减小的潜在因素。
2、當使用芯板製作橫向焊盤圖案,並且在高溫下壓制樹脂塗覆銅箔的RCC時,基材的尺寸增大或减小。 加層後,內外底板資料存在尺寸膨脹和收縮的因素。
3、蝕刻銅視窗的尺寸和位置也會導致錯誤。
4、雷射器本身的光點和表面位移引起的誤差。
5、二階盲孔的對準更加困難,並且容易導致位置誤差。
基於以上原因,根據生產中獲得的相關科技數據和實際運行經驗,採取的主要科技策略如下:
1.為了减少排版尺寸,大多數HDI PCB製造商使用450進行多層排版*600或525*600mm。 然而,對於具有0.10 mm線寬和0.15 mm盲孔直徑的手機面板,最佳佈局尺寸為350。* 450毫米。 上限。
2、新增雷射直徑:目的是新增銅窗覆蓋的面積。 具體方法是“波束直徑=孔徑+90~100”mM。當能量密度較低時,再發射一次或兩次來解决問題。
3、打開大銅窗的過程:此時,只有銅窗的尺寸變大,孔徑不變,囙此雷射孔的直徑不再完全由視窗的位置决定,囙此孔的位置可以直接基於基靶在芯板上的位置。
4、將開窗方法由光化學成像和蝕刻改為YAG雷射:先用YAG雷射根據芯板的底孔指向開窗,然後用CO2雷射燒掉其視窗位置上的孔,以解决成像引起的誤差。
5、二次分層製作二階微盲孔方法:當芯板兩側塗有樹脂銅箔RCC時。 之後,如果再次累積RCC並形成二階盲孔,則將累積二階盲孔。 在“兩個”盲孔對準的情况下,必須通過瞄準“一個接一個”來形成孔。 覈心板的原始目標不能重複使用。 也就是說,當“累積一個”到孔和焊盤中時,其板邊緣也將成為目標。 囙此,在按下“Ji 2”的RCC後,可以通過X光機鑽取“Ji 2”的四個額外機械基準孔,以對準“Ji 1”,然後對這些孔進行襯砌。 這種方法可以使“Ji 2”盡可能與“Ji 1”對齊。
B、傳球不正確
根據許多生產經驗,主要是由於基材成型中的品質問題,主要品質問題是樹脂塗覆銅箔壓制後的介電層厚度必然會不同。 在鑽孔能量相同的情况下,電介質層較薄部分的墊層不僅承受更多能量,而且反射更多能量。 囙此,孔壁被敲打成向外膨脹的壺。 這將對多層之間的電互連質量產生重大影響。
由於孔徑不正確,分層多層印刷電路板(MLPCB)高密度互連結構的可靠性將帶來一系列科技問題。
囙此,必須採取工藝措施來控制和解决問題。 主要採用以下工藝:
1、嚴格控制覆膜銅箔與層壓銅箔的介電層厚度差在510mM到M之間。
2、改變雷射的能量密度和脈衝槍的數量。 可以通過測試方法找到批量生產的工藝條件。
3、孔底夾渣、孔壁碎渣清除不到位。
這種類型的 HDI PCB 品質問題最有可能是由於輕微的不當控制而發生的. 特別適用於大板上多孔型層壓板, 如果沒有品質問題,就不可能保證100%的質量. 這是因為加工過的大模具上的微盲孔數量過大, 平均約60-90,000個孔. 介質層的厚度不同, 當使用相同能量的雷射鑽孔時,殘留在底座上的殘留物的厚度也是如此. 不可能確保在處理鑽屑後徹底清潔所有殘留物. 此外, 不良的檢查方法通常會導致後續 HDI PCB 存在缺陷時,底墊和孔壁之間的鍍銅和粘合.