Tecnología de empaquetado de chips a nivel de obleas
Wlcsp, También conocido como Tecnología de embalaje a nivel de obleas En inglés, A diferencia de los chips tradicionales Material de embalaje method (cutting and then sealing, Y al menos el 20% del volumen del chip original Material de embalaje). Esta última tecnología es la primera en empaquetar y probar todo el chip, Luego cortar en partículas de CI una por una, Por consiguiente,, Volumen posterior Material de embalaje Igual al tamaño original del cristal desnudo IC. Se llama la corriente principal del futuro Tecnología de embalaje. Manufacturers that have been invested in R & D include FCT, Aptos, Casio, Poesía narrativa, Fujitsu, Mitsubishi Electronics, Etc..
Realiza todas las operaciones en la oblea directamente, terminando así el proceso de fabricación de la oblea frontal. In the Paquete de chips Proceso, Separación de chips y obleas, Por consiguiente, Wlcsp Puede alcanzar el mínimo Material de embalaje Volumen del mismo tamaño de chip, Es casi el último juego. Material de embalaje miniaturization Tecnología.
Tecnología de embalaje a nivel de obleas, integrating thin-film passive device Tecnología and large-area specification manufacturing technology, No sólo ofrece soluciones de ahorro de costos, Además, se proporciona un factor de forma consistente con el proceso de montaje de la superficie existente.. Escala de chips Material de embalaje La tecnología no sólo proporciona una hoja de ruta para la mejora del rendimiento, Además, se reduce el tamaño de los dispositivos pasivos integrados..
Desde que se anunció la viabilidad de la tecnología wlcsp en 1.998, varios tipos de wlcsp han aparecido en el mercado en los últimos años. La tecnología se ha utilizado en dispositivos electrónicos móviles, como chips de alimentación de teléfonos móviles, y se ha ampliado a aplicaciones de productos lógicos.
Wlcsp Es una variante de la tecnología de interconexión Flip chip. Con la ayuda de Tecnología wlcsp, La superficie activa del chip desnudo se invierte y se conecta al PCB con una bola de soldadura. The size of these solder balls is usually large enough (300 at 0.5mm spacing and pre reflow) μ m), Se puede omitir el proceso de llenado inferior necesario para la interconexión flip - chip
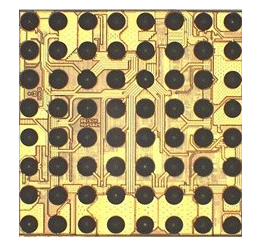
Paquete wlcsp
Wlcsp se puede dividir en dos tipos de estructura: proyección directa y capa de redistribución (RDL).
Colisión directa
Colisión directa Wlcsp contains an optional organic layer (polyimide) that acts as a stress buffer on the surface of the active die. Poliimida cubre toda la región del chip desnudo, excepto la región de la ventana alrededor de la almohadilla de unión. A subbump metal layer (UBM) is sputtered or electroplated over Esto windowed area. UBM es una pila de diferentes capas metálicas, Incluyendo la capa de difusión, Capa de barrera, Capa humectante y capa antioxidante. The solder ball falls on the UBM (so called drop ball), A continuación, las protuberancias de soldadura se forman mediante soldadura reflow..
Capa de redistribución (RDL)
Capa de redistribución (RDL) Wlcsp this technology can convert bare chips designed for bonding lines (bonding pads are arranged around) into Wlcsp. A diferencia de las colisiones directas, this Wlcsp Uso de poliimida de dos capas. La primera capa de poliimida se deposita en el chip desnudo y la almohadilla de Unión se mantiene en el Estado de la ventana. La capa RDL convierte la matriz periférica en la matriz de área por pulverización o galvanoplastia. La estructura posterior es similar a la proyección directa - incluyendo una segunda capa de poliimida, UBM y Fall Ball.
Ventajas de wlcsp:
The Material de embalaje Patrón Wlcsp No sólo reduce eficazmente el tamaño del módulo de memoria, Además, el dispositivo móvil también cumple los requisitos de alta densidad del espacio corporal. Por otra parte, En términos de rendimiento, Mejora la velocidad y estabilidad de la transmisión de datos. El equipo de montaje SMT estándar se puede utilizar sin un proceso de llenado inferior.
1. Tamaño mínimo del método de embalaje del chip Original:
The biggest feature of Wlcsp Paquete de chips a nivel de oblea Reducir eficazmente el volumen de embalaje, hacer que la forma de embalaje sea más ligera y delgada. Por consiguiente,, Puede coincidir con dispositivos móviles para satisfacer las características de los productos portátiles ligeros y cortos.
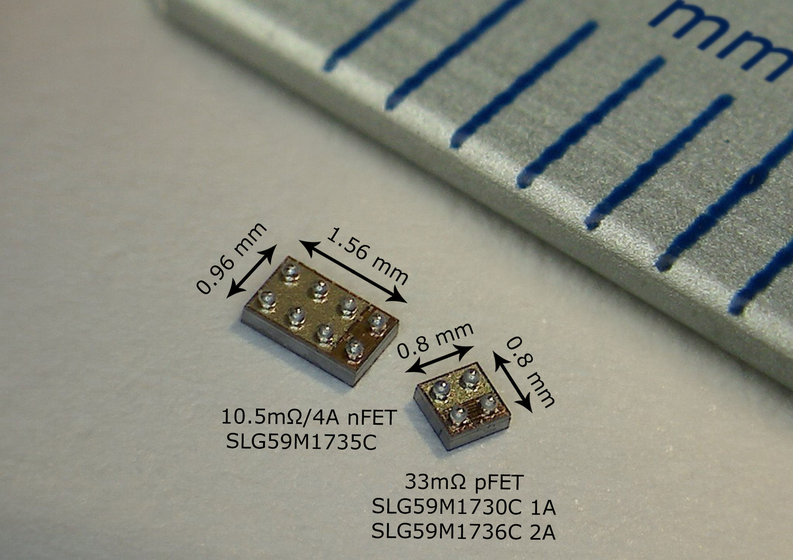
Embalaje de tamaño mínimo
2. Ruta de transmisión de datos corta y alta estabilidad:
Cuando se utiliza Paquete wlcsp, due to the short and thick circuit wiring (yellow line marked a to b), Puede aumentar eficazmente la frecuencia de transmisión de datos, Reducir el consumo actual y mejorar la estabilidad de la transmisión de datos. Debido a las características de auto - calibración de la pieza ligera desnuda en el proceso de soldadura, Alto rendimiento de montaje.
3. Buenas características de disipación de calor
Porque Wlcsp Tener un plástico o cerámica sellados menos convencional Material de embalaje, La energía térmica durante el funcionamiento del chip IC puede disiparse eficazmente sin aumentar la temperatura del cuerpo principal. Esta función es muy útil para la disipación de calor de los dispositivos móviles. Puede reducir la Inductancia y mejorar el rendimiento eléctrico.
Wlcsp no sólo puede realizar la tecnología importante de alta densidad, embalaje de alto rendimiento y sip, sino que también desempeña un papel clave en la tecnología de PCB integrado. Aunque el proceso de Unión de alambre es muy maduro y flexible, el circuito multicapa, el patrón de alambre fino y la combinación de la tecnología wlcsp y la Unión de alambre indican que tendrá una aplicación más amplia y nuevas oportunidades.
Desventajas de wlcsp: el costo de wlcsp proviene del procesamiento de obleas o paquetes. Si se requiere una producción a gran escala, es necesario aumentar la fuerza de trabajo. Esto aumentará los costos de producción en consecuencia.
El futuro Tecnología wlcsp
Wlcsp Se ha aplicado al teléfono móvil, Tarjeta de memoria, Desde su aplicación en relojes electrónicos en 2000, los navegadores de automóviles y los dispositivos digitales. Los próximos años, Habrá más uso de chips Tecnología wlcsp En mercados móviles de alto rendimiento, como los teléfonos móviles.
La combinación de la tecnología wlcsp y el proceso de incrustación de PCB puede garantizar la estabilidad de la calidad de montaje de PCB. Esto se debe a que wlcsp no sólo es fácil de instalar PCB, sino que también tiene la característica de "chips bien conocidos".
Tecnología wlcsp Ofrece más posibilidades para la producción de equipos electrónicos ligeros y compactos. Wlcsp Se ha utilizado en el montaje de circuitos. No hace mucho, También se convierte en una parte importante del SIP. Fusión MCP Wlcsp La tecnología tradicional de Unión de cables también ha entrado en la producción a gran escala.
Perspectivas Wlcsp En los últimos años, Podemos confiar en ello. Wlcsp Seguirá desarrollándose y ampliándose a otras esferas en un futuro próximo..