3DIC eterogeno deve ancora affrontare la soglia di produzione di massa
Sebbene la tecnologia di stacking tridimensionale 3DIC+TSV possa aumentare la densità del chip con l'area più piccola, ridurre i costi e ridurre le dimensioni del prodotto e quindi migliorare le prestazioni e l'affidabilità del chip, Samsung è anche il primo a introdurre una memoria flash NANDFlash impilata 3DIC omogenea, memoria DDR3 e chip WideI / ODRAM impilati per computer desktop e notebook. Aziende di progettazione IC come Qualcomm e BroadComm hanno anche introdotto la tecnologia 3DTSV per progettare IC di nuova generazione ad alta densità.
L'attuale applicazione integrata di 3DIC appartiene ancora allo stesso processo di produzione, all'integrazione omogenea di chip (Homogenous), come DRAM, NANDFlash die o microprocessore multi-core. IEK prevede che da quest'anno (2013), 3DIC come DRAM e NANDFlash con impilamento omogeneo dovrebbe entrare in produzione di massa. Per quanto riguarda l'integrazione eterogenea di chip logici (Logic), chip di memoria (DRAM), IC a radiofrequenza (RF), amplificatori di potenza (PA), chip di conversione fotoelettrica, ecc., è limitata da questioni tecniche come il consumo energetico e i coefficienti del materiale di imballaggio. Deve ancora essere superata.
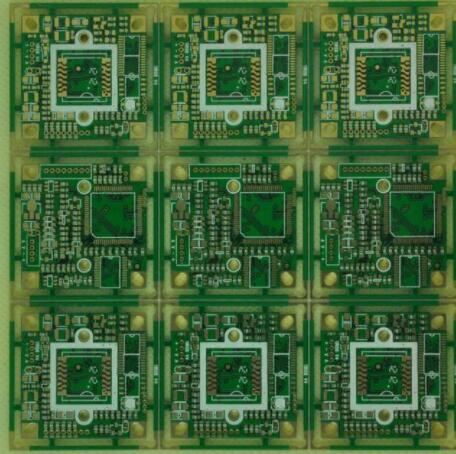
La tecnologia intermediaria 2.5D è la prima a introdurre FPGA, GPU/APU nella produzione di massa
Come accennato in precedenza, 3DIC viene utilizzato in Hetergeneus Integrated. Si impila chip di silicio nudo con diversi processi logici e caratteristiche operative e utilizza la tecnologia TSV (Silicon Drilling) per interconnettere i chip. Quando diversi tipi di chip sono impilati, i problemi di consumo energetico e dissipazione del calore richiederanno un trattamento speciale.
Se solo un chip DRAM con tensione 1V e consumo energetico 2W è impilato, la corrente di avvio è di circa due ampere. Se una CPU multi-core o un'unità di elaborazione grafica (GPU) da 2GHz è impilata su di essa, richiederà facilmente decine di watt o anche di più. Cento watt, la corrente di avviamento della luce può essere alta fino a decine di ampere, che può essere gestito quasi da batterie auto-grade. Questo tipo di chip è fatale per la progettazione di dispositivi portatili mobili; e fornisce grande corrente in un'area così limitata e densa. Il design del cablaggio del circuito di alimentazione e la selezione dei chip di alimentazione sono sfide tecniche e anche la corrente stessa è la più grande fonte di interferenza che influisce sull'efficienza e la stabilità del circuito.
I chip CPU e GPU possono solitamente riscaldarsi fino a 120 gradi. Tuttavia, quando il dado DRAM e NANDFlash superano 85°C, il meccanismo di aggiornamento e la tolleranza di conservazione saranno anormali. Se la CPU è combinata con DRAM, NANDFlash Stacked insieme, il calore elevato della CPU influenzerà DRAM e NANDFlash; Inoltre, come i dispositivi di conversione fotoelettrica, la stabilità dell'operazione sarà notevolmente ridotta quando la temperatura raggiunge 80 ° C o più. Ci sono anche diversi tipi di materiali nudi dello stampo. Quando impilati insieme, deve essere considerato l'effetto di stress termico sul meccanismo di imballaggio causato da diversi coefficienti di espansione termica e anche il surriscaldamento causerà la deformazione dello strato impilato del wafer e persino la rottura dello stagno. Come organizzare correttamente la sequenza di impilamento di questi chip con caratteristiche di temperatura diverse in modo che non si influenzino l'un l'altro durante la dissipazione del calore è una sfida tecnica molto grave. Questo è il motivo per cui 3DIC, che è stato prodotto in serie, appare per primo nei prodotti stacked DRAM a bassa potenza e NANDFlash equivalenti.
La tecnologia 2.5DIC (o 2.5DIntrposer) è stata inizialmente proposta dal leader della fabbrica (ASE), e in seguito è diventata un termine seguito dall'industria dei semiconduttori. Il metodo è quello di rendere gli stampi di vari processi / caratteristiche di lavoro non impilati l'uno sull'altro, ma disposti in parallelo e vicini l'uno all'altro, posizionati sul materiale a base di vetro o silicio Interposer (interposer) per il collegamento e quindi collegati al fondo Il circuito stampato accorcia il tempo di ritardo del segnale e migliora le prestazioni complessive del sistema; Ogni dado parallelo può essere testato individualmente e poi perforato e assemblato fianco a fianco. Non ha bisogno di passare attraverso il test di calore / radiazione elettromagnetica, a condizione che sia posizionato sul bordo intermedio (Interposer) può passare attraverso un test di integrazione globale dopo l'imballaggio. Quando si esegue l'impilamento 3DIC, i test termici/elettromagnetici devono essere eseguiti su ogni strato dello stack; se uno dei dadi è difettoso, l'intero dispositivo di impilamento 3DIC deve essere rimborsato.
2.5DIC è considerato dall'industria dei semiconduttori come una tecnologia intermedia per il passaggio al futuro 3DIC. Oltre a utilizzare Interposer per fungere da ponte di comunicazione tra chip, occorre prestare attenzione anche a questioni come la combinazione di matrice e Interposer, proprietà dei materiali e stress termico. Rispetto al 3DIC, 2.5DIC ha un collo di bottiglia tecnico più basso. L'interposer di silicio utilizzato nel circuito stampato (SIEnterposer) generalmente non ha bisogno di utilizzare il processo di produzione avanzato 40nm o anche 28nm come il chip del processore e il costo di produzione può essere ridotto.
Prendiamo come esempio il chip Xilinx2.5D FPGA del processore. Dopo che i chip FPGA nudi 28/40nm sono disposti fianco a fianco, sono posizionati su un interposer di silicio 65nm. Il costo totale è inferiore al precedente processo SOC 40nm o addirittura 28nm. Pertanto, il campo di applicazione di 2.5DIC non è limitato ai chip di memoria. Chip di calcolo logico ad alte prestazioni e altamente integrati come FPGA, CPU, GPU, ecc., hanno iniziato ad applicare la tecnologia 2.5Dinnterposer.
Applicazione killer 2.5D/3DIC
I semiconduttori che hanno introdotto il concetto 2.5DIC nella produzione di massa sono rappresentati dai principali produttori Xilinx e Altera (Programmable logic Gate Array). Entrambe le aziende utilizzano la tecnologia CoWos (ChiponWaferonSubstrate) 2.5DIC di TSMC. Come i chip Virtex-72000TFPGA di Xilinxâ, i dadi nudi 28nm sono disposti strettamente fianco a fianco. I micro urti sotto gli stampi nudi sono collegati ad un interposer di silicio 65nm. Dopo di che, sono collegati alle sfere di saldatura dalla tecnologia TSV e poi penetrati. Collegare la sfera di saldatura alla scheda PCB sottostante.
Inoltre, il chip grafico IntelIrisPro5200 (GT3e) abbinato al processore IBM Power8, al processore Corei di quarta generazione (Haswell) e semi-personalizzato di AMD8. L'APU core utilizzerà anche la tecnologia di imballaggio 2.5DIC.
Per quanto riguarda la parte 3DIC, oltre all'impilamento omogeneo di chip DRAM (WideI/O) e chip NANDFlash, Altera ha recentemente annunciato i prodotti FPGA 20nm di prossima generazione, che utilizzeranno il processo 20nm TSMC s di prossima generazione più 3DIC eterogenea integrazione e tecnologia di impilamento 3DIC. Integrando più di due set di stampi FPGA, chip processore multi-core ARM, chip HardCopyASIC personalizzabile dall'utente, processore di segnale digitale DSP di precisione regolabile e chip di memoria MemoryCube impilato multi-strato.
ASE, Silicon Products, Licheng e Nanmao hanno una quota del 56% del mercato globale delle fonderie di imballaggio e collaudo, che è anche la chiave per l'ultimo miglio della catena industriale 3DIC. ASE adotta lo standard 3DS-IC della piattaforma di specificazione SEMI e collabora attivamente con DesignHouse e Foundry per completare le specifiche di interconnessione DietoDie, DietoSiP overlay e 3D stacking, misura e conferma di affidabilità dell'imballaggio; In Fonderia, Memorie e confezionamento e collaudo di schede portanti 3D, infissi, procedure di tenuta tra fabbriche, nonché partecipazione ai wafer TSV, metodi di accumulo di memoria JEDECJC-11WideI/O e specifiche relative alla garanzia della qualità 3DQA.
Inoltre, TSMC ha anche introdotto la tecnologia di produzione integrata CoWoS (ChiponWaferonSubstrate) della struttura 2.5D / 3DIC, fornendo TSV / 3D, vari materiali urtanti tra cui la tecnologia di piantagione di sfere, interposer del silicio (Si-Interposer) e varie integrazione del sottosistema, ecc. Allo stesso tempo, continuare a investire nella tecnologia 2.5D / 3DIC per accelerare l'introduzione dell'intera catena industriale di EDA, IP, test, apparecchiature, fornitori di wafer di silicio e impianti di imballaggio. UMC e gli impianti di confezionamento e collaudo a valle sono alla ricerca di un modello industriale aperto (OpenEcosystemModel) per sviluppare la tecnologia 3DIC.
IEK ha sottolineato che la tecnologia 3DIC è stata introdotta nei chip di memoria come NANDFlash e DRAM prima del 2010. Dal 2010 è stata introdotta anche la produzione di massa di componenti CIS (CMOS image sensor) e MEMS (microelettromeccanico). Ci sono applicazioni come chip dell'amplificatore di potenza (PA), imballaggio del chip di illuminazione LED e imballaggio dell'elemento di conversione fotoelettrico. Nel 2013 si prevede che i MemoryCube omogenei multistrato e WideI/ODRAM saranno prodotti in serie; L'eterogeneo 3DIC (Heterogeneous 3DIC) che integra CPU multi-core, FPGA, ASIC, memoria e componenti optoelettronici dovrebbe essere introdotto tra il 2014 e il 2015.