Negli ultimi cento anni, con il rapido sviluppo del circuito integrato, anche la tecnologia del cartone di imballaggio IC è stata migliorata, la domanda di applicazione dell'industria IC sta diventando sempre più grande, l'integrazione sta diventando sempre più alta. Il processo generale di sviluppo del packaging: TO-DIP-PLCC-QFP-PGA-BGA-CSP-MCM, gli indicatori tecnici sono generazione avanzata per generazione, il rapporto area chip e area pacchetto è sempre più vicino a 1, le prestazioni elettriche e l'affidabilità migliorano gradualmente, il volume è più piccolo e sottile.
1.MCM (componente multi-chip)
Infatti, è un componente chip, l'ultima tecnologia. È una tecnologia di imballaggio che assembla più chip nudi semiconduttori su un substrato di cablaggio. Pertanto, elimina i materiali e i processi di imballaggio IC, risparmiando così i materiali. riducendo il processo di produzione necessario, in modo stretto il prodotto è assemblaggio ad alta densità
Apri Tencent News per vedere altre immagini
2. CSP (pacchetto a livello di chip)
Il pacchetto CSP è un pacchetto a livello di chip. Come tutti sappiamo, i chip sono essenzialmente piccoli. Pertanto, il pacchetto CSP dell'ultima generazione di tecnologia di imballaggio del chip di memoria può rendere il rapporto area chip/pacchetto di più di 1:1.14, abbastanza vicino. La situazione ideale di 1:1 è valutata dall'industria come la forma più alta di singolo chip. Rispetto al pacchetto THE BGA, il pacchetto CSP può aumentare la capacità di archiviazione di tre volte nello stesso spazio. Questo pacchetto è caratterizzato da piccole dimensioni, un gran numero di terminali di ingresso / uscita e buone prestazioni elettriche. Ci sono CSP BGA (matrice di griglia a sfera), LFCSP (telaio di piombo), LGA (matrice di griglia), WLCSP (livello di wafer) e così via.
1.CSP BGA

2. LFCSP (struttura principale)
LFCSP, questo pacchetto è simile al telaio di piombo che utilizza circuiti di imballaggio in plastica convenzionali, ma è più piccolo nelle dimensioni e più sottile nello spessore, con pastiglie che si estendono nella zona interna del chip. L'LFCSP è un pacchetto di plastica basato su un telaio di piombo. L'interconnessione interna del pacchetto è solitamente ottenuta tramite cablaggio e la connessione elettrica esterna è ottenuta saldando i pin periferici alla scheda PCB. Oltre ai perni, LFCSPS ha tipicamente cuscinetti di calore esposti più grandi che possono essere saldati al PCB per migliorare la dissipazione del calore.
3. LGA (Grid Array)
Questo è un pacchetto grid-array, simile a BGA, tranne che BGA è saldato, mentre LGA può essere sbloccato e sostituito in qualsiasi momento. Cioè, è sostituibile rispetto al BGA, ma il processo di sostituzione deve essere molto attento.
4. WLCSP (livello wafer)

4. BGA (Ball grid Array)
Uno degli array di contatto a sfera, pacchetti di montaggio superficiale. Sul retro del PCB, i bulk sferici sono realizzati in modalità display al posto dei pin e il chip LSI viene assemblato sulla parte anteriore del PCB, che viene quindi sigillato con resina stampata o potting. Conosciuto anche come Bump Display Carrier (PAC). BGA comprende principalmente: PBGA (pacchetto di plastica BGA), CBGA (pacchetto di ceramica BGA), CCBGA (pacchetto di cilindro ceramico BGA), TBGA (pacchetto di supporto BGA) e così via. Dispositivi di imballaggio BGA attualmente utilizzati, secondo il tipo di substrato, includono principalmente CBGA (pacchetto di griglia ceramica), PBGA (pacchetto di griglia plastica), TBGA (pacchetto di griglia portante), FC-BGA (pacchetto di griglia flip-chip), EPBG (pacchetto di griglia di plastica potenziato), ecc.
4-1 CBGA (ceramica)

CBGA ha la più lunga storia nella famiglia di pacchetti BGA. La piastra di base è ceramica multistrato e la piastra di copertura metallica è saldata sulla piastra di base con saldatura di tenuta per proteggere il chip, il piombo e il pad. Questo è un pacchetto di montaggio superficiale con un set di saldature nella parte inferiore per un facile accesso.
4-2FCBGA
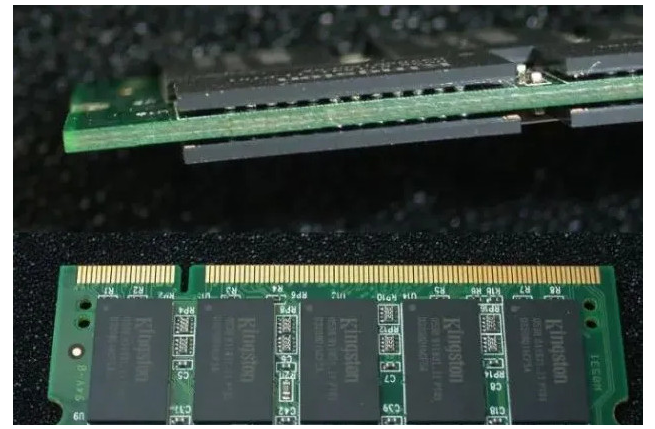
FCBGA realizza il collegamento diretto tra la sfera di saldatura del chip e il substrato di BGA tramite flip chip. Nei prodotti BGA, è possibile ottenere una maggiore densità di imballaggio e migliori prestazioni elettriche e termiche.
4-3PBGA

Pacchetto BGA, utilizza resina BT / laminato di vetro come substrato, plastica di stampaggio epossidico di plastica come materiale di tenuta. Questo tipo di chip di incapsulamento è sensibile all'umidità e non è adatto per l'incapsulamento del dispositivo con elevati requisiti di tenuta e affidabilità.
4-4 SBGA

SBGA utilizza un design avanzato del substrato, comprese alette in rame per una migliore dissipazione del calore, mentre utilizza processi e materiali di assemblaggio affidabili per garantire alta affidabilità e prestazioni superiori. Combinando prestazioni elevate e peso leggero, un tipico pacchetto SBGA da 35 mm² monta ad un'altezza inferiore a 1,4 mm e pesa solo 7,09.
5.PGA (Needle Grid Array)

Incapsulazione del perno del display. In un pacchetto plug-in, i perni verticali sul fondo sono disposti in una matrice. Il substrato di imballaggio è fondamentalmente un substrato ceramico multistrato. Utilizzato per circuiti LSI logici ad alta velocità su larga scala. I pin sono nella parte inferiore del chip, tipicamente quadrati, e la distanza dal centro al pin è generalmente di 2,54 mm. Il numero di pin varia da 64 a 447. Ci sono generalmente due tipi: CPGA (Ceramic Pin Grid Array Package) e PPGA (Plastic Pin Grid Array Package).
6. QFP (Quad Flat Package)
Questo tipo di pacchetto è un pacchetto piatto quadrato, di solito quadrato, con quattro lati dei perni. Questo pacchetto implementa la spaziatura del pin del chip CPU è molto piccola, il pin è molto sottile. Generalmente il circuito integrato su larga scala o su larga scala adotta questo pacchetto, il numero di pin è generalmente superiore a 100. Grazie alle sue dimensioni ridotte, i parametri parassitari sono ridotti, adatti per applicazioni ad alta frequenza. Tali pacchetti sono: In questo processo, CQFP (Pacchetto Piatto Quad Ceramic), PQFP (Pacchetto Piatto Quad Plastico), SSQFP (Pacchetto Piatto Quad Autolegante), TQFP (Pacchetto Piatto Quad Slim), SQFP (Pacchetto Piatto Quad Shrink)
1. LQFP (sottile)
Questo è un QFP sottile. Si riferisce al QFP con uno spessore del pacchetto di 1,4 mm, che è il nome utilizzato dall'industria giapponese del macchinario elettronico secondo la specifica di forma di QFP recentemente sviluppata.
2. TQFP (Thin Square)
7. LCC (porta chip senza piombo o piombo)
Portachip ceramico con perni, uno di un pacchetto di montaggio superficiale, con perni che conducono dai quattro lati della confezione. È un pacchetto per IC ad alta velocità hf, noto anche come ceramica QFN o QFN-C.
1. CLCC (perno dell'ala)
2. Paesi meno sviluppati
Portachip a forma di C, il perno viene tirato fuori dalla parte superiore del chip e piegato verso il basso in una forma a forma di C
3.PLCC
I perni sono disegnati dai quattro lati della confezione e sono a forma di t e realizzati in plastica. La distanza del centro del perno era di 1,27mm e il numero del perno variava da 18 a 84. È più facile da operare di QFP, ma più difficile ispezionare l'aspetto dopo la saldatura.
8. SIP (incapsulamento singolo in linea)
Un singolo cavo di pacchetto in linea conduce da un lato della confezione in linea retta. Di solito un passaggio passante, i perni conducono da un lato della confezione e sono allineati in linea retta. Quando assemblato su un circuito stampato, il pacchetto è laterale. La distanza del centro del perno è solitamente di 2.54mm, il numero del perno varia da 2 a 23, la maggior parte dei quali sono prodotti personalizzati. Le forme dei pacchetti variano.
9. SOIC (IC piccolo)
SOIC è un pacchetto di circuito integrato di forma piccola. Il numero di cavi esterni non deve superare 28 pezzi di forma ridotta. Generalmente, ci sono due tipi di incapsulamento: corpo largo e corpo stretto. Questo è circa il 30-50% in meno di spazio rispetto allo stesso pacchetto DIP. Lo spessore è ridotto di circa il 70%.
10. SOP (piccolo pacchetto)
L'imballaggio SOP è una forma di imballaggio componente. Materiali di imballaggio comuni sono: plastica, ceramica, vetro, metallo e così via, ora l'uso di base di imballaggi in plastica. Ha una vasta gamma di applicazioni, utilizzato principalmente in una varietà di circuiti integrati. Poi sono arrivati TSOP (pacchetto sottile di profilo piccolo), VSOP (pacchetto di profilo molto piccolo), SSOP (pacchetto di profilo ridotto), TSSOP (pacchetto di profilo ridotto sottile), MSOP (pacchetto di microprofilati), QSOP (pacchetto di profilo di dimensione quarto), QVSOP (pacchetto di profilo molto piccolo di dimensione quarto), e altri.
1. SSOP (tipo ridotto)
2. TSOP (pacchetto sottile di forma piccola)
3. TSSOP (riduzione sottile)
11. SOT (Small transistor)
SOT è un tipo di pacchetto SMD. Per i dispositivi con meno di 5 pin (3pin, 4pin), il pacchetto SMD è solitamente adottato. Piccole dimensioni, molti transistor sono utilizzati in questo pacchetto.
Questo è anche un pacchetto transistor. Generalmente entrambi i lati hanno perni, il numero di perni è 3, 4, 5, la maggior parte non più di 7.
12. DIP (pacchetto doppio filo)
I pacchetti DIP sono noti anche come pacchetti dual - in - line o pacchetti dual - in - line. La maggior parte dei circuiti integrati di piccole e medie dimensioni utilizzano questa forma di imballaggio, il numero di pin non è generalmente più di 100. I chip in questo pacchetto hanno due file di cavi. I perni possono essere saldati direttamente ad una presa di chip della struttura DIP o ad una posizione di saldatura con lo stesso numero di fori. La sua caratteristica è in grado di realizzare facilmente la saldatura di perforazione della scheda PCB, buona compatibilità con la scheda madre.
1. CerDIP (Pacchetto ceramico doppio in linea)
Pacchetto ceramico Cerdip dual in linea per ECL RAM, DSP (Digital Signal Processor) e altri circuiti. Cerdip con finestra di vetro viene utilizzato per EPROM cancellabile ULTRAVIOLET e circuiti microcomputer con EPROM incorporato, ecc.
2. PDIP (pacchetto di plastica)
Questo tipo di pacchetto di plastica doppio - in - linea è abbastanza comune. Adatto per l'installazione di PCB attraverso foro. L'operazione semplice, può utilizzare il debug della presa IC. Ma la dimensione del pacchetto è molto più grande del chip, l'efficienza dell'imballaggio è molto bassa. Un sacco di area di installazione efficace.
13. TO (pacchetto di forma transistor)
TO è un pacchetto di forma del transistor. Uno è un tipo di pacchetto transistor che consente al piombo di essere montato in superficie, e l'altro è un pacchetto di cassa metallica rotondo senza componenti di montaggio superficiale. Questo pacchetto è ampiamente usato, molti transistor, tubi MOS, tiristori e così via sono utilizzati questo pacchetto.