Con l'emergere di imballaggi miniaturizzati ad alta densità, i requisiti per l'alta velocità Scheda PCB e l'assemblaggio ad alta precisione sono diventati più critici, Le attrezzature e i processi di assemblaggio correlati sono diventati più avanzati e flessibili. Poiché flip-chip ha un fattore di forma più piccolo, diametro e campo della palla più piccoli di BGA o CSP, offre possibilità senza precedenti per il processo di posizionamento della palla, tecnologia del substrato, compatibilità dei materiali, processo di fabbricazione, attrezzature e metodi di ispezione. sfida. Oggigiorno, ci sono sempre più forme di imballaggio miniaturizzate e ad alta densità di dispositivi elettronici, such as multi-module packaging (MCM), system-in-package (SiP), flip-chip (FC, Flip-Chip) and other applications. L'avvento di queste tecnologie ha ulteriormente offuscato la linea tra imballaggio e assemblaggio secondario. Senza dubbio, con l'emergere di imballaggi miniaturizzati ad alta densità, i requisiti per l'assemblaggio ad alta velocità e ad alta precisione sono diventati più critici, Le attrezzature e i processi di assemblaggio correlati sono diventati più avanzati e flessibili. Poiché flip-chip ha un fattore di forma più piccolo, diametro e campo della palla più piccoli di BGA o CSP, offre possibilità senza precedenti per il processo di posizionamento della palla, tecnologia del substrato, compatibilità dei materiali, processo di fabbricazione, attrezzature e metodi di ispezione. sfida. These requirements are analyzed in detail below:
1. Per i requisiti del controllo della pressione di montaggio, considerando che il substrato flip-chip per PCB è relativamente fragile di silicio, se si applica una grande pressione durante il processo di recupero del materiale e di immersione del flusso, è facile essere fratturato, e allo stesso tempo Piccoli urti di saldatura si deformano facilmente durante questo processo, quindi cerca di utilizzare una pressione di montaggio relativamente bassa. Il requisito generale è di circa 150g. Per chip ultrasottili, come 0.3mm, a volte la pressione di montaggio è anche necessaria per essere controllata a 35g.
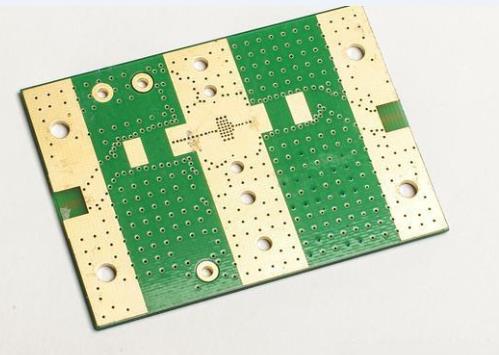
2. Per i requisiti di precisione e stabilità del posizionamento, per dispositivi con campo palla fino a 0.1mm, quale precisione di posizionamento è richiesta per ottenere un rendimento elevato? La deformazione e la deformazione del substrato, la dimensione e la deviazione di posizione della finestra della maschera di saldatura, e l'accuratezza della macchina influenzerà l'accuratezza finale del posizionamento. Non discuteremo l'influenza della progettazione e produzione del substrato sul posizionamento, ma qui discutiamo solo la precisione di posizionamento della macchina.
3. I requisiti del processo di assemblaggio del chip per l'apparecchiatura di posizionamento, per rispondere alle domande di cui sopra, let's build a simple hypothetical model:
1) Assume that the solder bumps of the flip-chip Scheda PCB sono sferici, and the corresponding pads on the substrate are circular and have the same diameter;
2) It is assumed that there is no influence of substrate warpage and manufacturing defects;
3) Does not consider the effects of Theta and shock;
4) During the reflow soldering process, il dispositivo è auto-neutrale, e il 50% del contatto tra la sfera di saldatura e la superficie bagnata può essere "tirato su" durante il processo di saldatura. Poi, sulla base delle ipotesi di cui sopra, se il diametro della sfera di saldatura con un diametro di 25μm è 50μm, the left and right position deviation (X axis) or the front and rear position deviation (Y axis) is 50% of the pad size. Le palle sono sempre sulle pastiglie. Per flip-chip Scheda PCBs con un diametro della sfera di saldatura di 25μm, se la capacità di processo Cpk deve raggiungere 1.33, la precisione della macchina deve raggiungere 12μm.
4. Secondo i requisiti delle telecamere e della tecnologia di elaborazione delle immagini, una fotocamera digitale con megapixel è necessaria per elaborare le immagini di flip-chip Scheda PCBs con campi di sfere di saldatura fini. Le fotocamere digitali con pixel più alti hanno ingrandimenti più elevati, tuttavia, più alti sono i pixel, the smaller the field of view (FOV), il che significa che i dispositivi più grandi potrebbero dover essere "fotografati" più volte. La sorgente luminosa della fotocamera è generalmente diodo ad emissione luminosa, che è diviso in sorgente luminosa laterale, sorgente luminosa anteriore e sorgente luminosa assiale, e può essere controllato in modo indipendente. La sorgente luminosa di imaging del chip flip per Scheda PCB adotta luce laterale, luce anteriore, o una combinazione di entrambi. Quindi come si sceglie una fotocamera per un dato dispositivo? Questo dipende principalmente dall'algoritmo dell'immagine. Per esempio, Ci vogliono N pixel per distinguere una palla di saldatura, e 2N pixel sono necessari per distinguere il campo della palla. Prendendo come esempio la fotocamera digitale Magellan sulla macchina di posizionamento Universal Instruments, Ci vogliono 4 pixel per distinguere una palla di saldatura. Scegli una fotocamera, supponendo che tutte le immagini siano pari al 75% della dimensione effettiva dell'oggetto. L'elaborazione di immagini di fiduciali flip-chip per Scheda PCBs è simile a quello dei fiduciali ordinari. Montaggio Flip-chip per Scheda PCBs utilizza spesso fiduciali locali in aggiunta ai fiduciali GLOBAL. In questo momento, the fiducials will be small (0.15-1.0mm), e la selezione delle telecamere si riferisce al metodo sopra. La scelta della sorgente luminosa deve essere presa in considerazione. Generalmente, La sorgente luminosa della fotocamera sulla testa SMD è luce rossa, e l'effetto è molto scarso quando si tratta del punto di riferimento sul circuito flessibile, e il punto di riferimento non può nemmeno essere trovato. The reason is that the surface of the reference point (copper) The color is very close to the substrate color, e la differenza di colore non è evidente. Se si utilizza la tecnologia della sorgente di luce blu di Universal Instruments, questo problema può essere risolto molto bene.
5. Selection of nozzles
Since the flip-chip substrate for PCB is silicon, la superficie superiore è molto piana e liscia, e la testa è un materiale plastico rigido con un ugello ESD poroso. Se si sceglie un ugello con una testa di gomma, come la gomma invecchia, il dispositivo può attaccarsi al dispositivo durante il processo di posizionamento, causare il posizionamento di spostare o togliere il dispositivo.
6. Requisiti per l'unità di applicazione del flusso. L'unità di applicazione del flusso è una parte importante del controllo del processo di immersione del flusso. Il principio di base del suo lavoro è quello di ottenere una pellicola di flusso stabile con uno spessore impostato, in modo che ogni sfera di saldatura del dispositivo possa essere facilmente immerso. Assumere la stessa quantità di flusso. Per controllare stabilmente lo spessore del film di flusso mentre soddisfa i requisiti di immersione ad alta velocità, the flux application unit must meet the following requirements:
1) It can meet the requirements of dipping multiple devices with flux at the same time (such as dipping 4 or 7 pieces at the same time) to increase the output;
2) The unit for flux should be simple, facile da usare, easy to control and easy to clean;
3) It can handle a wide range of fluxes or solder pastes. La gamma di viscosità dei flussi adatti al processo di immersione è ampia, e può gestire flussi sia più sottili che più viscosi, and the obtained film thickness should be uniform;
4) The dipping process can be controlled, e i parametri del processo di immersione saranno diversi a causa di materiali diversi, quindi i parametri di processo del processo di immersione devono essere controllati individualmente, come accelerazione verso il basso, pressione, tempo di sosta, accelerazione verso l'alto, ecc.
7. Per i requisiti dell'alimentatore, per soddisfare la produzione di lotti ad alta velocità e ad alta resa, anche la tecnologia di alimentazione è molto critica. Metodi di imballaggio con chip flip-chip per Scheda PCBs mainly include: 2*2 or 4*4 inch JEDEC reels, 200mm or 300mm wafer reels (Wafer), and reel reels (Reel). I corrispondenti alimentatori sono:, Alimentatore impilabile automatizzato, Alimentatore per wafer, e alimentatore nastro. Tutte queste tecnologie di alimentazione devono essere in grado di alimentare ad alta velocità, e l'alimentatore per wafer è inoltre richiesto di essere in grado di gestire una varietà di metodi di imballaggio del dispositivo, Come ad esempio: L'imballaggio del dispositivo può essere vassoi JEDEC, o wafer nudi, o anche chip completi nella macchina. Azione ribalta. Let's take an example to illustrate the characteristics of Unovis's bare die feeder (DDF Direct Die Feeder):
1) Can be used in hybrid circuits or sensors, moduli multi-chip, system-in-package, RFID and 3D assembly;
2) The disc can be fed vertically to save space, and one machine can install multiple DDFs;
3) The chip can be flipped in DDF;
4) Can be installed on a variety of patch platforms.
8. Requisiti per il sistema di supporto e posizionamento del bordo, alcuni chip flip PCB sono utilizzati su circuiti stampati flessibili o circuiti stampati sottili. In questo momento, il supporto piatto del substrato è molto importante. The solution often uses a carrier plate and a vacuum suction system to form a flat support and positioning system that meets the following requirements:
1) Support control in the Z direction of the substrate, and programming adjustment of the support height;
2) Provide customized board support interface;
3) Complete vacuum generator;
4) Non-standard and standard carrier boards can be applied.
9. Ispezione dopo saldatura a riflusso e indurimento del riempitore, ci sono ispezioni non distruttive e ispezioni distruttive per l'ispezione del prodotto dopo il completamento del sottoriempimento. The non-destructive inspection includes:
1) Use an optical microscope to conduct visual inspection, come controllare se il riempitore si arrampica sul lato del dispositivo, se si forma un buon filetto di bordo, e se la superficie del dispositivo è sporca, ecc.;
2) Use an X-ray inspector to check whether the solder joints are short-circuited, a circuito aperto, offset, bagnato, vuoti nei giunti di saldatura, ecc.;
3) Electrical test (Continuity test), che può verificare se c'è qualche problema con il collegamento elettrico. Per alcune schede di prova con un design a catena margherita, the location of the solder joint failure can also be determined through the continuity test;
4) Use ultrasonic scanning microscope (C-SAM) to check se ci sono vuoti, stratificazione e flusso completo dopo sottoriempimento. Le ispezioni distruttive possono sezionare giunti di saldatura o sottoriempimento, combinato con microscopia ottica, metallographic microscopy or scanning electron microscopy and energy dispersive analyzers (SEM/EDX) to examine the microstructure of solder joints, e.g., microcrack/micropori, cristallizzazione di stagno, composti intermetallici, condizioni di saldatura e bagnatura, se il sottoriempimento ha vuoti, crepe, delaminazione, e se il flusso è completo, ecc. I difetti comuni dei prodotti dopo la saldatura a riflusso e il processo di sottoriempimento sono:/circuito aperto, scarsa bagnatura del giunto di saldatura, vuoto del giunto di saldatura/bolla, cracking giunto di saldatura/fragilità, sottoriempimento e delaminazione dei trucioli e cracking dei trucioli, ecc. . Per la completezza del sottoriempimento, whether there are voids, crepe e delaminazione nel riempitivo, it needs to be observed by an ultrasonic scanning microscope (C-SAM) or a flat section parallel to the bottom surface of the chip. I difetti aumentano la difficoltà. La delaminazione tra il materiale di sottoriempimento e il truciolo tende a verificarsi ai quattro angoli dei dispositivi sollecitati o all'interfaccia dei giunti di riempimento e saldatura.
Flip-chip per PCB ha mostrato vantaggi in termini di costo del prodotto, prestazioni e imballaggi ad alta densità, e la sua applicazione è gradualmente diventata mainstream. A causa delle piccole dimensioni del flip-chip utilizzato per Scheda PCBs, è necessario garantire alta precisione, elevata resa e elevata ripetibilità, che pone sfide alle nostre attrezzature e processi tradizionali, which are reflected in the following aspects:
1) The design of the substrate (hard board or soft board);
2) Assembly and inspection of equipment;
3) Manufacturing process, processo di montaggio del chip, Processo di fabbricazione dei PCB, SMT process;
4) Material compatibility.
Una comprensione completa dei problemi di cui sopra è la base per un processo di assemblaggio flip-chip di successo per Scheda PCB.