La porosità è solitamente un problema legato ai giunti saldati. Soprattutto quando si utilizza la tecnologia PCB per riflusso della pasta di saldatura, nel caso di chip ceramici senza piombo, la maggior parte dei pori grandi (>0,0005 pollici / 0,01 mm) si trovano tra i giunti di saldatura LCCC e i giunti di saldatura del circuito stampato Allo stesso tempo, nella saldatura a filetto vicino al castello LCCC, ci sono solo pochi pori piccoli. L'esistenza di pori influenzerà le proprietà meccaniche del giunto saldato e danneggerà la resistenza, la duttilità e la vita a fatica del giunto. Questo perché la crescita dei pori si fonderà in crepe estensibili e causerà affaticamento. I pori aumenteranno anche lo stress e la covarianza della saldatura, che è anche la causa del danno. L'impianto di lavorazione trucioli SMT di Shanghai ha sottolineato che, inoltre, la saldatura si restringe durante la solidificazione, la delaminazione dei gas di scarico e il flusso entrante durante la saldatura galvanizzata attraverso fori sono anche le ragioni della porosità.
Nel processo di saldatura PCB, il meccanismo di formazione dei pori è più complicato. In generale, i pori sono causati dallo scarico del flusso inserito nella saldatura nella struttura a sandwich durante il riflusso (2,13) La formazione dei pori è principalmente determinata dalla saldabilità dell'area metallizzata e cambia con la diminuzione dell'attività di flusso, l'aumento del carico metallico della polvere e l'aumento dell'area di copertura sotto il giunto di piombo.
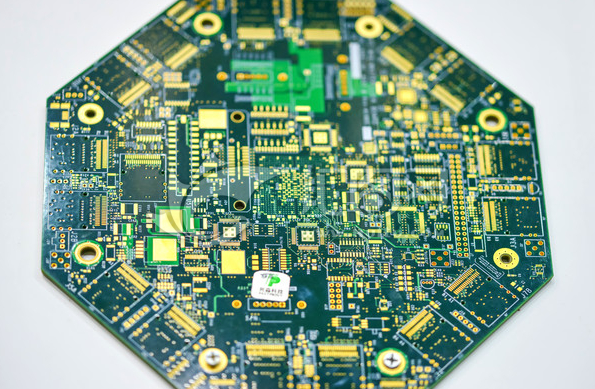
Ridurre le dimensioni delle particelle di saldatura può solo aumentare la porosità. Inoltre, la formazione dei pori è anche correlata alla ripartizione del tempo tra la coalescenza della polvere di saldatura e l'eliminazione degli ossidi metallici fissi. Più prima la pasta di saldatura si fonde, più vuoti si formano. Generalmente, la proporzione di pori grandi aumenta con l'aumento dei pori totali. Rispetto alla situazione mostrata dai risultati dell'analisi dei pori totali, quei fattori istruttivi che causano pori avranno un impatto maggiore sull'affidabilità dei giunti saldati. Alcune società di saldatura dei circuiti stampati hanno sottolineato che i metodi per controllare la formazione dei pori includono:
1. migliorare la saldabilità dei componenti PCB / camicia inferiore;
2. Utilizzare flusso con maggiore attività di flusso;
3. ridurre gli ossidi della polvere di saldatura;
4.Using un'atmosfera di riscaldamento inerte.
5. Rallenta il processo di preriscaldamento prima di riflusso. Rispetto alla situazione di cui sopra, la formazione dei pori nell'assemblea BGA segue un modello leggermente diverso. In generale. Nell'assemblaggio BGA che utilizza blocchi saldatori in latta 63, i pori sono principalmente in Generati durante la fase di assemblaggio a livello di scheda. Sul circuito stampato pre-stagnato, la quantità di pori nel connettore BGA aumenta con la volatilità del solvente, la composizione del metallo e l'aumento della temperatura di riflusso, e aumenta anche con la diminuzione della dimensione delle particelle; Questo può essere spiegato dalla viscosità che determina il tasso di scarico del flusso. Secondo questo modello, un fluido con una viscosità più elevata alla temperatura di riflusso impedirà che il flusso venga scaricato dalla saldatura fusa. Pertanto, aumentando la quantità di flusso entrated aumenterà il tasso di scarico. La possibilità di gas, con conseguente maggiore porosità nel gruppo BGA. Senza considerare la saldabilità della zona fissa di metallizzazione, l'effetto dell'attività del flusso e dell'atmosfera di riflusso sulla generazione dei pori sembra essere trascurabile La proporzione di pori grandi aumenterà con l'aumento dei pori totali, il che indica che i fattori che causano i pori in BGA hanno un impatto maggiore sull'affidabilità dei giunti saldati rispetto a quelli mostrati dai risultati dell'analisi dei pori totali. L'impatto è simile alla situazione della città vuota nel processo SMT.
Quando la pasta di saldatura è in un ambiente riscaldato, il reflow della pasta di saldatura è diviso in cinque fasi. In primo luogo, il solvente utilizzato per raggiungere la viscosità richiesta e le prestazioni di serigrafia inizia ad evaporare e l'aumento della temperatura deve essere lento (circa 3°C al secondo) per limitare l'ebollizione e gli spruzzi, per evitare la formazione di piccole perle di stagno. Inoltre, alcuni componenti sono più sensibili allo stress interno. Se la temperatura esterna dei componenti PCB aumenta troppo velocemente, causerà la rottura.
Il flusso è attivo e inizia l'azione di pulizia chimica. Il flusso solubile in acqua e il flusso non pulito avranno la stessa azione pulente, ma la temperatura è leggermente diversa. Rimuovere gli ossidi metallici e alcuni contaminanti dal metallo e dalle particelle di saldatura da incollare. Buoni giunti metallurgici per saldare stagno richiedono superfici "pulite"
Quando la temperatura continua ad aumentare, le particelle di saldatura prima si sciolgono individualmente e iniziano il processo di liquefazione e assorbimento superficiale dello stagno. Questo copre tutte le superfici possibili e inizia a formare giunti di saldatura.
Questa fase è la più importante. Quando le singole particelle di saldatura sono tutte fuse, si combinano per formare stagno liquido. In questo momento, la tensione superficiale inizia a formare la superficie del piede di saldatura. Se lo spazio tra il perno del componente e il pad PCB supera 4 mil, è molto probabile che la tensione superficiale del PCB separi il cavo dal pad, il che causa un circuito aperto nel punto di stagno. Nella fase di raffreddamento, se il raffreddamento è veloce, la forza del punto di stagno sarà leggermente più grande, ma non dovrebbe essere troppo veloce per causare stress di temperatura all'interno del componente.