Con il rapido sviluppo della tecnologia micro-elettronica, l'ampia applicazione di circuiti integrati su larga scala e ultra-grande scala e il progresso della tecnologia di micro-assemblaggio, la produzione di circuiti stampati PCB HDI si sta sviluppando verso la direzione stratificata e multifunzionale e i fili grafici del circuito stampato PCB sono sottili e micro-porosi con spaziatura stretta. La tecnologia di perforazione meccanica utilizzata nella lavorazione non può più soddisfare i requisiti e ha rapidamente sviluppato un nuovo metodo di lavorazione del micro-foro, vale a dire la tecnologia di perforazione laser.
Principio di formazione del foro laser per HDI PCB
Il laser è un potente fascio di luce che viene stimolato da uno stimolo esterno per aumentare l'energia, in cui la luce infrarossa e visibile hanno energia termica e la luce ultravioletta hanno energia ottica. Ci sono tre fenomeni che si verificano quando questo tipo di luce colpisce la superficie del pezzo in lavorazione: riflessione, assorbimento e penetrazione.
Colpendo un punto laser su un substrato attraverso un altro pezzo di ottica, ci sono molteplici modalità di composizione e ci sono tre reazioni con il punto illuminato.
La funzione principale della perforazione laser è quella di rimuovere rapidamente il materiale del substrato da elaborare. Dipende principalmente dall'ablazione fototermica e dall'ablazione fotochimica o cosiddetta escissione.
1. ablazione fototermica: il principio dei fori formati da un materiale in lavorazione che assorbe la luce laser ad alta energia ed è riscaldato per fondere ed evaporare in un tempo molto breve. Sotto l'azione di alta energia, il residuo carbonizzato nero sulla parete porosa formata da questo processo deve essere pulito prima della porizzazione.
2. ablazione fotochimica: si riferisce all'alta energia fotonica nella regione ultravioletta che supera 2eV volt elettrone. Il risultato di fotoni ad alta energia con lunghezza d'onda laser oltre 400 nanometri. Questo fotone ad alta energia distrugge la lunga catena molecolare dei materiali organici e diventa particelle più piccole, ma la sua energia è più grande della molecola originale ed è costretto a fuggire da esso, in modo che il materiale del substrato viene rapidamente rimosso e i micro-pori si formano sotto il pizzico esterno.
Pertanto, questo tipo di processo non contiene ebollizione e non si verificherà carbonizzazione. Pertanto, la pulizia della pre-porosizzazione è molto semplice.
Questi sono i principi di base della formazione dei pori laser. Attualmente, ci sono due metodi di perforazione laser più comunemente usati: il laser utilizzato per la perforazione dei fori nei circuiti stampati consiste principalmente del laser a gas CO2 eccitato RF e del laser UV a stato solido Nd: YAG.
3. circa l'assorbimento della piastra di base: Il tasso di successo del laser ha una relazione diretta con l'assorbimento del materiale di base. Il circuito stampato è una combinazione di foglio di rame, panno di vetro e resina. L'assorbimento di questi tre materiali varia a seconda della lunghezza d'onda, ma la lamina di rame e il panno di vetro sono 0,3m in luce ultravioletta. μ Le seguenti regioni hanno tassi di assorbimento più elevati, ma cadono bruscamente dopo essere entrati in luce visibile e IR. I materiali in resina organica mantengono tassi di assorbimento abbastanza elevati in tutti e tre i segmenti spettrali. Questa è la caratteristica dei materiali in resina e la base per la popolarità della tecnologia di perforazione laser.
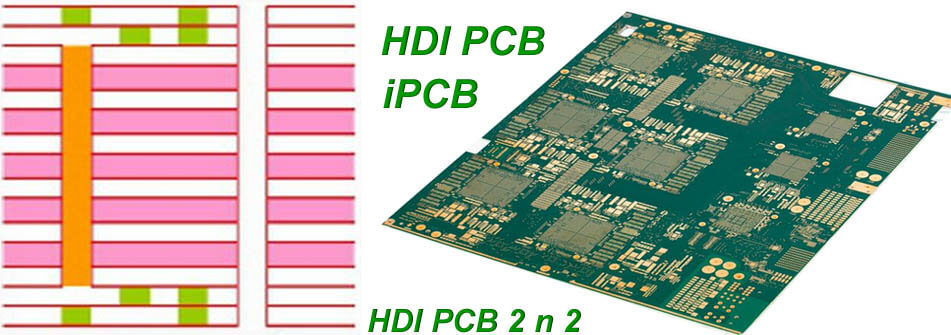
Diversi processi del PWB HDI per la formazione del foro del laser di CO2
Ci sono due metodi principali di perforazione per la perforazione laser CO2, la perforazione diretta e la perforazione della maschera della medicazione. La cosiddetta tecnologia di foratura diretta consiste nel modulare il diametro del raggio laser attraverso il sistema di controllo principale del dispositivo allo stesso diametro del foro sul circuito stampato e direttamente elaborare il foro sulla superficie dielettrica senza foglio di rame. Il processo della maschera di rivestimento consiste nel rivestire la superficie del cartone stampato con una maschera speciale e rimuovere il foglio di rame dalla superficie del foro mediante esposizione / sviluppo / incisione con il processo convenzionale. Questi fori vengono poi irradiati con un raggio laser più grande dell'apertura per rimuovere la resina dello strato dielettrico esposto. Sono descritti separatamente quanto segue:
1. Metodo di apertura della finestra in bronzo:
Per prima cosa premere uno strato di foglio di rame rivestito in resina RCC sul pannello interno. Una finestra è fatta dalla fotochimica, quindi la resina è incisa per esporla e quindi il materiale del substrato all'interno della finestra è ablato dal laser per formare un foro micro-cieco:
Quando il fascio è migliorato, passa attraverso l'apertura per raggiungere due gruppi di scanner micro riflettenti tipo galvanometro, che sono allineati verticalmente una volta all'obiettivo F Î positivo. L'area del tubo viene raggiunta dove si può realizzare l'emozionante piano di lavoro e quindi i fori micro-ciechi vengono bruciati uno ad uno.
Una volta posizionato da un fascio rapido di elettroni in un'area tubolare di pollice quadrato, il foro cieco da 0,15 mm può essere perforato con tre colpi. La larghezza dell'impulso del primo cannone è di circa 15 μ S, che fornisce energia per la formazione del foro. Successivamente, la pistola può essere utilizzata per pulire il residuo nella parte inferiore della parete del foro e per correggere il foro.
Sezione trasversale SEM e vista completa di 45 gradi del foro micro-cieco da 0.15mm con buon controllo dell'energia del laser. Questo processo di apertura della finestra è utilizzato come piastra di destinazione di supporto. Quando la tipografia di grandi dimensioni o fori ciechi di secondo ordine non sono necessari molto spesso, il loro allineamento è difficile.
2. Metodo di apertura della finestra:
Il diametro dei fori formati dal precedente processo è lo stesso di quello della finestra di rame aperta. Un leggero errore di funzionamento può causare la deviazione della posizione della finestra aperta, con conseguente disallineamento della posizione del foro cieco con il centro del pad base. La deviazione della finestra di rame può essere dovuta all'espansione e alla contrazione del materiale della matrice e alla distorsione del negativo utilizzato per il trasferimento dell'immagine. Quindi il processo di apertura della grande finestra di rame è quello di allargare il diametro della finestra di rame a 0,05 mm più grande di quello del pad di base. Di solito, la dimensione del foro è determinata dalla dimensione del foro. Quando il foro è 0.15mm, il diametro del pad base dovrebbe essere di circa 0.25mm e il diametro della grande finestra dovrebbe essere di 0.30mm. Quindi la perforazione laser può essere fatta per allineare la posizione di burnout precisamente al foro micro-cieco del pad base. La sua caratteristica principale è che ha un grande grado di libertà di scelta. Durante la perforazione dei fori laser, è possibile scegliere di premere il programma del pad di base interno per fare fori. Questo evita efficacemente il disallineamento causato dallo stesso diametro della finestra in rame di quello dei fori, che impedisce al punto laser di puntare verso la finestra anteriore e provoca la comparsa di molti semifori incompleti o fori residui su grandi lotti di lastre.
3. Processo diretto di formazione dei pori sulla superficie della resina del PCB HDI
Ci sono diversi tipi di metodi di perforazione laser che utilizzano il laser PCB HDI per perforare i fori:
A. La piastra di base è rivestita con foglio di rame rivestito in resina sullo strato interno e quindi inciso fuori tutto il foglio di rame, laser CO2 può essere utilizzato per formare direttamente fori sulla superficie della resina nuda e quindi i fori possono essere ulteriormente trattati secondo il processo di placcatura.
B. La piastra di base è un processo simile che utilizza il foglio semi-indurito FR-4 e la lamina di rame invece della lamina di rame rivestita in resina.
C. Processo per successiva laminazione del foglio di rame con resina fotosensibile rivestita.
D. Fatto da film secco come strato dielettrico e processo di pressatura della lamina di rame.
E. Il processo di rivestimento di altri tipi di film caldo con lamina di rame.
4. ablazione diretta del foglio di rame ultra-sottile
Dopo che il foglio di rame della resina è premuto su entrambi i lati della piastra interna del nucleo, lo spessore del foglio di rame di 17m può essere ridotto a 5micron con il metodo "mezza incisione" e quindi trattato con ossidazione nera, i fori possono essere formati dal laser CO2.
Il principio di base è che la superficie nera ossidata assorbirà la luce intensamente, in modo che il foglio di rame super sottile e la superficie della resina possano essere porati direttamente sulla premessa di aumentare l'energia del fascio del laser CO2. Tuttavia, la cosa più difficile è garantire che il "metodo di mezza incisione" possa ottenere strati di rame uniformemente spessi, quindi una particolare attenzione dovrebbe essere prestata alla loro fabbricazione. Naturalmente, il materiale strappabile con supporto di rame UTC. Foglio di rame è equivalente a un libro di circa 5um.
Secondo questo tipo di lavorazione delle lastre, i seguenti aspetti principali sono attualmente adottati nel processo:
Ciò stabilisce principalmente rigorosi criteri di qualità e tecnici per i fornitori di materiali per garantire che la differenza di spessore dello strato dielettrico sia 510 μ M a M. Poiché solo l'uniformità dello spessore dielettrico del foglio di rame rivestito in resina può essere garantita, l'accuratezza del passaggio e la pulizia del fondo del foro possono essere garantite con la stessa energia laser. Allo stesso tempo, è necessario adottare le migliori condizioni di processo per rimuovere lo sporco di perforazione nell'operazione successiva per garantire che il fondo del foro cieco sia pulito e privo di residui dopo la perforazione laser. Ha un buon effetto sulla qualità della placcatura elettrolitica e galvanica del foro cieco.
Nd: Processo del PWB di perforazione del laser di YAG HDI
Nd:YAG è granato di alluminio al neodimio e ittrio. Laser UV emesso da due cristalli solidi insieme. Recentemente, i raggi laser più comunemente usati eccitati da un impulso a diodi possono essere utilizzati per creare un sistema di sigillatura laser efficace senza raffreddamento ad acqua. La terza lunghezza d'onda armonica di questo laser è 355 nanometri. La quarta lunghezza d'onda armonica è 266 nanometri. La lunghezza d'onda è modulata da un cristallo ottico.
La più grande caratteristica di questo tipo di perforazione laser è UV ultravioletto. Regione dello spettro, mentre la lamina di rame e le fibre di vetro costituite da laminati rivestiti di rame assorbono fortemente nella regione ultravioletta, insieme alla piccola energia di tali punti luce laser, possono penetrare fortemente attraverso la lamina di rame e il panno di vetro e formare fori direttamente. Poiché il calore laser del tipo di cui sopra è piccolo, non produce scorie di carbone dopo la perforazione laser CO2, che fornisce una buona superficie per le successive operazioni della parete del foro.
Nd: la tecnologia laser YAG elabora i fori ciechi del logo e passa attraverso i fori su una varietà di materiali. Esegue fori nel laminato rivestito di rame poliimide con un diametro minimo di 25 micron. Dall'analisi dei costi, il diametro più economico utilizzato è 25125 micron. La velocità di perforazione è 10000 fori/min. La punzonatura laser diretta può essere utilizzata con un'apertura massima di 50 micron. La superficie interna del foro formato è pulita e priva di carbonizzazione e facile da galvanizzare. Può anche perforare fori in laminato rivestito di rame PTFE con un diametro minimo di 25 micron e un diametro più economico di 25125 micron. La velocità di perforazione è 4500 fori/min. Non è richiesta alcuna pre-incisione della finestra. I fori sono puliti e non richiedono particolari requisiti di lavorazione. Ci sono altri materiali come la lavorazione del foro di sagomatura. I seguenti processi possono essere utilizzati in specifiche lavorazioni: 1. Due processi combinati sono adottati in base alla velocità di due tipi di perforazione laser
Il metodo di funzionamento di base è quello di utilizzare YAG per ablare il foglio di rame sulla superficie della posizione del foro in primo luogo e quindi utilizzare il laser CO2 che è più veloce della perforazione YAG per ablare la resina direttamente per formare il foro.
Problemi di qualità nella produzione effettiva di PCB HDI
Nel processo di perforazione laser, ci sono molti problemi di qualità, che non sono pronti per essere descritti completamente. Solo i problemi di qualità più comuni sono proposti per il peer reference.
A. disallineamento tra la posizione di perforazione laser CO_2 e la posizione dell'obiettivo inferiore nel metodo a finestra aperta
Nella perforazione laser del PWB HDI, il sistema di posizionamento del fascio è molto importante per l'accuratezza della sagomatura dell'apertura. Sebbene il sistema di posizionamento del fascio sia utilizzato per un posizionamento preciso, le fiamme con forma di foro sono spesso prodotte a causa di altri fattori. I problemi di qualità che sorgono nel processo produttivo sono analizzati come segue:
1. rendere negativo per il pad interno della saldatura della piastra centrale e la grafica del filo, e RCC con foglio di rame rivestito in resina. Negativo per l'apertura della finestra dopo l'aggiunta dello strato, poiché entrambi sono fattori potenziali per aumentare e diminuire le dimensioni a causa dell'umidità e della temperatura.
2. la dimensione del materiale di base aumenta o diminuisce quando la piastra centrale è utilizzata per fare il modello del cuscinetto di adesione trasversale e il RCC del foglio di rame rivestito in resina è premuto ad alta temperatura. Dopo l'aggiunta di strati, esistono i fattori di espansione dimensionale e contrazione dei materiali interni ed esterni del basamento.
3. Le dimensioni e la posizione della finestra di rame inciso causeranno anche errori.
4. Errore causato dal punto luce del laser stesso e dallo spostamento della superficie.
5. L'allineamento dei fori ciechi di secondo ordine è più difficile e può facilmente causare errori di posizione.
Sulla base dei suddetti motivi, in base ai pertinenti dati tecnici ottenuti in produzione e all'effettiva esperienza operativa, le principali strategie tecnologiche adottate sono le seguenti:
1. Per ridurre le dimensioni della tipografia, la maggior parte dei produttori di PCB HDI utilizzano 450 per la tipografia multistrato * 600 o 525 * 600mm. Tuttavia, per i pannelli del telefono cellulare con larghezza del cavo di 0,10 mm e diametro del foro cieco di 0,15 mm, la migliore dimensione del layout è 350. 450mm. Limite superiore.
2. Aumentare il diametro del laser: lo scopo è quello di aumentare l'area coperta dalla finestra di rame. Il metodo specifico è "diametro del fascio = diametro del foro + 90 ~ 100" μ M. Quando la densità di energia è bassa, sparare uno o due colpi più per risolvere il problema.
3. Prendere il processo di apertura di una grande finestra di rame: in questo momento, solo la dimensione della finestra di rame diventa più grande e l'apertura non viene cambiata, quindi il diametro dei fori laser non è più completamente determinato dalla posizione della finestra, in modo che la posizione del foro può essere direttamente basata sulla posizione del bersaglio base sulla piastra centrale.
4. Cambiare il metodo di apertura della finestra dall'imaging fotochimico e l'incisione al laser YAG: usando i punti luce del laser YAG per aprire la finestra secondo il foro base della piastra centrale in primo luogo, quindi usando il laser CO2 per bruciare il foro sulla sua posizione della finestra, per risolvere l'errore causato dall'imaging.
5. strato due volte per fare il metodo micro-cieco del foro di secondo ordine: quando la piastra centrale è rivestita con RCC della lamina di rame della resina su entrambi i lati. Dopo di che, se RCC deve essere accumulato ancora una volta e viene fatto un buco cieco di secondo ordine, il buco cieco di secondo ordine sarà accumulato. Nel caso di allineamento a "due" fori ciechi, i fori devono essere formati puntando a "uno per uno". L'obiettivo originale della piastra centrale non può essere riutilizzato. Cioè, quando "ne accumula uno" in fori e pastiglie, i suoi bordi della tavola faranno anche bersagli. Pertanto, dopo aver premuto il RCC di "Ji 2", quattro fori di dato meccanici aggiuntivi di "Ji 2" possono essere perforati attraverso la macchina a raggi X per mirare su "Ji 1", e quindi i fori sono allineati. Questo metodo può rendere "Ji 2" allineato con "Ji 1" per quanto possibile.
B. Passaggio errato
Sulla base di molte esperienze di produzione, principalmente a causa dei problemi di qualità nella formatura del materiale di base, il problema principale di qualità è che lo spessore dello strato dielettrico dopo la pressatura della lamina di rame rivestita in resina diverrà inevitabilmente. Con la stessa energia dei fori di perforazione, il cuscino della parte più sottile dello strato dielettrico non solo porterà più energia, ma rifletterà anche più energia. Così, la parete del foro viene sbattuta in un bollitore espanso verso l'esterno. Ciò avrà un impatto significativo sulla qualità dell'interconnessione elettrica tra strati di strati multistrato.
A causa delle dimensioni errate dei pori, l'affidabilità della struttura di interconnessione ad alta densità del circuito stampato multistrato stratificato (MLPCB) porrà una serie di problemi tecnici.
Occorre pertanto adottare misure di processo per controllare e risolvere il problema. Vengono utilizzati principalmente i seguenti processi:
1. controllare rigorosamente la differenza di spessore dello strato dielettrico tra foglio di rame rivestito in resina e foglio di rame laminato a 510 μ M a M.
2. Cambiare la densità di energia del laser e il numero di pistole pulsate. Le condizioni di processo per la produzione di massa possono essere trovate attraverso metodi di prova.
3. Le scorie nella parte inferiore del foro e le scorie rotte alla parete del foro non vengono rimosse correttamente.
Questo tipo di problema di qualità PCB HDI è più probabile che si verifichi a causa di un leggero controllo improprio. Soprattutto per i laminati con tipo poroso su grande piatto, è impossibile garantire al 100% qualità senza problemi di qualità. Questo perché il numero di fori micro-ciechi sullo stencil di grandi dimensioni elaborato è troppo grande, con una media di circa 60-90.000 fori. Lo spessore dello strato di supporto varia, così come lo spessore del residuo lasciato sulla base quando si utilizza la perforazione laser con la stessa energia. Non è possibile garantire che tutti i residui siano accuratamente puliti dopo il trattamento dello sporco di perforazione. Inoltre, metodi di ispezione inadeguati spesso si traducono nella successiva placcatura in rame PCB HDI e nel legame tra il pad inferiore e la parete del foro quando c'è un difetto.