BGAのフルネームは「グリッドアレイ」であり、グリッドアレイ構造を有するPCBを意味する。有機担体を用いた集積回路パッケージ方法である。BGAを備えたPCBボードには通常、より多くの小さな穴があり、BGA下の貫通穴は通常、直径8 ~ 12 milの完成穴として設計されています。BGA下部貫通孔は閉塞する必要があり、パッドはインクの付着を許さず、パッドは穿孔していない。
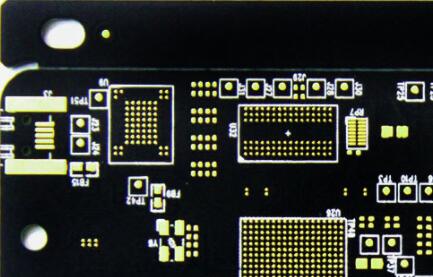
BGAは、溶接ボールアレイを用いたパッケージ方法のコンポーネントである。パッケージ基板の底部に半田ボールが発生し、基板のインタフェースとして基板が基板に接続されています。BGAコンポーネントは表面実装コンポーネントに適しており、回路には大量のピンがあり、パッケージ密度が高く、機能が強く、信頼性が高い。BGAのCPUは主にノートパソコンに使用されています。
BGAパッド設計通則
1)パッドの直径は通常、ボールの直径より小さい。信頼性の高い付着力を得るために、通常は20〜25%低下させる。パッドが大きいほど、2つのパッド間の配線スペースが小さくなります。
2)BGA基板上のパッドはPCB上のパッドと同じ直径を有する。
3)BGAのパッド設計はテンプレート開口部が0.08 mm 3のペースト漏れを引き起こすことを確保しなければならず、これは溶接点の信頼性を確保するための最低要求である。
BGA包装技術原理
BGAパッケージの主なプロセスは、半田ボールの生産、基板の生産、チップボンディング、パッケージの硬化、切断パッケージを含む。
1)ハンダボールの生産:高純度スズ鉛合金又は無鉛材料を用いてハンダボールを生産し、規則的な球形ピンアレイを形成する。
2)基板生産:多層プリント配線板を基板として採用し、高密度、高性能の電気相互接続を実現する。
3)ダイボンディング:チップを基板に接続し、無鉛または鉛系半田を用いて基板に接続する。
4)カプセル化と硬化:チップをエポキシ樹脂でカプセル化し、環境影響から保護する。
5)パッケージの分割:パッケージされたチップを個別のBGAパッケージに切断する。
BGAパッケージング技術
1.パッド設計:溶接品質と信頼性を確保するために、パッド設計は一定の基準に従わなければならない。まず、パッドの寸法が半田ボールの寸法に一致することを確保しなければならない。次に、熱膨張と熱収縮に対するスペーサ形状とレイアウトの影響を考慮する必要がある。最後に、溶接の信頼性を高めるために、パッドの表面処理にも注意しなければならない。
2.溶接技術:BGA溶接は通常リフロー溶接技術を採用する。溶接品質を保証するためには、溶接温度、時間、炉温曲線を制御する必要がある。また、溶接時の熱応力にも注意し、溶接欠陥が発生しないようにしなければならない。
3.品質検査:BGAパッケージ溶接後、接続の信頼性を確保するために品質検査を行う必要がある。一般的な検出方法はX線検出、音響放射検出などを含む。X線検出は溶接点の内部構造を直感的に観察し、溶接欠陥を検出することができる。音響放射試験は、音響信号を解析することにより溶接品質を決定する。
4.メンテナンスとメンテナンス:溶接不良のBGA包装に対して、専用メンテナンス設備を使用して再溶接することができる。通常、修復プロセスには、パッドのクリーニング、ボールの補充、チップの再接続などのステップが含まれます。修復中は、チップが破損しないように加熱温度と時間を制御する必要があります。
5.設計とレイアウト:回路設計において、BGAパッケージのレイアウトと配線は極めて重要である。電気性能、熱性能、機械的強度などの要素を十分に考慮しなければならない。配置の過程で、高性能電子システムを実現するために、信号の完全性、電源の安定性、熱管理などの問題に注意しなければならない。
BGAパッケージの利点と欠点
利点:
1)高密度:BGAパッケージはより大きなピン間隔を有し、より高い数量のI/Oピンを実現でき、高性能集積回路の要求を満たす。
2)優れた信号伝送性能:溶接ボールの接続経路が短いため、BGAパッケージは低い寄生インダクタンスと容量を持ち、信号の高速伝送に有利である。
3)良好な熱性能:BGAパッケージの溶接ボールは有効に熱伝導でき、チップの動作温度を下げるのに役立つ。
短所:
高需要生産技術:BGAパッケージは溶接技術と設備に対する要求が高く、生産コストを増加した。
BGAパッケージは、パッケージの底部に規則的な球形ピンアレイを形成することを特徴とする表面実装技術である。このパッケージ方法はピン間隔が大きく、熱性能がよく、信号伝送性能が優れているなどの利点があり、高速高性能集積回路に広く応用されている。