チップパッケージとは、半導体装置を含む材料を指す。パッケージは、腐食や物理的な損傷から保護するために回路材料をパッケージし、プリント配線基板に接続された電気接点の実装を可能にするケースです。
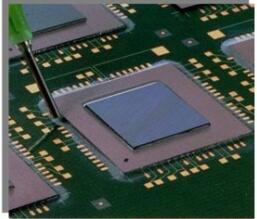
半導体集積回路チップを実装するためのハウジングは、チップの配置、固定、封止、保護、およびその熱特性を高める役割を果たす。また、チップの内部世界と外部回路との橋渡しとしても機能しています。チップ上の接点はパッケージケースのピンにワイヤを介して接続され、ピンはプリント基板上のワイヤを介して他のデバイスと接続されています。そのため、パッケージはCPUやその他のLSI集積回路において重要な役割を果たしている。
一般的なタイプのチップパッケージ
1.二列直挿式
DIP(複列直挿パッケージ)とは、複列直挿フォーマットでパッケージ化された集積回路チップを指す。ほとんどの中小規模集積回路(IC)では、このパッケージ形式が使用されており、ピンの一般的な数は100を超えていません。DIPでカプセル化されたCPUチップには、DIP構造を持つチップソケットに挿入する必要がある2列のピンがあります。もちろん、同じ数の溶接穴と幾何学的配置を持つ回路基板に直接挿入して溶接することもできます。DIPパッケージチップをチップソケットから挿入して抜き取るときは、ピンが破損しないように特に注意してください。
特徴:
1)PCB(プリント基板)上のパンチと溶接に適用し、操作が簡単である。
2)パッケージ面積とチップ面積の比較的に大きいため、体積も大きい。
インテル®シリーズCPUの8088は、このパッケージ形式を採用しており、キャッシュメモリと初期ストレージチップを搭載しています。
2.コンポーネントパッケージ
PQFP(Plastic Quad Flat Package)パッケージ内のチップピン間の距離は非常に小さく、ピンは非常に薄い。一般に、大型または超大型集積回路ではこのパッケージ形式が使用され、ピンの一部は通常100を超える。このような形でカプセル化されたチップは、マザーボードにSMD(表面実装装置技術)を用いて溶接されなければならない。SMDを使用して実装されたチップは、マザーボードの表面に対応するピンの溶接点が設計されることが多いので、マザーボードに穴をあける必要はありません。チップの各ピンを対応する溶接点に位置合わせし、マザーボードとの溶接を実現します。この方法で溶接されたチップは、専用の工具がないと取り外しが難しい。
PFP(プラスチックフラットパッケージ)モードでカプセル化されたチップは、PQFPモードでカプセル化されたものと同じである。唯一の違いは、PQFPが通常正方形であり、PFPが正方形または矩形であることである。
特徴:
1)SMD表面実装技術によるPCB基板への実装と配線に適している。
2)高周波使用に適している。
3)操作が簡単で、信頼性が高い。
4)チップ面積とパッケージ面積の比率が相対的に小さい。
インテル®シリーズCPUの80286、80386、および486マザーボードの一部は、このパッケージ形式を使用しています。
3.PGAピンネットフォーマット
PGA(Pin Grid Array Package)チップパッケージは、チップの内部と外部に複数の正方形アレイピンを有し、各正方形アレイピンはチップの円周に沿って一定の距離で配列されている。ピンの数に応じて、2~5個の円に閉じ込めることができます。インストール中に専用のPGAソケットにチップを挿入します。CPUのインストールと取り外しを容易にするために、486チップからZIFというCPUスロットが登場し、PGAパッケージCPUのインストールと取り外しの要件を満たすために設計されています。
特徴:
1)挿入と除去操作がより便利で信頼性が高い。
2)より高い周波数に適応できる。
インテルシリーズCPU、80486、Pentium、およびPentiumProは、このパッケージ形式を使用しています。
4.BGAグリッドアレイタイプ
BGAパッケージ技術はさらに5つに分類できる
1)PBGA(プラスチックBGA)基板:通常は2〜4層の有機材料からなる多層板である。インテルシリーズCPUでは、PentiumII、III、IVプロセッサーはこのパッケージ形式を採用しています。
2)CBGA(セラミックBGA)基板:セラミック基板を指し、チップと基板間の電気的接続は通常FlipChip(FC)を用いて実装される。インテル®シリーズCPUでは、PentiumI、II、およびPentiumProプロセッサーがこのパッケージ形式を採用しています。
3)FCBGA(FilpChipBGA)基板:硬質多層基板。
4)TBGA(TapeBGA)基板:基板は帯状軟質1-2層PCB回路基板である。
5)CDPBGA(Carity Down PBGA)基板:パッケージ中心に正方形の窪みを有するチップ領域(キャビティ領域とも呼ばれる)を指す。
特徴:
1)I/Oピンの数は増加したが、ピン間の距離はQFPパッケージよりはるかに大きく、これにより生産性が向上した。
2)BGAの消費電力は増加するが、制御可能な陥没チップ溶接を使用することで電気加熱性能を向上させることができる。
3)信号伝送遅延が小さく、適応周波数が大幅に向上する。
4)この部品は共面溶接ができ、信頼性が大幅に向上した。
チップパッケージは、外部環境からチップを保護します。チップは非常に脆弱で、温度、湿度、ほこり、静電などの外部環境の影響を受けやすい。チップをカプセル化しないと、これらの要因の影響を受けやすく、チップが破損したり、故障したりすることがあります。したがって、チップの長期的な安定性と信頼性を確保するために必要な保護を提供することができます。また、必要な電気的および機械的接続を提供することもできます。チップは他の電子部品に接続して回路の機能を実現する必要がある。