パッケージ基板
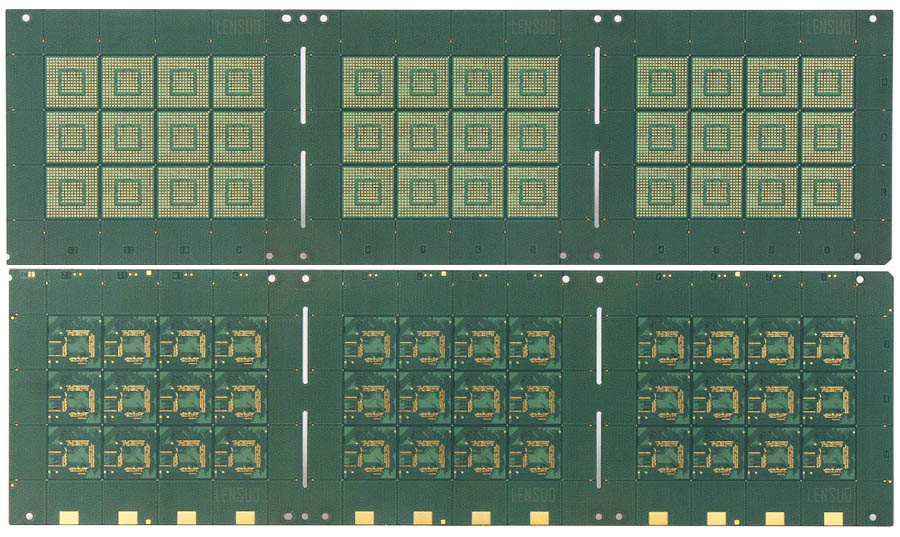
LGA PCB ( LGA ICパッケージ基板)
製品名: パッケージ基板
板材:三菱ガスハロゲンフリーBT HL 832 NX - A - HS
最小線幅/線距離:30 / 30 um
表面技術ニッケル‐パラジウム金(enepig)
板厚:0.3 mm
床数:4床
穴直径:レーザー穴0.075 mm、機械的穴0.1 mm
使用 パッケージ基板
機能 三菱ガスBT 材料
三菱ガスBT材料の特徴


WLP、WLCSPはサイズが小さく、重量が小さい
でもここに問題がある。WLPおよびWLCSPは、従来のICのピン数が増加しているが、従来のICのピン数が増加するにつれて、WLPおよびWLCSPパッケージのボールピッチ要件は厳しくなるが、回路設計に必要な電気的特性は、一般的なICに要求される電気的サポートとは異なるが、WLPおよびWLCSPのサイズはダイサイズに低減されている。加えて、WLPおよびWLCSPを有するPCBに接続されることができるコンタクトおよび回路は、非常に小さい。PCBの設計では、ソリューションは一般的なICアプリケーションソリューションと同じくらい簡単ではありません。
ウエハレベルパッケージングの使用には、コストと全体の大きさを低減することが目的であるが、ウェハレベルパッケージングを導入する際には、ウェハレベルパッケージングの使用によりPCBのコストがかかり、対応する配線を行う必要がある。パンチ処理の改善により,pcbの特性は,接続問題のないwlpとwlcsp成分と完全に整合できる。特に、WLPとWLCSPを設計方式で使用すると、PCBはより複雑になり、その役割がより重要になる。PCBの品質に起因する端末製品の安定性を避けるために設計中に慎重な計画が必要である。
基本的に、既存の設計製品において、キャリアボードを設計している場合、利用可能なキャリアボード領域は小さくなり小型化され、技術者は継続的に縮小する設計要件に直面しなければならない。例えば、ウェアラブル電子製品は、時計や携帯電話などの電子回路のために、使用可能なキャリアボードスペースは非常に貴重である。端末設計に使用するpcb領域を減らすためには,wlpやwlcspなどの小型icパッケージの導入は避けられない設計傾向である。
ウェーハステージのコンポーネントパッケージングは、キャリアボードのフットプリントを大いに節約する
WLPおよびWLCSPパッケージは、「シリコン」基板実装プロセス上に直接組み込まれているので、ICは基本的にはボンディングワイヤを使用する必要がないので、高周波成分の場合は、より良い高周波電気特性を直接得ることができ、サイクル時間を短縮することができる。また,fabでパッケージングを行うことができ,パッケージングコストを同時に節約することができるが,技術者にとっては,設計案をコスト削減の方向で考慮しなければならない。WLPおよびWLCSPコンポーネントにマッチするために、PCBコストもある程度制限されなければならない。トレードオフ設計に注意を払うか、対応する回路レイアウトを採用する。
一般的に言えば、WLPおよびWLCSPコンポーネントをインポートするために、技術者は最初にPCB回路レイアウト計画を実行する前にWLPとWLCSP(IEパッケージサイズ)の足跡を取得しなければならず、同時に、WLPおよびWLCSPコンポーネントのサイズ/接触エラーおよび接触を確認し、ピッチ、スタート回路レイアウト、プロセス部品配置のような構成要素の重要な情報を確認する。得られた部品パラメータを設計・計画することができ,wlpとldcspの大きさと接触が小さくなるので,適用可能なicピンのはんだ付けを考慮する必要がある。マットデザイン.
PCBはSMDおよびNSMDフォーム用に微調整する必要がある
これは、WLPとWLCSPパッドタイプと一致することができますし、はんだマスク定義(SMD)と非ハンダマスク定義(NSMD)を使用することができます。半田マスク定義型のSMD半田パッドは、半田ボールをはんだ付けして半田ボールをはんだ付けする半田マスクを使用するように設計されている。この設計解は、半田付け又は剥離プロセス中に半田パッドが引き上げられる可能性を低減することができる。しかし、SMD形態の欠点は、SMDが半田ボールに接続された銅表面の表面積を減少させ、同時に隣接するパッド間のスペースを減少させることであり、これはパッド間のトレースの幅を制限し、PCBをオンにすることもできる。穴は弾力性を使用。ほとんどの設計スキームでは、より一般的に使用されるものは、SMD設計スキームである。なぜなら、SMDの半田付けパッドは、より良好な半田接続特性を有することができ、はんだおよびはんだパッドは、製造プロセス中に一緒に集積することができるからである。
非はんだマスクで定義されたはんだパッド(NSMD)に関しては、設計方法は、はんだパッド領域を定めるために銅をはんだバンプ半田付けに使用することである。この設計解は、PCBと半田ボールとを接続するためにより大きな表面積を提供することができる。同時に、SMD設計形態と比較して、NSMDは、また、半田付けパッドと半田付けパッドとの間のより大きな絶縁距離を提供し、半田付けパッド間のより広い配線間隔を許容し、PCBのスルーホールを使用するためのより高い柔軟性を有する。しかし、NSMDがハンダ付けである場合、剥離している他の操作は容易にハンダ・パッドを引くことができる。
スペーシングには特別な配慮が必要である
ピッチサイズの考慮も非常に重要であり、特に、PCBがSMDまたはNSMDの形態の場合、異なる解の予約されたピッチサイズもわずかに異なり、ピッチサイズは半田ボールの中心間の距離であり、ピッチサイズが大きい半田ボール間の距離を指す。配線用の半田パッドと半田パッドとの間の配線スペースが大きくなる。
0.5 mmの設計スキームでは、より大きな間隔により、より多くの配線スペースが提供されるか、または設計がより広いラインおよびより多くの銅材料を使用することができ、これは、より高い伝送電流がトレース内で駆動されることを意味し、絶縁距離はまた、設計を容易に完了することができることを意味する。絶縁距離のために、一般に必要なデザイン仕様をチェックする必要があります、一般的な絶縁距離は3 ~ 3.5ミル(ミル)です。0.4 mmピッチ幅の設計と比較して、使用可能な配線スペースがより柔軟であり、縮小ピッチにより利用可能な絶縁ピッチが同時に減少するので、設計が困難である。これは回路で使用できる銅変化を表す。より少ない場合には、送信された駆動電流はそれに応じて減少する。
PCB配線に関しては、WLP及びWLCSP成分の特性により、使用可能な半田ボールピッチは極めて小さい。基本的には、機械的孔開放装置を使用して、PCBホールを作製することは不可能である。機械的穴の穴径が大きすぎるので、孔開放工程によって、開口部プロセスの誤差によって上部の細い線が損傷を受けることもある。しかし、WLPおよびWLCSPコンポーネントを使用するPCBsでは、回路がずっときつくので、より高価であるレーザ・ドリルされたビアが代わりに使用される。
一般的に言えば、中型と高単価の製品は、高コストのレーザ穿孔PCB生産ソリューションを使用し、レーザ穿孔はまた、生産のための多層ボードで使用され、コストは4層以上になります。その板はとても背が高い。若干の低コストアプリケーションのために、それは多層ボードおよびレーザオープニング設計を使用するために基本的に費用効果がない。別の比較的珍しい設計解は、WLPチップのスタッキングバンプアレイを使用することであり、これは、WLPチップ上の半田ボールをスタッキングするために使用することができ、製品開発者がより多くの利用可能なスペースのために戦うことができる。PCB回路レイアウトを実施する。しかし、実際には、スタッガードバンプ配列を持つWLPのコストはかなり高い。WLPとWLCSPコンポーネントが開発されるとき、同時に、この解決を考慮しなければなりません。部品生産の難易度は高く,部品コストが増加する。
まとめ
WLPおよびWLCSPコンポーネントのウェハーレベルチップサイズパッケージングは、最終製品のサイズを低減するための優れた改善効果を有しているが、PCB設計計画は、開発中のレーザ多層の高密度多層基板および精密製造プロセスを同時にアップグレードしなければならない。元々、ICコンポーネントによって保存されたキャリアスペースとコンポーネントコストは部分的にPCB設計とその後の大量生産に移されるでしょう。代わりに、小さなコンポーネントは、製品の生産ラインで使用されます。処理またはメンテナンスはまた、実装するのがより難しいいくつかの操作上の問題を引き起こします。
WLPおよびWLCSPコンポーネントは、ウエハレベルのチップサイズパッケージである。最終IC外観とパッケージサイズはチップとほぼ同じである。ウエハレベルのチップサイズパッケージングは、従来のICを低減する、コンポーネントサイズの大幅な減少のような多くの利点を有する。面積および厚みのために、部品の重量は軽く、コンポーネントは、大量生産ライン生産により適した自動給餌およびパーティングによって製造することができ、これは全体的な製造コストを低減することができ、また、高周波用途のためにWLPおよびWLCSPコンポーネント自体の電気特性であっても、性能はより良くなる。これは、携帯電話、ノートブックコンピュータ、および着用可能なスマート製品などの軽量で、サイズの縮小する必要があるモバイルデバイスで使用されます。彼らはすべてのキャリアの面積と製品の重量を大幅に減らすために使用することができます。WLPおよびWLCSPコンポーネントの設計を改善するために、再配線層技術、バンプなどの導入の前に、WLPおよびWLCSPコンポーネントが、より詳細に集積化可能であれば、WLP、WLCSPコンポーネントおよびPCBの組み合わせを容易に設計することができる。