フリップチップは、その名の通り、チップの表面(IC回路を製造する側)を基板に下向きに接続するパッケージ方法である。電気信号端子は従来の半田で作られ、基板と相互接続することができる。このタイプの相互接続では、入出力端子(I/O)はチップ全体を覆うことができるので、同じピッチでもフリップチップ相互接続の密度はワイヤボンディングの密度よりもはるかに高い。ワイヤボンディング相互接続では、I/Oはチップの周りにしか配置できません。そのため、ピッチがどんなに小さくても、フリップチップ相互接続のI/O密度を実現することはできない。バンプ技術はフリップチップ相互接続技術全体の鍵である。
ウェハバンプ技術の概要ウェハバンプを製造する鍵は、バンプ下の金属層(UBM)の堆積である。IBMが初期に使用していた用語は、相互接続のための結合層を提供すること、バンプ材の原子が下の金属構造に拡散するのを防止するための原子拡散バリア層を提供する、以下の誘電体材料及び金属は、接着層を提供し、汚染物質が誘電体層の水平方向に沿って下の金属に移動するのを防止するバリア層として機能する。現在使用されているUBMのほとんどはスパッタリングプロセスで作られています。スパッタリングプロセスはUBMを製造する最もコスト効率の高いプロセスである。特に蒸発プロセスと比較して。溶接スポット構造の信頼性に影響を与える最も直接的な要素はUBMの生産品質である。一般的に、UBM構造は破損せずに複数回(通常20回まで)の還流に耐えなければならない。UBMは、はんだバンプとパッドメタライズ層を結合するための構造であるため、せん断応力と引張応力試験にも合格しなければならない。機械的損傷試験において、はんだバンプの故障の一般的な基準は、故障がはんだ自体に発生することである。したがって、UBMは十分な強度を持たなければならない。時間、温度、湿度、バイアス電圧などにより性能が低下することはありません。
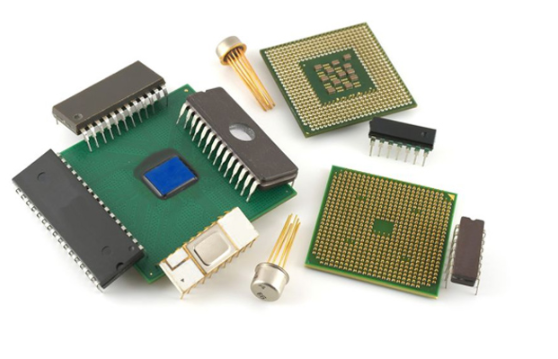
フリップチップ市場の傾向フリップチップパッケージは主流のパッケージ相互接続技術となっている。これまで、フリップチップは相互接続技術ではなくパッケージとして認識されてきた。例えば、フリップチップグリッドアレイパッケージ(FCBGA)は、主に積層基板技術を使用して組み立てとパッケージのプロセスを完了するが、高性能集積回路用途に限られている。次の図はフリップチップの応用分野を示している:
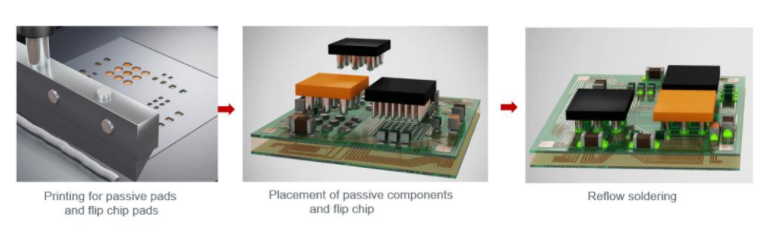
(1)バンプ間隔:バンプ間隔を小さくするとI/O密度を高めることができる、アスファルト変化の傾向(250ミクロンから125ミクロンへ徐々に移行)、
(2)溶接点凹部法:蒸発スクリーン印刷めっき、
(3)バンプ半田成分:高鉛含有量低共晶無鉛(Sn−Ag)−Cuカラムピッチ<125ミクロン、
(4)包装成分:セラミックス基板高密度相互接続積層基板プリプレグ積層基板低熱膨張係数積層基板?コアレス基板。
(5)包装構造:密封モノリシックカバー(SPL)-非密封モノリシックカバー補強材+カバーベアチップ成形
従来のFCCSPのアプリケーション市場は以下の通りである:
FCSPアプリケーション市場:
(1)チップサイズに対するバンプ(I/O)密度:200 I/O以上または5.5 mm以上のチップサイズに使用する、低密度製品はWLCSPを使用して、より良いコストとより低いコストを得ることができます。
(2)低電力:一般電力<2 w、=""on=""chip=""board level=""packaging=""can=""be=""used=""for=""power=""bare=""fccsp="""""">2 wに依存)。
(3)面積:ハンドヘルドデバイスの場合、40 nm/65 nm技術はチップサイズを縮小したが、より多くのI/Oは周辺I/Oを配置するのに十分な面積がないため、基板リードを使用してこの領域を扇動する必要がある。
(4)価格:高I/O小サイズチップに対して、周辺面積が不足し、Au線コストとリード線の扇出しのための大サイズ基板は価格競争力のあるFCSPの発展を推進する。
(5)成形、試験と把持が容易で、一般的な形式はCABGAと同じである。
まとめ
フリップチップは常にエキサイティングなパッケージ技術である。しかし、従来のワイヤボンディングパッケージに比べて、そのコストはフリップチップが主流の技術になることを制限している。しかし、コストの制約は徐々に解消されつつあり、ストリップパッケージフリップチップの使用はコストを大幅に削減している。積層基板は製品コストの大部分を占めているため、積層基板のコストを低減することはフリップチップパッケージコストを低減する最も有効な方法である。
また、FPFC設計について、Amkorは大量の研究を行い、既存の面積アレイフリップチップ設計をファインピッチ設計に転換した。80%の研究により、金属層の減少と外寸法の減少による細ピッチ周辺設計は基板のコストを低減できることが分かった。フリップチップパッケージ基板のコスト(そのコストが最も高い)を低減することにより、フリップチップパッケージを他の市場で広く使用することができる。