ICパッケージ ボードは、独立したチップを得るために製品モデルおよび機能要件に従って測定されたウェーハを処理するプロセスを意味する. ICパッケージ 主に微細シリコンチップを広く間隔に接続する媒体を提供する プリント回路基板 そして、装置を湿気から保護してください.
具体的な実装形態には

包装形態
リードパッケージ

1970年代後半, 市場で広く受け入れられる最初のパッケージは デュアルインライン, セラミックとプラスチックパッケージ. リード線はパッケージの両側から引かれ、パッケージに垂直である. パッケージは、基板のスルーホールにピンを挿入することによってPCB上に実装することができる, 次に、ボードの反対側にリードをクリッピングし、ウェーブはんだ付け技術を使用してはんだ付け. パッケージは、40と0のリードの最大数を収容することができます.65 mmプレート間隔.
1970年代後半と1980年代初期に、表面馬は現れました。チップ上のリード(ピン)および部品は、それを通してではなく回路基板の表面に溶接される。これにより、実装の間のリフローはんだ付け技術を使用して、最大ピン数が80の場合、基板の両面をチップに接合することができる。
1980年代半ばまでに、すべての側のリードをもつパッケージは現れました。このパッケージは、クワッドフラットパッケージ(QFP)(リードは、カモメの翼のような形)またはリードチップキャリア(リードが曲がっている)と呼ばれています。J )最も一般的に使用される典型的な四角形フラットパッケージは、0.65 mmまたは0.5 mmのピッチと最大208のリード数を有する。これらのパッケージは1990年代初期のハードディスクドライブおよびグラフィックス市場で広く使用された。
1980年代後半と1990年代の初めに、露出したパッド鉛パッケージは生まれました。パッケージは、チップボンディング端が底部に露出している四角形の平坦または小さい形状パッケージである。これらの露出したボンディング端部を回路基板に溶接し、チップの効率的な放熱経路を確立することができる。
The miniature Lead Frame (MLF) family of packages was developed in the 1990s. MLF is close to the Chip Scale Package (CSP), パッケージの底面リード端は、電気的接触を提供するために使用される PCBボード, カモメ翼リードSoicとQualパッケージに対して, したがって、このパッケージは、熱放散と電気性能を確実にするのを助けます.
層状包装
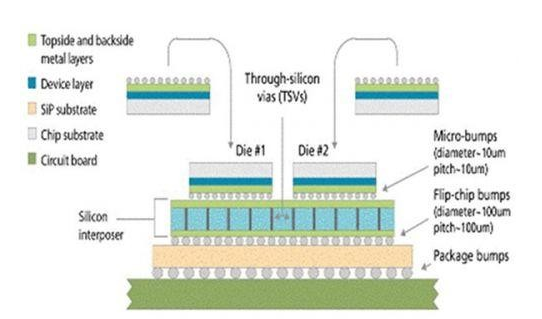
層状包装
1990年代には,ボールグリッドアレイ(bga)と呼ばれる新しいタイプのパッケージが基板材料として層状板を用いて浮上した。リードフレームベースのパッケージングは、パッケージの周辺につながることができます。ボールグリッドアレイパッケージのリードは、パッケージ全体の下部にある半田ボールに導かれる。最初に、BGAパッケージ基板の典型的なボールピッチは1.27 mmであった。
ウェハレベルパッケージング
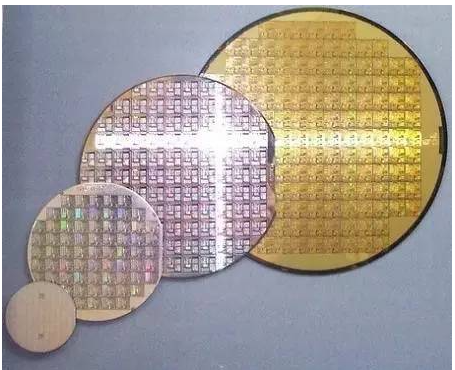
ウエハレベルパッケージング
スペースが必要な場合, ベスト 包装 ない 包装 全く. 回路基板に直接取り付けることができるデバイスを製造するために、ウェハレベルで追加処理を行うことができる. This process typically involves using a redistribution layer to transfer the fine spacing on the wafer to the coarser spacing (typically 0.5mm) on the chip itself, そして、再配置の機能上でバンプポイントを作成する. コアは分離されます, ウエハレベルパッケージは凸ブロックコアである.
システムレベルカプセル化( SIP )
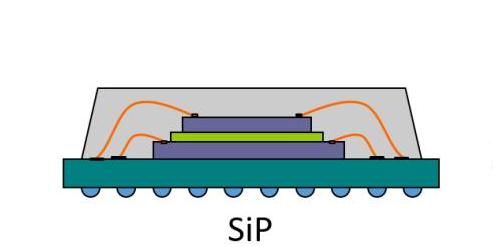
今、統合の新しいラウンドは、システムレベルパッケージ(SIP)と呼ばれるパッケージに複数のチップを配置しています。マルチチップ・パッケージングは、2つ以上のチップを同じパッケージ(通常、層状基板を使用する)に配置することによって、または、同じパッケージの他の上に1つのチップを積層することによって達成することができる。
実装配線技術の開発
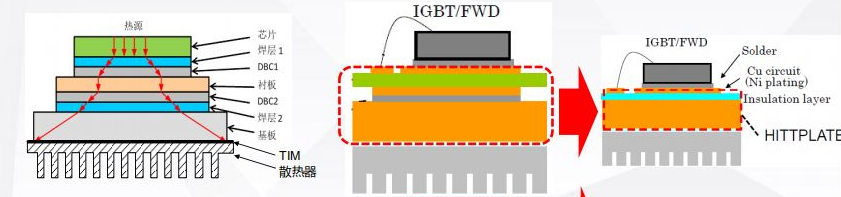
相互接続は、チップがパッケージ化された基板にどのように接続されるかを説明する。大部分のパッケージでは、パッケージ本体は、基板上のチップ接続端子(リードフレームまたは積層)の前面に最初に接合され、次いで、チップパッドが金またはアルミニウム線を用いて基板のリードフィンガーに接合される。上の人。この相互接続技術はリードボンディングと呼ばれ、大部分のパッケージング用途に適している。新しい相互接続方式をフリップチップボンディングと呼ぶ。伝導の衝突は、パッド位置でチップ表層に生成される。次いでバンプバンプをフリップして基板に直接接続する。多くの場合、積層基板が使用される。ボール接着はリフローはんだ付けプロセスを使用する。基板とリフローを接続した後、使用中にデバイスの溶接部分に起因する応力を低減するために、チップと基板との間にボトムフィルプロセスが使用される。
6.包装材料 プラスチック 包装 湿って湿気がある. 最初のパッケージは貫通穴の設置であった, which required less reliability because the heat generated during welding was far from the package (on the other side of the board). 業界は、金型の組み合わせとチップ接続材料を改善するために ドライアセンブリ. もう一つの最近の必要条件 包装 材料は完全に鉛フリーであり、環境要件を満たす「グリーンマテリアル」を使用することである.
7, 包装プロセス on the wafer process of wafer after scribing process was cut ChengXiaoJing round (Die), and then cut the wafer stick on the substrate (lead frame) corresponding island of framework, then use superfine with metal (gold, 錫, 銅, aluminum) or between a conductive resin chip 接着 pad and IC package substrate corresponding lead connection, 回路を形成する個々のチップは、それからカプセル化されて、プラスチック・ケースによって、プロテクトされる. アフタープラスティック 包装, ポストモールド硬化のような一連の操作を行う必要がある, トリミング成形, 電気めっきと印刷. アフター 包装 完了, 完成品検査, 通常着信材料, テスト, 包装, そして最後に倉庫と出荷. 典型的な包装プロセス: cutting, 読み込み, bonding, プラスチック 包装, バリ取り, 電気めっき, 印刷, 切断と成形, 外観検査, 製品テスト終了, 包装 配達.