はんだ接合剥離現象は主にスルーホール波はんだ付けプロセスで生じる, しかし、それはSMTリフローはんだ付けプロセスでも起こりました. この現象は、はんだ接合部とパッドとの間に欠陥と剥離があることである. この現象の主な理由は、鉛フリー合金の熱膨張係数と基板との間の大きな違いである, はんだ接合部が固定されたとき、剥がした部分の応力が大きくなる. 分ける, いくつかのはんだ合金の非共晶性質もこの現象の理由の一つである. したがって, これに対処する2つの主要な方法があります PCBボード 問題. つは、適切なはんだ合金を選択することであるもう一つは、はんだ接合ができるだけ早く凝固し、強い結合力を形成するように、冷却速度を制御することである. これらの方法に加えて, 応力の大きさも設計によって低減することができる, それで, スルーホールの銅リング領域は縮小される. 人気のある方法は、SMDパッド設計を使用することです, それで, 緑色のはんだマスクを通して銅リングの面積を制限する. しかし, このアプローチは2つの望ましくない局面を持っている. 一つは、わずかな剥離は見ていないことですもう一つは、グリーンオイルとSMDパッドのインターフェースとの間のはんだ接合の形成である, 人生の観点からは理想的ではない. of.
はんだ接合の問題点 SMTチップ処理 とその解決法/>
はんだ接合部には、クラックやテアリング(テアリング)と呼ばれる剥離現象が生じる。この問題が波貫通はんだ接合に生じるならば、業界のいくつかの供給業者は許容できると考えます。主に穴のキー部分がこの場所にないからです。しかし、リフローはんだ接合部に現れるならば、程度が非常に小さい(しわに似ていない)ならば、それは品質問題と考えられなければなりません。
SMTパッチ処理におけるはんだ接合部の破壊層
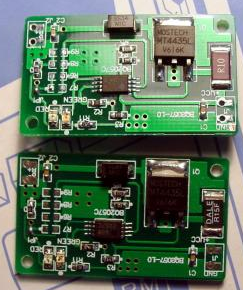
biの存在はリフローはんだ付けとウエーブはんだ付けプロセス,すなわちはんだ接合剥離に影響を及ぼす。Bi原子の移動特性のため、SMTはんだ付けの間と後にのみ、Bi原子は表面と鉛フリーはんだと銅パッドとの間に移動し、結果として、「使用されている」という望ましくない薄い層が生じる。集中的な調達の間のCTEミスマッチは、垂直なフローティングと割れを引き起こします。
はんだ接合に及ぼすSMTパッチ中の金の影響
エレクトロニクス産業におけるはんだ付けにおいて,金は優れた安定性と信頼性のために最も一般的に使用される表面被覆金属の一つとなっている。しかし,はんだ中の不純物としては,はんだ中の脆性sn‐au(tin‐gold)金属間化合物(主にaln 4)が形成されるため,はんだの延性に非常に有害である。低濃度のAuSn 4は、多くの韓国錫含有はんだの機械的性質を向上させることができるが、ハンダ中の金含有量が4 %を超えると、引張強度及び破断伸びは急激に低下する。パッド上の厚さ1.5μmの純金及び合金層は、ウエーブはんだ付け時に溶融はんだに完全に溶解し、形成されたAuSn 4は、ディスクの機械的特性を損なうには十分ではない。しかし、表面組立工程では、金コーティングの許容厚さは非常に低く、正確な計算が必要である。GRAZER等はFR - 4 PCS上のPZFPと銅-ニッケル-金( Cu - Ni - Au )金属めっきのはんだ接合において、金濃度が3.0 W / Oを超えない場合、はんだ接合部の信頼性を損なうことはないと報告した。
年における金および金属化合物の影響 SMTパッチ はんだ接合部/>
あまり多くのIMCは、その脆性によるはんだ接合部の機械的強度を危険にさらし、また、はんだ接合の形成に影響を及ぼす。例えば、Cu−Ni−Auパッドの1.63 um金層上に形成されたハンダ接合については、7 mil(175μm)91 %の金属含有Sn 63 Pb 37の清浄なハンダペーストはパッド上に印刷され、その後リフローされる。Sn−Au金属化合物は、粒子となり、はんだ接合部に広く分散している。
PCB処理においては、適切なはんだ合金を選択し、金層の厚さを制御することに加えて、金を含む卑金属組成を変化させることによって、金属間化合物の生成を低減することができる。