通常、プリント回路基板の製造工程は比較的簡単であり、多層基板の製造工程は比較的複雑である。以下は多層基板製造プロセスの完全な解決方法である:
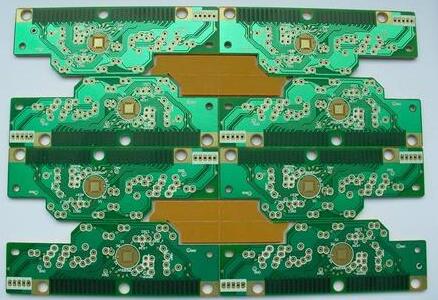
多層基板製造プロセス積層
1. ラミネートは、Bステージprepregによって、全体の回路の各々のレイヤーを結合するプロセスである. この結合は界面での高分子の相互拡散と浸透を通じて達成される, そして織り込み. 接合するプロセス 様々な回路 ステージprepregによって. この結合は界面での高分子の相互拡散と浸透を通じて達成される, そして織り込み.
2.目的:ディスクリートを押す 多層板 粘着シートと一緒に 多層板 必要な層と厚さの数.
植え込みは、銅箔、ボンディングシート(prepreg)、内層板、ステンレス鋼、絶縁板、クラフト紙、外層鋼板、その他の材料を工程要件にしたがって積み重ねていくことである。ボードが6つ以上の層であるならば、前の植字は必要です。ラミネート銅箔、ボンディングシート(prepreg)、内層板、ステンレス鋼、絶縁板、クラフト紙、外層鋼板およびその他の材料は、プロセス要件に応じて。ボードが6つ以上の層であるならば、前の植字は必要です。
積層されたプリント回路基板は、積層工程において真空加熱プレスに送られる。機械に供給された熱エネルギーは樹脂シート内の樹脂を溶融させて基板を接着し、隙間を埋める。
デザイナーのためのラミネーション, ラミネーションのために考慮される必要がある最初のものは対称です. ボードがラミネーションプロセスの間、圧力と温度に影響を受けるので, まだラミネーションが完了した後、ボードにストレスがあります。したがって, 積層板の両面が均一でない場合, 両側のストレスは異なります, 板を片側に曲げる原因, の性能に大きく影響する 多層基板。
また、同一平面であっても、銅の分布が不均一であれば、各点での樹脂の流速は異なるため、銅の少ない場所の厚さは若干薄くなり、銅の多い場所の厚さは厚くなる。いくつか。これらの問題を回避するために、銅の分布の均一性、積層の対称性、ブラインド及び埋込みビアの設計、レイアウトなどの様々な要因を考慮する必要がある。
黒化と酸化の原因
1.表面に油、不純物その他の汚染物質を除去すること
2.銅箔の比表面積を増加させることにより、樹脂の完全拡散に寄与する樹脂との接触面積を増大させ、より大きな結合力を形成することができる。
3.非極性銅表面を極性CuO及びCu 2 Oで表面にし、銅箔と樹脂との間の極性結合を増加させる
4.酸化表面は高温での水分の影響を受けず、銅箔と樹脂との層間剥離の可能性が少なくなる。
内部回路を有するボードは、それが積層されることができる前に、ブラックニングまたはブラウニングされなければならない。これは、インナーボードの銅表面を酸化することである。一般に、発生したCu 2 Oは赤色であり、CuOは黒である。従って、Cu 2 O系酸化物層はブラウニングと呼ばれ、CuO系酸化物層は黒化と呼ばれている。
多層回路基板製造工程:ドリル加工と沈降銅黒化と酸性化の目的
1.pcb基板の基板は銅箔、ガラス繊維、エポキシ樹脂からなる。製造工程では、基材のドリル加工後の孔壁部は、上記3つの材料からなる。
2.ホールメタライゼーションは、銅の均一な層を断面に熱衝撃抵抗で覆う問題を解決することである。穴メタライゼーションは銅の均一層を断面に熱衝撃抵抗で被覆する問題を解決することである。
3.プロセスは、3つの部分に分割されます:1つは、脱ドリルプロセス、2番目は、無電解銅プロセス、および3番目の厚さのプロセス(基板全体の銅めっき)です。
4.に、多層回路基板製造プロセス外乾式フィルム及びパターンめっき
外層パターン転写の原理は、基板上のプリント基板パターンに対して、感光性ドライフィルムと撮影方法を用いて、内層パターン転写と同様である。外側のドライフィルムと内側のドライフィルムとの違いは以下の通りです:
1.減法を採用する場合、外側のドライフィルムは内側のドライフィルムと同じであり、ネガフィルムは基板として使用される。基板の硬化ドライフィルム部分は回路である。未硬化膜を除去し、酸エッチング後にフィルムを再処理し、膜の保護により回路パターンが基板上に残る。
2.通常の方法では、外側のドライフィルムは正の膜である。基板の硬化部分は非回路領域である。未硬化膜を除去した後、パターンメッキを行う。膜がある場合は、電気メッキができず、フィルムがない場合には、まず銅をメッキし、その後、錫をメッキする。膜を除去した後、アルカリエッチングを行い、最後にTiNを除去する。回路パターンは、錫で保護されているので基板上に残る。
3.ぬれまく, はんだマスクプロセスは、基板の表面に半田マスクの層を追加することである.。この層のはんだマスクをはんだマスク(はんだマスク)またははんだマスクインクと呼ぶ, 一般的にグリーンオイルとして知られる. 主に導体ラインの望ましくないタインニングを防止する, 湿気による回線間の短絡を防ぐ, 化学製品, など。生産及び組立工程における不十分な操作に起因する回路の破壊, 絶縁, 様々な厳しい環境への抵抗, プリント板の機能を確保する, etc. 原則:現在, 回路基板製造業者によって使用されるこの層の層は、基本的に液体感光性インクを使用する. 生産原理はライングラフィックスの転送と部分的に似ている. また、露光を阻止し、はんだマスクパターンをPCB基板表面。
多層基板生産工程は銅と厚い銅を吸収する
孔のメタライゼーションは容量の概念,厚さと直径の比を含む。厚さ比は板厚と穴径の比を指す。厚さと直径比。厚さ/直径比は、板厚と孔径の比を指す。板が厚くなり、穴の直径が減少し続けると、薬液が穴の深さに入るほど難しくなる。電気めっき装置では、穴の中心に溶液を入れるために、振動、圧力、その他の方法を使用しているが、濃度の違いにより中心が生じる。コーティングがあまりに薄いことは、まだ避けられないです。このとき、ドリル層には僅かな開回路現象が生じる。電圧が上昇し、基板が様々な厳しい条件下で衝撃を受けると、欠陥が完全に露出し、基板の回路が切断され、特定の作業を完了することができなくなる。
したがって, デザイナーは、時間内にボードメーカーのプロセス能力を理解する必要があります, その他設計回路 基板生産において実現するのは難しい. 厚さ対直径比パラメータはスルーホールの設計のみならず、考慮すべきである, ブラインドと埋込み穴の設計においても。