日常的なPCBA処理では、BGAのフルネームはBall Grid Array(半田ボールアレイパッケージ)であり、パッケージ基板の底部に回路のI/O端として半田ボールアレイを作成し、プリント基板(PCB)と相互接続する。この技術を用いてパッケージ化された装置は、表面実装装置である。これは集積回路に有機キャリアプレートを用いたパッケージ方法である。このプロセスの品質を決定し、制御するためには、半田の数、ワイヤ、パッドの位置、濡れ性など、長期的な信頼性に影響する物理的要素を理解し、テストする必要があります。BGAデバイスの性能と組み立ては従来のコンポーネントより優れているが、多くのメーカーはBGAデバイスの大規模生産に投資したくない。主な原因はBGAデバイスの溶接点試験が非常に困難であり、その品質と信頼性を保証するのが容易ではないことである。
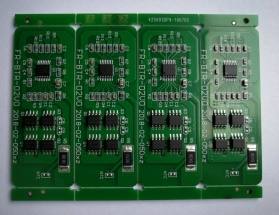
現在の情報時代では、電子業界の急速な発展に伴い、パソコンや携帯電話などの製品がますます人気を集めている。電子製品の機能要件はますます多くなり、性能要件はますます高くなっていますが、体積要件はますます小さくなり、重量要件はますます軽くなっています。これにより、電子製品は多機能、安全、小型化、軽量化の方向に発展している。これを実現するために、集積回路チップの特徴的なサイズはますます小さくなり、複雑さが増していきます。そのため、回路内のI/O数が増加し、パッケージのI/O密度が増加し続けます。この発展の要求を満たすために、いくつかの*高密度パッケージ技術が登場し、BGAパッケージ技術はその一つである。
BGAパッケージは1990年代初めに登場し、現在では成熟した高密度パッケージ技術に発展している。すべてのパッケージタイプの半導体ICの中で、BGAパッケージは1996年から2001年までの5年間で最も急速に成長した。1999年、BGAの生産量は約10億だった。しかし、これまで、この技術は高密度、高密度のデバイスパッケージに最適であり、ファインピッチと高I/O端末数の方向に発展している。BGAパッケージ技術は主にPCチップセット、マイクロプロセッサ/コントローラ、ASIC、ゲートアレイ、メモリ、DSP、PDA、PLDなどのデバイスのパッケージに適用される。
PCBA加工におけるBGAパッケージの特徴:
1.包装面積が小さい、
2.機能が増加し、ピンの数が増加した、
3.PCB板は溶融と溶接の過程で自己中心的で、錫めっきが容易である、
4.信頼性が高く、電気性能が良く、全体的なコストが低い。
PCBA処理されたBGA付きPCBボードは、通常、多数の小さな穴を有する。ほとんどのお客様のBGAビア設計の完成品の孔径は8~12ミルです。BGAの表面と孔との間の距離は、例えば31.5ミル、通常10.5ミル以上である。BGAビアを塞ぐ必要があり、BGAパッドにインクを充填することはできず、BGAパッドに穴を開けない。
PCBAプロセスでは、従来のSMTプロセスプログラムと装置を用いて組立生産を行う場合、BGAデバイスは常に20(PPM)未満の欠陥率を実現することができる。1990年代初頭以降、SMT技術は成熟した段階に入っている。しかし、電子製品が便利/小型化、ネットワーク化、マルチメディア化の方向に急速に発展するにつれて、電子組み立て技術に対してより高い要求を提出した。密度組立技術は絶えず出現しており、その中でBGA(グリッドアレイパッケージ)は実用段階に入った高密度組立技術である。