процесс упаковки и тестирования чипов IC:
герметизация интегральных схем refers to the chip (Die) and different types of frame (L/F) and plastic sealing material (EMC) formed by different shapes of the Package body.
There are many kinds of герметизация интегральных схем, which can be classified as follows:
According to packaging materials, it can be divided into:
упаковка из металла, керамики, пластмассы



металлическая упаковка в основном для военной или авиационно - космической техники, no commercial products;
Ceramic packaging is better than metal packaging, военная продукция, a small amount of commercial market;
пластиковая упаковка используется для потребления электронной продукции, ее стоимость низкая, технология проста, надежно высокая, занимает подавляющее большинство рынка доли;
в зависимости от способа соединения с панелью PCB можно разделить на:
упаковка PTH и SMT


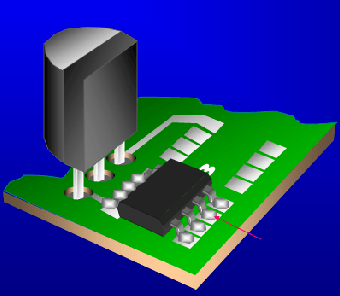
PTH штифт отверстие;
В настоящее время технология SMT для нанесения покрытий на поверхность используется в большинстве IC на рынке по типу SMT.
According to the package appearance, it can be divided into:
SOT, SOIC, TSSOP, QFN, QFP, BGA, поставщик услуг, сорт.
Two key factors determine the form of encapsulation:
Encapsulation efficiency. площадь кристалла/package area, as close as possible to 1:1;
Pin number. The more pins, более продвинутый, but the difficulty of the process also increases accordingly;
Among them, CSP, due to the use of Flip Chip technology and bare Chip package, площадь кристалла/package area =1:1, Какая самая современная технология.
QFN -- Quad Flat no-lead Package QFN -- Quad Flat No-lead Package
герметизация SOIC - SOIC
TSSOP - тонкий миниатюрный усадочный контур
QFP - четырёхплоское уплотнение
BGA -- Ball Grid Array Package
герметизация на уровне кристалла
герметизация интегральных схем Structure
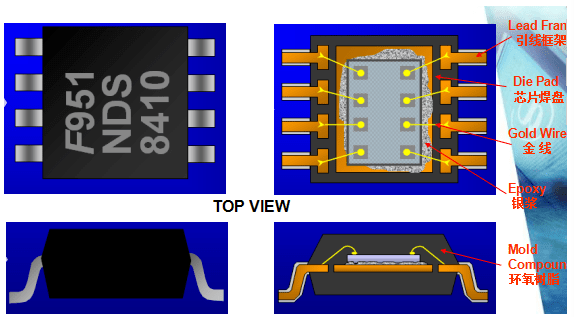
Raw Material in AssemblyWafer

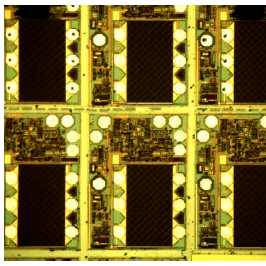
* См.

обеспечение подключения и крепления цепей;
The main material is copper, which will be coated with silver and NiPdAu.
The L/F технология включает травление и штампование;
легкоокисляемость, хранение в азотных газгольдерах, влажность менее 40% RH;
Except BGA and CSP, другая упаковка будет использовать рамку, while BGA will use Substrate;
а См.

установить электрическое и физическое соединение между чипом и рамкой внешнего провода;
золотой провод 99.99% high purity gold;
одновременно, по соображениям себестоимости, в настоящее время применяются технологии медных и алюминиевых проводов. преимущества: Снижение себестоимости, увеличение сложности технологии, снижение коэффициента приемки;
диаметр провода определяет ток проводимости; 0.8mil, 1.0mil, 1.3 мils, 1.5 и 2 мили.0mils;
основными компонентами модульных / эпоксидных смол являются эпоксидная смола (эпоксидная смола) и различные добавки (отвердительы, модификаторы, дегидраторы, красители, огнезащитные составы и т.д.);
Основные функции: пресс - форма и рамка проводов в расплавленном состоянии, для обеспечения физической и электрической защиты от внешних помех;
условия хранения: минус 5 градусов, при постоянной температуре 24 часа;
Epoxy

Epoxy resin filled metal powder (Ag); It has three functions: fixing the Die on the Die Pad; Heat dissipation, эффект проводимости;
- температура хранения ниже 50°C, поддержание температуры спины в течение 24 часов до использования;
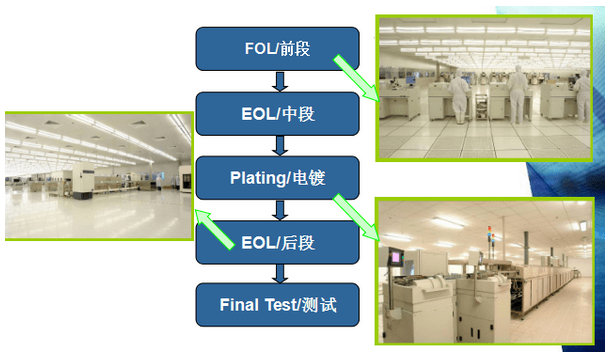
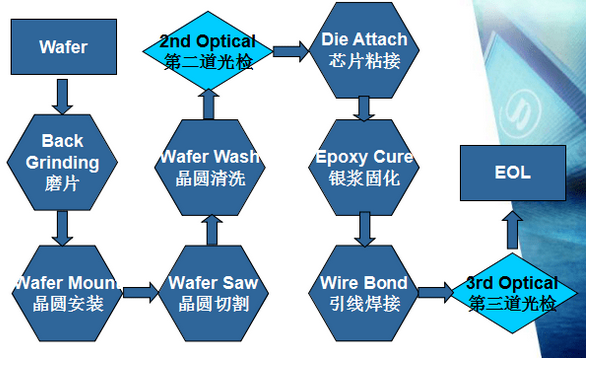
FOL-Front of Line
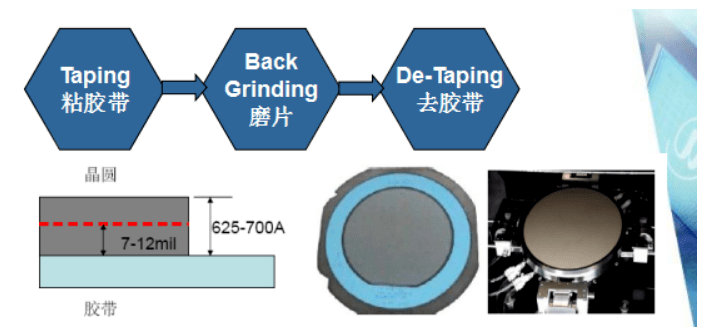
FOL-Back Grinding
для уменьшения толщины вафли (8 мм - 10 мм), необходимой для пломбирования.
абразивное время, Необходимо наклеить резиновую ленту на активную область, чтобы защитить цепь, а также шлифовать заднюю часть. После шлифования, remove the tape and measure the thickness;
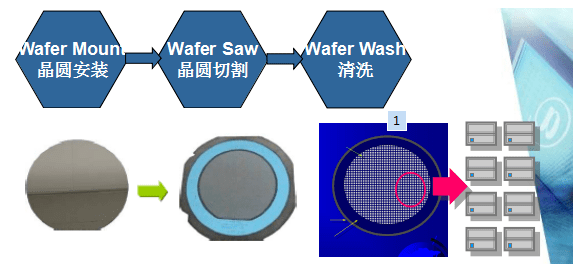
FOL Wafer Saw
полупроводниковые пластины вставлены в синюю плёнку (полиэфирную пленку), так что даже после разреза они не могут быть разорваны;
разрезать всю пластину на отдельные кости через пилу, чтобы облегчить последующее подключение к кристаллу и другие процессы.
основная очистка от пыли из пил, очистка вафли;




FOL -- 2nd Optical Inspection
главная цель заключается в том, чтобы проверить наружность кремниевых пластин под микроскопом после их резания пилой для кремниевых пластин и посмотреть, не расходуются ли они впустую.
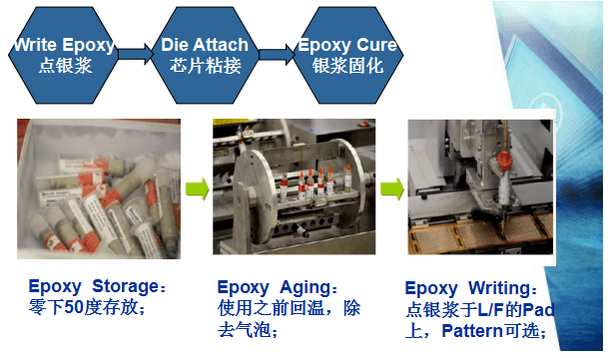
"плесень соединение"
подбирать чип process:
1. кристалл на полиэфирной пленке под крышей шпинделя, making it easy to break away from the blue film;
извлечение из них чипов и завершение процесса транспортировки из вафли в L / F;
3. Collect the chip Bond on the L/заливка пластырем, and the specific position is controllable;
4, разрешение головок ключа: x - 0. 2um; Y - 0.5 мкм; Z - 1,25 мкм;
5. Bond Head Speed: 1.3m/s;
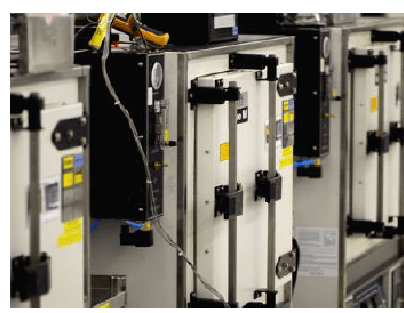
FOL Epoxy Cure

175°C, час азотная среда, to prevent oxidation:
проверка качества соединения пресс - формы:
штамповочный станок

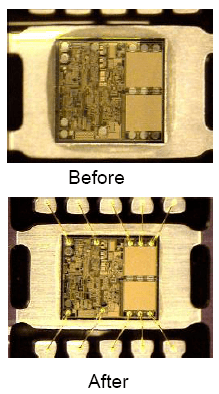
соединение проводов
High purity gold (Au), copper (Cu) or aluminum (Al) wires are used to connect the Pad and the Lead by welding. паяльная тарелка является внешней точкой соединения схемы на кристалле, and the Lead is the connection point on the Lead Frame.
W/B is the most critical process in the технология упаковки.
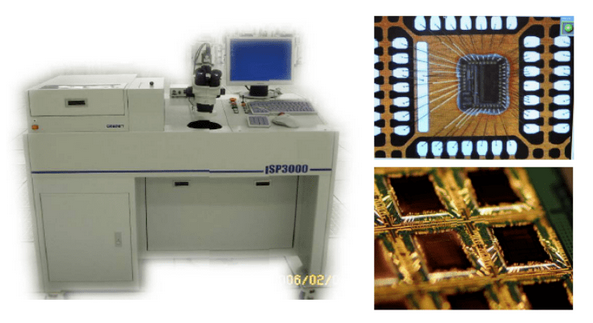
Третий оптический контроль
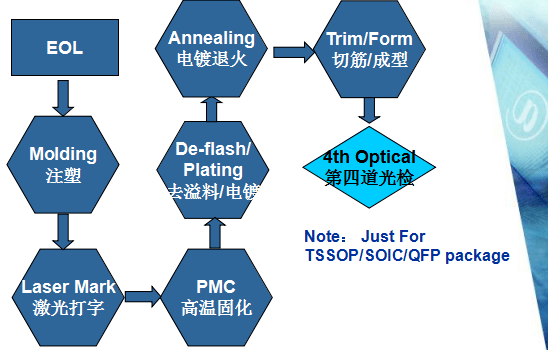
нижняя линия

EOL - formation
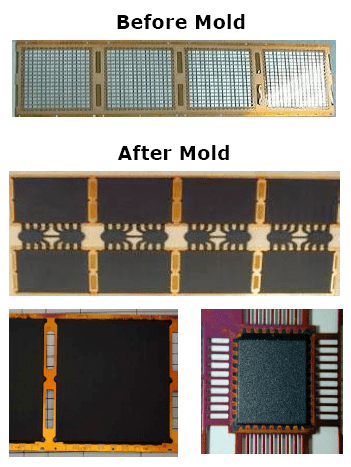
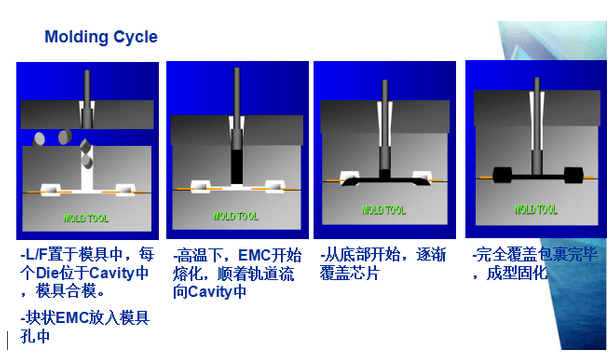
![d3bc3dff15527c02238cd9132914802a.png [例句] - - Папуа - Новая Гвинея](/public/upload/image/20210817/d3bc3dff15527c02238cd9132914802a.png)
EOL - лазерная маркировка
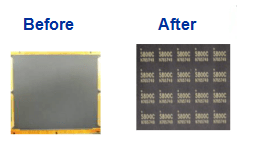
упаковывать лазерные надписи на лицевой или задней стороне. Содержание: наименование продукции, дата производства, партия производства и так далее.

постмодульное затвердевание
Used for curing plastics after Molding to protect IC internal structure and eliminate internal stress. температура отверждения: 175 ++ / - 5 ° C; Cure Time: 8 HRS
![e3088cfb3e7d01780062ff99a04a0aa8.png [例句] - - Папуа - Новая Гвинея](/public/upload/image/20210817/e3088cfb3e7d01780062ff99a04a0aa8.png)
EOL De-flash
назначение: выход на борт с целью удаления избыточного формования между проводами вокруг корпуса после формования; способ: промывать слабокислой водой, водой высокого давления.

EOL - гальванизация
использовать металл и химию, a coating is applied to the surface of the Leadframe to prevent the effects of the external environment (moisture and heat). и сделать так, чтобы компоненты на панелях PCB были легко сварены, чтобы повысить электропроводность.
обычно имеются два вида гальванических покрытий:
Pb-free: lead-free electroplating, using is >99.95% of high purity Tin (Tin), широко используемые в настоящее время технологии, in line with the RoHS requirements;
Это оловянно - свинцовый сплав. на олово приходится 85 процентов, а на свинец - 15 процентов. поскольку она не соответствует требованиям рохс, в настоящее время она в основном ликвидирована.

![0aaa7d235de5e4a1fa7ee842e14c7def.png [例句] - - Папуа - Новая Гвинея](/public/upload/image/20210817/0aaa7d235de5e4a1fa7ee842e14c7def.png)
EOL Post Annealing Bake
Цель: обеспечить, чтобы продукция, не содержащая свинца после гальванизации, обжигалась при высокой температуре в течение некоторого времени, с тем чтобы устранить потенциальные проблемы роста кристалла в процессе гальванизации; условия: 150 + / - 5 - с; 2 часа
![bff79421253a69d73f975f739e917dfd.png [例句] - - Папуа - Новая Гвинея](/public/upload/image/20210817/bff79421253a69d73f975f739e917dfd.png)
The process of cutting the Lead Frame of a slice into individual units (IC); Form: Shape the IC product after подрезать, reach the shape required by the process, and put it into the Tube or Tray;
![32b29df6cd34d31139d4c68498c7e7f5.png [例句] - - Папуа - Новая Гвинея](/public/upload/image/20210817/32b29df6cd34d31139d4c68498c7e7f5.png)
EOL Final Visual Inspection
Проверьте внешний вид продукта под лупой малого увеличения.
5. Сосредоточьтесь на потенциальных отходах процесса EOL, таких как дефекты литья, дефекты покрытия, дефекты обрезки/формы и т. д.