L'imballaggio multi-chip (MCP) ha soddisfatto a lungo la necessità di confezionare più prestazioni e caratteristiche in uno spazio sempre più piccolo (PCB). È naturale aspettarsi che l'MCP della memoria venga esteso per includere ASIC come i processori a banda base o multimediali. Ma vi sono difficoltà in questo senso, vale a dire elevati costi di sviluppo e costi di proprietà/riduzione. Come risolvere questi problemi? Il concetto di imballaggio a cascata IC (POP) sta guadagnando ampia accettazione nel settore.
POP (Packaging on Packaging), noto anche come assemblaggio della pila, noto anche come strato di imballaggio. POP è un pacchetto composto da due o più bgas (ball-grid array package) impilati uno sopra l'altro. In generale, la struttura del pacchetto stack di POP adotta la struttura della sfera di saldatura BGA, che integra dispositivi logici del segnale digitale o misto ad alta densità nella parte inferiore del pacchetto POP per soddisfare le caratteristiche dei dispositivi logici multi-pin. Come nuovo tipo di forma di imballaggio altamente integrata, POP è utilizzato principalmente in moderni smartphone, fotocamere digitali e altri prodotti elettronici portatili e svolge un ruolo molto ampio.

MCP è una tecnologia ibrida che impila verticalmente vari tipi di chip di memoria o non di memoria di diverse dimensioni in una custodia incapsulata in plastica. Risparmia spazio sul piccolo circuito stampato PCB in questo modo.
Dal punto di vista dell'architettura, SIP è quello di integrare più chip funzionali, inclusi processore, memoria e altri chip funzionali in un unico pacchetto, in modo da realizzare una funzione completa di base. Dal punto di vista dei prodotti elettronici terminali, SIP non si preoccupa solo delle prestazioni/consumo energetico del chip stesso, ma realizza anche il consumo corto, sottile, multifunzionale e basso di energia dell'intero prodotto elettronico terminale. Dopo l'aumento di prodotti leggeri come dispositivi mobili e dispositivi indossanti, la domanda SIP sta diventando sempre più evidente.
Il concetto di base di SoC è quello di integrare più dispositivi sullo stesso chip di metallo nudo per raggiungere l'obiettivo di ridurre le dimensioni, migliorare le prestazioni e ridurre i costi. Tuttavia, nel mercato della telefonia mobile, dove i cicli di vita dei progetti sono molto brevi e i requisiti di costo sono molto impegnativi, le soluzioni SOC presentano limitazioni significative. Dal punto di vista della configurazione della memoria, diversi tipi di memoria richiedono molta logica, e padroneggiare diverse regole e tecniche di progettazione può essere molto impegnativo, influenzando i tempi di sviluppo e la flessibilità richiesta dall'applicazione.
SOC e SIP
SOC è molto simile a SIP in quanto entrambi combinano un sistema contenente componenti logici, componenti di memoria e persino componenti passivi in un'unica unità. Dal punto di vista progettuale, SOC è un elevato grado di integrazione dei componenti richiesti dal sistema su un chip. Dal punto di vista dell'imballaggio, SIP è un metodo di confezionamento affiancato o sovrapposto per diversi chip. È un unico pacchetto standard che integra più componenti elettronici attivi con funzioni diverse, dispositivi passivi opzionali e altri dispositivi come MEMS o dispositivi ottici per raggiungere determinate funzioni.
In termini di integrazione, in generale, SoC integra solo sistemi logici come AP, mentre SIP integra AP+ MobiledDR. In una certa misura SIP=SoC+DDR. Con una sempre maggiore integrazione in futuro, l'EMMC sarà probabilmente integrato nel SIP. Dal punto di vista dello sviluppo degli imballaggi, SOC è stato stabilito come la direzione chiave e di sviluppo della futura progettazione elettronica dei prodotti a causa dei requisiti dei prodotti elettronici in termini di volume, velocità di lavorazione o caratteristiche elettriche. Tuttavia, con l'aumento dei costi di produzione di SOC e i frequenti ostacoli tecnici negli ultimi anni, lo sviluppo di SOC si trova di fronte a colli di bottiglia, rendendo così sempre più l'attenzione dello sviluppo di SIP da parte dell'industria.
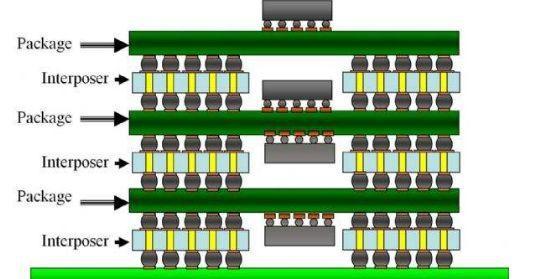
Percorso di sviluppo da MCP a POP
I prodotti di memoria combo (Flash + RAM) che integrano più FLASH NOR, NAND e RAM in un unico pacchetto sono ampiamente utilizzati nelle applicazioni del telefono cellulare. Queste soluzioni monopacchetto includono pacchetto multi chip (MCP), pacchetto a livello di sistema (SIP) e modulo multi chip (MCM).
La necessità di fornire maggiori funzionalità in telefoni cellulari sempre più piccoli è un fattore importante della crescita di MCP, tuttavia, sviluppare soluzioni che migliorano le prestazioni mantenendo una dimensione ridotta è una sfida formidabile. Non solo le dimensioni sono un problema, ma anche le prestazioni sono un problema, come l'uso della memoria MCP con interfacce SDRAM e DDR quando si lavora con chipset a banda base o coprocessori multimediali nei telefoni cellulari.
L'imballaggio POP stack è un buon modo per ottenere miniaturizzazione con un alto grado di integrazione. Nel packaging stack, il out-of-package (POP) sta diventando sempre più importante nel settore degli imballaggi, soprattutto nelle applicazioni mobili, grazie alla sua capacità di impilare unità logiche ad alta densità.
Vantaggi dell'incapsulamento POP
1. dispositivi di memorizzazione e dispositivi logici possono essere testati o sostituiti separatamente, per garantire il rendimento;
2. Il pacchetto POP di doppio strato salva l'area del substrato e il più grande spazio longitudinale consente più strati di imballaggio;
3.Mixed DRAM, DDRAMSRAM, FLASH e microprocessore lungo il PCB longitudinale;
4. Per i diversi produttori di chip, fornire flessibilità di progettazione, può essere semplicemente mescolato insieme per soddisfare le esigenze dei clienti, ridurre la complessità e il costo di progettazione;
5. Attualmente, la tecnologia può essere utilizzata per sovrapporre e assemblare il chip di strato nella direzione verticale;
6. La connessione elettrica dei dispositivi superiore e inferiore impilati insieme realizza una velocità di trasmissione dei dati più veloce e può far fronte all'interconnessione ad alta velocità tra dispositivi logici e dispositivi di archiviazione