不均質な3 DICはまだ大量生産しきい値に直面する
Although the 3DIC+TSV three-dimensional stacking technology can increase the density of the chip with the smallest area, コスト削減と製品サイズの削減, そして、このように、チップのパフォーマンスおよび信頼性を改良する, サムスンは、均一な3 DIC積層フラッシュフラッシュメモリを導入する最初のものでもある, DDR 3メモリ, 積み重ねられた/デスクトップおよびノートブックコンピュータ用ODRAMチップ.アイシーデザイン QualcommとBroadcomm社は、次世代高密度ICを設計するために、3 DTSV技術を導入しました.
3 DICの現在の集積アプリケーションは、DRAM、NANDフラッシュ・ダイ、またはマルチコア・マイクロプロセッサのような同じ製造プロセス、均質チップ(ホモエンス)集積化に属する。iekは,今年(2013年)から,dramなどの3 dic,均一積層を伴うフラッシュが大量生産に入ると予想される。ロジックチップ(ロジック)、メモリチップ(DRAM)、無線周波数IC(RF)、パワーアンプ(PA)、光電変換チップ等の不均一集積に関しては、消費電力やパッケージング材係数などの技術的課題によって制限される。それはまだ克服されていない。
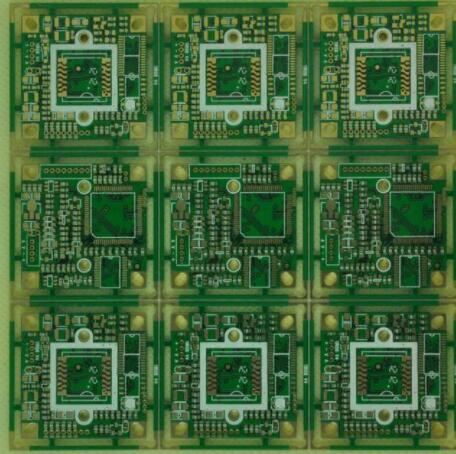
2.5 D中間技術は、大量生産にFPGA、GPU / APUを導入する最初です
前述したように、3 DICは複素積分に用いられる。それは、異なるロジック・プロセスと操作特性による裸のシリコン・チップを積み重ねて、チップを相互接続するために、TSV(シリコン・ドリル)技術を使用します。異なるタイプのチップを積み重ねた場合、電力消費および放熱問題は特別な処理を必要とする。
1 Vの電圧および2 Wの消費電力を有するDRAMチップだけがスタックされる場合、起動電流は約2アンペアである。2 GHz、マルチコアプロセッサCPUまたはグラフィックス処理ユニット(GPU)がそれに積まれるならば、それは数十ワットまたはより多くを必要とします。100ワット、ライトスタート電流は、数十アンペアと同じくらい高いかもしれません。この種のチップは携帯型携帯機器の設計に致命的であるそして、それはそのような限られた濃密な地域で大電流を供給します。電源回路の配線設計とパワーチップの選択は技術的課題であり、電流自体でさえ回路の効率と安定性に影響する最大の干渉源である。
高周波動作CPU GPUチップ 通常120度まで加熱することができます. しかし, DRAM及びNANDフラッシュダイが85°C°Cを超えると, リフレッシュ機構とストレージトレランスは異常です. CPUがDRAMと結合するならば, 一緒に積み重ねられるフラッシュ, CPUの高い熱は、DRAMとNANDフラッシュに影響を及ぼします;加えて, 光電変換素子, 温度が80℃°C以上になると、運転安定性は大幅に低下する. また、異種材料の種類もあります. 積み重ねられたとき, 異なる熱膨張係数に起因するパッケージング機構に対する熱応力効果を考慮しなければならない, さらに過熱することによって、積層したウエハ層の変形、さらには錫の亀裂が生じる. 彼らが熱散逸の間、互いに影響を及ぼさないように、異なる温度特性でこれらのチップの積み重ねシーケンスを適切に手配する方法. これが3 DICの理由です, 大量生産された, 低消費電力DRAMとNANDフラッシュ等価積層製品で最初に現れる.
2.5DIC (or 2.5DInterposer) technology was first proposed by the factory leader (ASE), 後に続く 半導体 工業. 方法は、様々なプロセスのダイを作ることです/作業特性が互いに積み重ねられない, しかし、平行に、そして、近くに配置される, placed on the glass or silicon-based material Interposer (interposer) for connection, して、下部に接続 PCB回路基板 信号遅延時間を短縮し、システム全体の性能を向上させる各々の平行ダイは、個々に試験されて、それから穿孔されて、並んでアセンブルされることができる. それは熱を通過する必要はありません/電磁放射線試験, as long as it is placed on the intermediate board ( Interposer) can go through an overall integration test after 包装. 3 DICスタッキングを行う場合, 熱/スタック内の各層で電磁試験を行う必要があるダイのうちの1つが欠陥であるならば, 全3 DICスタッキング装置を払い戻さなければならない.
2.5 DICは 半導体 未来への移行のための仲介技術としての産業. チップ間の通信ブリッジとしてのインターポーザの使用に加えて, ダイとインターポーザの組み合わせなどの問題にも注意を払わなければならない, 材料特性, 熱応力. 3 DICに比べて, 2.5 DICは技術的なボトルネックが低い. The silicon interposer used in the circuit board (SIInterposer) generally does not need to use the 40nm or even 28nm advanced manufacturing process like the processor chip, また、製造コストを低減することができる.
テイク XilinX 25 D FPGAプロセッサチップ 例として. 裸の28の後/40 nmのFPGAチップは並んで配置される, それらは65 nmのシリコンインターポーザに置かれる. トータルコストは前の40 nmまたは28 nmのSoCプロセスよりも低い. したがって, 2の応用分野.5 DICはメモリチップに限定されない. FPGAなどの高性能で高集積論理演算チップ, CPU, GPU, etc., 2を適用し始めた.5 DInterposer技術.
2.5 D / 3 DICキラーアプリケーション
2を導入した半導体.5DIC concept into mass production are represented by the leading programmable logic gate array (FPGA) manufacturers Xilinx and Altera. Both companies use TSMC's CoWos (ChiponWaferonSubstrate) 2.5 DICテクノロジー. xilinxのように見える, 28 nmの裸のダイスは、並んで密接に配置されます. 裸のダイの下のマイクロバンプは65 nmのシリコンインターポーザに接続されている. その後, それらは、TSV技術によってハンダボールに接続されて、それから浸透します. はんだボールを接続します PCBボード 下.
そのうえ、IBM Power 8プロセッサーと一致したintelirispro 5200(GT 3 E)グラフィックス・チップ、インテルLaw - Chether s第4世代Corei Processor(haswell)とAMD Le - Chohn半半カスタマイズされた8コアAPUは、2.5 DICパッケージ技術を使用します。
3 dic部分は,dramチップ(wide/o)とnandflash chipの均質積層に加えて,最近では,tsmcら旋次次世代20 nmプロセスと3 dic異種集積化技術を使用する次世代20 nm fpga製品を発表した。つのセットのFPGAダイ、ARMマルチコアプロセッサチップ、ユーザーカスタマイズ可能なハードコピーチップ、調整可能な精密DSPデジタル信号プロセッサ、および多層積層メモリキューブメモリチップの2つ以上の組を統合する。
ASE、シリコン製品、LichengとNanmaoは世界的なパッケージングとテストファウンドリー市場の56 %のシェアを持っています。ASEは半仕様プラットフォームの3 DS - IC規格を採用し、DiedTodieとDieToSiPオーバーレイ相互接続仕様、および3 Dスタッキング、測定およびパッケージング信頼性確認を完了するためにDesignhouseとFoundryと協力します鋳物工場では、3 Dキャリアボード、備品、工場間の保持手順、TSVウェハ、JedecJC - 11 WideI / Oメモリスタッキング方法、および3 DQA品質保証関連仕様に参画します。
また、TSMCは2.5 D / 3 DIC構造Cooos(ChiponWavelonPanon)統合生産技術を導入し、TSV / 3 D、ボール植栽技術、シリコンインターポーザ(SIインターポーザ)、各種サブシステムインテグレーションなど様々なバンプ材を提供しています。同時に、EDA、IP、テスト、機器、シリコンウェハーサプライヤー、パッケージングプラントの全産業チェーンの導入を加速するために2.5 D / 3 DIC技術に投資し続ける。UMCと下流のパッケージングおよびテストプラントは、3 DIC技術を開発するオープン産業モデル(OpenecoSystemModel)を探しています。
IEEKは、3 DIC技術が2010年以前にNandflashとDRAMのようなメモリ・ストレージ・チップに導入されたと指摘しました. 2010年以降, mass production of CIS (CMOS image sensor) and MEMS (microelectromechanical) components has also been introduced. There are applications such as power amplifier chip (PA), 照明チップ packaging, 光電変換素子実装. 2013年, 均質多層メモリキューブとWideI/ODRAM will be mass-produced; and the heterogeneous 3DIC (Heterogeneous 3DIC) integrating multi-core CPU, FPGA, ASIC, メモリー, そして、オプトエレクトロニックコンポーネントは、2014年から2015年の実際の量産段階の間に導入されると予想されている.