過去100年間、集積回路の急速な発展に伴い、ICパッケージボード技術も向上し、IC業界の応用ニーズはますます大きくなり、集積度はますます高くなっている。パッケージの一般的な開発過程:TO-DIP-PLCC-QFP-PGA-BGA-CSP-MMC、技術指標は世代より先進的で、チップ面積とパッケージ面積の比はますますTO 1に近づき、電気性能と信頼性は徐々に向上し、体積はより小さく、より薄い。
1.MCM(マルチチップアセンブリ)
実際には、これはチップコンポーネントであり、最新の技術です。配線基板上に複数の半導体ベアチップを組み込むパッケージ技術である。そのため、ICパッケージの材料とプロセスを排除し、材料を節約することができます。同時に必要な製造過程が減少したため、厳密には製品は高密度組立である
テンセントニュースを開いてもっと画像を見る
2.CSP(チップレベルパッケージ)
CSPパッケージはチップレベルパッケージである。チップは本質的に小さいことが知られている。そのため、CSPパッケージの最新世代のメモリチップパッケージ技術は、チップ面積とパッケージ面積の比を1:1.14以上にすることができ、かなり近い。1:1の理想像は業界でシングルチップの最高の形と評価されている。CSPパッケージは、BGAパッケージボードと比較して、同じ空間内でストレージ容量を3倍に増やすことができます。このパッケージの特徴は体積が小さく、入出力端子の数が多く、電気性能が良いことである。CSP BGA(グリッドアレイ)、LFCSP(リードフレーム)、LGA(グリッドアレイ)、WLCSP(ウェハレベル)などがある。
1.CSP BGA

2.LFCSP(リード構造)
LFCSP、このパッケージは、従来のプラスチックパッケージ回路を使用したリードフレームに似ていますが、サイズが小さく、厚さが薄く、指パッドがチップの内部領域まで伸びています。LFCSPはリードフレームに基づくプラスチックパッケージである。パッケージの内部相互接続は通常配線によって実現され、外部電気接続は周辺ピンをPCB基板に溶接することによって実現される。LFCSPSは一般に、リードに加えて、放熱を高めるためにPCBに溶接することができるより大きな暴露熱パッドを有する。
3.LGA(グリッドアレイ)
これはBGAのようなメッシュアレイパッケージですが、BGAは溶接されており、LGAはロック解除と交換が可能です。つまり、BGAに比べて交換可能ですが、交換には非常に注意が必要です。
4.WLCSP(ウェハレベル)

4.BGA(グリッドアレイ)
ボールコンタクトアレイの1つで、表面にパッケージを取り付けます。PCBの裏面には、表示モードでピンの代わりにボールブロックを用い、LSIチップをPCBの表面に組み込み、モールド樹脂またはポッティングで封止した。バンプディスプレイキャリア(PAC)とも呼ばれる。BGAは主に:PBGA(プラスチックパッケージBGA)、CBGA(セラミックパッケージBGA)を含む。
4-1 CBGA(セラミックス)

CBGAはBGAパッケージファミリーの中で最も歴史が古い。基板は多層セラミックスであり、金属カバーはチップ、リード、パッドを保護するためにシール半田で基板に半田付けされている。これは表面実装パッケージで、底には半田のセットがあり、アクセスが容易です。
4-2FCBGA
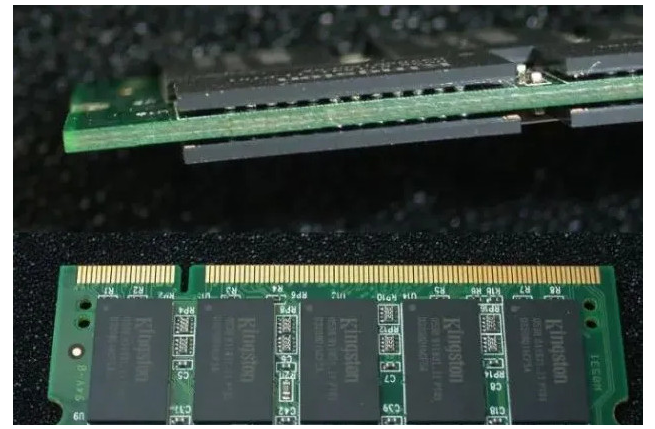
FCBGAはフリップチップによりチップ半田ボールとBGA基板の直接接続を実現した。BGA製品では、より高いパッケージ密度を実現し、より良い電気的および熱的性能を得ることができます。
4-3PBGA

BT樹脂/ガラス積層板を基材とし、プラスチックエポキシ成形プラスチックを封止材として使用するBGAパッケージ。このパッケージチップは湿気に敏感であり、気密性と信頼性に要求の高いデバイスパッケージには適していない。
4-4 SBGA

SBGAは、高い信頼性と優れた性能を確保するために、信頼性の高い組立プロセスと材料を使用しながら放熱を強化するための銅フィンを含む先進的な基板設計を採用しています。高性能と軽量を組み合わせて、典型的な35 mm²SBGAパッケージを1.4 mm未満の高さに取り付け、重量は7.09にすぎません。
5.PGA(ピングリッドアレイ)

ピンパッケージングを表示します。挿入パッケージでは、下部の垂直ピンが配列されています。パッケージ基板は、基本的には多層セラミックス基板である。高速大規模論理LSI回路用。ピンはチップの底部にあり、通常は正方形であり、中心からピンまでの距離は通常2.54 mmである。ピンの数は64から447までさまざまです。通常、CPGA(セラミック針格子アレイパッケージ)とPPGA(プラスチック針格子アレイパッケージ)の2種類があります。
6.QFP(四平面パッケージ)
このタイプのパッケージは四角い平たいパッケージで、通常は四角いもので、4つの側面のピンが付いています。このパッケージで実現されたCPUチップはピンピッチが小さく、ピンが薄い。一般的に大型または超大規模集積回路ではこのパッケージが採用されており、ピンの数は一般的に100以上である。より小さなパッケージサイズのため、寄生パラメータが低減され、高周波応用に適している。このパッケージは、このプロセスでは、CQFP(セラミック四平面パッケージ)、PQFP(プラスチック四平面パッケージ)
1.LQFP(薄い)
これは薄いQFPです。パッケージの厚さが1.4 mmのQFPを指し、これは日本の電子機械業界が最新開発したQFP形状規範に基づいて使用している名称である。
2.TQFP(細い正方形)
7.LCC(鉛または鉛フリーチップキャリア)
ピン付きセラミックチップキャリアであり、表面実装パッケージの一種であり、ピンはパッケージの4つの側面から引き出される。高速hf IC用のパッケージであり、セラミックQFNまたはQFN-Cとも呼ばれています。
1.CLCC(フラップピン)
2.最も先進国でない国
C字型ピンチップキャリアは、ピンがチップの頂部から引き出されてC字状に下方に湾曲する
3.PLCC
これらのピンはパッケージの4つの側面から抜き取られ、t形をしてプラスチックで作られています。ピンの中心間隔は1.27 mmで、ピンの数は18~84個です。QFPよりも操作しやすいが、溶接後の外観検査は難しい。
8.SIP(単線パッケージ)
1つの直列パッケージリード線がパッケージの片側から直線的に引き出されます。通常は直通で、ピンはパッケージの片側から引き出され、一直線に並んでいます。プリント基板に組み込むと、パッケージは横に立っています。ピンの中心距離は通常2.54 mmで、ピンの数は2から23まで様々で、多くはカスタム製品です。パッケージの形状はそれぞれ異なります。
9.SOIC(小型IC)
SOICは小型集積回路パッケージである。外部リード線の数は28個の小型ICを超えてはならない。通常、パッケージにはワイドボディと狭ボディの2種類があります。これは、同じDIPパッケージよりも約30〜50%少ないスペースです。厚さは約70%減少した。
10.SOP(小包装)
SOP包装は、コンポーネント包装の1つの形態である。一般的な包装材料としては、プラスチック、セラミックス、ガラス、金属などがありますが、現在は基本的にプラスチックで包装されています。広範な応用があり、主に各種集積回路に応用されている。次に、TSOP(薄型小型パッケージ)、VSOP(非常に小型パッケージ)、SSOP(縮小型パッケージ)、TSSOP(薄型縮小型パッケージ)、MSOP(マイクロファイルパッケージ)、QSOP(4分の1サイズの外形パッケージ)、QVSOP(4等分サイズの非常に小型外形パッケージ)などである。
1.SSOP(縮小型)
2.TSOP(薄型小包装)
3.TSSOP(スリム化)
11.SOT(小型トランジスタ)
SOTはSMDパッケージです。5ピン(3ピン、4ピン)未満のデバイスには、通常SMDパッケージが採用されている。このパッケージには、小さなサイズ、複数のトランジスタが使用されています。
これもトランジスタパッケージです。一般的に両側にピンがあり、ピンの数は3つ、4つ、5つで、最大7つまでです。
12.DIP(2線パッケージ)
DIPパッケージは、デュアルオンラインパッケージまたはデュアルオンラインパッケージとも呼ばれます。ほとんどの中小規模集積回路はこのパッケージ形式を採用しており、ピンの数は一般的に100を超えない。このパッケージのチップには2列のリードがあります。ピンは、DIP構造チップソケットまたは同じ数の穴を有する溶接位置に直接溶接することができる。その特徴は簡単にPCB板の穴あけ溶接を実現でき、マザーボードとの互換性が良いことである。
1.CerDIP(セラミック二列直挿パッケージ)
ECL RAM、DSP(デジタル信号プロセッサ)、およびその他の回路用のCerdipセラミック二列直挿パッケージ。ガラス窓Cerdipは、ULTRAVIOLET消去可能EPROMやEPROMを内蔵したマイクロコンピュータ回路などに使用されている。
2.PDIP(プラスチック包装)
このプラスチックのデュアルオンライン包装はよく見られます。PCBスルーホール実装に適しています。操作が簡単で、ICコンセントを使ってデバッグすることができます。しかし、パッケージサイズはチップよりずっと大きく、パッケージ効率は低い。有効なインストール領域が多数あります。
13.TO(トランジスタ形状パッケージ)
ICパッケージプレートTOはトランジスタ形状のパッケージである。1つはリード線の表面実装を可能にするトランジスタパッケージタイプであり、もう1つは表面実装コンポーネントのない円形の金属シェルパッケージである。このパッケージは広く使用されており、多くのトランジスタ、MOS管、サイリスタなどがこのパッケージを使用している。