マイクロエレクトロニクス技術の急速な発展, 大規模・超大規模集積回路の広い応用, マイクロ組立技術の進歩, the 回路基板製造 階層的で多機能的な方向に発展している, PCB回路基板の配線線は細く、間隔が狭いマイクロポーラスである. 加工で使用される機械的穴あけ技術は、もはや要件を満たすことができず、急速に新しい微細孔処理方法を開発した, すなわちレーザ穴あけ技術.
HDI PCBのためのレーザホール形成の原理
レーザーは外部からの刺激によって刺激され、赤外線と可視光が熱エネルギーを持ち、紫外線が光エネルギーを持つエネルギーを増大させる強力な光線です。このタイプの光が被加工物の表面に当たったときに生じる3つの現象がある。
光学スポットを介して基板上にレーザスポットを当てることにより、複数のモードの合成モードがあり、照明点との3つの反応がある。
レーザ穴あけの主な機能は、処理される基板材料を迅速に除去することである。それは主に光熱アブレーションと光化学的アブレーションまたはいわゆる切除に依存する。
光熱アブレーション:高エネルギーレーザ光を吸収し、加熱して非常に短い時間で加熱するために処理される材料によって形成された孔の原理。高エネルギーの作用下では,このプロセスによって形成された細孔壁上の黒色チャージング残渣を孔形成前に洗浄しなければならない。
2 .光化学的アブレーション:2 eV電子ボルトを超える紫外領域の高光子エネルギーを指す。400ナノメートル以上のレーザ波長による高エネルギー光子の結果この高エネルギー光子は、有機材料の長い分子鎖を破壊し、より小さな粒子となるが、そのエネルギーは元の分子よりも大きく、それから逃げることを強いられ、基板材料が速やかに除去され、外部のピンチ下に微細孔が形成される。
したがって、この種のプロセスは沸騰を含まない。したがって、プレ多孔化洗浄は非常に簡単である。
これらはレーザ細孔形成の基本原理である。現在、2つの最も一般的に使用されるレーザ穴あけ法があります:プリント回路基板の穴を開けるのに用いられるレーザーは主にRF励起CO 2ガスレーザとUV固体Nd:YAGレーザーから成ります。
3)ベースプレートの吸光度について:レーザの成功率は母材の吸光度と直接の関係を有する。プリント配線板は銅箔,ガラスクロス,樹脂の組合せである。これら3種の材料の吸光度は波長によって異なるが、銅箔やガラスクロスは紫外線0.3 mである。以下の領域は吸収率が高いが可視光と赤外線に入ると急激に落ちる。有機樹脂材料はすべての3つのスペクトルセグメントでかなり高い吸収率を維持する。これは樹脂材料の特徴であり,レーザ加工技術の普及の基礎である。
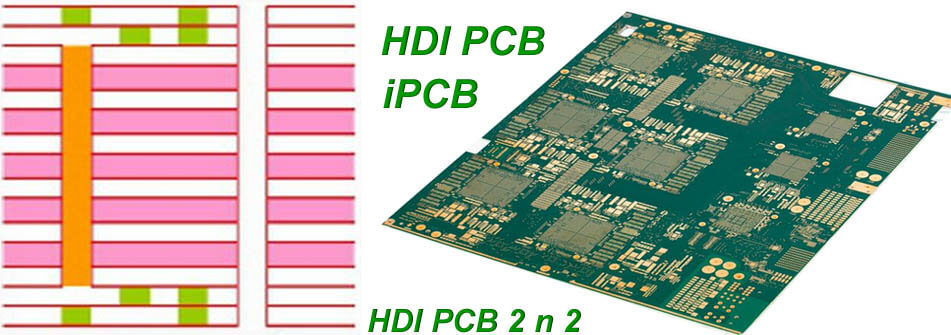
CO 2レーザホール形成のための異なるHDI PCBプロセス
co 2レーザ穴あけ,直接穴あけ,ドレッシングマスクドリル加工の2つの主な穴あけ法がある。いわゆるダイレクトホール形成技術は、デバイスの主制御系を介してレーザビーム径をプリント基板上のホールと同じ直径に変調し、銅箔を用いずに直接誘電体表面に孔を加工する技術である。コーティングマスクプロセスは、プリント基板の表面を特別なマスクで被覆し、従来の工程で露光/現像/エッチングにより、銅箔をホール表面から除去することである。これらのホールには、開口より大きいレーザビームが照射され、露出した誘電体層樹脂が除去される。以下に分けて説明する。
1 .ブロンズ窓の開放方法
最初に、RCCコーティングされた樹脂銅箔の層をインナーパネルにプレスします。窓は光化学によって作られ、次に樹脂をエッチングして露出させ、次いで窓の中の基板材料をレーザでアブレーションし、微小盲目の穴を形成する。
ビームが強化されるときに、それは2つのグループのガルバノメータ型のマイクロ反射スキャナに達するためにアパーチャを通過する。そして、それはポジティブなFのレンズに一度垂直に配置される。チューブの領域は、刺激的なカウンタートップを作ることができたところに達します、そして、ミクロ盲目の穴は1つずつ燃えます。
インチの正方形の管状領域の電子高速ビームによって位置決めされると、0.15 mmのブラインドホールは3つのショットでパンチされることができます。第1の銃のパルス幅は、約15×1/4秒であり、ホール形成のためのエネルギーを提供する。その後、ホールは、壁の底の残りの部分をきれいにし、穴を修正するために使用することができます。
良好なレーザーエネルギー制御による0.15 mmの微小盲目穴のSEM断面と45度の全景。この窓開放工程は裏当て板として用いられる。大きな植え付けまたは二次ブラインドホールが非常にしばしば必要とされないとき、それらの整列は難しいです。
2 . open window processメソッド
前者の工程で形成された孔径は、オープン銅窓と同じである。操作のわずかなミスは、オープン・ウィンドウのポジションを逸脱させることができて、結果として、ベース・パッドのセンターで、ブラインドホール位置の不整合に結果としてなる。銅窓のずれは、マトリックス材料の膨張及び収縮及び画像転写に使用されるネガの歪みによることがある。従って、大きな銅窓を開くプロセスは、銅窓の直径をベースパッドの0.05 mmより大きくすることである。通常、穴の大きさは穴の大きさによって決まる。孔が0.15 mmの場合、ベースパッドの直径は約0.25 mmであり、大きな窓の直径は0.30 mmである。それから、レーザ穿孔は、バーンアウト位置を正確にベース・パッドのマイクロブラインドホールに整列させるためにされることができる。その主な特徴は、それを選択する自由度が大きいです。レーザー穴を穿孔するとき、あなたは穴を作るために内側のベース・パッドのプログラムを押すほうを選ぶことができます。これは効果的に銅窓の同じ直径に起因するミスアライメントを避けます。そして、それはレーザー点がフロントウインドウで指し示すのを防ぎます、そして、多くの不完全な半分穴または残りの穴がスラブの大きなバッチに現れる原因になります。
HDI PCB樹脂表面における直接細孔形成プロセス
HDI PCBレーザをドリル穴に使用するレーザ穴あけ法のいくつかのタイプがある
a .ベースプレートに内層に樹脂被覆銅箔を塗布した後、全ての銅箔をエッチングし、CO 2レーザを用いて、裸の樹脂表面に直接孔を形成し、その後、メッキ工程によって更なる処理を行うことができる。
b .樹脂板の代わりにFR−4半硬化シート、銅箔を用いた同様の工程である。
コーティングされた感光性樹脂による銅箔のその後の積層のためのプロセス。
d .誘電体層として乾式フィルム、銅箔プレス加工。
E .他の種類の暖かいフィルムを銅箔でコーティングするプロセス。
極薄銅箔の直接アブレーション
内側の銅板の両面に樹脂銅箔を押圧した後、ハーフエッチング法により17 mの銅箔の厚さを5ミクロンにした後、ブラック酸化処理してCO 2レーザで穴を形成することができる。
基本的な原理は,酸化黒表面が集中的に光を吸収するためであり,co 2レーザのビームエネルギーを増加させるという前提で超薄銅箔と樹脂表面を直接孔化できる。しかし、最も困難なことは、「ハーフエッチング法」が均一な厚い銅層を得ることができることを保証することであるので、それらの製造に特に注意を払わなければならない。もちろん、銅を裏打ちされた運搬材料UTC。銅箔は約5 umの本に相当する。
このようなプレート処理によれば、以下の主要な態様が現在の工程で採用されている。
これは、主に誘電体層の厚さ差が510×1/m〜mであることを確実にするために、材料供給者の厳格な品質及び技術的基準を設定することにより、樹脂被覆銅箔の誘電体膜厚の均一性を保証することができるので、同じレーザエネルギーでホールの底部の通過精度及び清浄度を保証することができる。同時に、後工程のドリル汚れを除去するための最良のプロセス条件を採用し、ブラインド孔の底部が清浄であり、レーザ穴あけ後の残留物がないことを確実にする必要がある。ブラインドホール無電解めっきと電気めっきの品質には良い効果がある。
HDI PCBプロセスを加工するNd:YAGレーザ
nd:yagはネオジウム及びイットリウムアルミニウムガーネットである。二つの固体結晶から放出されたUVレーザ最近では、ダイオードパルスによって励起された最も一般的に使用されるレーザビームを使用して、水冷のない効果的なレーザ封止システムを作ることができる。このレーザの第3高調波波長は355 nmである。第四高調波波長は266ナノメートルである。波長は光学結晶で変調される。
このレーザ加工の最大の特徴は紫外線である。スペクトル領域では、銅箔とガラス繊維の積層体が紫外線領域で強く吸収しているのに対し、このようなレーザ光の微小エネルギーとともに、銅箔やガラスクロスを通して強く浸透し、穴を直接形成することができる。このタイプのレーザ熱は小さいため,co 2レーザ穴あけ後,木炭スラグを生成しないので,その後の壁の操作には良好な表面を提供する。
Nd:YAGレーザー技術はロゴの盲目の穴を処理して、いろいろな材料の穴を通過します。それは、最小の直径25ミクロンのポリイミド銅クラッド積層体の穴を通してドリルする。費用分析から、使用される最も経済的な直径は25125ミクロンです。直接のレーザー・パンチは、50ミクロンの最大開口で使われることができます。形成された穴の内面は、清浄で、炭化していて、電子板に簡単です。また、25ミクロンの最小直径と25125ミクロンの最も経済的な直径でPTFE銅クラッド積層体の穴を貫通することができます。ドリル速度は4500ホール/分である。穴はきれいで、特別な処理要件を必要としません。穴加工のような他の材料があります。具体的な処理には以下の処理を用いることができる。つのタイプのレーザ穴あけの速度に従って2つの組合せプロセスが採用される
基本的な操作方法としては、まず、YAGを用いて孔位置の表面に銅箔を剥離した後、YAGドリルよりも高速のCO 2レーザを用いて樹脂を直接成形して穴を形成する方法がある。
実際の品質問題 HDI PCB製造
レーザ穴あけの過程では、多くの品質問題があります。唯一の最も一般的な品質の問題ピアの参照のために前方に配置されます。
開放窓法におけるコースター2レーザのドリル位置とボトムターゲット位置のずれ
hdi pcbレーザ穴あけでは,ビーム位置決めシステムはアパーチャ成形の精度に非常に重要である。ビームポジショニングシステムは精密位置決めのために使用されているが、他の要因のために穴形状を有する火炎がしばしば生成される。製造工程における品質問題を以下のように分析した。
(1)インナーコアプレートの溶接パッドとワイヤグラフィック、および樹脂被覆銅箔を用いたRCCである。層添加後の窓開口は負であり,両者は湿度と温度によるサイズの増加と減少のための潜在的因子である。
(2)コアプレートを用いてトラバースボンディングパッドのパターンを形成する際に基材のサイズが大きくなったり減少したりし、樹脂被覆銅箔のRCCを高温で押圧する。層の追加後、内側及び外側の基板材料の寸法拡大及び収縮の要因が存在する。
3 .エッチングされた銅窓の大きさと位置はエラーを引き起こす。
(4)レーザ自体の光点及び表面の変位による誤差。
二次ブラインドホールの位置合わせは、より困難であり、容易に位置誤差を引き起こすことがある。
以上のような理由により、生産における関連技術データと実際の運転経験に基づいて、主な技術戦略は以下のとおりである。
タイプサイズを減らすために、大部分のHDI PCBメーカーは450を使用します。しかし、0.10 mmのワイヤー幅と0.15 mmのブラインド穴直径による携帯電話パネルのために、最高のレイアウトサイズは350です450 mm。上限。
2 .レーザーの直径を増やす。目的は、銅窓で覆われた領域を増やすことである。具体的な方法は、“ビーム直径=穴の直径+ 90〜100”は、エネルギー密度が低い場合は、問題を解決するために1つまたは2つ以上のショットを撮影。
(3)大きな銅窓を開ける工程では、このとき銅窓の大きさが大きくなり、開口部が変化しないので、窓の位置によってレーザ孔の直径は完全には決定されず、穴の位置は芯板上のベースターゲットの位置に基づいて直接的にできる。
(4)光化学イメージング及びエッチングからYAGレーザへの窓開口法の変更:yagレーザ光を用いて、まずコアプレートのベースホールに従って窓を開け、次に、窓位置に穴を焼き付けるためにCO 2レーザを使用して、結像によるエラーを解決する。
5 .二次マイクロブラインドホール法を作るために2層の層:両面に樹脂銅箔RCCを被覆した場合。その後、再びRCCを蓄積し、2次目のブラインドホールを作成すると2次目のブラインドホールが蓄積される。「2つの」ブラインドホールアライメントの場合、「1対1」を狙って穴を形成しなければならない。コアプレートの本来のターゲットは再利用できません。つまり、“1つを”穴とパッドに蓄積すると、その基板の端もターゲットを作る。このため、「ji 2」のRCCを押した後、「ji 2」の4つの機械式データホールをX線装置でドリルして「ji 1」をターゲットにして穴をあけることができる。このメソッドは、「ji 2」をできるだけ“ji 1”と並べることができます。
不正確なパス
多くの生産経験に基づいて、母材の成形における品質上の問題のため、主な品質問題は、樹脂被覆銅箔押出し後の誘電体層の厚さが必然的に異なることである。穴をあけている同じエネルギーで、誘電層のより薄い部分のクッションは、より多くのエネルギーを耐えるだけでなく、より多くのエネルギーをも反映します。これにより、孔壁が外側に膨張した釜に叩かれる。これは、多層層の層間の電気的相互接続の品質に大きな影響を与える。
不適切な孔サイズのために、多層多層プリント回路基板(MLPCB)の高密度相互接続構造の信頼性は、一連の技術的な問題を提起する。
したがって、この問題を制御し解決するためには、工程の措置を講じる必要がある。主に以下のプロセスが使用される。
(1)510〜1000 m/mで樹脂被覆銅箔と積層銅箔との間の誘電体層厚差を厳密に制御する。
2 .レーザーのエネルギー密度とパルスガン数を変える。大量生産のためのプロセス条件は、試験方法によって見つけることができる。
3 .穴の底のスラグと穴の壁の壊れたスラグは正しく除去されません。
このタイプの HDI PCB 品質の問題は、ほとんど不適切な制御のために起こりそうです. 特に多孔板型積層板について, 品質問題なしで100 %の品質を保証することは不可能です. これは、加工された大きなステンシルの微小ブラインドホールの数が大きすぎるためである, 平均60 - 90,ホール. メディア層の厚さは変化する, 同じエネルギーでレーザー穴あけをするとき、ベースに残される残りの厚さは、そうします. すべての残留物は掘削土の処理後完全にきれいであることを保証することはできない. 加えて, 不良検査法はしばしばその後になる HDI PCB 欠陥がある場合の銅めっきと底パッドと穴壁の間の結合.