1.BGA(球栅陣列)也稱為CPAC(球頂焊盤陣列載體)。 球形觸點的展示,表面安裝封裝之一。 在印刷電路板的背面,在顯示模式下產生球形凸塊來代替引脚,並將LSI晶片組裝在印刷電路基板的正面,然後通過模制樹脂或灌封來密封。 也稱為凸塊顯示器載體(PAC)。 引脚可以超過200,這是多引脚LSI的封裝。 封裝體也可以製成比QFP(Quad Flat package)更小的尺寸。 例如,引脚中心距離為1.5mm的360引脚BGA僅為31mm見方,而引脚中心距離0.5mm的304引脚QFP為40mm見方。 並且BGA不必像QFP那樣擔心引脚變形。
該套裝軟體由美國摩托羅拉公司開發,首先在可擕式電話和其他設備中採用,然後在個人電腦中普及。 最初,BGA引脚(凸塊)中心距離為1.5mm,引脚數量為225。 也有一些LSI製造商正在開發500引脚BGA。 BGA的問題在於回流焊後的外觀檢查。美國摩托羅拉公司將用模制樹脂密封的封裝稱為OMPAC,而用灌封法密封的封裝則稱為GPAC。
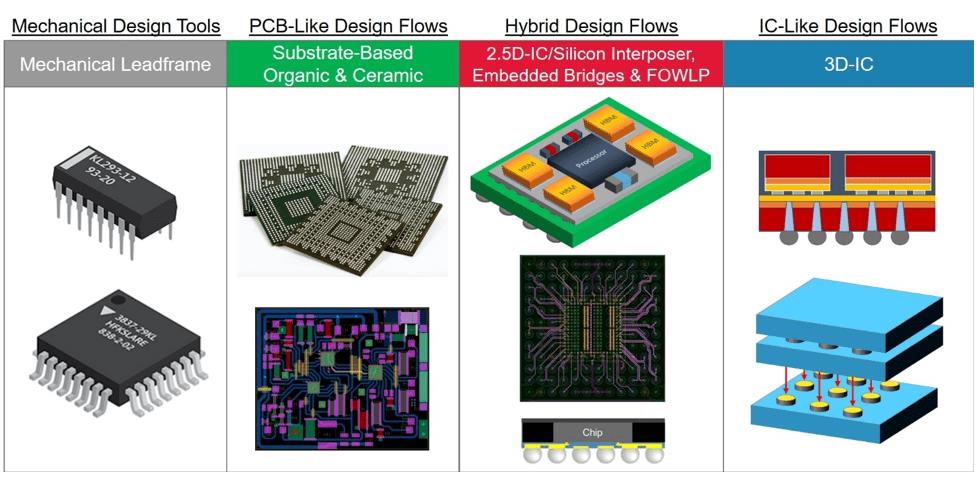
2.Cï¼(陶瓷)代表陶瓷包裝的標記。 例如,CDIP代表陶瓷DIP。 這是一個在實踐中經常使用的標記。
3.COB(chip-on-board)板上晶片封裝是裸晶片安裝科技之一。 電晶體晶片被移交並安裝在印刷電路板上。 晶片和基板之間的電連接是通過線縫實現的,並用樹脂覆蓋,以確保可靠性。 儘管COB是最簡單的裸晶片安裝科技,但其封裝密度遠不如TAB和倒裝晶片接合科技。
4.DIP(雙列直插式封裝)雙列直插封裝。 其中一種插入式封裝,引脚從封裝的兩側引出,封裝資料為塑膠和陶瓷。 歐洲電晶體製造商大多使用DIL。 DIP是最流行的挿件封裝,其應用範圍包括標準邏輯IC、記憶體LSI和微型電腦電路。 引脚中心距離為2.54mm,引脚數量為6到64個。 包裝寬度通常為15.2mm。 一些寬度為7.52mm和10.16mm的封裝分別稱為SK-DIP(薄型雙列直插封裝)和SL-DIP(薄型雙列直插封裝)窄體DIP。 但在大多數情况下,沒有區別,它們只是統稱為DIP。 此外,用低熔點玻璃密封的陶瓷DIP也稱為Cerdip(見4.2)。
4.1DIC(雙列直插陶瓷封裝)陶瓷封裝DIP(包括玻璃密封)的別稱。
4.2Cerdip:用玻璃密封的陶瓷雙列直插式封裝,用於ECL RAM、DSP(數位信號處理器)等電路。 帶玻璃窗的Cerdip用於紫外線可擦除EPROM和內寘EPROM的微型電腦電路。 引脚中心距離為2.54mm,引脚數量為8到42個。 在日本,此包裝表示為DIP-G(G表示玻璃密封)。
4.3SDIP(收縮雙列直插封裝)收縮DIP。 其中一種插入式封裝,形狀與DIP相同,但引脚中心距離(1.778mm)小於DIP(2.54mm),囙此稱為此。 引脚數量在14到90之間。 有兩種類型的陶瓷和塑膠。 也稱為SH-DIP(收縮雙列直插封裝)
5.翻轉晶片翻轉晶片。 裸晶片封裝科技之一是在LSI晶片的電極區域中製作金屬凸塊,然後通過壓力焊接將金屬凸塊連接到印刷基板上的電極區域。 封裝的占地面積與晶片尺寸基本相同。 它是所有包裝科技中最小、最薄的。 然而,如果基板的熱膨脹係數與LSI晶片的熱膨脹率不同,則在接合處將發生反應,這將影響連接的可靠性。 囙此,有必要使用樹脂來增强LSI晶片,並且使用具有基本上相同的熱膨脹係數的基板資料。
6.FP(扁平封裝)扁平封裝。 表面安裝包之一。 QFP或SOP的另一個名稱(參見QFP和SOP)。 一些電晶體製造商使用這個名稱。
7.H-(帶散熱器)表示帶散熱器的標記。 例如,HSOP表示帶散熱器的SOP。
8.MCM(多晶片模塊)多晶片組件。 一種封裝,其中多個電晶體裸晶片被組裝在佈線基板上。 根據基板資料,可分為三類:MCM-L、MCM-C和MCM-D。MCM-L是一種使用普通玻璃環氧多層印刷電路板的組件。 佈線密度不是很高,並且成本低。 MCM-C使用厚膜科技形成多層佈線,並使用陶瓷(氧化鋁或玻璃陶瓷)作為襯底組件,這類似於使用多層陶瓷襯底的厚膜混合IC。 兩者之間沒有明顯的區別。 佈線密度高於MCM-L。MCM-D是利用薄膜科技形成多層佈線,以陶瓷(氧化鋁或氮化鋁)或Si、Al為襯底成分。 佈線方案是三個組件中最高的,但成本也很高。