當PCB的線寬和線間距小於50μM(2mil)時,傳統的CCL減法處理(SP)幾乎是無用的。 現在,CSP或FC包層和其他IC基板的線/寬度接近15μm/15μm。在大排板的批量生產方面,只有沒有銅箔塗層的絕緣板可以被選為mSAP(半加成工藝)半加成方法的起點。
mSAP(半加成工藝)的生產工藝
內層-ABF層壓板-雷射鑽孔-化學鍍銅籽晶層-光刻膠圖案化-電解鍍銅-光刻膠去除-籽晶層蝕刻
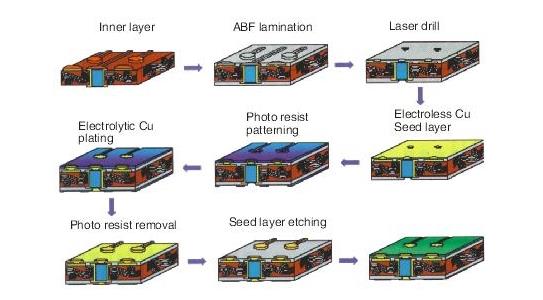
1.ABF薄資料的結構
在具有完整電路和黑色氧化處理的大型雙面(或四層)內部薄芯板(芯厚2.5mil)上,B級ABF膜板(帶有白色無銅但聚酯保護膜(聚酯薄膜,聚酯薄膜))在兩側真空壓制,然後需要在180℃下硬化30分鐘。 該ABF(味之素邦德電影)是日本公司“大雲味之素”旗下的“味之素精細科技”公司(AFT)的高價板塊。 目前有三種產品:
A、通用SH9K(Tg165℃,TMA)
B、無鹵GX-3(Tg153℃)
C、無鹵低Z膨脹大GX-13(Tg156℃)а2的Z膨脹僅為155 ppm/℃。
請注意,AFT公司不僅推出了載體類別中常見的ABF產品,還推出了軟紙板行業中ABF-XA5的2L型基材和ABF-LE-T的3L型基材。
2.IC基板真空壓膜
首先,按照傳統的多層板制造技術完成內芯板,然後將樹脂孔和整個板表面完全壓平,以便於ABF薄資料的雙面粘合。 根據Ajinomoto Fine Techno(AFT)網站上的資料,活性膜切割機切割的ABF三層資料類似於幹膜類型,然後使用真空型活性膜粘貼機。 首先,在內芯板的兩側粘貼去除了阻擋層的ABF雙層資料。 連續真空膜的溫度約為110℃,持續約30秒,然後使用熱壓床在110℃和5kgf/cm2的高壓下將膜壓平並固化60秒。 之後,可以去除聚酯(PET)透明維護膜,並且可以繼續附著的ABF膜資料的後硬化工作。 以GX13為例,它需要在180℃下再固化30分鐘(Cure)來計算附加層的完成程度。
3.mSAP雷射打孔、全板除膠
老化後ABF的膜厚約為30~70μM,薄板為30~40μM。 無銅表面的整個板材去毛刺後,整個板材表面和孔壁可以形成非常粗糙的外觀,化學銅將有助於細紋幹膜的粘附。
去除晶體載體板的膠渣的作用與普通PCB的作用沒有太大區別。 它仍然是三個站,即預溶脹、錳(Mn+7)溶膠和中和和回收。 不同之處在於,一般的PCB只處理通孔或盲孔的孔壁區域,但除了盲孔的孔壁之外,整個電路板的ABF表面需要擴展和蝕刻,以製造1μm厚的銅層(比一般PCB厚兩倍多)在外觀上更粗糙, 這使得幹膜光刻膠和電鍍銅在大面積細線操作中獲得更好的粘附性。
4.mSAP半添加法去除橡膠渣的區別
通常,多層板的除膠渣僅用於PTH或μ-通孔等孔壁,處理總面積不大。 然而,SAP方法不僅處理微盲孔壁,而且還響應於表面上沒有銅的兩個大板。 兩者之間的巨大差异不能在同一個網站上處理。 首先需要改變的是Mn+6的及時電解氧化,以保持浴液的最小效果; 二是如何去除高溫浴溶液中回收的Mn+4沉澱; 第三是如何清除強鹼儲罐液體反應生成CO2時產生的Na2CO3。 現時,還沒有很好的方法來處理諸如Mn+4和Na2CO3等固體問題,根據處理的總面積,只能倒入部分罐液。 當然,我們還應該參攷儲罐液體的比重來控制Na2CO3的總量,以確定是否需要更換新的儲罐。 由此可見,SAP的成本决不能與一般PCB脫膠渣的成本相比。
ABF薄膜資料與硬紙板的區別在於,在中和和回收後,應加入咬掉SiO2或玻璃珠等填料的過程,以新增外表面積,以確保後續銅層的附著力。 缺陷在於,板的死角顯著增加,導致隨後被咬的銅層被蝕刻形成獨立的線,而用於活化的貴金屬鈀層仍將留在板中,埋下細線之間絕緣不良的隱憂。 特別是當外部面板用一層薄薄的綠色油漆進行維護時,在高溫和高濕度環境中長期運行時難免會發生絕緣故障,甚至會導致信號完整性問題。
5.光致抗蝕劑成像前的低應力化學銅
ABF外觀完成2μm化學銅後,可以壓制和粘貼幹膜光刻膠, 然後曝光和顯影以獲得許多線和許多盲孔(18×24“板的兩側通常超過80萬個盲孔) 用於盲孔的鍍銅和銅填充。 這裡的電鍍銅等於普通PCB的二次銅,而化學銅層就像普通PCB的CCL銅箔上添加的化學銅和一次銅。
由此可見,SAP法的化學銅比一般PCB的化學銅起著更重要的作用,其厚度也需要新增到1! μM至少是平時的兩倍。 為了獲得更好的附著力,這裡的銅層還特別注意促進晶體生長和應力降低; 不僅生產速度會變慢(不到常規銅的一半),而且各種CP級化學品的成本也會新增三倍以上。 一般的HDI多層板現在買不起,只要FC載體板能勉强選擇這種高品位、低應力、單價高的化學銅。
6.幹膜成像後電鍍銅
SAP使用的鍍銅與普通HDI用於填充盲孔的鍍銅相同。 這是一種具有低縱橫比和非深孔的高速鍍銅。 換言之,它是短孔鍍銅,幾乎不關注延伸率和抗拉强度。 在ELIC主導的反復添加層和填充盲孔的市場中,這些反復高速鍍銅的主要需求是“快速”。 然而,在酸性鍍銅的有限電流密度(Jlim)的自然產生的限制下, 只要它盡可能接近銅浴中陽極和陰極之間的間隙(垂直懸掛電鍍已從20cm縮短至5~10cm,而水准行走電鍍更為迫切至2cm),銅浮子的電阻可降低至低於可用電流密度。 同時,可以通過提高浴液溫度(從20℃到40℃)來降低電阻和電流。 然而,以這種管道,不能連續使用可溶性銅球來維持陽極和陰極之間間隔的穩定性。 囙此,鈦類不溶性陽極廣泛應用於充孔鍍銅領域。 然而,不溶性陽極遭受各種氧氣灾害,特別是有機添加劑的開裂和過度使用,尤其是用量最大的載體。 囙此,浴液致命傷害的總有機化合物(TOC)正在穩步上升。 為了保持鍍銅的最低質量,我們必須按時倒入部分鍍液(每週倒入1/10的鍍液),只需補充去離子水以抑制TOC的上升。 至於鈦陽極的快速消耗和氧化銅的補償已成為成本的另外兩個負面因素。 傳統深孔慢鍍銅和新盲孔快鍍銅之間的區別取決於哪種態度。
7.mSAP蝕刻部分銅後完成線路
在完成填充盲孔和加厚線的鍍銅工藝之後,可以去除光致抗蝕劑,並且可以直接進行整體蝕刻。 現時,線路板上非線路絕緣區域的化學銅非常容易被去除,囙此線路的鍍銅層肯定會被磨損,不會受到任何不分青紅皂白的全面腐蝕,但不會損害優雅。 細紋不僅肩部油膩,底部殘留的脚也消失了。 質量更好! 這種方法稱為差分蝕刻。
8.相鄰OSP焊盤顏色异常
OSP處理的各種極板在某些電容器的兩個焊盤上通常有不同顏色的棕色。 通過可焊性測試和劣質客戶的批量生產,不存在不良焊點的問題。 然而,堅持不懈的客戶仍然在相互追逐,不斷要求真正的原因和改進。 PCB製造商也將嘗試各種方法,甚至追跡液體藥物供應商。 如果沒有任何解決方案,難免會質疑規劃和佈局是否存在問題。 他們想把球踢回客戶,以擺脫麻煩。 然而,在缺乏證據的情况下,我們不得不承認錯誤,以各種管道解决爭端。
9.mSAP銅的蝕刻定量
為了進一步瞭解OSP工藝中電鍍銅層的三個焊盤被咬掉了多少以及厚度有多大,特意使用顯微鏡軟件量測三個銅焊盤的厚度以進行比較。
除了這種微截面軟件的厚度量測外,WyCo的精細粗糙度測量儀還可以用於量測電極資料表面上標記的兩種類型的銅焊盤,從而再次證明推斷的正確性。 根據獲得的數據,獨立暗焊盤的均勻銅高度為29.1μm。互連盲孔淺色焊盤的平均銅高度為25.3μm 請注意,接下來兩張圖片中的藍色顯示了最下麵的板的外觀。 綠色是銅焊盤的高度,外側邊緣的紅色是較高的綠色油漆。
10.OSP膜的形成
清潔的銅表面首先溶解在配備有甲酸或乙酸的OSP槽溶液中的Cu+1中,該單價銅離子將立即與液體藥物中的有機物質咪唑絡合(交錯),形成棕色有機膜並逐漸變厚。 上述帶有盲孔的輕質銅焊盤咬銅速度快且猛烈,這導致其一價銅的一部分被快速氧化為藍色二價銅並進入浴液而不形成膜。 囙此,其皮膚膜的厚度不可避免地低於獨立襯墊的厚度,囙此深色和淺色之間存在强烈的對比。
這裡我們分享了在mSAP工藝中大規模生產IC基板的方法。