Bài viết này mô tả các công nghệ đóng gói COG (chip trên kính) và COF (chip linh hoạt). Với sự phát triển của công nghệ đóng gói mật độ cao, công nghệ COG và COF đã được sử dụng rộng rãi trong một loạt các màn hình phẳng và các sản phẩm di động cá nhân. Công nghệ COG và COF đã trở thành công nghệ đóng gói chính được sử dụng trong sản xuất LCD do mật độ cao, đa I/O và chủ yếu sử dụng bao bì chất kết dính dẫn điện.
[Từ khóa] COG, COF, isodirectional dẫn keo, LCD đóng gói
1 Lời mở đầu
Sự phổ biến của các thiết bị điện tử di động và màn hình lớn đã thúc đẩy sự phát triển nhanh chóng của công nghệ sản xuất điện tử chi phí thấp, mật độ cao và mật độ cao. Màn hình LCD, TV LCD, TV plasma và các sản phẩm điện tử kích thước lớn khác, điện thoại di động, máy ảnh kỹ thuật số, máy ảnh kỹ thuật số và các sản phẩm điện tử vừa và nhỏ khác, cũng như các sản phẩm 3C khác, đều có xu hướng mỏng và ngắn. Điều này đòi hỏi mật độ cao và kích thước nhỏ. Công nghệ đóng gói thế hệ mới, có thể được cài đặt tự do để đáp ứng các yêu cầu trên. Trong bối cảnh này, công nghệ COG và COF đã phát triển nhanh chóng và trở thành hình thức đóng gói chính của IC điều khiển màn hình phẳng như LCD và PDP và là một phần quan trọng của các mô-đun hiển thị này. Đồng thời, sử dụng công nghệ đóng gói keo dẫn điện đẳng hướng, lĩnh vực ứng dụng của nó đang nhanh chóng mở rộng và đã được áp dụng trong các sản phẩm vi điện tử như RFID, thiết bị điện tử y tế, điện tử cá nhân di động và các sản phẩm khác.
2 Cấu trúc của COG và COF
Tên đầy đủ của COG là chip thủy tinh, được gọi là công nghệ chip thủy tinh trong tiếng Trung Quốc. Nó đóng gói IC trực tiếp trên kính thông qua keo dẫn điện đẳng hướng (ACF), cho phép đóng gói kết nối giữa các lồi dẫn điện IC và đĩa dẫn điện trong suốt ITO trên kính. Tên đầy đủ của COF là chip-on-flex hoặc chip-on-film, là công nghệ chip trong tiếng Trung Quốc trên chất nền linh hoạt, cũng trở thành công nghệ lắp ráp màng mềm. Tương tự như công nghệ COG, chip IC được đóng gói trực tiếp trên bảng mạch in linh hoạt để đạt được mục đích mật độ đóng gói cao, giảm trọng lượng, giảm khối lượng và tự do uốn và lắp đặt.
Nếu IC, chất nền linh hoạt, bảng thủy tinh, PCB và các thành phần thụ động khác (tụ điện, điện trở, v.v.) được kết nối theo cách thích hợp (ví dụ: IC được kết nối trực tiếp với bảng thủy tinh thông qua ACF hoặc ACF được sử dụng cho chất nền linh hoạt với IC và bảng thủy tinh). Để kết nối, chất nền linh hoạt và các thành phần thụ động có thể được kết nối bằng hàn hồi lưu truyền thống, Chất nền linh hoạt và PCB có thể được kết nối bằng hàn hoặc cắm truyền thống để tạo thành mô-đun hiển thị với gói COG hoặc COF.
Bao bì COG và COF chủ yếu sử dụng chất kết dính dẫn đẳng hướng để đạt được kết nối giữa IC và chất nền thủy tinh hoặc chất nền linh hoạt, IC chủ yếu sử dụng cấu trúc chip đảo ngược. Công nghệ lồi của chip đảo ngược và quy trình lồi trên nền sẽ được giới thiệu cụ thể cho độc giả trong các bài viết trong tương lai. Sau đây chủ yếu giới thiệu các quy trình cơ bản của sản xuất linh hoạt và công nghệ quy trình kết nối ACF.
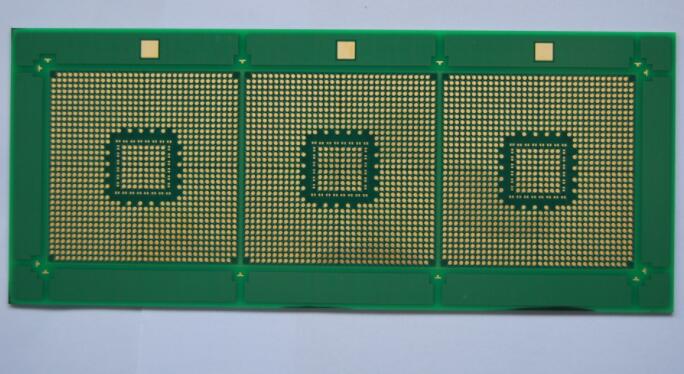
3 Sản xuất mạch tốt trên chất nền linh hoạt
Khi mật độ hiển thị của màn hình tăng lên, chip điều khiển I/O cần phải tăng lên đáng kể và khoảng cách giữa các tấm chì đã dưới 30μm. Do đó, các yêu cầu về mô hình mạch tốt cho chất nền linh hoạt cũng đang tăng lên và khoảng cách giữa các tấm kết nối đã tăng lên. Nó đã đạt đến 15 hòn đảo và tiếp tục giảm. Do đó, công nghệ sản xuất bảng mạch linh hoạt trở thành trọng tâm của nghiên cứu. Hiện nay, sản xuất mạch tốt trên chất nền linh hoạt chủ yếu bao gồm trừ, bán cộng và cộng.
3.1 Trừ
Phương pháp giảm lớp là phương pháp chính của sản xuất FPC truyền thống. Nó được dán một màng khô chống ăn mòn nhạy cảm với ánh sáng hoặc phủ một lớp chống ăn mòn nhạy cảm với ánh sáng lỏng trên FCCL, sau đó thông qua tiếp xúc, phát triển, khắc, lột và cuối cùng tạo thành mô hình mạch mong muốn. Khoảng cách chiều rộng đường có thể đạt được bằng cách trừ pha có liên quan chặt chẽ đến độ phân giải của lớp chống ăn mòn nhạy sáng. Độ phân giải của lớp chống ăn mòn nhạy sáng được xác định bởi độ dày của chất chống ăn mòn. Độ dày càng mỏng, mô hình mạch càng tinh tế có thể được hình thành trên lớp chống ăn mòn nhạy sáng. Điều này là do ánh sáng bị phân tán khi nó đi qua lớp chống ăn mòn. Lớp chống ăn mòn càng dày, mức độ tán xạ càng lớn và lỗi của các đường hình thành càng lớn. Để chiều rộng đường dưới 50μm, độ dày của màng khô phải dưới 20μm, nhưng rất khó để tạo ra màng khô quá mỏng, vì vậy mọi người thích sử dụng quy trình màng ướt mỏng hơn màng khô và có thể tự kiểm soát. Công ty thậm chí có thể sử dụng trống để phủ một chất chống ăn mòn quang học lỏng để sản xuất màng ướt 5 micron. Nhưng màng ướt quá mỏng chắc chắn sẽ xuất hiện lỗ kim, bong bóng, trầy xước và các khuyết tật khác, không đồng nhất như màng khô, vì vậy nó không thể thay thế màng khô trong thời gian ngắn. Vì những lý do trên, kết hợp với hiện tượng khắc bên không thể tránh khỏi trong quá trình khắc, chiều rộng đường giới hạn của phép trừ là 20 μm. Nếu bạn muốn có được mạch điện mỏng hơn, bạn sẽ phải làm việc với lá đồng siêu mỏng của 9, 5 và thậm chí 3 hòn đảo mỏng hơn để giảm thời gian khắc càng nhiều càng tốt, ăn mòn bên ít và có được nếp nhăn. Tuy nhiên, những lá đồng dày này và các quy trình liên quan vẫn đang trong giai đoạn thử nghiệm và không thể sản xuất hàng loạt. Chất nền của phương pháp bán cộng này chủ yếu là lá đồng mỏng 5 μm, đôi khi có thể được sử dụng với lá đồng truyền thống sau khi giảm độ mỏng bằng cách khắc. Trong phương pháp này, tán xạ ánh sáng không ảnh hưởng xấu đến mô hình mạch và có thể sử dụng lớp chống ăn mòn dày hơn để tạo mạch dưới 20 μm. Lý do để phún xạ các lớp mỏng Cr giữa PI và các lớp đồng tiếp theo là để tăng lực liên kết giữa PI và các lớp đồng và để ngăn chặn sự bong tróc tiếp theo của các lớp đồng. Phương pháp này có thể tạo ra các mạch tốt nhất hiện có với khoảng cách dây lên đến 3 Isla ¼m. Một ưu điểm khác của phương pháp này là màng khô nhạy sáng dày có thể được sử dụng để tăng độ dày của mạch, chẳng hạn như tỷ lệ độ dày và chiều rộng gấp 8 lần, có thể ức chế sự gia tăng điện trở DC (R) khi tinh chỉnh mạch. Tuy nhiên, phương pháp này đòi hỏi thiết bị sản xuất bằng chất bán dẫn, với quy trình phức tạp và chi phí tương đối cao.4 Công nghệ kết nối chip với chất nền
Hiện nay, các công nghệ kết nối cho chất nền linh hoạt và mạch tích hợp chủ yếu bao gồm kết nối eutectic Au-Sn, kết nối chất kết dính dẫn đẳng hướng và kết nối chất kết dính không dẫn điện.
4.1 Quá trình kết nối eutectic vàng-thiếc
Quá trình này sử dụng các điểm lồi vàng trên chip IC và dây dẫn bên trong FPC đóng hộp để tạo thành eutectic vàng-thiếc trên bề mặt tiếp xúc bằng cách nung nóng và điều áp để đạt được mục đích kết nối. Nhiệt độ hàn của phương pháp này phải cao hơn nhiệt độ hình thành eutectic vàng (325-330 ° C), một thử nghiệm khắc nghiệt về khả năng chịu nhiệt của cơ sở. Ngoài ra, rất khó để nắm bắt nhiệt độ hàn thích hợp. Khi nhiệt độ của phần kết nối tương đối thấp, sự hình thành eutectic của các dây dẫn bên trong là không đủ, dẫn đến việc mở các dây dẫn bên trong. Tuy nhiên, khi nhiệt độ của phần kết nối quá cao, công cụ hàn sẽ tăng lên và rời đi, trong khi eutectic vàng-thiếc vẫn ở trạng thái nóng chảy, điều này sẽ dễ dàng dẫn đến sự xuất hiện của việc mở dây dẫn bên trong. Ngoài ra, khi nhiệt độ thấp và thiếc được mạ dày trên dây dẫn bên trong, thiếc sẽ không được hấp thụ bởi vàng (không hình thành eutectic), dẫn đến ngắn mạch và rò rỉ. Điều rất quan trọng là chọn nhiệt độ phù hợp, và bây giờ nhiệt độ 400 độ C được sử dụng thường xuyên hơn.
Để đáp ứng nhu cầu liên kết khoảng cách hẹp, người ta cũng đã nghiên cứu phát triển một quá trình liên kết ép nóng giữa vàng và tiếp xúc vàng, sử dụng cơ chế khuếch tán kim loại để tạo thành các liên kết kim loại cục bộ. Tuy nhiên, do điểm nóng chảy của vàng khá cao, liên kết vàng với vàng đòi hỏi nhiệt độ liên kết cao hơn và thời gian liên kết lâu hơn so với liên kết vàng với thiếc để tạo ra sự khuếch tán. Tại thời điểm này, sự biến dạng của chất nền có thể cực kỳ nghiêm trọng. Tuy nhiên, việc sử dụng công nghệ hàn hỗ trợ siêu âm và công nghệ làm sạch bề mặt plasma có thể làm giảm hiệu quả nhiệt độ cần thiết cho hàn. Ngành công nghiệp thường tin rằng quá trình eutectic có thể đáp ứng khoảng cách giữa các đường kết nối trên 20um, nếu không sẽ dễ xảy ra ngắn mạch.
4.2 Quá trình kết nối màng keo dẫn điện đẳng hướng (ACF)
Vật liệu ACF phân tán các hạt kim loại nhỏ hoặc các quả bóng nhựa mạ kim loại trong vật liệu nhựa và tồn tại dưới dạng màng trong trạng thái giai đoạn B. Sau khi ACF được tham gia giữa các điểm lồi của IC và mạch trên bề mặt, nhựa được sử dụng áp suất, nhiệt độ và thời gian thích hợp để chảy và các hạt dẫn điện tiếp xúc với các điểm lồi và mạch trên bề mặt để đạt được độ dẫn điện. Đồng thời, do kích thước hạt dẫn điện thích hợp và lượng bổ sung được chọn, các điểm lồi và lồi không thể tiếp xúc với nhau để đạt được các đặc tính dẫn điện đẳng hướng.
Có nhiều loại ACF khác nhau trên thị trường, nhưng phổ biến nhất là các hạt nhựa mạ vàng có đường kính 3-5 angstrom, được hình thành bằng cách phân tán trong một hệ thống epoxy nhiệt rắn với mật độ 40.000-60.000/mm2. Bởi vì nhựa epoxy được chữa khỏi và co lại sau khi ép nóng, độ bền liên kết giữa IC lồi và mạch bề mặt là tốt, và các hạt dẫn điện bị ép đùn và biến dạng, lực đàn hồi kết quả làm cho các hạt dẫn điện tiếp xúc chặt chẽ hơn với giao diện trên và dưới và dẫn điện tốt hơn. Ngoài ra, vì các hạt dẫn điện có tính đàn hồi, chênh lệch áp suất do các hạt dẫn điện tạo ra có thể được bù đắp bằng lực đàn hồi của các hạt dẫn điện ngay cả khi bề mặt kết nối không bằng phẳng. Tuy nhiên, ACF có vấn đề ngắn mạch do các hạt dẫn điện và chiều rộng đường quá nhỏ dẫn đến rất ít hạt dẫn điện có thể bị bắt tại các điểm tiếp xúc, khiến nó không thể xử lý các kết nối IC có chiều rộng đường dưới 17 μm. Kết nối ACF không đáng tin cậy về điện như quy trình eutectic. Nó cũng có thể bị biến dạng do ứng suất nhiệt trong quá trình hàn hồi lưu sau đó, dẫn đến giảm độ dẫn hoặc thậm chí mở mạch. Tuy nhiên, độ tin cậy của ACF hoàn toàn có thể đáp ứng các yêu cầu miễn là các thông số khác nhau (nhiệt độ nén, áp suất, thời gian, tốc độ gia nhiệt, v.v.) trong quá trình liên kết ACF được nắm vững. Ngoài ra, quy trình ACF có nhiệt độ ép thấp (dưới 200 ° C), xử lý đơn giản, sản lượng cao và bảo vệ môi trường. Nó đã trở thành phương pháp kết nối chính của COG và COF. Đồng thời, ACF cũng là cách chính để kết nối các tấm đế và tấm kính linh hoạt.
4.3 Quá trình kết nối chất kết dính không dẫn điện (NCA)
Phương pháp tiếp xúc NCA chủ yếu dựa vào sự tiếp xúc trực tiếp của chip với các điện cực ở cả hai bên của chất nền để đạt được độ dẫn, trong khi mục đích của NCA là hoàn thành việc uốn điện cực bằng cách làm cứng và co lại nhựa và sử dụng các tính chất cơ học của nhựa để duy trì sự tiếp xúc và dẫn điện giữa các điện cực. Cần có sức mạnh đàn áp. Vai trò của vật liệu NCA là cung cấp lực liên kết giữa điểm lồi và điểm gián tiếp của mạch nền và bảo vệ các điểm tiếp xúc và duy trì độ tin cậy tốt. Do đó, vật liệu phải có các đặc tính sau: tính chất cơ học và vật lý tốt, bao gồm Tg cao, mô đun đàn hồi cao, hệ số co ngót cao và giãn nở nhiệt thấp, hiệu quả làm ướt tốt, chống ẩm, hiệu suất liên kết và chống va đập; Nó có thể được chữa khỏi trong một thời gian ngắn ở nhiệt độ cao (20 giây, 150~250 độ C); Nó có tính chất cách điện tuyệt vời. Quy trình NCA tương thích với quy trình ACF, chỉ cần thêm một đơn vị liên kết điện trước thiết bị căn chỉnh. Trong quy trình NCA, các điểm lồi và mạch nền tiếp xúc trực tiếp với cơ học và xác suất xảy ra ngắn mạch bên là rất nhỏ. Do đó, NCA có thể xử lý các kết nối IC (17 μm hoặc nhỏ hơn) nhỏ hơn khoảng cách giới hạn của các quy trình eutectic và ACF. Tuy nhiên, NCA yêu cầu vật liệu cao hơn ACF. Ví dụ, độ phẳng của chiều cao lồi chip phải tốt, bề mặt của chất nền phải rất phẳng, chất nền phải có độ ổn định kích thước cao hơn và dây kết nối phải được mạ vàng để tránh hình thành lớp oxy hóa. Độ tin cậy kết nối của NCA vẫn chưa được kiểm tra. Những yếu tố này hạn chế việc sử dụng NCA, khiến nó tạm thời không thể trở thành chương trình chính thống.
6 Kết luận
Với sự phát triển của công nghệ đóng gói mật độ cao, công nghệ COG và COF đã được sử dụng rộng rãi trong một loạt các màn hình phẳng và các sản phẩm di động cá nhân. Công nghệ COG và COF đã trở thành hình thức đóng gói chính của IC điều khiển LCD do những ưu điểm như mật độ cao, đa I/O và chủ yếu sử dụng bao bì chất kết dính dẫn điện. COF là một công nghệ đóng gói rất hứa hẹn. Do sự tiến bộ của công nghệ sản xuất mạch linh hoạt, độ bền uốn của nó cao, các thành phần thụ động có thể được thêm vào, không cần phải làm dây dẫn treo và sử dụng diện tích bảng điều khiển cao. Nó đã mở rộng sang lĩnh vực đóng gói mật độ cao ngoài bao bì LCD, kết hợp với công nghệ kết nối ACF, công nghệ COF đã trở thành hình thức đóng gói mật độ cao nhất hiện nay.