IC Encapsulation terminologie interprétation (1) 1. Affichage de contacts sphériques BGA (Ball Grid Array) dans l'un des boîtiers montés en surface. Sur la face arrière de la carte de circuit imprimé, les billes sont faites selon la méthode d'affichage. Au lieu de broches, les puces LSI sont montées sur la face avant du substrat de circuit imprimé, puis scellées avec une résine moulée ou un joint. Également appelé porte - écran convexe (PAC). Les broches peuvent dépasser 200, ce qui est un boîtier pour LSI Multi - broches. Le corps du boîtier peut également être plus petit que qfp (Quad Flat Package). Par exemple, 360 broches avec une distance de 1,5 mmbga au Centre des broches sont seulement 31mm carrés; Tandis que le qfp 304 broches avec une distance de 0,5 mm au centre de la broche est un carré de 40 mm. BGA n'est pas aussi préoccupé par la déformation des broches que qfp. Ce package a été développé par la société américaine Motorola. Il a été initialement utilisé pour les téléphones portables et d'autres appareils et sera disponible aux États - Unis à l'avenir. Il peut être promu dans les ordinateurs personnels. À l'origine, les broches BGA (surélevées) avaient une distance centrale de 1,5 mm et un nombre de broches de 225. Maintenant, certains fabricants de LSI développent également des BGA à 500 broches. Le problème avec les BGA est l'inspection visuelle après le soudage par refusion. On ne sait pas s'il existe des méthodes efficaces d'inspection visuelle. On a fait valoir qu'en raison de la grande distance de centrage de la soudure, la connexion peut être considérée comme stable et ne peut être traitée que par un contrôle fonctionnel.?? Motorola, États - Unis, appelle les boîtiers scellés avec de la résine moulée ompac, tandis que les boîtiers scellés avec la méthode de remplissage sont appelés gpac (voir ompac et gpac).
2. Bqfp (paquet plat quadrangulaire avec pare - chocs) paquet plat de goupille quadrangulaire avec rembourrage. Un des paquets qfp. Des protubérances (tampons) sont prévues aux quatre coins du corps de l'emballage pour empêcher les broches de se plier et de se déformer pendant le transport. Les fabricants américains de semi - conducteurs utilisent principalement des microprocesseurs et des ASIC dans leurs circuits. La distance au centre de la broche est de 0635 mm et le nombre de broches est d'environ 84 à 196 (voir qfp).
3. Un autre nom pour un PGA monté en surface (voir PGA monté en surface).
4.c - (céramique) indique le marquage de l'emballage en céramique. Par example, CDIP signifie céramique DIP. C'est un marqueur qui est souvent utilisé dans la pratique.
5.cerdipceramic double Encapsulation en ligne scellée avec du verre pour ECL RAM, DSP (processeur de signal numérique) et autres circuits. Withcerdip pour vitres pour micro - ordinateurs avec EPROM effaçable par UV et EPROM intégré. La distance au Centre des broches est de 2,54 mm et le nombre de broches est de 8 à 42. Au Japon, cet emballage est indiqué par DIP - G (G pour Glass Seal).
6. Cerquadone dans un boîtier monté en surface, qfp en céramique sous scellé pour encapsuler des circuits LSI logiques tels que DSP. Le port cerquad avec fenêtre est utilisé pour encapsuler le circuit EPROM. La dissipation thermique est meilleure que le qfp en plastique et peut résister à une puissance de 2 W de 1,5 ½ dans des conditions naturelles de refroidissement par air. Mais l'emballage coûte 3 à 5 fois plus cher que le plastique qfp. La distance au centre de la broche est de 1,27 mm, 0,8 mm, 0,65 mm, 0,5 mm, diverses spécifications telles que 0,4 mm. Le nombre de broches varie de 32 à 368.
7. Clcc (Ceramic Lead Chip carrier) un type de support de puce en céramique avec des broches, est l'un des boîtiers montés en surface. Les broches sortent des quatre côtés du boîtier et sont en forme de T. circuits de micro - ordinateur pour encapsuler EPROM effaçable UV et EPROM avec fenêtre. Ce paquet est également appelé qfj, qfj - G (voir qfj).
8. COB (Chip on Board) Chip on board Encapsulation est l'une des technologies de montage de puce nue. La connexion électrique de la carte est réalisée par la méthode de couture de fil, la connexion électrique entre la puce et le substrat est réalisée par la méthode de couture de fil et recouverte de résine. Bien que COB soit la technologie de montage de puce nue la plus simple, sa densité de boîtier est beaucoup moins élevée que la technologie Tab et la technologie de soudage par contre - bobinage.
9. DFP (Dual Flat Package) double face de plomb paquet plat. C'est un autre nom pour SOP (voir SOP). Il y avait ce terme dans le passé, mais il est maintenant largement utilisé.
10. DIC (Dual column inline Ceramic Packaging) Un autre nom pour la céramique DIP (y compris le joint en verre) (voir DIP).
11. Dil (Dual column inline) Un autre nom pour DIP (voir DIP). Ce nom est souvent utilisé par les fabricants européens de semi - conducteurs.
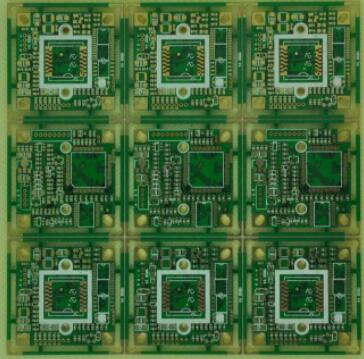
12. Double Encapsulation en ligne de colonne. L'un des boîtiers de plug - in, où les broches sortent des deux côtés du boîtier et les matériaux d'emballage sont en plastique et en céramique. DIP est le boîtier de plug - in le plus populaire, avec une gamme d'applications comprenant des circuits intégrés logiques standard, des mémoires LSI et des circuits micro - informatiques. La distance au Centre des broches est de 2,54 mm et le nombre de broches varie de 6 à 64. La largeur du boîtier est généralement de 15,2 MM. Certains boîtiers ont une largeur de 7,52 mm et les boîtiers de 10,16 mm sont appelés DIP mince et DIP mince (DIP étroit), respectivement. Mais dans la plupart des cas, il n'y a pas de différence. DIP pour faire court. En outre, la céramique DIP scellée avec du verre à bas point de fusion est également appelée cerdip (voir cerdip).
13. DSO (double petite fourrure de coton) double face plomb petit contour paquet. Un autre nom pour SOP (voir SOP). Certains fabricants de semi - conducteurs utilisent ce nom.
14. Dicp (Dual Band - loaded Package) double face de l'emballage de plomb. Un des TCP (tape Carrier packages). Les broches sont faites sur une bande isolante et sortent des deux côtés du boîtier. En raison de ses avantages, il utilise la technologie tab (soudage automatique par bande) et le boîtier a un profil très mince. Il est souvent utilisé pour les lecteurs d'affichage à cristaux liquides LSI, mais la plupart sont des produits personnalisés. En outre, le boîtier de livre LSI à mémoire de 0,5 mm d'épaisseur est en phase de développement. Au Japon, selon l'eiaj (Japan Electronic Machinery), les normes de l'Association industrielle stipulent que dicp est nommé DTP.
15. DIP (double Band - loaded Packaging) est le même que ci - dessus. Le nom standard de l'Association japonaise de l'industrie des machines électroniques est DTCP (voir DTCP).
16, FP (flat Packaging) paquet plat. Un des packages de montage en surface. Un autre nom pour qfp ou SOP (voir qfp et SOP). Certains fabricants de semi - conducteurs adoptent ce nom.
17, puce inversée puce de soudage inversée. L'une des techniques d'encapsulation à puce nue consiste à réaliser des plots métalliques dans les zones d'électrodes de la puce LSI, puis à connecter les Plots métalliques aux zones d'électrodes de la carte de circuit imprimé par soudage sous pression. L'empreinte du boîtier est sensiblement la même que la taille de la puce. La technologie d'encapsulation totale est - elle le type le plus petit et le plus mince en chirurgie? Cependant, si le coefficient de dilatation thermique du substrat est différent de celui de la puce LSI, une réaction se produit au niveau de la connexion, ce qui affecte la fiabilité de la connexion. Par exemple. Il est donc nécessaire d'utiliser une résine pour renforcer la puce LSI, Et on utilise un matériau de substrat ayant sensiblement le même coefficient de dilatation thermique.
18. Fqfp (Fine distance Quad flat Packaging) petit centre de broche distance qfp. Il s'agit généralement d'un qfp (voir qfp) dont la distance entre les centres des fils est inférieure à 0,65 MM. Certains fabricants de fils adoptent ce nom.
19. Surnom de BGA par CPAC (Global top pad Array operator) Motorola Corporation of America (voir BGA).
20, CQFP (quad fiat package with guard ring)Four-side lead flat package with guard ring. One of the plastic QFPs, the pins are masked with a resin protection ring to prevent bending and deformation.Before assembling the LSI on the printed circuit board, cut the lead from the guard ring and make it into a seagull wing shape (L shape). This packageIt has been mass-produced by Motorola in the United States. The pin center distance is 0.5mm, and the number of pins is about 208 at most.
21, H - (avec radiateur) signifie marque avec radiateur. Par exemple, hsop signifie SOP avec radiateur.
22, pin grid array (type de montage en surface) PGA monté en surface.généralement, le PGA est un type de boîtier enfichable avec une longueur de broche d'environ 3,4 mm.le PGA monté en surface dans le boîtier a des broches similaires à l'affichage au fond, la longueur varie de 1,5 mm à 2,0 mm.l'installation est réalisée par La méthode de soudage par contact avec la carte de circuit imprimé, d'où le nom de soudage bout à bout PGA. Le corps du boîtier peut être fait différemment car la distance au centre de la broche n'est que de 1,27 mm, ce qui est plus petit que la moitié d'un PGA enfichable. Avec plus de tailles et de nombres de broches que l'enfichable (250½528), il s'agit d'un boîtier pour LSI logique à grande échelle. Ce substrat d'encapsulation comporte un substrat céramique multicouche et un substrat d'impression en résine époxy de verre. L'encapsulation de substrats céramiques multicouches est entrée en application pratique.
23, jlcc (J - Lead Chip carrier) J - Pin Chip Carrier. Un autre nom pour clcc avec fenêtre et céramique qfj avec fenêtre (voir clcc et qfj). Nom adopté par le fabricant du conducteur.
24, LCC (Leadless Chip carrier) support de puce sans fil. Se réfère à un boîtier monté en surface dans lequel les quatre côtés du substrat céramique sont en contact uniquement avec les électrodes et non avec les fils. Est haute vitesse et haute fréquence IC Packaging, également appelé céramique qfn ou qfn - C (voir qfn).
25, LGA (Land Grid Array) paquet d'affichage de contact. C'est - à - dire que l'encapsulation avec les contacts d'électrodes à l'état matriciel est réalisée sur la surface inférieure. Il suffit de brancher la prise lors de l'assemblage. LGA en céramique nowpractical avec 227 contacts (1,27 mm de distance au Centre) et 447 contacts (2,54 mm de distance au Centre) pour circuits LSI logiques haute vitesse. Le LGA peut accueillir plus de broches d'entrée et de sortie dans un boîtier plus petit que le qfp. De plus, en raison de la faible impédance des fils, il est idéal pour les LSI à haute vitesse. Cependant, en raison de la complexité de la production des douilles et de leur coût élevé, elles sont maintenant largement peu utilisées. Attendez - vous à ce que ses besoins augmentent à l'avenir.
Explication des termes d'encapsulation IC (2)
26, loc (Lead - on - chip) paquet de fil sur puce. L'une des technologies d'encapsulation LSI, une structure dans laquelle l'extrémité avant du cadre de connexion est située au - dessus d'une puce qui forme des points de soudure surélevés près du Centre et utilise des coutures pour les connexions électriques. La largeur de la puce contenue dans un boîtier de même taille est d'environ 1 mm par rapport à la structure par rapport au cadre de plomb d'origine placé près des côtés de la puce.
27, lqfp (Low Profile Quad plane Package) mince qfp. Se réfère à qfp avec une épaisseur de corps d'encapsulation de 1,4 mm, qui est un nouveau type de qfp développé par l'Association japonaise de l'industrie des machines électroniques.
28, L - quadone céramique qfp. Le Nitrure d'aluminium utilisé pour encapsuler le substrat a une conductivité thermique 7 - 8 fois supérieure à celle de l'alumine et une meilleure dissipation thermique. Le cadre de l'encapsulation est en alumine et la puce est scellée par Encapsulation, ce qui réduit les coûts. Est un package développé pour Logic LSI qui permet la puissance W3 dans des conditions naturelles de refroidissement par air. 208 broches (0,5 mm de distance au Centre) et 160 broches (0,65 mm de distance au Centre) LSI Logic packages et la production de masse a commencé en octobre 1993.