Pour plus d'informations sur les capacités techniques du substrat IC, cliquez sur télécharger la fiche de données sur les capacités technologiques pour télécharger le document. Si vous avez des questions, veuillez nous contacter.
À propos du substrat IC, Cliquez sur: Substrat IC
Si vous avez des difficultés avec la conception du substrat, Veuillez cliquer pour télécharger les règles de conception du substrat IC: ![]()
Ou contactez l'Ingénieur de l'IPCB pour obtenir de l'aide par courriel: eng-ic@ipcb.com
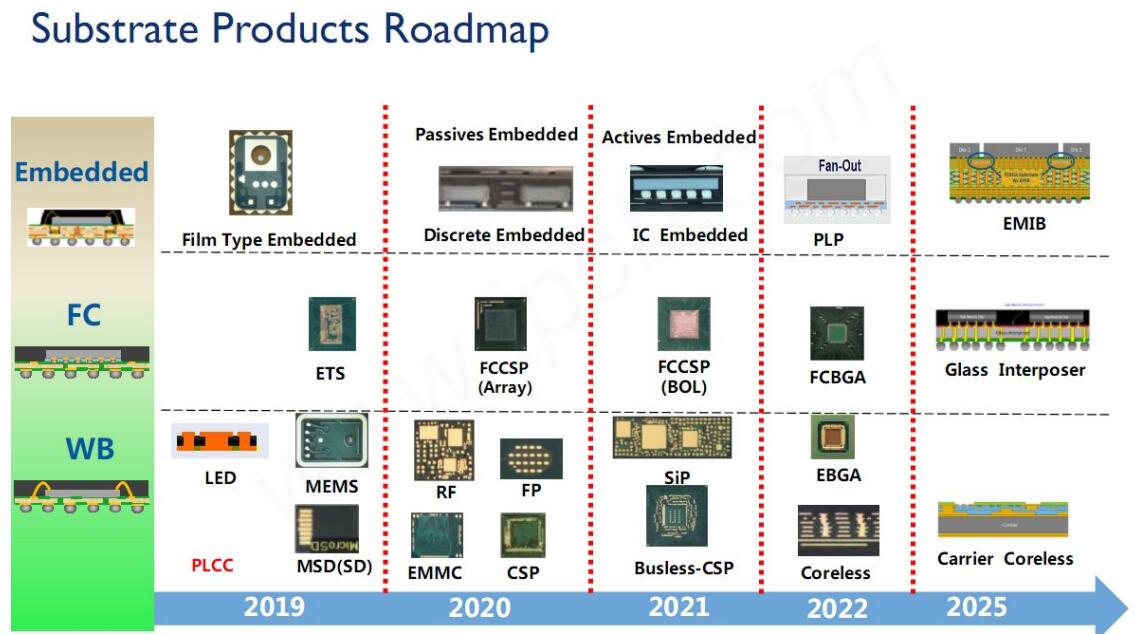

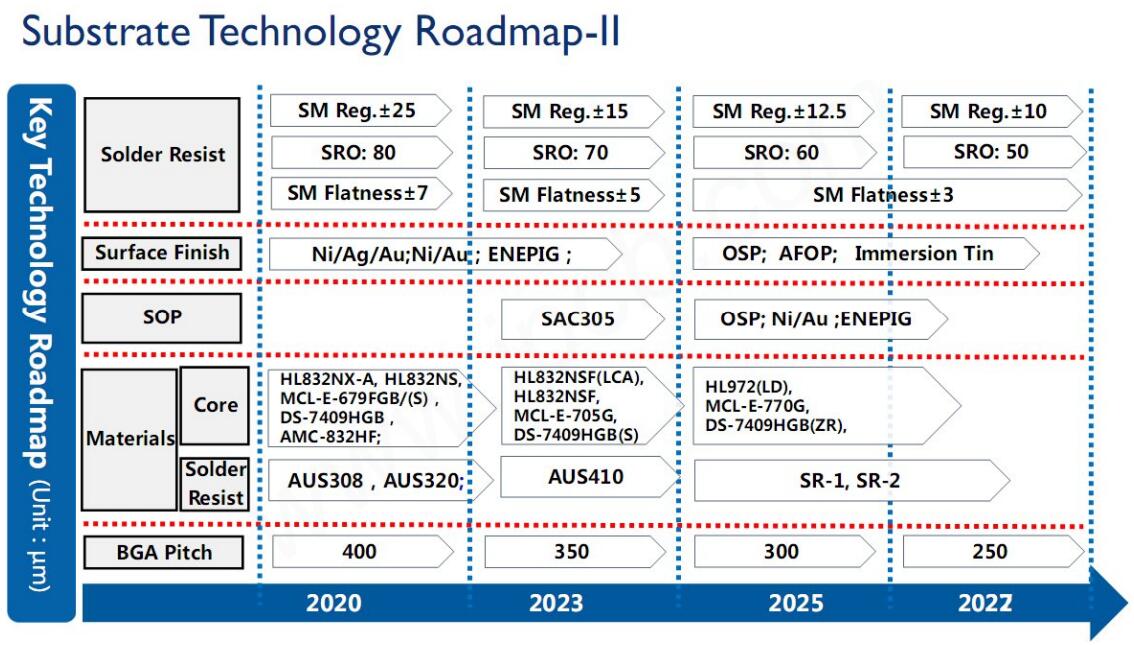
Substrat d'emballage du système (SIP)
Le système d'emballage est une plate - forme de système qui assemble plusieurs puces hétérogènes, éléments de détection et éléments passifs en un seul paquet. Ses applications comprennent le module à puces multiples (MCM), l'emballage à puces multiples (MCP), l'emballage à puces empilées, l'emballage en milieu d'emballage (PIP) et le support de composants embarqués. Le système encapsulé fournit aux concepteurs de systèmes de circuits intégrés une solution d'intégration de fonctions informatiques en plus du système à puce (SOC). Il a l'avantage d'intégrer des puces hétérogènes provenant de différentes sources, plus petites et plus minces, et d'entrer rapidement sur le marché.
SIP peut être un module multi - puces (module multi - Puces; MCM) Plan 2D package, ou peut réutiliser la structure d'emballage 3D pour réduire efficacement la zone d'emballage, sa technologie de liaison interne peut être pure Lead Bond (Lead bond), peut également utiliser la puce flip, mais les deux peuvent également être utilisés en combinaison. En plus des structures d'emballage 2D et 3D, une autre façon d'intégrer les composants dans un substrat multifonctionnel peut également être incluse dans le champ d'application du sip. La technologie intègre principalement différents composants dans un substrat multifonctionnel et peut également être considérée comme un concept SIP pour réaliser l'intégration fonctionnelle. Différentes configurations de puces et différentes techniques d'assemblage interne permettent aux types de paquets SIP de produire de nombreuses combinaisons. L'IPCB peut être personnalisé ou fabriqué de manière flexible en fonction des besoins du client ou du produit.
Substrat encapsulé en réseau à billes en plastique (PBGA)
Il s'agit du substrat de base du réseau sphérique pour la liaison et l'encapsulation des fils. Le matériau de base est une feuille de cuivre imprégnée de fibre de verre. Le substrat d'emballage en réseau à billes en plastique peut être utilisé pour l'emballage des puces avec un nombre relativement élevé de broches. Au fur et à mesure que la fonction de la puce est mise à niveau, avec l'augmentation du nombre de broches de sortie / entrée, la structure d'encapsulation traditionnelle du cadre de plomb devient insuffisante, tandis que le substrat d'encapsulation du réseau à billes en plastique fournit une solution rentable.
Plaque de base d'emballage à puce inversée (fccsp)
La puce semi - conductrice n'est pas reliée au substrat par liaison de plomb, mais est interconnectée au substrat par des bosses à l'état de la puce flip, de sorte qu'elle est appelée fccsp (Flip Chip Scale Package). L'encapsulation de la taille de la puce Flip montrera un avantage supplémentaire sur le plan des coûts. Dans le passé récent, les coûts de traitement des bosses sur les puces ont également diminué, ce qui a entraîné une réduction rapide des coûts d'emballage. L'encapsulation de la taille de la puce inversée est devenue un IC à haut nombre de broches.
Plaque de base encapsulée à grille à billes à puce inversée (fcbga)
Le substrat FC - BGA (Flip Chip Ball Grid Array) est une sorte de substrat semi - conducteur haute densité qui peut réaliser la haute vitesse et la multifonction de la puce LSI. Les réseaux de grilles à billes à puce Flip offrent d'excellentes performances et des avantages financiers dans les paquets avec un nombre très élevé de broches de sortie / entrée, comme les microprocesseurs ou les processeurs d'image.
Si vous avez besoin d'un substrat IC, n'hésitez pas à contacter l'IPCB par courriel: sales@ipcb.com
|
Substrat SIP IC |
BGA IC Baseboard |
Plaque de base du paquet emmc |