Comment réduire les vides de soudage et les défauts de diverses puces IC sur la carte de circuit imprimé PCBA après avoir introduit le soudage de l'électronique matérielle PCBA dans le processus sans plomb, le processus de soudage a des défauts et des défauts spécifiques au soudage sans plomb en raison des caractéristiques de la soudure sans plomb, telles que le Point de fusion élevé, la mauvaise mouillabilité, la fenêtre de processus étroite, etc. Par exemple, des perles d'étain et des points de soudure. Rugosité, soudure par fuite, moins d'étain et cavités. Il est bien connu que des vides se forment lors du soudage de grandes pièces plates et de faible hauteur, telles que des pièces qfn. L'utilisation de ces types de composants augmente. Afin d'atteindre la norme IPC, la formation d'un vide provoque des maux de tête chez de nombreux concepteurs de cartes PCB, les fonderies EMS de soudage PCBA et le personnel de contrôle de la qualité. Les paramètres qui optimisent les propriétés des vides sont généralement la composition chimique de la pâte à souder, le profil de température de reflux, le revêtement du substrat et de l'assemblage, et la conception optimisée des plots et des pochoirs SMT. Cependant, en pratique, il existe des limites évidentes à la modification de ces paramètres. Malgré de nombreuses optimisations, il arrive souvent que le taux de vide soit trop élevé. La cause sous - jacente des vides de soudure est que l'air ou les gaz volatils enveloppés dans la pâte à souder ne sont pas complètement évacués après sa fusion. Les facteurs d'influence comprennent le matériau de pâte à souder, la forme d'impression de pâte à souder, la quantité d'impression de pâte à souder, la température de reflux, le temps de reflux, la taille de la soudure, la structure, etc. Type de technologie d'emballage de puce d'IC: LGA, PGA, BGA
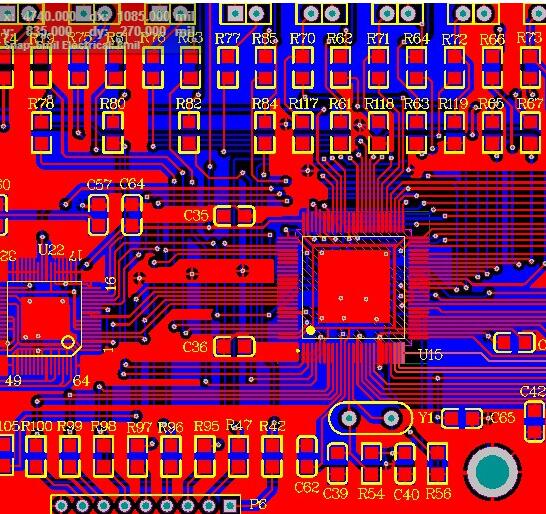
En tant qu'ingénieur SMT dans l'industrie de la fabrication électronique, il est difficile d'analyser et d'améliorer le processus sans maîtriser le processus d'assemblage de surface SMT. Avant de comprendre le processus d'assemblage, vous devez maîtriser la structure d'encapsulation des composants montés en surface. La structure d'encapsulation et le processus d'assemblage ont été analysés en détail. Puce IC et composants électroniques structure d'encapsulation SMT composants montés en surface type d'encapsulation classification les composants montés en surface (SMd) sont des objets montés en surface. Comprendre la structure d'encapsulation de SMD est important pour optimiser le processus SMT. La structure d'encapsulation de SMD est la base de la conception du processus. Donc, ici, nous ne classons pas par le nom de l'emballage, mais par la structure des broches ou des extrémités soudées. Selon cette division, le boîtier SMD comprend principalement des composants de puce (puces), des broches en forme de J, des broches en forme de l, des BGA, des BTC et des pièces moulées. Boîtier BGA (Ball Grid Array) qui, selon sa structure, comprend principalement un boîtier en plastique BGA (P - bga), une puce inversée BGA (F - bga), une bande porteuse BGA (t - bga) et une céramique BGA (C - bga) de quatre classes. Les dispositifs de terminaison de soudage par le bas BTC sur le pavé sont largement utilisés, tels que les dispositifs spéciaux tels que les dispositifs à matrice sphérique (BGA / CSP / WLP / POP) et qfn / LLP. BTC est encapsulé dans les boîtiers BTC répertoriés dans IPC - 7093. Il existe qfn (Quad flat no Lead Package), son (smalloutline no Lead), DFN (Dual flat no Lead), LGA (Land Grid Array), mlfp (micro leadframe Package). Parmi eux, qfn est un boîtier sans fil qui est carré ou rectangulaire. Au Centre du fond du boîtier se trouve un grand Plot exposé pour la conduction thermique et la connexion électrique est réalisée par un grand Plot à la périphérie du boîtier. Parce qu'il n'y a pas de fils, la zone d'installation est inférieure à qfp et la hauteur est inférieure à qfp. Couplé à d'excellentes propriétés électriques et thermiques, ce boîtier est de plus en plus utilisé dans l'industrie électronique. Qfn radiateur pad contrôle des vides est un problème dans le processus de soudage qfn et l'un des problèmes qui existent dans l'industrie. Comme les boîtiers de petite taille sont de plus en plus capables de transporter des puces de haute puissance, les boîtiers de composants terminaux inférieurs tels que qfn deviennent de plus en plus importants. Avec les exigences croissantes en matière de performance de fiabilité, il est essentiel d'optimiser les performances thermiques et électriques des composants de gestion de l'alimentation dans des boîtiers tels que qfn. De plus, afin de maximiser la vitesse et les performances RF, la réduction des vides est importante pour réduire le chemin de courant du circuit. Avec la réduction de la taille des boîtiers et l'augmentation des besoins en énergie, le marché doit réduire les vides sous les coussins thermiques des composants qfn. Par conséquent, il est nécessaire d'évaluer les facteurs de processus clés qui créent des vides et de concevoir la meilleure solution. L'emballage qfn a d'excellentes propriétés thermiques, principalement grâce à la grande surface de coussinets Dissipateurs de chaleur au fond de l'emballage. Afin de conduire efficacement la chaleur de la puce au PCB, le fond du PCB doit être conçu avec des coussinets de dissipation de chaleur et des trous de dissipation de chaleur correspondants. Les tapis Dissipateurs de chaleur fournissent une zone de soudage fiable et les trous traversants fournissent un moyen de dissiper la chaleur. Ainsi, lorsque les Plots exposés au fond de la puce sont soudés à des plots chauds sur le PCB, le gaz dans la pâte à souder sur les pores chauds et les plots de grande taille peut déborder, provoquant certains trous d'air. Pour le procédé SMT, il est pratiquement impossible d'éliminer ces pores en ce qui concerne les grandes cavités. La seule façon de réduire les pores est de les minimiser. Le nom complet de LGA est "land Grid Array", ou "Planar Grid Array Package", c'est - à - dire que l'encapsulation des contacts d'électrodes à l'état matriciel est faite sur la surface inférieure. Sa forme est très similaire à celle d'un élément BGA, car ses dimensions de Plots sont plus grandes que celles d'une bille BGA. Le diamètre est environ 2 à 3 fois plus grand et il est également difficile de contrôler les vides. Comme pour les composants qfn, l'industrie n'a pas établi de normes de processus pertinentes, ce qui a causé des problèmes dans une certaine mesure à l'industrie de l'usinage électronique. Le nom complet de BGA est connu sous le nom de "Ball Grid Array", ou "Ball Grid Array Packaging". Actuellement, cette méthode d'encapsulation est utilisée par la grande majorité des processeurs mobiles Intel, par exemple tous les processeurs Intel se terminant par H, HQ, U, y, etc. (y compris, mais sans s'y limiter, les basses tensions). BGA peut être un produit extrême de LGA et PGA, contrairement à leurs caractéristiques qui peuvent être remplacées à volonté. Une fois le BGA emballé, il est impossible pour un joueur moyen de le démonter et de le remplacer de la manière normale, mais parce qu'il est fait en une seule fois., Ainsi, BGA peut faire de plus en plus court.les principaux défauts des points de soudure de la puce BGA sont: cavités, desoudage (circuit ouvert), pontage (court - circuit), fissures à l'intérieur des billes de soudure, perturbation des points de soudure, soudage à froid, les billes de soudure ne sont pas complètement fondues et déplacées (les billes de soudure ne sont pas alignées avec les plages de PCB), les billes de soudure, etc.