Questo manoscritto introduce le tecnologie di imballaggio COG (chip on glass) e COF (chip on flex). Con lo sviluppo della tecnologia di imballaggio ad alta densità, le tecnologie COG e COF sono state ampiamente utilizzate in vari display a schermo piatto e prodotti mobili personali. Le tecnologie COG e COF sono diventate la principale tecnologia di imballaggio utilizzata nella produzione LCD a causa della loro alta densità, I/O multipli e principalmente utilizzando imballaggi adesivi conduttivi.
COG, COF, adesivo conduttivo anisotropico, pacchetto LCD
1 Prefazione
La diffusione dei prodotti elettronici mobili e dei display a grande schermo ha promosso il rapido sviluppo della tecnologia di produzione elettronica a basso costo, ad alta densità e ad alta densità. I prodotti elettronici di grandi dimensioni come monitor LCD, TV LCD, televisori al plasma, prodotti elettronici di piccole e medie dimensioni come telefoni cellulari, fotocamere digitali, videocamere digitali e altri prodotti 3C stanno tutti tendendo verso leggerezza, sottigliezza e brevità. Ciò richiede alta densità e piccole dimensioni. Una nuova generazione di tecnologia di imballaggio che può essere installata liberamente per soddisfare le esigenze di cui sopra. In questo contesto, le tecnologie COG e COF si sono sviluppate rapidamente, diventando una forma di imballaggio importante di IC driver per display a schermo piatto come LCD e PDP, e quindi diventando una parte importante di questi moduli di visualizzazione. Allo stesso tempo, con la tecnologia di imballaggio adesivo conduttivo anisotropico, i suoi campi di applicazione si stanno rapidamente espandendo e sono stati applicati in RFID, apparecchiature elettroniche mediche, prodotti elettronici personali mobili e altri prodotti micro elettronici.
2 La struttura del COG e del COF
Il nome completo di COG è chip su vetro e in cinese è chiamato chip su tecnologia di vetro. Incapsula direttamente l'IC sul vetro attraverso adesivo conduttivo anisotropico (ACF) e realizza l'interconnessione e l'incapsulamento di urti conduttivi IC e pad conduttivi trasparenti ITO sul vetro. Il nome completo di COF è chip su flex o chip su film, che è la tecnologia del chip su substrati flessibili in cinese e diventa anche la tecnologia di assemblaggio del film morbido. Simile alla tecnologia COG, il chip IC è imballato direttamente sul circuito stampato flessibile per raggiungere lo scopo di alta densità di imballaggio, riduzione del peso, riduzione del volume e libertà di piegarsi e installare.
Se il IC, il substrato flessibile, il pannello di vetro, il PCB e altri componenti passivi (condensatori, resistenze, ecc.) sono collegati in modo appropriato (come il IC direttamente collegato al pannello di vetro tramite ACF, o il substrato flessibile e il IC e il pannello di vetro usano ACF) Per il collegamento, il substrato flessibile e i componenti passivi possono essere collegati tramite saldatura tradizionale a riflusso, e il substrato flessibile e PCB possono essere collegati tramite saldatura tradizionale o spina) per formare un modulo di visualizzazione con imballaggio COG o COF.
Gli imballaggi di COG e COF utilizzano principalmente l'adesivo conduttivo anisotropico per realizzare l'interconnessione tra IC e substrato di vetro o substrato flessibile e l'IC adotta principalmente la struttura del chip flip. La tecnologia di urto del flip-chip e la tecnologia di urto sul substrato saranno specificamente introdotti ai lettori in futuri articoli speciali. Quanto segue introduce principalmente la tecnologia di base flessibile di produzione e di processo di interconnessione ACF.
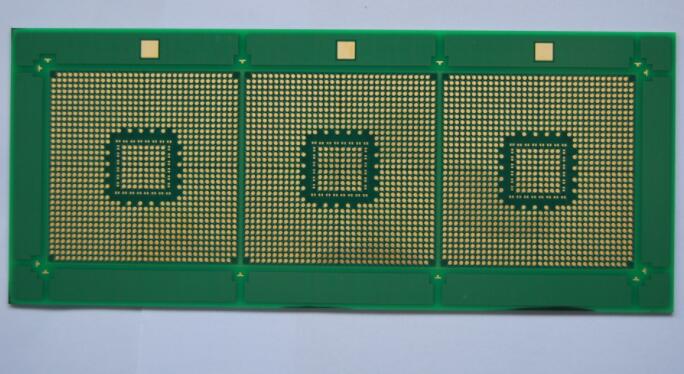
3 Produzione di circuiti sottili su substrati flessibili
Man mano che la densità del display aumenta, l'I/O del chip driver deve aumentare notevolmente e il passo tra i pad di piombo è stato inferiore a 30μm. Pertanto, anche i requisiti per i modelli di circuito fine dei substrati flessibili stanno aumentando e la spaziatura dei pad di interconnessione è stata aumentata. Ha raggiunto i 15μm e continua a diminuire. Pertanto, la tecnologia di produzione dei circuiti stampati flessibili è diventata il fulcro della ricerca. Attualmente, la produzione di circuiti sottili su substrati flessibili comprende principalmente metodi sottrattivi, semi-additivi e additivi.
3.1 Metodo stratificato
Il metodo dello strato sottrattivo è il metodo principale della produzione tradizionale di FPC. È incollare uno strato di pellicola secca fotosensibile resistente o rivestimento di uno strato di resistenza fotosensibile liquida sul FCCL e quindi attraverso esposizione, sviluppo, incisione, stripping e infine formare il modello di circuito richiesto. L'altezza della larghezza della linea che può essere raggiunta con il metodo sottrattivo è strettamente correlata alla risoluzione dello strato fotosensibile di resistenza. La risoluzione dello strato fotosensibile di resistenza è determinata dallo spessore dello strato di resistenza. Più sottile è lo spessore, più sottili modelli di circuito possono essere formati sullo strato di resistenza fotosensibile. Questo perché la luce si disperderà quando passa attraverso lo strato di resistenza. Più spesso è lo strato di resistenza, maggiore è il grado di dispersione e maggiore è l'errore della linea formata. Per realizzare una larghezza di linea inferiore a 50μm, lo spessore del film secco deve essere inferiore a 20μm, ma è molto difficile produrre un film secco che è troppo sottile, quindi le persone sono più disposte a utilizzare un processo di film umido che è più sottile del film secco e può essere controllato da sé. L'azienda può anche utilizzare un rullo per rivestire photoresist liquido per produrre una pellicola bagnata da 5μm. Ma la pellicola bagnata troppo sottile avrà inevitabilmente difetti come fori di spillo, bolle, graffi e la sua uniformità non è buona come la pellicola asciutta, quindi non può sostituire la pellicola asciutta a breve termine. A causa delle ragioni di cui sopra, insieme all'inevitabile fenomeno di incisione laterale durante l'incisione, la larghezza limite della linea del metodo sottrattivo è di 20μm. Se si desidera ottenere un circuito più sottile, è necessario collaborare con fogli di rame ultrasottili 9μm, 5μm o anche 3μm, in modo da abbreviare il più possibile il tempo di incisione, ridurre la corrosione laterale e ottenere linee sottili. Tuttavia, questi spessi fogli di rame e processi correlati Tutti sono ancora in fase sperimentale e non possono essere prodotti in serie.3.2 Metodo dello strato semi-additivo Se si desidera creare un circuito più raffinato, è possibile prendere in considerazione l'utilizzo del metodo dello strato semi-additivo. Questo materiale di base del metodo semi-additivo è per lo più una lamina di rame sottile di 5 μ m, e talvolta la lamina di rame convenzionale può essere utilizzata dopo essere stata diluita mediante incisione [9]. In questo metodo, la dispersione della luce non ha effetti negativi sul modello del circuito e uno strato di resistenza più spesso può essere utilizzato per rendere il circuito al di sotto di 20μm.3.3 Metodo dello strato additivo Il metodo di aggiunta dello strato è un metodo in cui un substrato isolante viene elaborato direttamente per formare un modello del circuito. Il motivo per la spruzzatura di uno strato sottile di Cr tra il PI e lo strato di rame successivo è quello di aumentare la forza di legame tra il PI e lo strato di rame e impedire che lo strato di rame successivo si stacca. Questo metodo può produrre i circuiti più fini attualmente disponibili, con una spaziatura di linea fino a 3μm. Un altro vantaggio di questo metodo è che un film secco fotosensibile può essere utilizzato per aumentare lo spessore del circuito, come un rapporto spessore-larghezza di 8 volte, che può sopprimere l'aumento della resistenza CC (R) quando il circuito è raffinato. Tuttavia, questo metodo richiede l'uso di apparecchiature per la produzione di semiconduttori e il processo è complicato e il costo è relativamente alto.4 Tecnologia di interconnessione di chip e substrato
Attualmente, le tecnologie di interconnessione di substrati flessibili e IC includono principalmente l'interconnessione eutettica Au-Sn, l'interconnessione adesiva conduttiva anisotropica e l'interconnessione adesiva non conduttiva.
4. 1 processo di connessione eutettica in oro-stagno
Questo processo utilizza gli urti d'oro sul chip IC e i cavi interni stagnati FPC per formare un eutettico oro-stagno sulla superficie di contatto attraverso il riscaldamento e la pressione per raggiungere lo scopo del collegamento. La temperatura di saldatura di questo metodo deve essere superiore alla temperatura di formazione del gold-tin eutettic (325-330°C), che è un test severo per la resistenza al calore del substrato. Inoltre, la temperatura di saldatura corretta è difficile da afferrare. Quando la temperatura della parte di collegamento è relativamente bassa, la formazione eutettica del cavo interno è insufficiente, con conseguente circuito aperto del cavo interno. Tuttavia, quando la temperatura della parte di collegamento è troppo alta, lo strumento di saldatura aumenterà e partirà mentre l'eutettico di stagno d'oro è ancora in uno stato fuso, il che porterà facilmente al verificarsi del circuito aperto interno del piombo. Inoltre, quando la temperatura è bassa e la placcatura di stagno sui cavi interni è più spessa, lo stagno non sarà assorbito dall'oro (nessuna formazione eutettica), che causerà cortocircuiti e perdite. È molto importante scegliere una temperatura adatta, e ora la temperatura di 400 gradi Celsius è più frequentemente utilizzata.
Al fine di soddisfare le esigenze di incollaggio a passo più stretto, le persone hanno anche studiato e sviluppato un processo di incollaggio a compressione calda dei contatti oro-oro, utilizzando meccanismi di diffusione del metallo per formare legami metallici locali. Tuttavia, poiché il punto di fusione dell'oro è abbastanza alto, per formare diffusione, l'incollaggio oro-oro richiede una temperatura di incollaggio più elevata e un tempo di incollaggio più lungo rispetto all'incollaggio oro-stagno. In questo momento, la deformazione del substrato può essere estremamente grave. Tuttavia, l'uso della tecnologia di saldatura assistita ad ultrasuoni e della tecnologia di pulizia delle superfici al plasma può ridurre efficacemente la temperatura richiesta per la saldatura. L'industria generalmente ritiene che il processo eutettico possa soddisfare la spaziatura di linea di più di 20um connessioni, altrimenti i cortocircuiti sono inclini a verificarsi.
4.2 Processo di connessione del film adesivo conduttivo anisotropico (ACF)
Il materiale ACF disperde particelle sottili di metallo o sfere di plastica placcate in metallo in un materiale resina ed esiste sotto forma di un film allo stato dello stadio B. Dopo aver legato l'ACF tra gli urti del IC e il circuito sul substrato, utilizzare pressione, temperatura e tempo appropriati per rendere il flusso della resina e le particelle conduttive contatto gli urti e il circuito sul substrato per ottenere la conduzione elettrica. Allo stesso tempo, a causa della selezione di una dimensione conduttiva appropriata delle particelle e quantità di aggiunta, i dossi e dossi non possono entrare in contatto l'un l'altro per raggiungere le caratteristiche di conduzione anisotrope.
Esistono vari tipi di ACF sul mercato, ma i più comunemente utilizzati sono i pellet di plastica placcati in oro con un diametro di 3-5μm, che si formano disperdendo in un sistema di resina epossidica termoindurente con una densità di 40.000-60.000 pz/mm2. Poiché la resina epossidica cura e si restringe dopo la pressatura a caldo, la forza di legame tra gli urti IC e il circuito del substrato è buona, le particelle conduttive sono schiacciate e deformate e la forza elastica risultante rende le particelle conduttive a contatto più stretto con le interfacce superiori e inferiori e la conducibilità è migliore. Inoltre, poiché le particelle conduttive sono elastiche, anche se la superficie di collegamento non è molto piana, la differenza di pressione generata dalle particelle conduttive può essere compensata dalla forza elastica delle particelle conduttive. Tuttavia, ACF ha problemi di cortocircuito a causa di particelle conduttive, e una larghezza di linea troppo piccola si traduce in pochissime particelle conduttive che possono essere catturate ai contatti, rendendolo incapace di far fronte alle connessioni IC con larghezza di linea inferiore a 17μm. L'affidabilità elettrica del collegamento ACF non è buona come il processo eutettico. Nel successivo processo di saldatura a riflusso, può anche essere deformato a causa di sollecitazioni termiche, con conseguente diminuzione della conducibilità elettrica o addirittura un circuito aperto. Tuttavia, finché i vari parametri del processo di incollaggio ACF (temperatura di compressione, pressione, tempo, velocità di riscaldamento, ecc.) sono padroneggiati, l'affidabilità di ACF può soddisfare pienamente i requisiti. Inoltre, il processo ACF ha bassa temperatura di pressatura (sotto 200 ° C), elaborazione semplice, rendimento elevato e protezione dell'ambiente. È diventato il principale metodo di interconnessione di COG e COF. Allo stesso tempo, ACF è anche il modo principale per collegare substrati flessibili e pannelli di vetro.
4.3 Processo di collegamento adesivo non conduttivo (NCA)
Il metodo di incollaggio NCA si basa principalmente sul contatto diretto tra il chip e gli elettrodi su entrambi i lati del substrato per ottenere la conduzione elettrica, mentre lo scopo di NCA è quello di completare la crimpatura dell'elettrodo mediante l'indurimento e la contrazione della resina e utilizzare le proprietà meccaniche della resina per mantenere il contatto e la conduzione tra gli elettrodi. La forza oppressiva necessaria. Il ruolo del materiale NCA è quello di fornire la forza di legame tra gli urti e i punti indiretti del circuito del substrato e di proteggere i contatti e mantenere una buona affidabilità. Pertanto, il materiale deve avere le seguenti caratteristiche: buone proprietà meccaniche e fisiche, tra cui alto Tg, alto modulo elastico, alto coefficiente di restringimento e basso coefficiente di espansione termica, buon effetto bagnante, proprietà impermeabili, proprietà adesive e resistenza agli urti; può essere curato in breve tempo ad alta temperatura (20sec, 150 ~ 250 gradi Celsius); ha eccellenti proprietà di isolamento elettrico. Il processo NCA è compatibile con il processo ACF, basta aggiungere l'unità elettroadesiva davanti all'apparecchiatura di allineamento. Nel processo NCA, gli urti e il circuito del substrato sono in contatto meccanico diretto e la probabilità di cortocircuito laterale è molto piccola. Pertanto, NCA può gestire connessioni IC (17μm o meno) che sono più piccole del passo limite dei processi eutettici e ACF. Tuttavia, NCA ha requisiti più elevati per i materiali rispetto all'ACF. Ad esempio, la planarità dell'altezza dell'urto del chip deve essere buona, la superficie del substrato deve essere molto piana, il materiale di base deve avere una maggiore stabilità dimensionale e le linee di collegamento devono essere galvanizzate con oro per evitare la formazione di strati di ossido. L'affidabilità della connessione dell'ANC deve ancora essere esaminata. Questi fattori hanno limitato l'uso delle ANC, rendendole temporaneamente incapaci di diventare un processo tradizionale.
6 Conclusione
Con lo sviluppo della tecnologia di imballaggio ad alta densità, le tecnologie COG e COF sono state ampiamente utilizzate in vari display a schermo piatto e prodotti mobili personali. Le tecnologie COG e COF sono diventate la forma di imballaggio principale dei driver IC LCD a causa dei loro numerosi vantaggi come ad alta densità, I/O multipli e principalmente utilizzando imballaggi adesivi conduttivi. COF è una tecnologia di imballaggio molto promettente. A causa dell'avanzamento della tecnologia di produzione di circuiti flessibili, la sua resistenza alla flessione è elevata, i componenti passivi possono essere aggiunti, non c'è bisogno di fare cavi sospesi e il tasso di utilizzo dell'area del pannello è alto. È stato esteso al campo degli imballaggi ad alta densità diversi dagli imballaggi LCD, combinato con la tecnologia di interconnessione ACF, la tecnologia COF è diventata una forma di imballaggio con la più alta densità di imballaggio attualmente.