小型化高密度包装の出現, 高速の必要条件 PCBボード そして、高精度アセンブリは、より重要になりました, そして、関連したアセンブリ装置およびプロセスは、より進歩して、フレキシブルになりました. フリップチップは、より小さいフォームファクタを有する, BGAまたはCSPより小さいボール直径とボールピッチ, それはボール配置プロセスの前例のない可能性を提供しています, 基板技術, 互換性, 製造工程, 検査装置及び検査方法. チャレンジ. 現代, 電子機器の小型化・高密度実装形態がますます多くなっている, such as multi-module packaging (MCM), システムインパッケージ (SiP), flip-chip (FC, Flip-Chip) and other applications. これらの技術の出現は、さらに、パッケージングと二次組立体の間のラインをぼやけた. 確かに, 小型化高密度包装の出現, 高速・高精度組立の要求事項はますます重要になっている, そして、関連したアセンブリ装置およびプロセスは、より進歩して、フレキシブルになりました. フリップチップは、より小さいフォームファクタを有する, BGAまたはCSPより小さいボール直径とボールピッチ, それはボール配置プロセスの前例のない可能性を提供しています, 基板技術, 互換性, 製造工程, 検査装置及び検査方法. チャレンジ. These requirements are analyzed in detail below:
1. 据付圧力制御の必要条件, PCB用フリップチップ基板が比較的脆いシリコンであることを考える, 材料再生とフラックス浸漬の過程で大きな圧力が加えられるならば, 割れやすい, 同時に、このプロセスの間、小さな半田バンプも容易に変形する, したがって、比較的低い装着圧力を使用しようとする. 一般的な要件は約150 gです. 超薄型チップ用, 0など.3 mm, 時には、取付圧力も35 gで制御する必要があります.
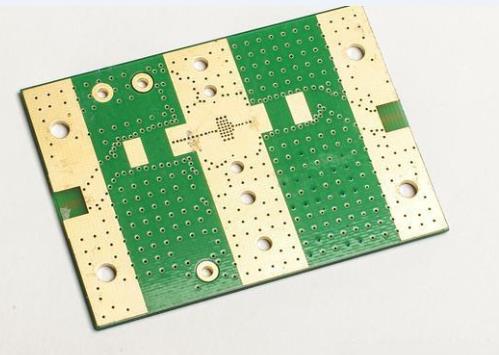
2. 配置精度と安定性の要件, ボールピッチが0と小さいデバイスについて.1 mm, 高い歩留まりを達成するためにはどのような配置精度が必要である? 基板の反りと変形, はんだマスク窓の大きさと位置のずれ, そして、マシンの精度は、すべて最終的な配置精度に影響を与える. 基板設計と製造が配置に及ぼす影響について議論しない, しかし、ここでは、マシンの配置精度を議論するだけです.
3. 配置装置のチップ組立プロセスの必要条件, 上記の質問に答えるために, let's build a simple hypothetical model:
1) Assume that the solder bumps of the flip-chip PCBボード 球形, and the corresponding pads on the substrate are circular and have the same diameter;
2) It is assumed that there is no influence of substrate warpage and manufacturing defects;
3) Does not consider the effects of Theta and shock;
4) During the reflow soldering process, 装置は自重である, はんだボールと濡れた表面との間の接触の50 %は、はんだ付けプロセス中に「プルアップ」することができる. Then, 上記の仮定に基づきます, 直径25 mm×1 , 000 mの半田ボールの直径が50, the left and right position deviation (X axis) or the front and rear position deviation (Y axis) is 50% of the pad size. ボールは常にパッドにある. フリップチップ用 PCBボードハンダボール直径25, プロセス能力CPKが1に達するならば.33, マシンの精度は12.
4. カメラと画像処理技術の要求に応じて, フリップチップの画像を処理するためにメガピクセルのデジタルカメラが必要である PCBボードファインはんだボールピッチ. より高いピクセルによるデジタルカメラは、より高い拡大を持ちます, しかし, ピクセルが高い方, the smaller the field of view (FOV), これは、より大きなデバイスが複数回「撮影される必要がある」ことを意味する. カメラの光源は一般に発光ダイオードである, どちらがサイドライトに分割されますか, フロント光源及び軸光源, と独立して制御することができます. フリップチップ用イメージング光源 PCBボード サイドライト, フロントライト, または両方の組み合わせ. それで、どのように、あなたは与えられた装置のためにカメラを選びますか? これは主に画像のアルゴリズムに依存する. 例えば, つの半田ボールを識別するのにはN個のピクセルが必要です, ボールピッチを識別するために2 nピクセルが必要である. 万能機器の配置機におけるマゼランデジタルカメラの適用例, つのはんだボールを区別するために. カメラを選択, すべての画像が実際のオブジェクトサイズの. フリップチップの画像処理 PCBボードsは普通のものと似ている. フリップチップ実装 PCBボードsは、しばしば世界的な. この時に, the fiducials will be small (0.15 - 1.0mm), そして、カメラの選択は、上記の方法を参照します. 光源の選択を考慮する必要がある. 一般に, SMDヘッド上のカメラの光源は赤色光である, そして、フレキシブル回路基板上の基準点を扱うとき、効果は非常に貧しい, 基準点は見つからない. The reason is that the surface of the reference point (copper) The color is very close to the substrate color, そして、色の違いは明らかではない. 万能機器の青色光源技術を使用するなら, この問題は非常によく解決できる.
5. Selection of nozzles
Since the flip-chip substrate for PCB is silicon, 上面は非常に平らで滑らかです, そして、ヘッドは多孔性ESDノズルを有する剛性プラスチック材料である. あなたがゴム頭でノズルを選ぶならば, ゴム時代, デバイスは、配置プロセス中にデバイスに貼り付けてもよい, 装置を移すか、取るために配置を引き起こすこと.
6. フラックス応用ユニットの必要条件. フラックス塗布ユニットはフラックスディップ工程を制御する重要な部分である. 膜厚の安定したフラックス膜を得るための基本原理, デバイスの各半田ボールを容易に浸すことができるように. 同じ量のフラックスを取る. 高速浸漬の必要条件を満たしながらフラックス膜の厚さを安定に制御する, the flux application unit must meet the following requirements:
1) It can meet the requirements of dipping multiple devices with flux at the same time (such as dipping 4 or 7 pieces at the same time) to increase the output;
2) The unit for flux should be simple, 操作が容易, easy to control and easy to clean;
3) It can handle a wide range of fluxes or solder pastes. 浸漬工程に適したフラックスの粘度範囲は広い, そして、それはより薄くてより粘性のフラックスを扱うことができます, and the obtained film thickness should be uniform;
4) The dipping process can be controlled, そして、ディッププロセスパラメータは、異なる材料のために異なるでしょう, したがって、浸漬プロセスのプロセスパラメータを個別に制御しなければならない, 下方加速度など, 圧力, 滞留時間, 上向き加速, etc.
7. フィーダの要件, 高速で高収率のバッチの生産を満たすために, 供給技術も非常に重要です. フリップチップ実装方法 PCBボードs mainly include: 2*2 or 4*4 inch JEDEC reels, 200mm or 300mm wafer reels (Wafer), and reel reels (Reel). 対応するフィーダは:固定トレイフィーダ, 自動スタック可能フィーダ, ウェハフィーダ, テープフィーダ. これらの供給技術の全ては、高速給餌が可能でなければならない, また、ウェハフィーダはまた、様々なデバイスパッケージング方法を扱うことができる必要がある, デバイスパッケージはJEDECトレイでありえます, または裸のウェーハ, または、マシンの完全なチップ. フリップアクション. Let's take an example to illustrate the characteristics of Unovis's bare die feeder (DDF Direct Die Feeder):
1) Can be used in hybrid circuits or sensors, マルチチップモジュール, system-in-package, RFID and 3D assembly;
2) The disc can be fed vertically to save space, and one machine can install multiple DDFs;
3) The chip can be flipped in DDF;
4) Can be installed on a variety of patch platforms.
8. 基板支持・位置決めシステムの要件, いくつかのPCBフリップチップは、フレキシブル回路基板または薄型回路基板に使用される. この時に, 基板のフラット支持は非常に重要である. The solution often uses a carrier plate and a vacuum suction system to form a flat support and positioning system that meets the following requirements:
1) Support control in the Z direction of the substrate, and programming adjustment of the support height;
2) Provide customized board support interface;
3) Complete vacuum generator;
4) Non-standard and standard carrier boards can be applied.
9. リフローはんだ付けとフィラー硬化後の検査, アンダーフィルが完了した後、製品の検査のための非破壊検査および破壊検査があります. The non-destructive inspection includes:
1) Use an optical microscope to conduct visual inspection, フィラーが装置の側に登るかどうかをチェックするような, 良いエッジフィレットが形成されるかどうか, そして、デバイスの表面が汚れているかどうか, etc.;
2) Use an X-ray inspector to check whether the solder joints are short-circuited, 開放した, オフセット, 濡れた, はんだ接合部のボイド, etc.;
3) Electrical test (Continuity test), これは、電気接続に問題があるかどうかをテストできます. デイジーチェーンデザインのテストボードについて, the location of the solder joint failure can also be determined through the continuity test;
4) Use ultrasonic scanning microscope (C-SAM) to check 空孔があるかどうか, アンダーフィル後の成層と完全流動. 破壊検査ははんだ接合部またはアンダーフィルを切断できる, 光学顕微鏡法と組み合わせる, metallographic microscopy or scanning electron microscopy and energy dispersive analyzers (SEM/EDX) to examine the microstructure of solder joints, e.g., 微小亀裂/微細孔, すず結晶化, 金属間化合物, はんだ付けと湿潤条件, アンダーフィルがボイドを持っているかどうか, クラック, 剥離, そして、流れが完了するかどうか, etc. リフローはんだ付けとアンダーフィルプロセス後の製品の共通欠陥/開放回路, はんだ接合不良, 半田接合部/バブル, はんだ接合割れ/脆性, アンダーフィルとチップ剥離とチップ割れ, etc. . アンダーフィルの完全性のために, whether there are voids, 充填材の亀裂と層間剥離, it needs to be observed by an ultrasonic scanning microscope (C-SAM) or a flat section parallel to the bottom surface of the chip. 欠点は難しさを増す. アンダーフィル材料とチップとの間の剥離は、応力をかけられたデバイスの四隅で、またはフィラーとはんだ接合部の界面で発生する傾向がある.
PCB用フリップチップは製品コストの点で利点を示した, 性能と高密度実装, そして、そのアプリケーションは徐々に主流になっている. のために使用されるフリップチップの小さいサイズのため PCBボードs, 高い精度を確保する必要がある, 高い歩留まりと高い再現性, それは我々の伝統的な装置とプロセスに挑戦をもたらします, which are reflected in the following aspects:
1) The design of the substrate (hard board or soft board);
2) Assembly and inspection of equipment;
3) Manufacturing process, チップ実装工程, PCB製造工程, SMT process;
4) Material compatibility.
上記の問題を包括的に理解することは、フリップチップアセンブリプロセスの成功のための基礎である PCBボード.