Die allgemeine Struktur von Jumper-Löchern und Sacklöchern ist ausreichend für Leiterplatten mit hoher Dichte, aber die Dichte der Kontakte ist nicht hoch genug für die Struktur Belastungsplatten, die eine höhere Dichte erfordern. Daher, bei der Konstruktion von Strukturen mit höherer Dichte, Designer werden ein Loch-an-Loch Design annehmen.
Weil gewöhnliche dünne dielektrische Materialien nicht genug Klebstoff haben, um die vergrabenen Löcher direkt zu füllen, Die vergrabenen Durchgangslöcher müssen vor der Oberflächenschicht eines solchen mit Klebstoff gefüllt werden. Leiterplatte wird gemacht, und der Füllprozess muss glatt sein Fest, ansonsten ist es leicht, die nachträgliche Qualitätsbeeinträchtigung durch Füllung zu vieler Hohlräume oder Unebenheiten zu verursachen. Zur Zeit, Die Auslastung dieser Art von Herstellungsverfahren in elektronischen Paketplatinen ist relativ hoch. Bei der Verwendung von Leiterplatten, es ist eine Notwendigkeit für dickere begraben Leiterplatten. Natürlich, Es liegt hauptsächlich an der unzureichenden Füllung des Druckplattenkleimflusses. Abbildung 6.3 zeigt den Zustand der durchgehenden Scheibe der gefüllten Leiterplatte.

Nach dem Füllen der Durchgangslöcher muss der interne Kreislauf durch Bürsten, Entfernen von Schlacke, chemischem Kupfer, Galvanik und Schaltungsproduktion abgeschlossen werden und dann die äußere Struktur weiter herstellen. Zu diesem Zeitpunkt, um die Dichte zu erhöhen, nimmt das Querverbindungsverfahren die Form von Löchern an den Löchern an. Natürlich hat eine solche Struktur eine höhere Dichte als indirekte Verbindungen. Abbildung 6.4 zeigt die gestapelte Struktur der Löcher auf den Löchern.
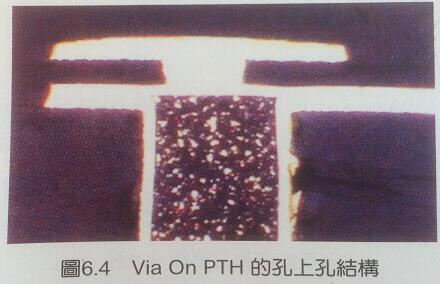
Da der Lochfüllprozess zu einem gewissen Grad Restblasen verursachen kann, beeinflusst die Restmenge der Blasen direkt die Qualität der Verbindung. Generell gibt es keinen klaren Standard für die zulässige Restmenge von Luftblasen. Solange die Zuverlässigkeit kein Problem ist, werden die meisten von ihnen keine Verletzungen verursachen. Fallen die Blasen jedoch in den Bereich der Öffnung, sind die Chancen auf Probleme relativ erhöht. Wie in Abbildung 6.5 gezeigt, handelt es sich um ein typisches Problem einer schlechten Verbindung, die durch Füllqualitätsfehler verursacht wird.

Weil die Öffnung Luftblasen hinterließ, Nach dem Bürsten wurde eine Blasenbildung erzeugt, und ein tiefes Loch wurde nach dem Galvanisieren hinterlassen. Es wurde während der Laserbearbeitung nicht gereinigt, so trat das Problem der schlechten Leitung auf. Daher, Die Abfülltechnik wird ein wichtiges technisches Problem für die Ladeplatte mit hoher Dichte, speziell für die Hersteller, die die Loch-auf-Loch-Struktur verwenden möchten.