Der Einfluss des Entwicklungstrends der Elektronikindustrie auf die Leiterplatte
Trends und Entwicklungen in der Montage
Die Multifunktion, hohe Übertragungsgeschwindigkeit und Miniaturisierung von tragbaren elektronischen Produkten sind die größte treibende Kraft für die kontinuierliche Verbesserung von Gesamthalbleitern, Verpackungen, Montage und PCBA-Leiterplatten. Im Folgenden wird der Entwicklungstrend der einzelnen Bauebenen in den nächsten fünf Jahren analysiert.
1 Motivation for change
Due to the need for rapid product revolution and market innovation, Das Design von tragbaren elektronischen Produkten hat einige Trendmerkmale entwickelt, einschließlich Miniaturisierung, geringes Gewicht, geringerer Energieverbrauch, erhöhte Funktionen, erweiterte Schnittstellen, drahtlose Verbindungen, modische Stile, und mehr. Erfüllen Sie die Bedürfnisse des grünen Umweltschutzes. Die Merkmale des Marktes sind der verkürzte Produktlebenszyklus, die Integration von 3C Anwendungen, größere Produktion, schnellere Reaktion auf den Markt in Echtzeit, und erhöhte Produktkomplexität und -vielfalt. Um mit diesen, Es ist notwendig, den Prozess der elektronischen Verpackung und Montage zu ändern. Ein Überblick über die neuesten Trends, ihre Übergänge, und ihre Herausforderungen; die Trends der einzelnen Komponenten, Trägerplatten, und Montage werden von folgenden.
Im Allgemeinen, Maximierung der Stiftanzahl und Paketgröße kann mehr I aufnehmen/O in geringer Menge. Um die Zunahme der Packungsgröße zu begrenzen, die Tonhöhe muss auf 0 reduziert werden.3mm-abhängig vom Preis der BGA und CSP Entwicklung. Unter der gleichen Fläche, BGA und CSP Pakete können mehr I aufnehmen/Os and also have wider bumps^3 pitch. In der Zukunft, werden die Preise von BGA und CSP weiter fallen, das viele QFP-Verpackungsmärkte ersetzen wird. It is especially worth noting that Seated hcight (the distance from the top of the package to the PCB surface) will be reduced.
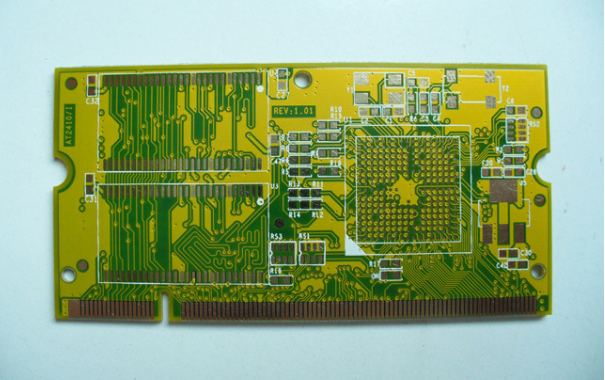
Two BGA package
By 2006, die Nummer I/Os werden auf 1200 ansteigen, das ist ein bestimmter Trend in der Anwendung von tragbaren Computern. Um die Größe des Hauptkörpers zu begrenzen und Zuverlässigkeitsprobleme zu vermeiden, Die Oberflächenkonfiguration der Stöße wird in Richtung eines Full-Area-Array-Typs entwickelt. Aus demselben Grund, die Neigung der Beule wird leicht reduziert. Die Sitzhöhe wird reduziert, um ein dünneres Endprodukt zu installieren. Die wichtigsten BGA Entwicklungstrends sind in Tabelle 9 dargestellt..2.
Three Chip-Scale Packages (CSPs)
CSPs have two types of external pins, one is bump (BGA type), the other is solder pad (LGA type). Die höchste Sitzhöhe von LGA ist aufgrund der fehlenden Unebenheiten niedriger. Daher, LGA ist beliebter geworden, Obwohl die niedrigere Abstandshöhe die Lebensdauer der zweiten Verbindungsebene verringert. Die gemeinsame Entwicklung der beiden Pakettypen ist, dass die höchste Sitzhöhe sinkt und die Anzahl der I/Os werden zunehmen. Die Größe der Verpackung ist auf 0 reduziert.3mm aufgrund der Steigung des Bugs/Landarray, die auch reduziert werden. Die Größe der Beule/Land wird auch reduziert. Tabelle 1 zeigt die wichtigsten CSP-Trends.
A special form of CSPs is wafer-level CSPs (wafer-level CSPs), Verpackungsarten, die vor dem Schneiden des Wafers in Matrizen durchgeführt werden. Der Hauptvorteil ist, dass die Kosten für diese Pakete niedrig sind, weil die Produktionseinheit eher ein Wafer als eine Matrize ist, und die Zunahme der Wafergröße ist auch förderlich für die Verringerung der Kosten dieses Pakettyps.
Four Flip chip on board
In the field of portable consumer products, die Nummer I/Os, die direkt mit dem Motherboard verbunden sind, haben beim FC-Typ leicht zugenommen, und die Größe des Würfels hat sich nicht viel geändert. 1C-Technologie kann Schaltungen mit höherer Dichte herstellen. Unter der gleichen Größe, Die Matrize kann mehr Funktionen haben.
Weil der Signalverstärkungsprozess auf dem Chip wenig Einfluss auf die Anzahl der I hat/Os. Sowohl die Matrizendicke als auch die Beulenneigung werden reduziert. Die minimale Stoßneigung variiert je nach eingesetzter Verbindungstechnik, die später erörtert werden. Der zusätzliche Unterfüllprozess zur Gewährleistung seiner Zuverlässigkeit behindert die direkte Anwendung von FC auf dem Motherboard. Sobald die alternative Technologie reif ist, wird die Anwendung von FC erheblich zunehmen. Possible alternatives are Iio-flow primer (a mixture of high-viscosity flux and primer) and back-sealing glue on the wafer.
Five comparison of various 1C package types
Table 3 is a comparison of the above-mentioned different package types. Aus QFP, BGA, CSP zu WL-CSP, die Dichte von Flip-Chip und I/O hat zugenommen, während der Pitch und die Packungsgröße geschrumpft sind. Die elektrischen und thermischen Eigenschaften haben sich verbessert, aber die Schwerlastfähigkeit, Verarbeitbarkeit, elektrische Prüfung, Schutzgrad des Kristallkorns, Kompatibilität mit 1C Design und Standard Reflow, und die Universalität der Komponenten sind schlecht geworden. In Bezug auf Zuverlässigkeit, QFPs und FCs liefern die besten Ergebnisse. QFP, WL-CSP und FLIP-CHIP haben Kostenvorteile, insbesondere QFP ist der niedrigste.
Six passive components passive components
It can be expected that by 2006, Die Größe der Kondensatoren und Widerstände wird auf 0101 Größe reduziert. The so-called integrated passive component refers to the integration of several passive functions in a silicon or ceramic die (I/O number> 2). Some passive components are also integrated into silicon 1C (such as decoupling capacitors).
Mehrschichtige Trägerplatten (ceramic or organic) are used in mold resistance assembly, und einige spezifische passive Funktionen sind darin integriert.