Die allgemeinen Leitlinien für Thermodesign für Leiterplatten are as follows:
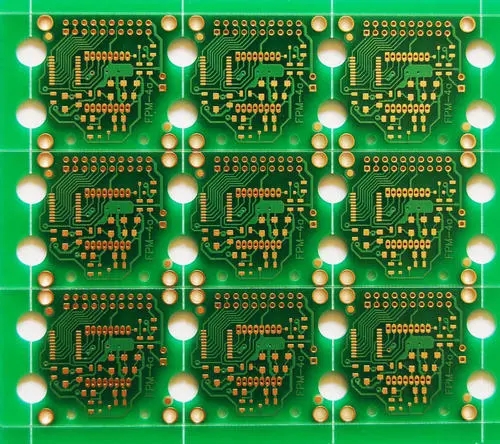
(1) During layout design, Zwischen den Bauteilen und zwischen Bauteilen und Spänen sollte so viel Platz wie möglich reserviert werden, um Belüftung und Wärmeableitung zu erleichtern.
(2) Keep components with low temperature specifications away from components with high temperature specifications. E.g:
CPU:100 degree Celsius HDD:60 degree Celsius
N/B:105 Grad Celsius FDD Scheibe:51.5 degree Celsius
S/B:85 degree Celsius CDROM:60 degree Celsius
VGA:85 degree Celsius PCMCIA CARD:65 degree Celsius
C/G:85 degree Celsius Other ICs:70 degree Celsius
(3) For ICs und components estimated to have heat dissipation problems, Es sollte genügend Platz für die Platzierung von Verbesserungslösungen reserviert werden. Zum Beispiel: Haben Sie keine größeren Teile um ICs herum, um die Platzierung von Metallkühlkörpern zu erleichtern, um Wärme in Zukunft abzuleiten.
(4) Large components (such as CPU) and cooling modules should be as close as possible to the edge of the CPU to reduce thermal resistance.
(5) The medium (TIM, thermal interface material) between the heat dissipation module and the CPU has a great influence on the efficiency of the module. Materialien mit niedrigem Wärmewiderstand sollten ausgewählt werden, oder sogar Phasenwechselmaterialien.
(6) The contact pressure between the group and the heat-dissipating component should be as large as possible within the specifications, und es sollte bestätigt werden, dass die beiden Kontaktflächen intakt verbunden sind, flach und gleichmäßig.
(7) The body part of the heat dissipation module should not be too small, und versuchen, die Kontaktfläche mit dem Heatpipe zu vergrößern, so dass die Wärme des Heizchips zum Wärmeableitungsmodul geleitet werden kann.
(8) The heat exchange fins in the Thermal module are enlarged in the direction perpendicular to the wind flow, die effektiver ist als in paralleler Richtung.
(9) H/P hat seine Grenzen in der Verwendung von Abflachen und Biegen, auf die geachtet werden sollte.
(10) The overall flow path design should avoid backflow to reduce wind resistance and noise.
(11) The gap between the outlet of the Module and the outlet of the N/B sollte mit einem geschlossenen Strömungskanal hergestellt werden, um zu verhindern, dass die heiße Luft zurück in den N fließt/B.
(12) The heat dissipation and ventilation design has a large opening rate, und ersetzt kleine runde Löcher oder Maschen durch große längliche Löcher, um Windwiderstand und Lärm zu reduzieren.
(13) Special attention should be paid to the shape and size of the air inlet of the fan, sowie das Design der Zunge und der Involute.
(14) There should be no obstruction within 3mm~5mm outside the air inlet of the fan.
(15) Chips with high calorific value should be placed on the motherboard as much as possible to avoid overheating of the bottom case; if it is necessary to place the chip under the motherboard, Der Raum zwischen dem Chip und dem unteren Gehäuse sollte reserviert werden, um die Luftdurchdringung voll zu nutzen, Gasdurchfluss oder Wärmeableitung. Platzieren Sie den Lösungsraum.
Das obige ist eine Einführung in die allgemeinen Richtlinien von Thermodesign für Leiterplatten. Ipcb wird auch für Leiterplattenhersteller and Leiterplattenherstellung Technologie.