Le nom complet de BGA est "Ball Grid Array", ce qui signifie PCB avec une structure de grille à billes. Il s'agit d'un procédé d'encapsulation de circuits intégrés utilisant un support organique. Les cartes PCB avec BGA ont généralement plus de petits trous et les trous traversants inférieurs BGA sont généralement conçus comme des trous finis de 8 à 12 mil de diamètre. Les Vias inférieurs BGA doivent être bouchés, les Plots ne permettent pas l'encrage et les Plots ne sont pas percés.
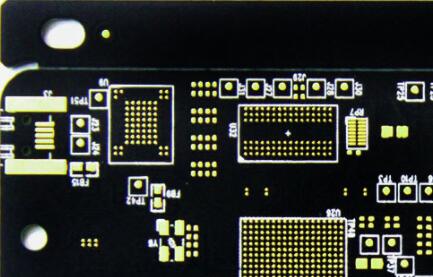
BGA est un composant qui utilise la méthode d'encapsulation par matrice de billes de soudure. Il produit des billes de soudure au fond du substrat d'encapsulation qui servent d'interface à la carte à circuit imprimé à laquelle elle est reliée. Les composants BGA sont adaptés aux composants montés en surface, avec un grand nombre de broches dans le circuit, une densité de boîtier plus élevée, des fonctionnalités plus puissantes et une fiabilité accrue. Le CPU de BGA est principalement utilisé pour les ordinateurs portables.
Règles générales pour la conception des Pads BGA
1) le diamètre des plots est généralement inférieur au diamètre des billes de soudure. Pour obtenir une adhérence fiable, elle est généralement réduite de 20 à 25%. Plus le Plot est grand, moins il y a d'espace de câblage entre les deux Plots.
2) Les Plots sur le substrat BGA ont le même diamètre que les Plots sur le PCB.
3) la conception des plots de BGA doit être telle que l'ouverture du coffrage provoque une fuite de pâte de 0,08 mm3, ce qui est le minimum requis pour assurer la fiabilité des plots de soudure.
Principes du processus d'emballage BGA
Les principaux processus technologiques de l'encapsulation BGA comprennent la production de billes de soudage, la production de substrats, le collage de puces, la solidification de l'encapsulation et l'encapsulation par découpage.
1) production de billes de soudure: utilisez un alliage étain - plomb de haute pureté ou un matériau sans plomb pour produire des billes de soudure, formant un réseau régulier de broches sphériques.
2) production de substrat: adoptez la carte de circuit imprimé multicouche comme substrat pour réaliser l'interconnexion électrique de haute densité et de haute performance.
3) chip Bonding: fixez la puce au substrat et utilisez une soudure sans plomb ou à base de plomb pour la fixer au substrat.
4) encapsulation et durcissement: les puces sont encapsulées avec de la résine époxy pour les protéger de l'environnement.
5) Split Packaging: découpez la puce encapsulée dans un boîtier BGA séparé.
Technologie d'emballage BGA
1. Conception de PAD: pour assurer la qualité et la fiabilité du soudage, la conception de pad doit suivre certaines directives. Tout d'abord, vous devez vous assurer que les dimensions des plots correspondent à celles des billes de soudure. Deuxièmement, il est nécessaire de prendre en compte les effets de la forme et de la disposition du coussin sur la dilatation thermique et la contraction thermique. Enfin, il convient également de prêter attention au traitement de surface des plots pour améliorer la fiabilité du soudage.
2. Processus de soudage: le soudage BGA utilise généralement la technologie de soudage à reflux. Pour garantir la qualité du soudage, il est nécessaire de contrôler la température de soudage, le temps et la courbe de température du four. En outre, il convient également de prêter attention aux contraintes thermiques lors du soudage et d'éviter l'apparition de défauts de soudage.
3. Contrôle de qualité: après le soudage du boîtier BGA, un contrôle de qualité est nécessaire pour assurer la fiabilité de la connexion. Les méthodes de détection couramment utilisées comprennent la détection par rayons X, la détection des émissions acoustiques, etc. la détection par rayons X permet d'observer visuellement la structure interne du point de soudure et de détecter les défauts de soudage. Le test d'émission acoustique détermine la qualité de la soudure en analysant le signal acoustique.
4. Réparation et entretien: pour l'emballage BGA mal soudé, il peut être re - soudé avec un équipement de réparation spécial. Généralement, le processus de réparation comprend des étapes telles que le nettoyage des plots, le réapprovisionnement des billes de soudure et la reconnexion des puces. Pendant la réparation, il est nécessaire de contrôler la température et le temps de chauffage pour éviter d'endommager la puce.
5. Conception et disposition: dans la conception de circuit, la disposition et le câblage des boîtiers BGA sont essentiels. Des facteurs tels que les propriétés électriques, les propriétés thermiques et la résistance mécanique doivent être pleinement pris en compte. Lors de la mise en page, il convient de prêter attention à des questions telles que l'intégrité du signal, la stabilité de l'alimentation et la gestion thermique pour obtenir un système électronique haute performance.
Avantages et inconvénients du boîtier BGA
Avantages:
1) haute densité: le boîtier BGA a un plus grand espacement des broches, ce qui peut atteindre un nombre plus élevé de broches d'E / s pour répondre aux exigences des circuits intégrés haute performance.
2) excellentes performances de transmission du signal: en raison du chemin de connexion plus court de la bille de soudure, le boîtier BGA une inductance et une capacité parasites inférieures, favorisant la transmission à grande vitesse du signal.
3) bonnes propriétés thermiques: les billes de soudure encapsulées BGA peuvent conduire efficacement la chaleur et aider à réduire la température de fonctionnement de la puce.
Inconvénients:
Processus de production à forte demande: les processus et les équipements de soudage bout à bout BGA packaging sont très exigeants et augmentent les coûts de production.
Le boîtier BGA est une technologie de montage en surface caractérisée par la formation d'un réseau régulier de broches sphériques au fond du boîtier. Cette méthode d'encapsulation présente les avantages d'un grand espacement des broches, de bonnes performances thermiques et de performances supérieures de transmission de signal, largement utilisées dans les circuits intégrés haute performance à grande vitesse.