3dic hétérogène encore confronté au seuil de production de masse
Bien que la technologie d'empilage 3D 3dic + TSV puisse augmenter la densité de la puce avec une surface minimale, réduire les coûts et la taille du produit, améliorant ainsi les performances et la fiabilité de la puce, Samsung a également été le premier à lancer une mémoire flash nandflash empilée 3dic homogène, une mémoire DDR3, Et les puces widei / odram empilées pour les ordinateurs de bureau et portables. Les sociétés de conception d'IC telles que Qualcomm et broadcomm ont également introduit la technologie 3dtsv pour concevoir la prochaine génération d'IC à plus haute densité.
Les applications intégrées actuelles de 3dic relèvent toujours du même processus de fabrication, l'intégration de puces homogènes (homogenous) telles que les DRAM, les puces nandflash ou les microprocesseurs multicœurs. Iek prévoit qu'à partir de cette année (2013), les 3dic tels que DRAM et nandflash avec empilement uniforme devraient entrer en production de masse. Quant à l'intégration hétérogène des puces logiques (Logic), des puces mémoire (DRAM), des circuits intégrés radiofréquences (RF), des amplificateurs de puissance (PA), des puces de conversion optoélectronique, etc., elle est limitée par des problèmes techniques tels que la consommation d'énergie et le coefficient du matériau d'encapsulation. Il reste à surmonter.
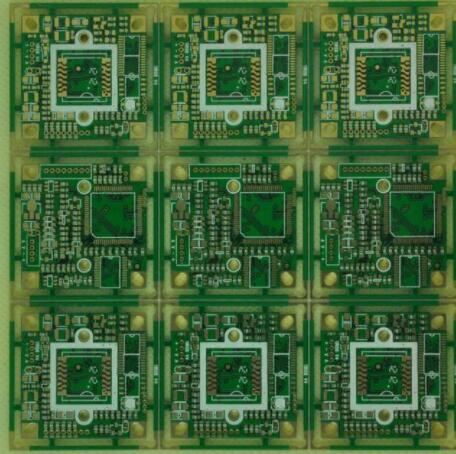
La technologie intermédiaire 2.5D est la première à introduire FPGA, GPU / Apu en production de masse
Comme mentionné précédemment, 3dic est utilisé pour les circuits intégrés hetergeneous. Il empile des puces de silicium nues avec des processus logiques et des caractéristiques de fonctionnement différents et utilise la technologie TSV (Silicon Drilling) pour interconnecter les puces. Lors de l'empilement de différents types de puces, les problèmes de consommation d'énergie et de dissipation thermique nécessiteront un traitement spécial.
Si seules les puces DRAM avec une tension de 1V et une consommation de 2W sont empilées, le courant de démarrage est d'environ 2 ampères. Si un processeur multicœur à 2 GHz ou une unité de traitement graphique (GPU) est empilé dessus, il peut facilement prendre des dizaines de watts ou plus. Une centaine de Watts, le courant de démarrage optique peut aller jusqu'à quelques dizaines d'ampères, ce qui peut presque être géré avec une batterie de qualité automobile. Une telle puce est mortelle pour la conception d'un appareil portable mobile; Et il fournit un courant important dans une telle zone limitée et dense. La conception du câblage des circuits d'alimentation et le choix des puces d'alimentation sont des défis techniques, et même le courant lui - même est la plus grande source de perturbation affectant l'efficacité et la stabilité du circuit.
Les puces CPU et GPU fonctionnant à haute fréquence peuvent généralement être chauffées à 120 degrés. Cependant, lorsque les puces DRAM et nandflash dépassent 85 ° C, des anomalies apparaissent dans le mécanisme de rafraîchissement et les tolérances de stockage. Si le CPU est combiné avec la DRAM, nandflash, la chaleur élevée du CPU affectera la DRAM et nandflash; De plus, comme pour les pièces de convertisseur optoélectronique, la stabilité de fonctionnement sera fortement diminuée lorsque la température atteindra 80°c ou plus. Il existe également différents types de matériaux de moule nu. Lors de l'empilement, il faut tenir compte des effets de contraintes thermiques sur le mécanisme d'encapsulation causés par différents coefficients de dilatation thermique, même une surchauffe pouvant entraîner une déformation des couches de plaquettes empilées, voire une rupture de l'étain. Comment organiser correctement l'ordre d'empilement de ces puces avec des caractéristiques de température différentes afin qu'elles ne s'influencent pas mutuellement lors de la dissipation de chaleur est un défi technique très difficile. C'est pourquoi 3dic, déjà produit en série, est apparu en premier dans les produits empilés équivalents DRAM et nandflash à faible consommation.
La technologie 2.5dic (ou 2.5dinterpriser) a été proposée pour la première fois par les chefs d'usine (ASE) et est devenue plus tard un terme utilisé dans l'industrie des semi - conducteurs. La méthode consiste à faire en sorte que les moules des différentes caractéristiques de processus / travail ne soient pas empilés les uns sur les autres, mais disposés parallèlement et à proximité les uns des autres, placés sur un interposer (interposer), un matériau à base de verre ou de silicium, pour la connexion, puis connectés au fond. La carte PCB réduit le temps de retard du signal et améliore les performances globales du système; Chaque moule parallèle peut être testé individuellement, puis perforé et assemblé côte à côte. Il n'a pas besoin d'être testé par rayonnement thermique / électromagnétique, il suffit de le placer sur une plaque intermédiaire (interposer) pour effectuer un test d'intégration globale après encapsulation. Lors de la réalisation d'un empilement 3dic, chaque couche de l'empilement doit être testée thermiquement / électromagnétiquement; Si l'un des moules présente un défaut, l'ensemble du dispositif d'empilage 3dic doit être compensé.
2.5dic est considéré par l'industrie des semi - conducteurs comme une technologie intermédiaire pour la transition vers le futur 3dic. Outre l'utilisation de l'insert comme pont de communication entre les puces, il est important de prêter attention aux problèmes tels que la combinaison de la puce et de l'insert, les propriétés du matériau et les contraintes thermiques. Le goulot d'étranglement technique du 2.5dic est inférieur à celui du 3dic. Les intermédiaires en silicium (siinterposer) utilisés dans les cartes ne nécessitent généralement pas de processus de fabrication avancés à 40 nm, voire 28 nm, comme les puces de processeur, et peuvent réduire les coûts de fabrication.
Prenons par exemple la puce de processeur FPGA xilinx2.5d. Après avoir disposé les puces FPGA 28 / 40nm nues côte à côte, elles ont été placées sur un intermédiaire en silicium de 65nm. Le coût total est inférieur aux procédés SOC 40 nm et même 28 nm précédents. Le domaine d'application de 2.5dic n'est donc pas limité aux puces mémoire. Les puces de calcul logique hautes performances et hautement intégrées telles que les FPGA, les CPU, les GPU et autres ont commencé à appliquer la technologie d'entreprise 2.5D.
2.5D / 3dic application de destruction
Les semi - conducteurs qui ont introduit le concept 2.5dic dans la production de masse sont représentés par Xilinx et altera, les principaux fabricants de réseaux de portes logiques programmables (FPGA). Les deux sociétés utilisent la technologie cowos (Chip Wafer Substrate) 2.5dic de TSMC. Tout comme la puce xilinxâs virtex - 72000tfpga, les puces nues de 28 nm sont disposées côte à côte. Les micro - points convexes sous la feuille nue sont connectés à un intermédiaire en silicium de 65 nm. Ensuite, ils sont connectés aux billes de soudure par la technologie TSV, puis pénétrés. Fixez la boule de soudure à la carte PCB ci - dessous.
De plus, une puce graphique intelirispro5200 (gt3e) compatible avec les processeurs IBM power8, les processeurs Intel corei de quatrième génération (haswell) et AMD semi - Custom 8. L'APU Core utilisera également la technologie d'encapsulation 2.5dic.
En ce qui concerne la partie 3dic, en plus de l'empilement homogène des puces DRAM (widei / o) et nandflash, alterA a récemment annoncé la prochaine génération de produits FPGA 20 nm qui utiliseront le processus 20 nm de TSMC de nouvelle génération, ainsi que la technologie d'intégration hétérogène et d'empilement 3dic. Intégration de plus de deux ensembles de puces FPGA, de puces de processeur ARM multicœur, de puces hardcopyasic personnalisées par l'utilisateur, de processeurs de signaux numériques DSP à précision réglable et de puces mémoire memorycube empilées multicouches.
ASE, Silicon products, liecheng et nammao détiennent 56% du marché mondial de l'encapsulation et du remplacement d'essai, ce qui constitue également la clé du dernier kilomètre de la chaîne industrielle 3dic. ASE adopte la norme 3ds - IC pour la plate - forme de spécification semi et travaille activement avec designhouse et Foundry pour compléter les spécifications dietodie, dietosip overlay Interconnect, ainsi que la confirmation de la fiabilité de l'empilage 3D, de la mesure et de l'encapsulation; Procédures de maintien entre la fonderie, la mémoire, l'encapsulation et le test de cartes porteuses 3D, de pinces, d'usines, ainsi que la participation aux spécifications relatives aux Wafers TSV, à la méthode d'empilement de mémoire jedecjc - 11widei / O et à l'assurance qualité 3dqa.
En outre, TSMC a introduit la technologie de production intégrée cowos (Chip Wafer Substrate) avec une structure 2.5D / 3dic, offrant des services de shopping à guichet unique tels que TSV / 3D, divers matériaux à points convexes, y compris la technologie de plantation de billes, un interpolateur de silicium (si - interposer) et diverses intégrations de sous - systèmes. Dans le même temps, continuer à investir dans la technologie 2.5D / 3dic pour accélérer l'introduction de l'ensemble de la chaîne industrielle de l'Eda, IP, tests, équipements, fournisseurs de plaquettes de silicium et usines d'encapsulation. L'UMC et les usines d'encapsulation et de test en aval étaient à la recherche d'un modèle industriel ouvert (openecosystem Model) pour développer la technologie 3dic.
Iek note que la technologie 3dic a été introduite dans les puces mémoire telles que nandflash et DRAM avant 2010. Depuis 2010, les composants CIS (capteur d’image CMOS) et MEMS (micro - électromécanique) sont également produits en série. Il existe des applications telles que la puce d'amplification de puissance (PA), le boîtier de puce d'éclairage LED et le boîtier d'élément de conversion photoélectrique. En 2013, la production à grande échelle de memorycube et widei / odram multicouches homogènes est prévue; Et le 3dic hétérogène (3dic hétérogène) qui intègre des CPU multicœurs, des FPGA, des ASIC, des mémoires et des composants optoélectroniques, avec une phase de production réelle prévue entre 2014 et 2015.