Au cours des cent dernières années, avec le développement rapide des circuits intégrés, la technologie des cartes d'emballage IC a également été améliorée et les applications de l'industrie des circuits intégrés sont de plus en plus demandées et intégrées. Processus général de développement de l'emballage: to - Dip - PLCC - qfp - PGA - BGA - CSP - MCM, les indicateurs techniques sont avancés d'une génération à l'autre, la zone de la puce et le rapport de la zone d'emballage sont de plus en plus proches de to 1, les performances électriques et la fiabilité sont progressivement améliorées, le volume est plus petit et plus mince.
1. MCM (composant Multi - puce)
En fait, il s'agit d'un composant de puce, la dernière technologie. C'est une technique d'encapsulation qui assemble plusieurs puces nues semi - conductrices sur un substrat de câblage. Par conséquent, il élimine les matériaux et les processus d'encapsulation IC, ce qui permet d'économiser du matériel, Tout en réduisant le processus de fabrication nécessaire, de sorte que le produit est strictement assemblé à haute densité
Ouvrir Tencent News voir plus d'images
2. CSP (paquet de niveau de puce)
L'Encapsulation CSP est une Encapsulation au niveau de la puce. Il est bien connu que les puces sont petites par nature. Par conséquent, l'encapsulation CSP avec la technologie d'encapsulation de puce mémoire de dernière génération peut permettre au rapport de la surface de la puce à la surface d'encapsulation d'atteindre plus de 1: 1,14, ce qui est assez proche. Le scénario idéal de 1: 1 a été évalué par l'industrie comme la forme la plus élevée d'une seule puce. L'Encapsulation CSP peut tripler la capacité de stockage dans le même espace par rapport aux cartes d'encapsulation BGA. Ce boîtier se caractérise par une petite taille, un grand nombre de bornes d'entrée / sortie et de bonnes performances électriques. Il y a CSP BGA (Ball Grid Array), lfcsp (Lead Frame), LGA (Grid Array) et wlcsp (Wafer Level), entre autres.
1. Société CSP BGA

2. Lfcsp (structure de fil)
Lfcsp, ce boîtier est similaire à un cadre de connexion utilisant un circuit d'encapsulation en plastique traditionnel, mais avec des dimensions plus petites et une épaisseur plus fine, avec des coussinets de doigt qui s'étendent jusqu'à la zone interne de la puce. Le lfcsp est un boîtier en plastique basé sur un cadre de plomb. Les interconnexions internes du boîtier sont généralement réalisées par câblage et les connexions électriques externes par soudage des broches périphériques sur la carte PCB. En plus des broches, les lfcsps ont généralement de plus grands coussinets thermiques exposés qui peuvent être soudés sur le PCB pour améliorer la dissipation de chaleur.
3. LGA (matrice de grille)
Il s'agit d'un boîtier de grille, similaire au BGA, sauf que le BGA est soudé, tandis que le LGA peut être déverrouillé et remplacé à tout moment. Cela dit, il est remplaçable par rapport à BGA, mais le processus de remplacement nécessite beaucoup de soin.
4. Wlcsp (niveau de disque)

4. Matrice de grille à billes
L'un des réseaux de contacts à billes, encapsulation montée en surface. Sur la face arrière du PCB, Remplacez les broches par des blocs sphériques en mode Affichage et Assemblez la puce LSI sur la face avant du PCB, puis Scellez - la avec une résine moulée ou un scellement. Également connu sous le nom de support d'affichage à bosse (PAC). BGA comprend principalement: PBGA (boîtier plastique BGA), cbga (boîtier céramique BGA), Epbg (Enhanced Plastic Grid Array Packaging), etc.
4 - 1 cbga (céramique)

Cbga est le plus ancien de la famille de boîtiers BGA. Le substrat est une céramique multicouche sur laquelle le couvercle métallique est soudé avec une soudure d'étanchéité pour protéger les puces, les fils et les Plots. Il s'agit d'un boîtier monté en surface avec un ensemble de soudures au fond pour un accès facile.
4 - 2fcbga société
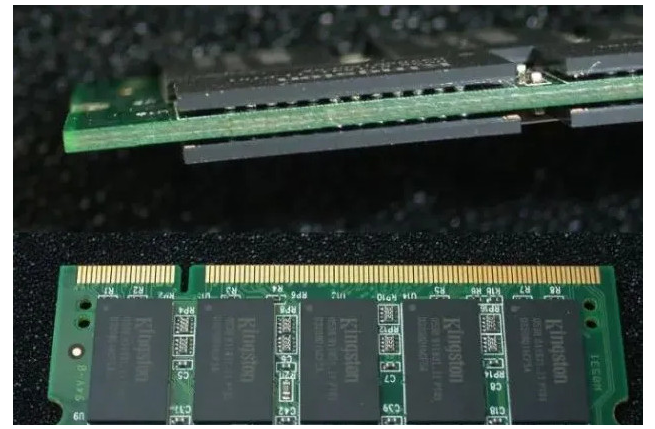
Fcbga permet une connexion directe entre la bille de soudage de la puce et le substrat BGA via une puce inversée. Dans les produits BGA, des densités d'encapsulation plus élevées peuvent être atteintes et de meilleures performances électriques et thermiques peuvent être obtenues.
4 à 3 LB / gallon

Boîtier BGA, il utilise un stratifié de résine / verre BT comme base et un plastique époxydé comme matériau d'étanchéité. Cette puce d'encapsulation est sensible à l'humidité et n'est pas adaptée à l'encapsulation de dispositifs nécessitant une étanchéité à l'air et une fiabilité élevées.
4 - 4 livres par pouce carré

Sbga utilise une conception de substrat avancée, y compris des ailettes en cuivre pour améliorer la dissipation thermique, tout en utilisant des processus d'assemblage et des matériaux fiables pour assurer une grande fiabilité et des performances supérieures. Alliant haute performance et légèreté, un boîtier sbga typique de 35 mm² est monté à une hauteur inférieure à 1,4 mm et ne pèse que 7,09.
5. PGA (réseau de grille d'aiguille)

Affiche l'encapsulation des broches. Dans un boîtier enfichable, les broches verticales du Bas sont disposées en rangées. Le substrat d'encapsulation est essentiellement un substrat céramique multicouche. Pour les circuits LSI logiques à grande vitesse et à grande échelle. Les broches sont situées à la base de la puce, généralement de forme carrée, et la distance du Centre à la broche est généralement de 2,54 MM. Le nombre de broches varie de 64 à 447. Il existe généralement deux types: cpga (Ceramic Needle Grid Array Packaging) et ppga (Plastic Needle Grid Array Packaging).
6. Qfp (paquet de quatre plans)
Ce type d'emballage est un emballage plat de forme carrée, généralement carrée, avec quatre broches latérales. Ce boîtier implémente un petit espacement entre les broches de la puce CPU et des broches minces. Les circuits intégrés à grande ou très grande échelle utilisent généralement ce type de boîtier, le nombre de broches est généralement supérieur à 100. En raison de sa petite taille de boîtier, les paramètres parasites sont réduits et adaptés aux applications à haute fréquence. Cette Encapsulation est: dans ce processus, cqfp (céramique Quad - plane Encapsulation), pqfp (plastique Quad - plane Encapsulation)
1. Lqfp (type mince)
C'est un qfp mince. Se réfère au qfp avec une épaisseur de boîtier de 1,4 mm, qui est le nom utilisé par l'industrie japonaise de la mécanique électronique selon la spécification de forme qfp nouvellement développée.
2. Tqfp (carré fin)
7. LCC (porteur de puce de plomb ou sans plomb)
Un porte - puce en céramique avec des broches, un type de boîtier monté en surface, avec des broches sortant des quatre côtés du boîtier. Il s'agit d'un boîtier pour circuits intégrés haute fréquence haute vitesse, également appelé céramique qfn ou qfn - C.
1. Clcc (goupille d'aile)
2. Pays les moins avancés
Porte - puce à broches en forme de C, broches tirées du Haut de la puce et pliées vers le bas en forme de C
3 livres / centimètre carré
Ces broches sont extraites des quatre côtés de l'emballage, sont en forme de T et sont en plastique. L'espacement entre les centres des broches est de 1,27 mm et le nombre de broches est compris entre 18 et 84. Il est plus facile à utiliser que le qfp, mais il est plus difficile de vérifier l'apparence après le soudage.
8. SIP (encapsulation de ligne unique)
Un seul fil d'encapsulation en ligne sort d'un côté de l'encapsulation sous la forme d'une ligne droite. Généralement traversant, les broches sortent d'un côté du boîtier et sont côte à côte en ligne droite. L'emballage se tient sur le côté lorsqu'il est assemblé sur une carte de circuit imprimé. La distance au centre de la broche est généralement de 2,54 mm et le nombre de broches varie de 2 à 23, la plupart étant des produits personnalisés. La forme de l'emballage varie.
9. SOIC (petit IC)
Le SOIC est un petit boîtier de circuit intégré. Le nombre de fils externes ne doit pas dépasser 28 petits ci. En général, il existe deux types d'encapsulation: Corps large et corps étroit. C'est environ 30 - 50% moins d'espace que le même boîtier DIP. L'épaisseur est réduite d'environ 70%.
10. SOP (petit paquet)
L'emballage SOP est une forme d'emballage de composants. Les matériaux d'emballage communs sont: plastique, céramique, verre, métal, etc., maintenant l'utilisation de base de l'emballage en plastique. Il a un large éventail d'applications et est principalement utilisé dans divers circuits intégrés. Viennent ensuite tsop (Thin Small Size Packaging), VSOP (Very Small Packaging), ssop (Small Size Packaging), tssop (Thin reduced Profile Package), msop (microfile Packaging), qsop (Quarter Size Profile Packaging), qvsop (Quarter Size Profile Packaging), etc.
1. Ssop (réduit)
2. Tsop (petit paquet mince)
3. Tssop (amincissement)
11. Sot (petit Transistor)
Sot est une Encapsulation SMD. Pour les dispositifs de moins de 5 broches (3 broches, 4 broches), un boîtier SMD est généralement utilisé. De petites tailles, plusieurs Transistors sont utilisés dans ce boîtier.
C'est aussi un boîtier de transistor. Il y a généralement des broches des deux côtés, le nombre de broches est de 3, 4, 5, pas plus de 7.
12. DIP (paquet à deux fils)
L'Encapsulation DIP est également appelée double Encapsulation en ligne ou double Encapsulation en ligne. La plupart des circuits intégrés de petite et moyenne taille prennent cette forme de boîtier et le nombre de broches ne dépasse généralement pas 100. La puce dans ce paquet a deux rangées de fils. Les broches peuvent être soudées directement à une prise de puce de structure DIP ou à un emplacement de soudage avec le même nombre de trous. Il se caractérise par la possibilité de réaliser facilement le soudage par perçage de la carte PCB, avec une bonne compatibilité avec la carte mère.
1. Double rangée en céramique Encapsulation directe
Cerdip Ceramic Dual Inline Package pour ECL RAM, DSP (Digital Signal Processor) et autres circuits. Vitrage cerdip pour ultraviolet EPROM effaçable et circuits micro - informatiques avec EPROM intégré, etc.
2. PDIP (emballage en plastique)
Ce double emballage en ligne en plastique est courant. Convient pour l'installation via PCB. Le fonctionnement est simple et peut être débogué avec la prise IC. Mais la taille de l'emballage est beaucoup plus grande que la puce et l'efficacité de l'emballage est faible. Beaucoup de zones d'installation efficaces.
13.to (boîtier de forme de Transistor)
La plaque d'encapsulation IC to est un Encapsulation en forme de transistor. L'un est un type de boîtier de transistor qui permet le montage en surface des fils, l'autre est un boîtier métallique circulaire sans composants montés en surface. Ce boîtier est largement utilisé, de nombreux transistors, transistors mos, Thyristors, etc.