Détails de la technologie d'emballage de puce de processus PCB
1. BGA (Ball Grid Array) est également appelé CPAC (ball top pad Array carrier). Affichage des contacts sphériques, un des boîtiers montés en surface. Sur la face arrière de la carte de circuit imprimé, des plots sphériques sont réalisés en mode Affichage à la place des broches et la puce LSI est Assemblée sur la face avant du substrat de circuit imprimé, puis scellée par moulage de résine ou par scellement. Également connu sous le nom de support d'affichage à bosse (PAC). Les broches peuvent dépasser 200, ce qui est l'encapsulation d'un LSI Multi - broches. Le corps du boîtier peut également être fabriqué dans une taille plus petite que le qfp (Quad Flat Package). Par exemple, un BGA à 360 broches avec une distance au centre de la broche de 1,5 mm n'est que de 31 mm carrés, tandis qu'un qfp à 304 broches avec une distance au centre de la broche de 0,5 mm est de 40 mm carrés. Et BGA n'a pas à se soucier de la déformation des broches comme qfp.
Développé par la société américaine Motorola, le package a d'abord été adopté dans les téléphones portables et autres appareils, puis popularisé dans les ordinateurs personnels. Initialement, la distance au Centre des broches BGA (bosses) était de 1,5 mm et le nombre de broches était de 225. Il existe également des fabricants de LSI qui travaillent sur un BGA à 500 broches. Le problème avec BGA est l'inspection visuelle après le soudage à reflux. La société américaine Motorola appelle les emballages scellés avec de la résine moulée ompac et ceux scellés avec la méthode de remplissage gpac.
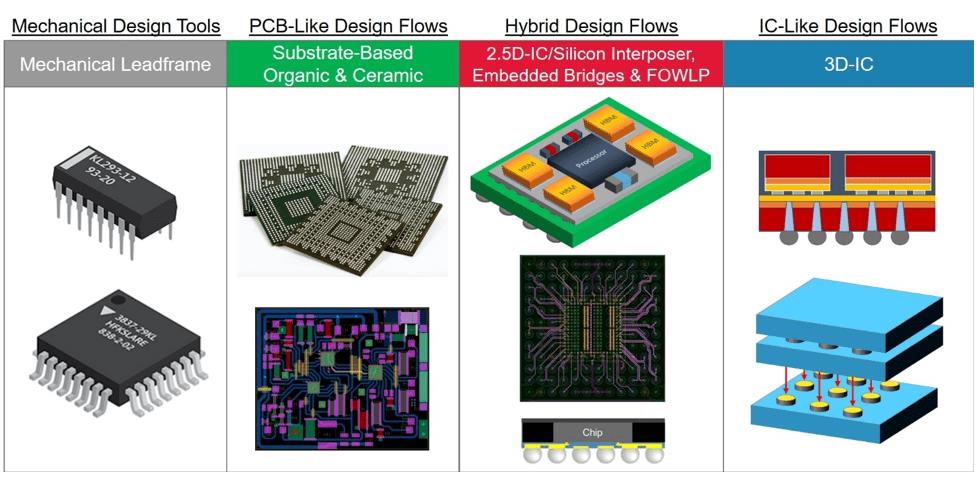
2.cï¼ (céramique) représente le marquage des emballages en céramique. Par example, CDIP signifie céramique DIP. C'est un marqueur qui est souvent utilisé dans la pratique.
3. COB (chip - on - Board) Chip - on - board Encapsulation est l'une des technologies de montage de puce nue. Les puces semi - conductrices sont remises et montées sur une carte de circuit imprimé. La connexion électrique entre la puce et le substrat est réalisée par couture et recouverte de résine pour assurer la fiabilité. Bien que COB soit la technologie de montage de puce nue la plus simple, sa densité de boîtier est beaucoup moins élevée que les technologies Tab et Flip - chip - Bonding.
4. DIP (double Encapsulation en ligne de colonne) Double Encapsulation en ligne de colonne. L'un des boîtiers enfichables avec des broches sortant des deux côtés du boîtier, le matériau d'emballage est en plastique et en céramique. Les fabricants européens de semi - conducteurs utilisent principalement dil. DIP est l'encapsulation plug - in la plus populaire et son champ d'application comprend les circuits logiques standard IC, les mémoires LSI et les circuits de micro - ordinateur. La distance au Centre des broches est de 2,54 mm et le nombre de broches est de 6 à 64. La largeur du boîtier est généralement de 15,2 MM. Certains boîtiers d'une largeur de 7,52 mm et 10,16 mm sont connus sous le nom de SK - Dip (Thin Two - column inline plug Package) et sl - Dip (Thin Two - column inline plug Package) narrowbody DIP, respectivement. Mais dans la plupart des cas, il n'y a pas de différence, ils sont simplement collectivement appelés DIP. En outre, la céramique DIP scellée avec du verre à bas point de fusion est également appelée cerdip (voir 4.2).
4.1dic (Dual column inline Ceramic Packaging) un nom particulier pour le boîtier en céramique DIP (y compris le joint en verre).
4.2cerdip: boîtier à double rangée en céramique scellé avec du verre pour circuits tels que ECL RAM, DSP (processeur de signal numérique), etc. Cerdip avec fenêtre en verre pour les circuits micro - informatiques avec EPROM effaçable UV et EPROM intégré. La distance au Centre des broches est de 2,54 mm et le nombre de broches est de 8 à 42. Au Japon, cet emballage est représenté par DIP - G (G pour Glass Seal).
4.3sdip (Shrink double inline plug Packaging) Shrink DIP. L'un des boîtiers enfichables, de même forme que le DIP, mais avec une distance au centre de la broche (1778 mm) inférieure à celle du DIP (2,54 mm), est donc appelé à cet effet. Le nombre de broches est compris entre 14 et 90. Il existe deux types de céramique et de plastique. Aussi connu sous le nom de SH - Dip (Shrink Dual - column inline plug Packaging)
5. Retournez la puce retournez la puce. L'une des techniques d'encapsulation à puce nue consiste à réaliser des plots métalliques dans les zones d'électrodes de la puce LSI, puis à relier les Plots métalliques aux zones d'électrodes du substrat imprimé par soudage sous pression. L'empreinte du boîtier est sensiblement la même que la taille de la puce. C'est la plus petite et la plus fine de toutes les technologies d'emballage. Cependant, si le coefficient de dilatation thermique du substrat est différent de celui de la puce LSI, une réaction se produira au niveau de la jonction, ce qui affectera la fiabilité de la connexion. Il est donc nécessaire d'utiliser une résine pour renforcer la puce LSI et d'utiliser un matériau de substrat ayant sensiblement le même coefficient de dilatation thermique.
6. FP (paquet plat) paquet plat. Un des packs de montage en surface. Un autre nom pour qfp ou SOP (voir qfp et SOP). Certains fabricants de semi - conducteurs utilisent ce nom.
7. H - (avec radiateur) signifie marque avec radiateur. Par exemple, hsop signifie SOP avec radiateur.
8. MCM (module multi - puce) composant Multi - puce. Un boîtier dans lequel plusieurs puces semi - conductrices nues sont assemblées sur un substrat de câblage. Selon le matériau du substrat, il peut être divisé en trois catégories: MCM - L, MCM - C et MCM - D. MCM - l est un composant qui utilise des cartes de circuits imprimés multicouches en résine époxy de verre ordinaire. La densité de câblage n'est pas très élevée et le coût est faible. Le MCM - C utilise la technologie des couches épaisses pour former un câblage multicouche et utilise de la céramique (alumine ou vitrocéramique) comme composant de substrat, ce qui est similaire à un ci hybride à couches épaisses utilisant un substrat en céramique multicouche. Il n'y a pas de différence évidente entre les deux. La densité de câblage est supérieure à celle du MCM - L. MCM - D est l'utilisation de la technologie des couches minces pour former un câblage multicouche avec de la céramique (oxyde d'aluminium ou Nitrure d'aluminium) ou du silicium, de l'aluminium comme composants du substrat. Le schéma de câblage est le plus élevé des trois composants, mais il est également coûteux.