マルチチップパッケージ(MCP)は、長期にわたり、ますます小さくなる空間(PCB)におけるより多くの性能と機能のパッケージ化のニーズを満たしてきた。ベースバンドやマルチメディアプロセッサのようなASICを含むようにメモリのMCPが拡張されることが望ましいのは自然である。しかし、高い開発コストと所有権/コスト削減という困難もあります。これらの問題をどのように解決しますか。カスケードICパッケージ(POP)の概念は業界で広く受け入れられている。
POP(Packaging on Packaging)は、スタックコンポーネントとも呼ばれ、包装層とも呼ばれます。POPは、2つ以上のbga(グリッドアレイパッケージ)が積層されたパッケージです。一般的に、POPのスタックパッケージ構造はBGA半田ボール構造を採用し、POPパッケージの底に高密度デジタルまたはハイブリッド信号論理デバイスを集積し、多ピン論理デバイスの特徴を満たす。POPは新型の高度に統合された包装形式として、主に現代のスマートフォン、デジタルカメラなどの携帯型電子製品に応用され、非常に広範な役割を果たしている。

MCPは、異なるサイズの様々なタイプのメモリまたは非メモリチップをプラスチックパッケージの筐体に垂直に積層するハイブリッド技術である。これにより、小型プリント配線基板PCBのスペースを節約することができる。
アーキテクチャの観点から見ると、SIPはプロセッサ、メモリ、その他の機能チップを含む複数の機能チップを1つのパッケージに統合し、基本的な完全な機能を実現する。端末電子製品の角度から見ると、SIPはチップ自体の性能/消費電力に注目するだけでなく、端末電子製品全体の短さ、薄さ、多機能、低消費電力を実現した。モバイル機器やウェアラブルデバイスなどの軽量化製品の台頭に伴い、SIPの需要はますます明らかになってきている。
SoCの基本概念は、同じベアメタルチップにより多くのデバイスを集積し、サイズの縮小、パフォーマンスの向上、コスト削減を実現することです。しかし、プロジェクトのライフサイクルが短く、コスト要件が高い携帯電話市場では、SOCソリューションには大きな限界があります。メモリ構成の観点から見ると、異なるタイプのメモリには多くのロジックが必要であり、異なる設計規則と技術を習得することは非常に困難であり、開発時間とアプリケーションに必要な柔軟性に影響を与える可能性があります。
SOCとSIP
SOCとSIPは、両方とも論理コンポーネント、メモリコンポーネント、またはパッシブコンポーネントを含むシステムを1つのユニットに統合するため、非常に似ています。設計の観点から見ると、SOCはシステムに必要なコンポーネントのチップ上の高度な集積である。パッケージの観点から見ると、SIPは異なるチップのための並列または重畳パッケージ方法である。これは単一の標準パッケージであり、いくつかの機能を実現するために、異なる機能を持つ複数の能動電子部品、オプションの受動デバイス、MEMSや光学デバイスなどの他のデバイスを統合しています。
統合の面では、一般的にSoCはAPなどの論理システムだけを統合し、SIPはAP+MobileDRを統合する。ある程度、SIP=SoC+DDRである。将来的に統合度が高くなるにつれて、EMMCはSIPに統合される可能性が高い。パッケージの発展の角度から見ると、電子製品の体積、加工速度または電気特性の要求のため、SOCは将来の電子製品設計の重点と発展方向として確立されている。しかし、近年のSOC生産コストの増加と技術的障害の頻繁な出現に伴い、SOCの発展はボトルネックに直面し、SIPの発展はますます業界の注目を集めている。
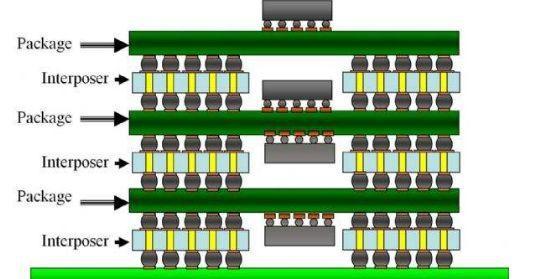
MCPからPOPへの発展経路
複数のFlash NOR、NAND、RAMを1つのパッケージに統合したコンポジット(Flash+RAM)メモリ製品は、携帯電話アプリケーションに広く使用されています。これらのシングルパッケージソリューションには、マルチチップパッケージ(MCP)、システムレベルパッケージ(SIP)、マルチチップモジュール(MCM)が含まれる。
ますます小さくなる携帯電話機においてより多くの機能を提供するためのニーズはMCPの成長の主な駆動力であるが、小さなサイズを維持しながら性能を向上させるソリューションの開発は困難な課題である。サイズだけでなく、携帯電話でベースバンドチップセットやマルチメディアコプロセッサを使用する場合、SDRAMとDDRインタフェースを持つMCPメモリを使用するなど、性能にも問題があります。
POPスタックパッケージは高度に統合された小型化を実現する良い方法である。スタックパッケージでは、パッケージ外(POP)は論理ユニットを高密度にスタックできるため、パッケージ業界、特にモバイルアプリケーションでますます重要になっています。
POPパッケージの利点
1.ストレージデバイスと論理デバイスは別々にテストまたは交換して、生産性を確保することができます。
2.2層POPパッケージは基板面積を節約し、より大きな縦方向空間はより多くのパッケージ層を許可する、
3.縦方向PCBに沿ってDRAM、DDRAMSRAM、FLASH及びマイクロプロセッサを混合する、
4.異なるメーカーのチップに対して、設計の柔軟性を提供し、簡単に混合して顧客のニーズを満たすことができ、設計の複雑性とコストを下げる、
5.現在、この技術は垂直方向に層チップを被覆して組み立てるために使用することができ、
6.上部デバイスと下部デバイスが積層された電気接続により、論理デバイスと記憶デバイスとの高速相互接続に対応できる、より高速なデータ転送速度を実現