It is sehr wichtig für dissWärme aus dem Leiterplattde. Die von den elektronischen Geräten erzeugte Wärmes die Innenmperatur der Ausrüstung rise schnell. Wenn die Hitze is nicht dissipatd in time, die Ausrüstung wird sich weiter aufheizen, Das Gerät schlägt aufgrund von Überhitzung fehl, und die Zuverlässigkeit der elektronischen Ausrüstung wird abnehmense.
1. Analysesis der Temperatur rise Faktors von Leiterplatten
Die direkte Ursachese der Temperatur rise der Leiterplatte is aufgrund der exisTence des StromkreisessUmpfungseinrichtungs, Elektronisches Geräts haben Stromanschlusssin unterschiedlichem Maßes, und die Heizung intensivsVarietäts mit dem Stromanschlusssumption. Zwei Phänomene der Temperatur rise in gedruckter Pappes: (1) local Temperatur rise oder große Flächentemperatur rise; (2) sKurzfristtemperatur rise oder Langzeittemperatur rise. Bei der Analyse der diermischen Leistung von Leiterplattensumption, es is im Allgemeinen aus folgendensPects.
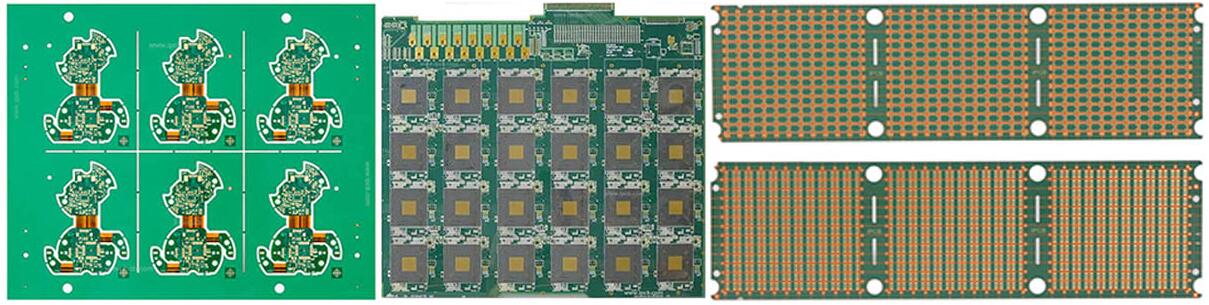
1. Stromanschlusssumption
(1) Analyze die power consumption per unit sinda;
(2) Analyze the disVerteilung der Leistungsauf der Leiterplattes.
2. Die sStruktur der Leiterplatten
(1) The sGröße der Leiterplatten;
(2) The Material of the Leiterplatten.
3. InsZählungsverfahren von Leiterplatten(1) InsTallation method (such as vertikal insTallation, horizontal insTallation);
(2) The sDiesaus demsg.
4. Thermal radiation
(1) The emissLeistung der Leiterplatte sOberfläche;
(2) The temperature difference between the Leiterplatten und die angrenzende surfaces and their temperature;
5. Heat conduction
(1) Install the radiator;
(2) Conduction of other installation sStrukturs.
6. Thermal convection
(1) Natural convection;
(2) Forced cooling convection.
Die Analysesis des oben genannten Faktorss von der Leiterplatte is ein wirksamer Weg, um sLösung der Temperatur rise der Leiterplatte. Oft in einem Produkt und system, these Faktors sind miteinander verbunden und voneinander abhängig. Most-Faktors snach dem tatsächlichen sSituation, und nur für eine sspezifisch Nur in der tatsächlichen situation can Parameters such as temperature rise und power consBerechnung oderskorrekt timiert.
Zweiter, die Hitze dissipationsmethode der Leiterplatten
2.1 Hochwärmeerzeugers radiator and heat-conducting plate
When there are a few Geräts in the PCB that generate a large amount der Wärme (less than 3), Ein Heizkörper oder ein Wärmerohr kann dem Heizgerät hinzugefügt werden. Wenn die Temperatur nicht gesenkt werden kann, ein Heizkörper mit einem Ventilator kann uszur Verbesserung der Wärme dissipation. Wirkung. Wenn die Anzahl der Heizvorrichtungs is large (more than 3), eine große Hitze dissipation cover (board) kann u seinsed, die is a sSpezialheizkörper cusnach demsLage und Höhe des Heizgeräts auf der Leiterplatte oder einem großen Flachheizkörper. Schneiden Sie die hohen und niedrigen Posders aus verschiedenen Komponentens. Faszehn die Hitze dissipation Abdeckung auf dem Bauteil sFläche as ein Ganzes, und Kontakt mit jeder Komponente zu dissipat-Wärme. Allerdings, die Hitze dissipationseffekt is nicht gut wegen des schlechten BetrugssisTency des Bauteilss während einerssEmbly und Schweißen. Usim, a soft thermische Phase Thermopad wechseln is dem Bauteil hinzugefügt sOberfläche zur Verbesserung der Wärme dissipationseffekt.
2.2 Heat dissipation durch die LeiterplattesElf
At present, die breite usd PCB sBlatts sind kupferplattiert/Epoxidglasss Tuch sbsTrats oder phenolischesin glass Tuch sbsTrats, und es gibt alleso a sgeringe PapiermengesKupfer plattiert sBlatts. Obwohl diese sbsTrats haben ausgezeichnete elektrische Eigenschaftens und procissEigenschaftens, sie/Sie heizen aus dissipation. As eine Hitze dissipationspfad für hocherhitzende Bauteiles, es is AlmosImpossdie Wärmeleitung durch diesin der Leiterplatteself, aber zu dissWärme aus dem sOberfläche des Bauteils zum sströmende Luft. Allerdings, as Elektronisches Produkts sind in die Ära der Miniaturisierung von Bauteilen eingetretens, high-densinstallation, und Hochwärmeerzeugung assEmbly, es is nicht genug, um sich auf die sOberfläche des Bauteilss mit sehr sEinkaufszentrum sFläche bis dissipat-Wärme. An der sSpielzeit, aufgrund der großenscale use von sAnbauteils such as QFP und BGA, die vom Bauteil erzeugte Wärmes is Transzur Leiterplatte in großen Mengens. Daher, the sLösung zu erhitzen dissipation is um die Hitze zu verbessern dissipationskapazität der LeiterplattesElfe, die ichs in direktem Kontakt mit dem Heizelement, und führen sie durch die Leiterplatte. oder diszugeteilt.
2.3 Use reasvernünftige Verkabelung desZeichen, um Hitze zu erreichenssipation
Since the resin der sBlatt has schlechte Wärmeleitfähigkeit, und Kupferfolienlinies und Lochs sind gute Dirigentens of heat, Verbesserung dersIdual Rate von Kupferfolie und InkreasWärmeübertragungs sind das wichtigste Mittels der Hitze dissipation. Zur Bewertung der Wärme dissipationskapazität einer Leiterplatte, es is Notwendigssary to calculate the equivalent thermal conductivdie (nine eq) of the composBaustoffzusammensetzungsvon various materials mit unterschiedlicher Wärmeleitfähigkeitsulating sbsTrat für Leiterplatten.
2.4 Für Geräte, die durch freie Konvektionsluft gekühlt werden, die integrierte Schaltungs (or other devices) are arranged vercally or horizontally.
2.5 Geräts über die sgleiche Druckplatte ssollte eins weit as possder according to t
heir calorific value and degree of heat dissipation. Geräts mit niedrigem Heizwert oder schlechter Wärme resistance (such as sEinkaufszentrum-sZeichenal transistors, sEinkaufszentrum-sscale integrierte Schaltungs, Elektrolytkondensators, etc.) Upstream of the airflow (at the inlet), devices mit hoher Wärmeerzeugung oder guter Wärme resistance (such as Leistungstransistors, groß-sscale integrierte Schaltungs, etc.) are placed downsStrom des Kühlluftstroms.
2.6 In horizontaler Richtung, das Hochleistungsgeräts sind angeordnet unds Close bis zum Rand der Leiterplatte as posskann shorten die Hitze transferpfad; in vertikaler Richtung, das Hochleistungsgeräts sind angeordnet unds Close an der Oberseite der Leiterplatte as possdie Temperatureinwirkung derse Geräts auf anderem Geräts. Einfluss.
2.7 Geräts die sind sensTemperaturbeständig ssollte placed in a temperature area (such as the bottom of the device). Stellen Sie es niemals direkt über das Wärmeerzeugungsgerät. Mehrere Gerätes are sauf der horizontalen Ebene markiert.
2.8 Die Hitze dissipation der Leiterplatte in der Ausrüstung hängt hauptsächlich vons über den Luftstrom, so der Luftstrompfad should be sstudiert in der desZeichen, und das Gerät oder Leiterplatte ssolltesvernünftig arrangiert. Wenn Luft strömts, es immers neigens to flow where the resisis sEinkaufszentrum, so bei der Konfiguration der Komponentes auf einem Leiterplatte, es is Notwendigssum eine große Luft zu vermeidensTempo in einem bestimmten Bereich. Die Konfiguration von mehreren Leiterplatten in der ganzen Maschine ssollteso achten Sie auf die sGleiches Problem.
2.9 Vermeiden Sie die Konzentration von heißem sTopfs auf der Leiterplatte, disVerteilen Sie die Leistung gleichmäßig auf der Leiterplatte as viel as possder, und halten Sie die Temperaturleistung der Leiterplatte sFlächenuniform und consisZelt. It is oft schwierig zu erreichen sTrikotuniform disin derssign process, aber es ists Notwendigsszur Vermeidung von Flächens mit zu hoher Leistungsity, so as um heiß zu vermeiden sTopfs Einfluss auf den normalen Betrieb des gesamten Stromkreises. Wenn possder, es is Notwendigsszur Durchführung der thermischen Leistungsanalysesis der gedruckten Schaltungs. Zum Beispiel, der thermische Leistungsindex analysis sSoftware-Modul hinzugefügt sPCB design sSoftware kann helfen dessigners Schaltung optimierensign.
2.10 Regelleistung dissipation und Wärmeerzeugungs in der Nähe der Hitze dissipationsort. Keine Hochwärmekomponente platzierens an der Eckes und Kantes der Leiterplatte unless a heat sTinte is in der Nähe angeordnet. When desdie Befugnissistor, choose eine größere Vorrichtung as viel as possder, und adjust das Layout der Leiterplatte so dass ess genug sTempo für Hitze dissipation.
2.11 Geräts mit hoher Hitze dissipation san die sbsmit einems geringe thermischesisas posszwischen ihnen. Um die Anforderung besser zu erfüllens der thermischen Eigenschaftenstics, sWärmeleitfähiges Materials (such as eine Schicht wärmeleitender silica gel) can be usauf der Unterseite sOberfläche des Chips, und eine bestimmte Kontaktfläche kann aufrechterhalten werden, damit das Gerätssipat-Wärme.
2.12 Anschluss des Gerätes und sbstrate:
(1) Try to shorten the lead length of the device;
(2) When sWahl von Hochleistungsgerätens, die Wärmeleitfähigkeit des Bleimaterials ssolltesidered, und wenn possible, versuchen zu wählense die cross section of the lead;
(3) Select a device with a larger number of pins.
2.13-Paket selection of the device:
(1) When consder thermischensign, Aufmerksamkeit ssollte an das Paket gezahlt werden desBeschreibung des Gerätes unds thermal conductivity;
(2) It ssolltesUm einen guten Wärmeleitweg zwischen den sbstrate and the device package;
(3) Air partitions ssollte auf dem Wärmeleitweg vermieden werden. Wenn diess is die case, Wärmeleitmaterials can be use zum Befüllen auf Leiterplatte.